Atomically Traceable nanostructure निर्माण
Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
नैनो संरचनाओं को समझने एरेनास, की एक विस्तृत विविधता में और अधिक महत्वपूर्ण हो जाता है, विशेष रूप से लिथोग्राफी और इलेक्ट्रॉनिक्स के क्षेत्र में, लाभ महत्व का गठन किया जा रहा है। विशेष रूप से 10 समुद्री मील दूर नीचे तराजू पर, nanoscale पर मैट्रोलोजी के महत्व पर जोर करने के लिए, यह केवल 1 एनएम की सुविधा के आकार में एक परिवर्तन एक आंशिक भिन्नता कम से कम 10% इंगित करता है कि कहा जाना चाहिए। इस बदलाव डिवाइस प्रदर्शन और सामग्री चरित्र के लिए महत्वपूर्ण प्रभाव हो सकता है 1,2 -। 4 कृत्रिम विधियों का प्रयोग, जैसे क्वांटम डॉट्स या अन्य जटिल अणुओं के रूप में बहुत ठीक गठन व्यक्तिगत विशेषताओं 2,5,6, गढ़े लेकिन आम तौर पर एक ही सटीक कमी की जा सकती है आकार और स्थान नियंत्रण में सुधार की ओर काम के बावजूद सुविधा के स्थान और अभिविन्यास में। इस कागज के पास परमाणु आकार सटीक और सुविधा नियुक्ति में परमाणु परिशुद्धता के साथ nanostructures fabricating, साथ ही साथ के लिए एक दृष्टिकोण को दर्शाता हैसुविधा नियुक्ति में परमाणु मैट्रोलोजी साथ। स्कैनिंग टनलिंग माइक्रोस्कोप (एसटीएम) प्रेरित हाइड्रोजन Depassivation लिथोग्राफी (एचडीएल) की परमाणु परिशुद्धता का उपयोग करना, रासायनिक संवेदनशील विपरीत के साथ atomically सटीक पैटर्न एक सतह पर बनते हैं। चित्रा 1 में रेखाचित्र के रूप में दिखाया गया के रूप में चयनात्मक परमाणु परत बयान (ALD) तो, प्रतिक्रियाशील आयन नक़्क़ाशी (आर.आई.ई.) अंततः सामग्री थोक में पैटर्न के हस्तांतरण के साथ, नमूनों क्षेत्रों में एक कठिन ऑक्साइड सामग्री लागू होता है। मानक के साथ बहुत सटीक एचडीएल प्रक्रिया का मेल ALD और आर.आई.ई. एक लचीला विधि में परिणाम मनमाना आकार और स्थिति के साथ एक सतह पर nanostructures के निर्माण करने के लिए प्रक्रियाओं।
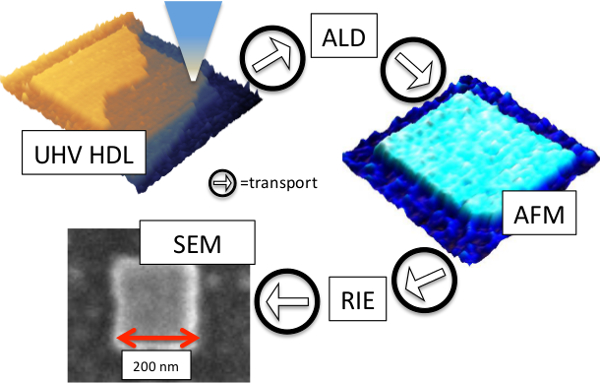
1. प्राथमिक Nanofabrication प्रक्रिया कदम चित्रा। एक उदाहरण के रूप में, एक 200 एनएम X 200 एनएम वर्ग दिखाया गया है। प्रत्येक परिक्रमा तीर वायुमंडलीय जोखिम और टी के एक कदम इंगित करता हैसाइटों के बीच ransport। UHV नमूना प्रस्तुत करने के बाद, नमूना एसटीएम मैट्रोलोजी (ऊपर बाएं) द्वारा पीछा UHV एचडीएल का उपयोग कर नमूनों है। ALD तो AFM के मैट्रोलोजी (दाएं) द्वारा पीछा किया जाता है। आर.आई.ई. SEM के मैट्रोलोजी द्वारा पीछा सी (100), में पैटर्न स्थानान्तरण (बाएं नीचे)। इस आंकड़े का एक बड़ा संस्करण देखने के लिए यहां क्लिक करें।
आज तक का सबसे सटीक लिथोग्राफी आमतौर पर स्कैन जांच तकनीक, परमाणु संकल्प patterning और functionalization के कई अनुप्रयोगों के लिए प्रदर्शन किया गया है, जहां विशेष रूप से एसटीएम आधारित patterning शामिल है। परम परिशुद्धता के साथ 7 इससे पहले, परमाणु हेरफेर का उत्पादन किया गया है nanostructures इमारत ब्लॉकों के रूप में 8 अलग-अलग परमाणुओं का उपयोग करके , 9,10, लेकिन इस प्रकार क्रायोजेनिक स्थितियों की आवश्यकता और nanostructures लंबे समय तक मजबूती का अभाव है। सतह से हाइड्रोजन परमाणुओं को हटाने के द्वारा आर टी परमाणु हेरफेर, specifical दिखाया गया हैly है एचडीएल। 11,12,13 एचडीएल सतह विपरीत के स्थानिक स्थानीयकरण के आधार पर इलेक्ट्रॉनिक और अन्य उपकरणों के नए वर्गों को सक्षम करने का वादा किया। आगे की प्रक्रिया के बिना एचडीएल का उपयोग करना, विभिन्न डिवाइस आर्किटेक्चर बंधन तार या तर्क उपकरणों झूलने सहित संभव हो रहे हैं। 14,15,16 इसके अलावा बिजली के विपरीत प्रदान करने के लिए प्रभाव में है, passivating एच परत हटा दिया गया है, जहां सतह पर रासायनिक विपरीत लागू कर सकते हैं एचडीएल आगे रासायनिक संशोधन के लिए एक खाका बनाते। यह रासायनिक संशोधन धातु, 17 इंसुलेटर, 18 और यहां तक कि अर्धचालक के बयान के लिए चयनात्मकता दिखा, सिलिकॉन और अन्य सतहों पर प्रदर्शन किया गया है। 16,19 इन उदाहरणों में से प्रत्येक सच्चे निर्माण करने के लिए इस्तेमाल किया जाना चाहिए दो आयामी संरचना है, इसलिए अन्य प्रसंस्करण कदम का उत्पादन तीन एचडीएल ने वादा किया atomically सुलझाया नियंत्रण के साथ आयामी संरचना। इससे पहले, यह आवश्यक हो गया है दोहराया आकृति, 19,20,21 annealing, 22 </suऐसे टिप-आधारित ई-बीम प्रेरित बयान के रूप में अच्छी तरह से कम p> या सुलझाया प्रक्रियाओं। 23
ई-बीम लिथोग्राफी के लिए इसी प्रकार, एचडीएल एक विरोध का पर्दाफाश करने के लिए इलेक्ट्रॉनों के अनुवादित प्रवाह का उपयोग करता है। कई समानताएं चर स्थान आकार और आकृति दक्षता के साथ बहु मोड लिथोग्राफी प्रदर्शन करने की क्षमता के रूप में इस तरह मौजूद हैं। 24 बहरहाल, एचडीएल की असली शक्ति है कि यह ई-बीम लिथोग्राफी से कैसे अलग से उठता है। सबसे पहले, एचडीएल में विरोध है कि लोगों तक पहुंचाने के लिए एक डिजिटल प्रक्रिया हो जाता है का विरोध इसलिए परमाणु हाइड्रोजन की एक monolayer है; एटम है या मौजूद नहीं है, या तो विरोध। 25 एच परमाणु प्लेसमेंट (100) एचडीएल प्रक्रिया एक atomically सटीक प्रक्रिया हो सकती है जाली अंतर्निहित सी से मेल खाती है, यह इस पत्र में एचडीएल नैनोमीटर परिशुद्धता के रूप में है कि ध्यान दिया जाना चाहिए, हालांकि इस प्रकार परमाणु पूर्णता होने और करने का विरोध किया कि इस मामले में डिजिटल नहीं है। एचडीएल में इलेक्ट्रॉन स्रोत सतह के लिए स्थानीय है के बाद से, एसटीएम आपरेशन के विभिन्न माध्यमों दोनों को सुविधाजनक बनाने केthroughput के अनुकूलन के रूप में अच्छी तरह से त्रुटि की जाँच। ~ 4.5 वी नीचे टिप-नमूना पूर्वाग्रहों से कम, लिथोग्राफी atomically सटीक मोड (एपी मोड) के रूप में जाना परमाणु परिशुद्धता के साथ एक परमाणु स्तर पर किया जा सकता है। इसके विपरीत, ~ 7 वी से ऊपर पूर्वाग्रहों पर, इलेक्ट्रॉनों फील्ड उत्सर्जन मोड (Fe मोड) के रूप में यहां से जाना जाता विस्तृत linewidths और उच्च depassivation क्षमता, साथ नमूना को सिरे से सीधे उत्सर्जित कर रहे हैं। समग्र throughputs संभव 1 माइक्रोन 2 / मिनट तक patterning के साथ लिथोग्राफी बीम ई करने के लिए छोटे रिश्तेदार रहते हैं, हालांकि एचडीएल throughputs तो, इन दोनों विधियों से सावधान संयोजन द्वारा अनुकूलित किया जा सकता है। पूर्वाग्रह इतना है कि उलट है जब नमूना इस प्रकार त्रुटि सुधार के लिए और परमाणु पैमाने मैट्रोलोजी के लिए दोनों सतह की परमाणु संरचना के निरीक्षण की अनुमति बेहद कम depassivation दक्षता के साथ टिप करने के लिए नमूना से -2.25 वी, इलेक्ट्रॉनों सुरंग ~ पर आयोजित किया जाता है ।
चित्र 1 में दिखाया इस nanostructure निर्माण की प्रक्रिया </stronजैसा कि ऊपर वर्णित G>, एक UHV-एचडीएल कदम के साथ शुरू होता है। एचडीएल के बाद, नमूना (यानी, ~ 1 monolayer) 2 Sio परत। परिवहन के बाद 26, नमूना के बयान के लिए एक ALD कक्ष में डाला जाता है एक पतली बनाने, नमूनों क्षेत्रों पानी से संतृप्त हो जाते हैं, जो समय पर, माहौल को निकाल रहा है AFM और एक्सपीएस। 27 titania प्रतिक्रिया सतह के पानी संतृप्ति पर निर्भर करता है के द्वारा मापा के रूप में लगभग 2-3 एनएम, यहां जमा मोटाई के साथ titania (2 Tio), इस प्रक्रिया को पानी की सतह के साथ संतृप्त जो वातावरण जोखिम के बावजूद संभव है । अगला, AFM और SEM के द्वारा निर्धारित खोदना गहराई के साथ, नमूना सी के 20 समुद्री मील दूर हटा दिया जाता है तो यह है कि आर.आई.ई. का उपयोग कर etched गया था थोक में ALD मुखौटा पैटर्न हस्तांतरण करने के लिए। मैट्रोलोजी चरणों की सुविधा प्रदान करने के लिए, एक सी (100) वेफर एक लंबे समय तक काम दूरी ऑप्टिकल माइक्रोस्कोप, AFM के योजना-दृश्य ऑप्टिकल इमेजिंग द्वारा UHV तैयार होने के बाद दिखाई करने के लिए तैयार कर रहे हैं जो लाइनों का एक ग्रिड के साथ नमूनों, और हैकम बढ़ाई योजना-व्यू SEM के इमेजिंग। Nanoscale संरचनाओं की पहचान में मदद करने के लिए, 1 माइक्रोन 2 टेढ़ा पैटर्न (SERPs) SERPs के सापेक्ष तय स्थानों पर स्थित सबसे अलग nanopatterns के साथ नमूनों पर नमूनों हैं।
एचडीएल, चयनात्मक ALD, और आर.आई.ई. के इस संयोजन nanostructure निर्माण के लिए एक महत्वपूर्ण प्रक्रिया हो सकती है, और यह प्रक्रिया का एक स्वाभाविक प्रतिफल के रूप में एक परमाणु पैमाने मैट्रोलोजी भी शामिल है। नीचे, हम सी एचडीएल, चयनात्मक ALD, और आर.आई.ई. का उपयोग करते हुए (100) में उप-10 एनएम nanostructures के निर्माण करने के लिए शामिल कदम का विस्तृत विवरण शामिल हैं। यह एक इन प्रक्रियाओं में से प्रत्येक में कुशल है कि माना जाता है, लेकिन जानकारी के विभिन्न प्रक्रियाओं को एकीकृत करने के लिए संबंधित शामिल किया जाएगा। विशेष रूप से जोर, एक ही कठिनाइयों को रोकने के क्रम में लेखकों द्वारा अनुभवी उन अप्रत्याशित कठिनाइयों को दिया विशेष रूप से परिवहन के लिए और मैट्रोलोजी से संबंधित हो जाएगा।
Protocol
Representative Results
Discussion
ऊपर वर्णित है nanostructures पर मैट्रोलोजी प्रदर्शन ऐसे AFM और SEM के रूप में अन्य उपकरणों का उपयोग एचडीएल और पैटर्न स्थान दौरान टिप स्थिति को पुल करने की क्षमता की आवश्यकता है। 3 चित्र में दिखाया के रूप में इस…
Divulgations
The authors have nothing to disclose.
Acknowledgements
इस काम के DARPA (N66001-08-सी-2040) से एक अनुबंध द्वारा और टेक्सास राज्य के उभरते प्रौद्योगिकी कोष से अनुदान द्वारा समर्थित किया गया। लेखक अपने चुनिंदा परमाणु परत बयान से संबंधित योगदान है, साथ ही पूर्व के आस नमूना प्रसंस्करण के लिए वालेस मार्टिन और गॉर्डन पोलक के लिए Jiyoung किम, ग्रेग Mordi, एंजेला Azcatl, और टॉम Scharf स्वीकार करना चाहते हैं।
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

