يمكن عزوها بالذرة البنية النانوية تلفيق
Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
كما يصبح أكثر أهمية تكنولوجيا النانو في مجموعة واسعة من المجالات، فهم الهياكل التي يجري تشكيلها مكاسب أهمية، وخاصة في مجالات الطباعة الحجرية والإلكترونيات. التأكيد على أهمية علم القياس على مقياس النانو، وتحديدا على مستويات أقل من 10 نانومتر، وتجدر الإشارة إلى أن الاختلاف في حجم الميزة فقط 1 نانومتر يشير إلى وجود تباين كسور لا يقل عن 10٪. هذا الاختلاف يمكن أن يكون لها آثار كبيرة على أداء الجهاز والطابع المادي 1،2 – 4 استخدام الأساليب الاصطناعية، والسمات الفردية شكلت بدقة متناهية مثل نقاط الكم أو الجزيئات المعقدة الأخرى يمكن أن تكون ملفقة، 2،5،6 ولكن تفتقر عموما نفس الدقة في ميزة التنسيب والتوجيه، على الرغم من العمل نحو تحسين حجم وموضع السيطرة. توضح هذه الورقة نهجا لافتعال النانو، بدقة تقترب من حجم الذرية والدقة الذرية في ميزة التنسيب، وكذلكمع المقاييس الذرية في ميزة التنسيب. باستخدام الدقة الذرية للمسح حفر نفق المجهر (STM) الهيدروجين الناجم عن Depassivation الطباعة الحجرية (HDL)، تتشكل أنماط دقيقة بالذرة مع تباين حساسة كيميائيا على السطح. ترسب طبقة الذرية الانتقائية (ALD) ثم يطبق مادة أكسيد الصلبة في المناطق المزخرف، مع رد الفعل ايون النقش (ري) نقل في نهاية المطاف أنماط في المواد السائبة، كما هو مبين في الشكل 1 تخطيطي. الجمع بين عملية HDL عالية الدقة مع المعيار ALD وRIE بمعالجة النتائج في طريقة مرنة لإنتاج النانو على السطح مع الشكل التعسفي وتحديد المواقع.
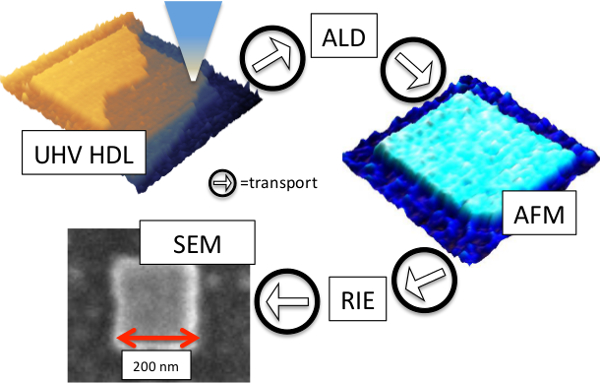
الشكل 1. Nanofabrication الابتدائية عملية خطوات. وكمثال على ذلك، يتم عرض 200 × 200 نانومتر نانومتر مربع. ويشير كل سهم دائري خطوة من التعرض في الغلاف الجوي ورransport بين المواقع. بعد الفائق عينة الإعدادية، هو نمط العينة باستخدام الفائق HDL تليها STM المقاييس (أعلى اليسار). ثم يتم تنفيذ محددة المدة، تليها AFM المقاييس (يمين). RIE نقل الأنماط في سي (100)، تليها SEM المقاييس (أسفل اليسار). الرجاء انقر هنا لمشاهدة نسخة أكبر من هذا الرقم.
والطباعة الحجرية أكثر دقة حتى الآن وعادة ما ينطوي تقنيات التحقيق الممسوحة ضوئيا، الزخرفة على وجه التحديد على أساس STM-حيث ثبت قرار الذري الزخرفة وfunctionalization للعديد من التطبيقات. 7 النانو سابقا، وقد أنتجت تلاعب ذرة بدقة متناهية باستخدام الذرات الفردية لبنات البناء، 8 ، 9،10 لكن النانو الشروط المطلوبة المبردة وبالتالي تفتقر إلى وقت طويل الأجل متانة. وقد تبين RT ذرة التلاعب عن طريق إزالة ذرات الهيدروجين من السطح، specificalلاي HDL. 11،12،13 HDL وعود لتمكين فئات جديدة من الأجهزة الإلكترونية وغيرها بناء على توطين المكاني على النقيض من السطح. باستخدام HDL دون مزيد من المعالجة، ومختلف أبنية جهاز ممكنة بما في ذلك التعلق الأسلاك السندات أو أجهزة منطق. 14،15،16 بالإضافة إلى توفير المقابل الكهربائية، HDL يمكن أن يعرض على النقيض الكيميائية على السطح حيث تمت إزالة تخميل H طبقة، في الواقع إنشاء قالب لمزيد من التعديل الكيميائي. وقد تجلى هذا التعديل الكيميائي على السيليكون وغيرها من الأسطح، والتي تبين الانتقائية لترسب المعادن، 17 العوازل، 18 وحتى أشباه الموصلات. 16،19 كل هذه الأمثلة تنتج هيكلين الأبعاد، خطوات المعالجة الأخرى لذلك يجب أن تستخدم لإنتاج ثلاثة صحيح هياكل الأبعاد مع السيطرة حلها بالذرة التي وعدت بها HDL. سابقا، وقد تطلب هذا الزخرفة المتكررة، 19،20،21 الصلب، 22 </suP> أو أقل جيدا حلها عمليات مثل القائم على طرف الإلكترونية شعاع الناجم عن ترسب 23
على غرار البريد شعاع الطباعة الحجرية، ويستخدم HDL على تدفق المترجمة من الإلكترونات لفضح مقاومة. وتوجد العديد من أوجه التشابه مثل القدرة على أداء متعدد الأوضاع الطباعة الحجرية مع متغير حجم البقعة والكفاءة الزخرفة. 24 ومع ذلك، فإن القوة الحقيقية لHDL تنشأ من كيف يختلف عن البريد شعاع الطباعة الحجرية. أولا، مقاومة في HDL هو أحادي الطبقة من الهيدروجين الذري بحيث تقاوم يصبح التعرض عملية الرقمية؛ ومقاومة ذرة إما هو أو غير موجود. 25 منذ وضع H ذرة يناظر سي الكامنة (100) شعرية عملية HDL يمكن أن يكون عملية دقيقة بالذرة، على الرغم من أنه تجدر الإشارة إلى أن في هذه الورقة HDL ديه دقة نانومتر كما بدلا من الاضطرار الكمال الذري وبالتالي ليس الرقمي في هذه الحالة. منذ مصدر الإلكترون في HDL المحلي إلى السطح، ومختلف وسائل عملية STM تسهل على حد سواءالإنتاجية الأمثل وكذلك فحص الخطأ. في التحيزات طرف عينة أدناه ~ 4.5 V، قد يتم تنفيذ الطباعة الحجرية على مستوى ذرة واحدة مع الدقة الذرية، والمعروفة باسم بالذرة وضع دقيق (وضع AP). في المقابل، في التحيزات فوق ~ 7 V، وتنبعث الإلكترونات مباشرة من طرف إلى العينة مع linewidths واسعة وكفاءات depassivation عالية، والمعروف هنا كما وضع الانبعاثات الميدان (وضع FE). ويمكن بعد ذلك الانتاجية HDL يكون الأمثل من قبل مجموعة حذرا من هذين الوضعين، على الرغم من أن الانتاجية الشاملة لا تزال صغيرة بالنسبة إلى البريد شعاع الطباعة الحجرية مع الزخرفة تصل إلى 1 ميكرومتر 2 / دقيقة الممكنة. عندما يتم عكس التحيز بحيث يتم عقد العينة في ~ -2.25 V، الإلكترونات نفق من العينة إلى طرف مع منخفضة للغاية كفاءة depassivation، مما يتيح فحص التركيب الذري من السطح على حد سواء لتصحيح الخطأ والمقاييس المقياس الذري .
هذه العملية تلفيق البنية النانوية هو مبين في الشكل 1 </stronز> يبدأ خطوة الفائق-HDL، كما هو موضح أعلاه. بعد HDL، وتنفيس العينة إلى الغلاف الجوي، في الوقت الذي المناطق نمط تصبح مشبعة بالماء، وتشكيل رقيقة (أي، ~ 1 أحادي الطبقة) شافي 2 طبقة. 26 وبعد النقل، ويتم إدخال العينة الى غرفة ALD لترسب تيتانيا (تيو 2)، مع سمك حوالي 2-3 نانومتر إيداع هنا، إذا ما قيست AFM وXPS 27 ولأن التفاعل تيتانيا يعتمد على تشبع المياه من السطح، وهذه العملية ممكنة على الرغم من تعرض الغلاف الجوي الذي يشبع السطح مع الماء . المقبل، لنقل نمط قناع ALD في الجزء الأكبر كان محفورا العينة باستخدام RIE بحيث تتم إزالة 20 نانومتر سي، مع عمق حفر يحددها AFM وSEM. من أجل تسهيل الخطوات المقاييس، ونمط وسي (100) رقاقة مع شبكة من الخطوط التي تم تصميمها لتكون واضحة بعد إعداد الفائق لمسافة طويلة في العمل المجهر الضوئي، والتصوير الضوئي AFM خطة الرأي، ومنخفضة التكبير خطة رأي SEM التصوير. للمساعدة في تحديد هياكل النانو، ومنقوشة أنماط 1 ميكرون 2 اعوج (بالاجور) على عينات مع nanopatterns الأكثر عزلة تقع في مواقع ثابتة قريبة بالاجور.
يمكن هذا المزيج من HDL، ALD انتقائية، وRIE تكون عملية هامة لالنانوية تلفيق، ويتضمن المقاييس المستوى الذري كمنتج ثانوي طبيعي من عملية. أدناه، ونحن تشمل وصفا مفصلا للخطوات المعنية لافتعال 10 نانومتر الفرعية النانو في سي (100) باستخدام HDL، ALD انتقائية، وري. يفترض أن واحد هو المهرة في كل من هذه العمليات، ولكن سيتم تضمين المعلومات المتعلقة بكيفية دمج مختلف العمليات. وسيتم التركيز بشكل خاص على تلك الصعوبات غير المتوقعة التي يمر بها الكتاب من أجل منع نفس الصعوبات، خصوصا المتعلقة بالنقل والمقاييس.
Protocol
Representative Results
Discussion
أداء القياس على النانو المذكورة أعلاه يتطلب القدرة على سد المواقع غيض خلال HDL ونمط الموقع باستخدام أدوات أخرى مثل AFM وSEM. وعلى النقيض من غيرها من أدوات الزخرفة متطورة مع ترميز مكانة عالية الدقة مثل البريد شعاع الطباعة الحجرية، تم إجراء HDL يؤديها هنا مع STM دون تحديد المو…
Disclosures
The authors have nothing to disclose.
Acknowledgements
وأيد هذا العمل من خلال عقد من DARPA (N66001-08-C-2040) ومنحة من صندوق التكنولوجيا الناشئة من ولاية تكساس. فإن الكتاب أن نعترف Jiyoung كيم، جريج Mordi، أنجيلا Azcatl، وتوم شارف على مساهماتهم المتعلقة انتقائية ترسب طبقة الذري، فضلا عن والاس مارتن وجوردون بولوك للخارج الموقع تجهيز العينات.
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

