Bruk av Offernanopartikler å fjerne effekten av Shot-støy i kontakt med Holes fabrikkert av E-beam Litografi
Summary
Jevnstore nanopartikler kan fjerne svingninger i kontakthulldimensjoner mønstret i poly (metylmetakrylat) (PMMA) fotoresist filmer av elektronstråle (E-stråle) litografi. Prosessen innebærer elektrotrakt til sentrum og innskuddsnanopartikler i kontakt hull, etterfulgt av fotoresist reflow og plasma- og våt-etsing trinn.
Abstract
Nano-mønstre fabrikkert med ekstrem ultrafiolett (EUV) eller elektronstråle (E-stråle) litografi utstillingen uventede variasjoner i størrelse. Denne variasjon har blitt tilskrevet statistiske fluktuasjoner i antall fotoner / elektroner som ankommer ved en gitt nano-region som følge av skudd-støy (SN). SN varierer inverst med kvadratroten av et antall fotoner / elektroner. For en fast dosering, er SN større i EUV og E-stråle litografier enn for tradisjonell (193 nm) optisk litografi. Bottom-up og top-down mønstrings tilnærminger kombineres for å minimalisere virkningene av skutt støy i nano-hulls mønster. Nærmere bestemt, et amino-silan overflateaktive selv setter sammen på en silisiumskive som deretter ring belagt med et 100 nm film av en PMMA-baserte E-stråle-fotoresist. Eksponering til E-bjelke og den påfølgende utvikling avdekke det underliggende overflateaktive film ved bunnen av hullene. Dyppe kjeks i en suspensjon av negativt ladet, citrat-capped, 20 nm ggamle nanopartikler (BNP) innskudd en partikkel per hull. Den eksponerte positivt ladet overflateaktivt middel film i hullet elektrostatisk trakter den negativt ladede nanopartikkel til sentrum av en eksponert hullet, som permanent fikserer posisjons registret. Deretter ved oppvarming nær glassovergangstemperaturen for polymeren fotoresist, flyter det fotoresistente film og omslutter nanopartikler. Denne prosessen sletter hullene er berørt av SN men forlater avsatt GNPs låst på plass av sterke elektro bindende. Behandling med oksygenplasma eksponerer GNPs ved å etse et tynt lag av fotoresist. Wet-etse de eksponerte GNPs med en løsning av I 2 / KI gir ensartede hull ligger i sentrum av fordypninger mønstrede av E-beam litografi. Forsøkene viser at den presenterte fremgangsmåten reduserer variasjonen i størrelsen på hullene forårsaket av SN fra 35% til under 10%. Fremgangsmåten utvider mønstrings grensene for transistoren kontakthullene til under 20 nm.
Introduction
Den eksplosive veksten i regnekraft, som kvantifiseres ved Moores lov 1, 2 (1), er et resultat av progressive fremskritt i optisk litografi. I denne top-down mønster teknikk, den oppnåelige oppløsning, R, er gitt av den kjente Raleigh teorem 3:

Her, λ og NA er lys bølgelengde og numerisk apertur, henholdsvis. Legg merke til at NA = η · sinØ, hvor η er brytningsindeksen for mediet mellom linsen og skiven; θ = tan-1 (d / 2l) for diameteren, d, til linsen, og avstanden, l, mellom sentrum av linsen og skiven. I løpet av de siste femti år har den litografiske oppløsningen forbedres ved bruk av (a) lyskildes, inkludert excimer lasere, med gradvis mindre UV bølgelengder; (b) smarte optisk design syssels fase skift masker 4; og (c) høyere NA. For eksponering i luft (η = 1), er NA alltid mindre enn enhet, men ved å innføre en væske med η> 1, slik som vann 5, mellom linsen og skiven, kan NA være forhøyet over en, for derved å forbedre oppløsningen av nedsenking litografi. Foreløpig levedyktige veier til en 20-nm node og utover inkluderer ekstreme UV-kilder (λ = 13 nm) eller mønstrings teknikker ved hjelp av komplekse doble og firedoble behandlingen av en flerlags fotoresist 6, 7.
Ved nanometer-lengdeskala, statistiske svingninger, forårsaket av skudd-støy (SN), i antallet av fotoner som kommer innen et nano-region forårsake variasjon i dimensjonene lithogra pHIC mønstre. Disse effektene er mer uttalt med eksponering for høy energi EUV lys og E-bjelker, systemer som trenger størrelsesordener færre fotoner / partikler i forhold til normal optisk litografi 8. Super kjemisk forsterket (med en kvantevirkningsgrad> 1) fotoresister også innføre en kjemisk SN forårsaket av en variasjon i antallet av fotoreaktive molekyler i utsatte nanoregions 9, 10. Lavere følsomhet photoresists som trenger lengre eksponeringer undertrykke disse effektene, men også redusere gjennomstrømningen.
På den molekylære skala, til bidraget line-kant ruhet fra molekylstørrelsefordeling som ligger til fotoresist polymerer kan bli redusert ved hjelp av molekylære motstår 11. En tilnærming som er komplementær til denne top-down prosessering av nano-mønster er bruk av bottom-up metoder 12,s = "xref"> 13 som er avhengige spesifikt på den rettede selvbygging (DSA) av diblokk polymerer 14. Evnen av disse fremgangsmåter for å lede kjernedannelse og for å skape ikke-uniform avstand mellom ønskede mønstre, som for eksempel hull eller ledninger, forblir utfordrende. Størrelsesfordelingen av molekylære komponenter 15, 16 også begrenser omfanget og utbyttet av fabrikasjons 17, 18. Lignende problemer begrense mikro utskrift av nanopartikler i myk litografi 19.
Dette notatet presenterer studier av en ny hybrid tilnærming (figur 1) som kombinerer klassisk top-down projeksjon litografi med elektro rettet selvbygging for å redusere effekten av SN / line-edge ruhet (LER) 20. Positivt ladet amingrupper på selv-sammensatte enkeltsjikt (SAMS) N – (2-aminoetyl)-11-Amino-undecyl-metoksy-silan (AATMS) som ligger under PMMA-filmen blir eksponert etter fremkalling. Den negativt ladet fotoresist film av PMMA elektro trakter negativt ladet gull nanopartikler (GNPs), avkortet med citrate, 21-24 i SN-påvirket hull 25. Re-flyt av PMMA fotoresist omslutter predeposited nanopartikler i filmen.
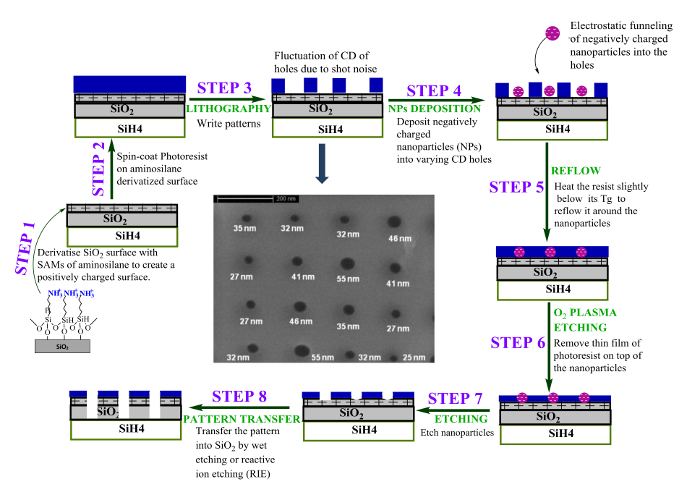
Figur 1: Skjematisk fremstilling av strategien for å fjerne effekten av shot-noise og line-edge ruhet for fordelingen av kontakt hullene ved hjelp av NPs av nøyaktig størrelse. Her er den kritiske dimensjon (CD) er den ønskede diameteren av hullene. Tilnærmingen (trinn 1) begynner med å avsette en selv-sammenstilt monolaget (SAM) silan-molekyl som bærer positivt ladede amingrupper på oksydet surfeess av en silisiumskive. Deretter blir E-stråle-litografi som brukes til å mønster hullene (trinn 2 og 3) i PMMA fotoresistent film, det blå lag, som genererer shot-noise, som vist i den innfelte SEM-bilde. Litografi eksponerer amingrupper i bunnen av hullene. Trinn 4 innebærer vannfasen deponering av kontrollert størrelse, citrat-avkortet (negativt ladet) gullnanopartikler (GNPs) i litografisk mønstrede hullene ved hjelp av elektrotrakt (EF). I trinn 5, varme skiven til 100 ° C, under glassovergangstemperaturen for PMMA, 110 ° C, fører til at flyt av fotoresist rundt forhånds avsatt nanopartikler. Etsing belagt PMMA med oksygenplasma (trinn 6) eksponerer GNPs, og etterfølgende våt-etsing (jod) av de eksponerte partikler (trinn 7) danner hull som tilsvarer størrelsen på GNPs. Når dette kombineres med reaktiv-ione / våt-etsing, er det mulig å overføre hullmønsteret i fotoresist på SiO2 (trinn 8) 31. Retrykt med tillatelse fra referanse 20. Klikk her for å se en større versjon av dette tallet.
Den elektrostatiske interaksjon mellom de motsatt ladede GNPs og amingrupper på substratet hindrer forskyvning av GNPs fra bindingssetet. Den reflow trinnet opprettholder den relative plasseringen av GNPs men sletter hullene og effektene av SN / LER. Plasma / våte etsetrinn regenerere hull som har størrelsen av BNP. Reaktiv-ion etsing overfører sitt mønster til SiO 2 hard-maske lag. Metoden baserer seg på bruk av mer ensartet størrelse nanopartikler enn en mønstret nanohole (NH), uttrykt som standardavvik, σ, slik at σ BNP <σ NH. Denne rapporten fokuserer på trinn (4 og 5 som er beskrevet i figur 1) som involverer avsetning av nanopartikler fra dispersjonen og denflyt av fotoresist rundt dem for å vurdere fordeler og begrensninger av fremgangsmåten. Begge trinnene er, i prinsippet, skalerbar til større substrater, krever ingen utstrakt modifikasjon av den strømflyten for fremstilling av moderne integrerte kretser på brikker.
Protocol
Representative Results
Discussion
Skudd-støy (SN) i litografi er en enkel følge av statistiske variasjoner i antallet av fotoner eller partikler (N) som ankommer i en gitt nano-region; Det er omvendt proporsjonal med kvadratroten av et antall fotoner / partikler:

hvor A og r er arealet og størrelsen på det eksponerte område, henholdsvis. For eksempel, ved bruk av en ArF 193 nm (6,4-eV) excimer laser til mønster 50…
Declarações
The authors have nothing to disclose.
Acknowledgements
Intel Corporation finansiert dette arbeidet gjennom tilskudd nummer 414 305, og Oregon nanoteknologi og mikroteknologi Initiative (ONAMI) gitt samsvarende midler. Vi erkjenner takknemlig støtte og råd av Dr. James Blackwell i alle faser av dette arbeidet. En spesiell takk går til Drew Beasau og Chelsea Benedict for å analysere partikkel posisjonering statistikk. Vi takker professor Hall for en grundig lesning av manuskriptet og Dr. Kurt Langworthy, ved University of Oregon, Eugene, OR, for hans hjelp med E-beam litografi.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referências
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

