Kurban Nanopartiküller Kullanım E-ışın Litografi tarafından Fabrikasyon İletişim Holes Shot gürültü Etkilerinin çıkarmak
Summary
Düzgün boyutlu nanopartiküller elektron demeti (E-ışını) litografi poli (metil metakrilat) desenli temas delik boyutları (PMMA) fotorezist filmlerde dalgalanmaları kaldırabilirsiniz. süreç fotorezist yeniden akıtma ve Plazma ve ıslak aşındırma adımları takip temas delik merkezi ve mevduat nanopartiküller, elektrostatik hunileflme- içerir.
Abstract
Nano desenler aşırı ultraviyole (EUV) veya elektron ışın demeti (E-ışını) boyutunda litografi sergi beklenmedik varyasyonları ile fabrikasyon. Bu varyasyon atış-gürültü (SN) kaynaklanan belirli bir nano-bölge ulaşan fotonlar / elektron sayısı istatistiksel dalgalanmalar sanılıyor. SN foton / elektron sayının kare köküne ters orantılı olarak değişir. sabit bir doz için, SN geleneksel (193 nm) optik litografi için daha EUV ve E-ışın litografiler büyüktür. Aşağıdan yukarıya ve yukarıdan aşağıya desenlendirme yaklaşımları nano delik desen çekildi gürültü etkilerini en aza indirmek için birleştirilmiştir. Spesifik olarak, daha sonra, bir PMMA esaslı e-ışını Fotorezist 100 mil film ile dönmeye kaplı bir silikon gofret bir amino-silan yüzey aktif madde kendi kendine bir araya getirmektedir. E-kiriş ve sonraki gelişimi maruz kalma delik diplerinde yatan yüzey filmi ortaya çıkarmak. negatif yüklü, sitrat-kapaklı, 20 nm g bir süspansiyonuna gofret daldırmaEski nanopartiküller (GSMH) mevduat delik başına bir parçacık. delik maruz pozitif yüklü yüzey filmi elektrostatik kalıcı pozisyonel kayıt gideren maruz delik, ortasına negatif yüklü nanoparçacık huniler. Sonra, paslanmaz çeliğin polimerin cam geçiş sıcaklığına yakın ısıtılması, fotorezist filmi yeniden yapılandırabilir ve nano-parçacıkları engulfs. Bu süreç SN etkilenen delikleri siler ancak bağlayıcı güçlü elektrostatik yerinde kilitli yatırılan GNPs bırakır. oksijen plazma ile muamele fotorezist ince bir tabaka oyma ile GNPs ortaya çıkarır. I 2 çözeltisi ile maruz GNPs Islak gravür / KI E-ışın demeti litografi desenli girinti merkezinde bulunan düzgün delikleri elde edilir. Deneyler bir yaklaşım% 10 altına kadar% 35 arasında SN neden delik boyutundaki değişmeyi azaltmaktadır göstermek sunulmaktadır. yöntem aşağıda 20 nm Transistör temas delik desenlendirme sınırlarını genişletir.
Introduction
Moore yasasına 1, 2 (1) ile sayısal olarak hesaplama gücü katlanarak büyümesi, optik litografi ilerleyici ilerlemelerin bir sonucudur. Bu yukarıdan aşağıya desenlendirme tekniği, ulaşılabilir çözünürlük, R, tanınmış Raleigh teoremi 3 ile verilir:

Burada, λ ve NA sırasıyla ışık dalga boyu ve sayısal açıklık vardır. Η lens ve gofret arasında ortamın kırılma endeksi NA olduğu = η · sinθ Not; lens ve gofret merkezi arasındaki θ = tan -1 (d / 2l) çap, d, lens ve mesafe, l. Son elli yılda, litografik çözünürlük: (a) bir ışık kaynağı kullanılarak geliştirilmişgiderek daha küçük UV dalga boyları olan eksimer lazerler de dahil olmak üzere, örneğin; (b) faz kayması maskeleri 4 kullanan akıllı optik tasarımlar; ve (c) daha yüksek NA. Hava (η = 1) 'de maruz kalma, NA birlik daha ama bir sıvı getirerek her zaman daha azdır lens ve gofret arasında böyle su 5 olarak Hm> 1, ile, NA ve böylece daldırma litografi çözünürlüğünü artırmak, 1 yüksekte olabilir. Şu anda ötesinde canlı 20 nm düğüme yolları ve çok katmanlı paslanmaz çeliğin 6, 7 karmaşık çift ve dört kişilik işlem kullanarak, aşırı UV kaynaklarının (λ = 13 nm) veya desenlendirme teknikleri içermektedir.
lithogra boyutlarında bir nano-bölge neden varyasyon içinde gelen fotonların sayısının atış-gürültü (SN) neden nanometre uzunluk ölçeklerinde istatistiksel dalgalanmalar, en phic desenler. Bu etkiler, yüksek enerji EUV ışığı ve e-kiriş normal optik litografi 8 ile karşılaştırıldığında büyüklüğü daha az fotonlar / parçacıkların emir ihtiyaç sistemlerine maruz kalma ile daha belirgindir. Süper-kimyasal olarak güçlendirilmiş (kuantum verimi> 1) fotorezist da maruz kalan nanoregions 9 10 fotoreaktif moleküllerin sayısının varyasyon neden olduğu bir kimyasal SN getirmektedir. uzun pozlama ihtiyaç alt hassasiyet photoresistler bu etkileri bastırmak, ama onlar da verim azaltır.
Moleküler ölçekte, katkı moleküler direnenleri 11 ile azalabilir fotorezist polimerler doğasında moleküler boyut dağılımından pürüzlülüğü-kenar hattına. Nano-desenlendirme bu yukarıdan aşağıya işleme tamamlayıcı bir yaklaşım, aşağıdan yukarıya yöntemleri 12 kullanımıdırİki bloklu polimerler 14 yönlendirilmiş kendini montaj (DSA) üzerine özellikle güveniyor s = "xref"> 13. çekirdeklenme yönlendirmek ve bu delik veya çizgiler olarak istenilen desen arasındaki eşit olmayan aralık oluşturmak için, bu işlemlerin özelliği, zor olmaya devam etmektedir. Moleküler bileşenleri 15 boyut dağılımı, 16 ölçek ve imalat 17, 18 verim sınırlar. Benzer sorunlar, yumuşak litografi 19 nanopartiküllerin microcontact baskı sınırlamak.
Bu yazıda SN / hat-kenar sertliği (LER) 20 etkisini azaltmak için elektrostatik yönelik öz-montaj ile klasik yukarıdan aşağıya projeksiyon litografi birleştiren yeni bir hibrid yaklaşımı (Şekil 1) çalışmaları sunmaktadır. (2-aminoetil) – Pozitif kendi kendini monte mono tabakaları N (SAMs) üzerinde amin gruplarına şarjPMMA filmi yatan -11-amino-undesil-metoksi-silan (AATMS) geliştikten sonra maruz kalmaktadır. SN etkilenen deliklere 25 içine 24 – PMMA negatif yüklü fotorezist filmi elektrostatik olumsuz, 21 sitrat ile şapkalı altın nanopartiküller (GNPs), tahsil hunilerini yönlendirecek. Yeniden akış PMMA Fotorezist film predeposited nano partikülleri engulfs.
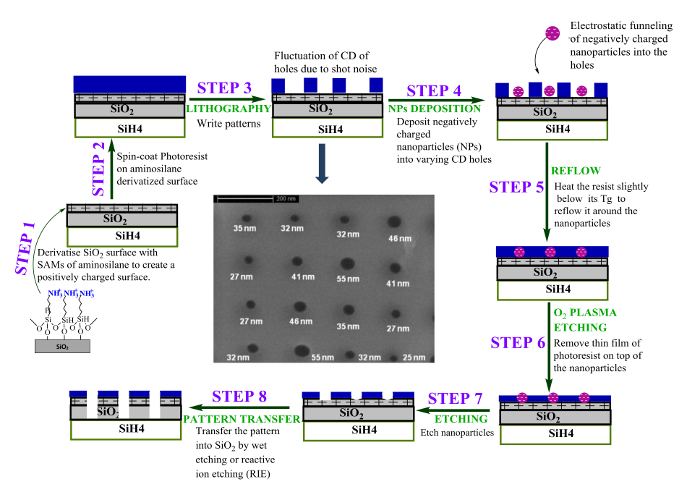
Şekil 1: stratejinin şematik kesin boyutta NPs kullanarak kişi deliklerinin desenlendirme için atış gürültü ve hat-kenar pürüzlülüğü etkilerini ortadan kaldırmak için. Burada, önemli boyuta (CD) deliklerin istenen çapıdır. yaklaşım, (aşama 1) oksit sörf pozitif yüklü amin grupları taşıyan silan molekülün kendi kendine bir araya tek tabaka (SAM) biriktirilmesi ile başlarBir silikon gofret as. Sonraki E-ışın litografi deseni delikleri kullanılır (adım 2 ve 3) içerlek SEM görüntüsünde gösterildiği gibi, atış-gürültü üretir PMMA fotorezist film, mavi tabaka içinde. Düz Baskı deliklerde amin gruplarını gösterir. Adım 4 kontrollü boyutu, elektrostatik aktarıldığını (EF) ile lithographically desenli deliklere sitrat-kapaklı (negatif yüklü), altın nano partiküller (GNPs) sulu faz, birikmesini gerektirir. Adım 5'te, PMMA, 110 ° C cam geçiş sıcaklığının altında, 100 ° C gofreti ısıtılması, ön tevdi nanopartiküller yaklaşık fotorezist yeniden oluşturulmasını neden olur. Asitlendirme yoluyla serbest kalan partiküllerin oksijen plazma (aşama 6) GNPs gösterir, ve daha sonra ıslak aşındırma (iyot) (basamak 7) benzer olan PMMA kaplanmış GNPs boyutuna karşı gelen delikleri oluşturur. Reaktif iyon / ıslak aşındırma ile birleştiğinde, SiO 2 (adım 8) 31 fotorezist delik deseni aktarmak mümkündür. YenidenReferans 20 izniyle basılmış. Bu rakamın büyük halini görmek için lütfen buraya tıklayınız.
alt tabaka üzerinde zıt yüklü GNPs ve amin grupları arasındaki elektrostatik etkileşim bağlanma sitesinden GNPs önlemektedir. yeniden akıtma adım GNPs göreli konumunu korur, fakat delik ve SN / LER etkilerini siler. Plazma / ıslak aşındırma adımlar GSMH boyutu var delikleri yeniden. Reaktif iyon dağlama SiO 2 sabit maske katmanları kendi desen aktarır. Yöntem, bir desenli nanohole (NH) daha muntazam boyutlu nano partikülleri ile dayanır, σ, standart sapma olarak ifade edilen bu GSMH σ <NH σ olduğu. Bu rapor, dispersiyonu ve gelen nanopartiküllerin çökeltme gibi (Şekil 1 'de tarif edilen 4 ve 5) adımları odaklanırçevrelerindeki fotorezist yeniden akıtma avantaj ve yöntemin sınırlarını değerlendirmek. Her iki adımlar yongaları üzerinde modern entegre devreler üreten akım hiçbir kapsamlı değişiklik gerektiren, ilke olarak, daha büyük yüzeylere şekilde büyütülebilir.
Protocol
Representative Results
Discussion
litografide sut gürültü (SN), belirli bir nano bölgede gelen foton veya partikül (N) sayıda istatistik dalgalanmalar basit bir sonucu olduğu; Bu foton / partiküllerin bir sayının kare köküne ters orantılıdır:

A ve r 'nin alanı ve açıkta kalan bölümün boyutu, burada. Örneğin, 52 mJ / cm2 poz dozunda bir ArF 193-nm (6.4-eV) desen 50-nm deliklere excim…
Declarações
The authors have nothing to disclose.
Acknowledgements
Intel Corporation, hibe numarası 414305 aracılığıyla bu işi finanse ve Oregon Nanoteknoloji ve Mikroteknoloji Girişimi (ONAMI) eşleşen fon sağlamıştır. Biz minnetle bu işin tüm aşamalarında Dr James Blackwell destek ve tavsiyeler kabul eder. Özel teşekkür parçacık konumlandırma istatistiklerini analiz etmek için Drew Beasau ve Chelsea Benedict gidin. Biz e-ışın litografi ile yaptığı yardım için, Oregon, Eugene Üniversitesi'nde, el yazması ve Dr. Kurt Langworthy dikkatli bir okuma için Profesör Hall teşekkür VEYA.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referências
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

