L'utilizzo di nanoparticelle sacrificali per eliminare gli effetti del colpo-rumore in fori di contatto fabbricato da E-litografia a fascio
Summary
Uniformemente nanoparticelle di dimensioni in grado di rimuovere le fluttuazioni dei contatti dimensioni dei fori di fantasia in poli (metacrilato di metile) film (PMMA) fotoresistente per fascio di elettroni (E-beam) litografia. Il processo prevede di focalizzazione elettrostatica al centro e deposito nanoparticelle in fori di contatto, seguita da fotosensibile riflusso e passi plasma e bagnato-incisione.
Abstract
Nano-modelli fabbricati con ultravioletta estrema (EUV) o fascio elettronico (E-beam) Litografia mostrano variazioni inattese delle dimensioni. Questa variazione è stata attribuita a fluttuazioni statistiche del numero di fotoni / elettroni in arrivo a un determinato nano-regione derivanti da un tiro-rumore (SN). La SN varia inversamente alla radice quadrata di un numero di fotoni / elettroni. Per un dosaggio fisso, il SN è più grande in EUV e e-beam litografie che per tradizione (193 nm) litografia ottica. Bottom-up e top-down patterning approcci sono combinati per ridurre al minimo gli effetti del rumore girato in nano-hole patterning. In particolare, un ammino-silano tensioattivi autoassembla su un wafer di silicio che viene successivamente spin-rivestiti con una pellicola 100 nm di un photoresist E-beam a base di PMMA. L'esposizione al fascio E e il successivo sviluppo scopre la pellicola tensioattivo sottostante al fondo dei fori. Immergendo il wafer in una sospensione di carica negativa, citrato-capped, 20 nm gvecchi nanoparticelle (PNL) depositi una particella per buco. Il film tensioattivo carica positiva esposta nel foro imbuti elettrostaticamente le nanoparticelle carica negativa al centro di un foro esposto, che fissa in modo permanente nel registro posizionale. Successivamente, mediante riscaldamento vicino alla temperatura di transizione vetrosa del polimero photoresist, il film fotoresist rifluisce e sommerge le nanoparticelle. Questo processo cancella i buchi affetti da SN, ma lascia PNL depositati bloccati in posizione da una forte elettrostatiche vincolante. Il trattamento con plasma di ossigeno espone PNL incidendo un sottile strato di fotoresist. Wet-incisione PNL esposte con una soluzione di I 2 / KI produce fori uniformi situate al centro di rientranze modellati mediante litografia a fascio. Gli esperimenti presentati mostrano che l'approccio riduce la variazione della dimensione dei fori causati da SN dal 35% al di sotto del 10%. Il metodo si estende i limiti patterning di fori transistore di contatto al di sotto di 20 nm.
Introduction
La crescita esponenziale della potenza di calcolo, come quantificato dalla legge di Moore 1, 2 (1), è un risultato dei progressi progressivi litografia ottica. In questa tecnica patterning top-down, la risoluzione ottenibile, R, è data dalla noto teorema Raleigh 3:

Qui, λ e NA sono la lunghezza d'onda della luce e apertura numerica, rispettivamente. Si noti che NA = η · sinθ, dove η è l'indice di rifrazione del mezzo tra la lente e il wafer; θ = tan -1 (d / 2L) per il diametro, d, della lente, e la distanza, l, tra il centro della lente e il wafer. Negli ultimi cinquant'anni, la risoluzione litografica è migliorata attraverso l'uso di (a) sorgente luminosas, tra cui laser a eccimeri, con lunghezze d'onda UV progressivamente più piccoli; (b) i disegni ottici intelligenti che impiegano maschere di fase-shift 4; e (c) superiori NA. Per l'esposizione in aria (η = 1), NA è sempre inferiore all'unità, ma introducendo un liquido con η> 1, come acqua 5, tra l'obiettivo e il wafer, NA può essere elevato sopra 1, migliorando così la risoluzione di litografia a immersione. Attualmente i percorsi praticabili a un nodo 20 nm e oltre comprendono sorgenti UV estreme (λ = 13 nm) o tecniche di patterning che utilizzano l'elaborazione doppia e quadrupla complesso di un fotoresist multistrato 6, 7.
Su scala nanometrica lunghezza, fluttuazioni statistiche, causate da un tiro-rumore (SN), del numero di fotoni che arrivano entro una causa variante nano-regione nelle dimensioni di lithogra modelli ENTI GRAFICI. Questi effetti sono più pronunciati con l'esposizione alla luce EUV ad alta energia ed E-travi, i sistemi che necessitano di ordini di grandezza meno fotoni / particelle rispetto al normale litografia ottica 8. Supersensitive chimicamente amplificata (con una efficienza quantica> 1) fotoresist introducono un SN chimica causata da una variazione nel numero di molecole fotoreattive in nanoregions esposte 9, 10. Lower fotoresist sensibilità che hanno bisogno di esposizioni più lunghe sopprimere questi effetti, ma riducono anche il throughput.
Sulla scala molecolare, il contributo alla linea-bordo rugosità dalla distribuzione delle dimensioni molecolari inerenti ai polimeri di resina fotosensibile può essere ridotto utilizzando resiste molecolari 11. Un approccio che è complementare a tale trattamento top-down di nano-patterning è l'uso di metodi bottom-up 12,s = "xref"> 13 che si basano in particolare sulla auto-assemblaggio diretto (DSA) di polimeri diblock 14. La capacità di questi processi di dirigere nucleazione e di creare la spaziatura non uniforme tra disegni desiderati, come i fori o linee, rimane difficile. La distribuzione delle dimensioni dei componenti molecolari 15, 16 limita anche la scala e la resa di fabbricazione 17, 18. Problemi simili limitano stampa microcontact di nanoparticelle in litografia soffice 19.
Questo documento presenta studi di un nuovo approccio ibrido (Figura 1) che unisce il classico litografia proiezione dall'alto con elettrostaticamente diretto autoassemblaggio per ridurre l'effetto di SN / linea-edge rugosità (LER) 20. Carica positiva gruppi amminici su monostrati auto-assemblati (SAM) di N – (2-amminoetil)-11-Ammino-undecil-metossi-silano (AATMS) sottostante il film PMMA sono esposti dopo lo sviluppo. La pellicola fotosensibile carica negativa di PMMA elettrostaticamente ad imbuto che carica negativa nanoparticelle d'oro (PNL), ricoperto con citrato, 21 – 24 nei fori SN colpite 25. Re-flusso del fotoresist PMMA sommerge nanoparticelle predeposited nel film.
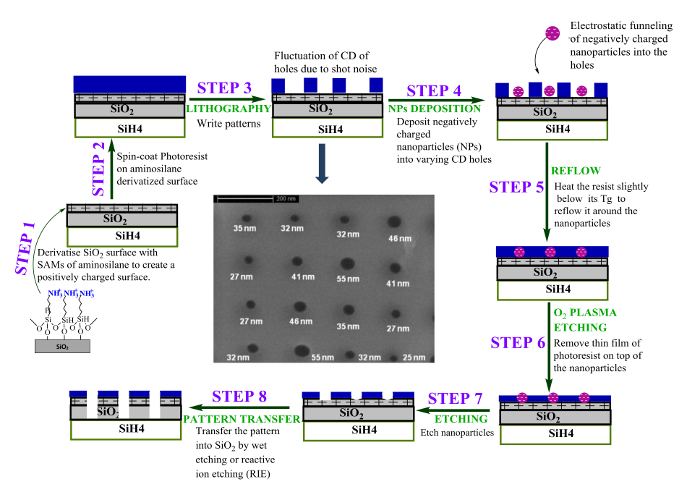
Figura 1: Rappresentazione schematica della strategia per rimuovere gli effetti del colpo-rumore e ruvidità line-edge per il patterning di fori di contatto con nanoparticelle di dimensioni precise. Qui, la dimensione critica (CD) è il diametro desiderato dei fori. L'approccio (step 1) inizia con deposizione di un monostrato auto-assemblato (SAM) della molecola di silano aventi gruppi amminici caricati positivamente sul surf ossidoasso di un wafer di silicio. Successivamente, la litografia e-beam viene utilizzato per i fori modello (punti 2 e 3) in PMMA pellicola fotosensibile, lo strato blu, che genera colpo-rumore, come illustrato nell'immagine SEM inserto in. Litografia espone gruppi amminici nella parte inferiore dei fori. Fase 4 comporta la deposizione fase acquosa di controllo di dimensioni, (carica negativa) nanoparticelle d'oro citrato-capped (PNL) nei fori litografia fantasia utilizzando focalizzazione elettrostatica (EF). Nel passaggio 5, riscaldando il wafer a 100 ° C, al di sotto della temperatura di transizione vetrosa del PMMA, 110 ° C, provoca il riflusso del fotoresist intorno nanoparticelle pre-depositato. Etching sovrapposto PMMA con plasma di ossigeno (fase 6) espone PNL, e successiva wet-etching (iodio) delle particelle esposte (fase 7) crea fori corrispondenti alle dimensioni del PNL. Una volta accoppiato con reattivi-ion / wet-etching, è possibile trasferire i fori nel fotoresist a SiO 2 (fase 8) 31. Ristampata con il permesso di riferimento 20. Clicca qui per vedere una versione più grande di questa figura.
L'interazione elettrostatica tra PNL carica opposta e gruppi amminici sul substrato impedisce lo spostamento del PNL dal sito di legame. La fase di riflusso mantiene la posizione relativa dei PNL, ma cancella i buchi e gli effetti della SN / LER. Plasma / fasi di attacco umido rigenerare fori che hanno la dimensione del PIL. Etching reattivo ioni di litio trasferisce il loro modello di SiO 2 strati hard-maschera. Il metodo si basa sull'utilizzo di nanoparticelle di dimensioni più uniformemente di un nanohole fantasia (NH), espressa come la deviazione standard, σ, in modo tale che σ PIL <σ NH. Questo rapporto si concentra sui gradini (4 e 5 descritti in figura 1) che prevedano la deposizione di nanoparticelle dalla dispersione e lareflow del fotoresist intorno a loro per valutare i vantaggi ei limiti del metodo. Entrambi i passi sono, in linea di principio, scalabile per substrati più grandi, senza necessità di modifiche sostanziali del flusso di corrente di produrre moderni circuiti integrati su chip.
Protocol
Representative Results
Discussion
Americano-rumore (SN) in litografia è una semplice conseguenza di fluttuazioni statistiche del numero di fotoni o particelle (N) che arrivano in una determinata nano-regione; è inversamente proporzionale alla radice quadrata di un numero di fotoni / particelle:

dove A e R sono, l'area e la dimensione della regione esposta, rispettivamente. Ad esempio, quando si utilizza un ArF 1…
Declarações
The authors have nothing to disclose.
Acknowledgements
Intel Corporation ha finanziato questo lavoro attraverso il numero di concessione 414.305, e la Nanotecnologia e microtecnologie Iniziativa Oregon (Onami) ha fornito i fondi corrispondenti. Noi riconosciamo con gratitudine il supporto e la consulenza del Dr. James Blackwell in tutte le fasi di questo lavoro. Un ringraziamento particolare va a Drew Beasau e Chelsea Benedetto per analizzare le statistiche di posizionamento delle particelle. Ringraziamo il professor Hall per una lettura attenta del manoscritto e Dr. Kurt Langworthy, presso la University of Oregon, Eugene, OR, per il suo aiuto con la litografia e-beam.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referências
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

