Uso de sacrificiais nanopartículas para eliminar os efeitos do Plano de ruído em contato Buracos fabricada por E-beam litografia
Summary
Uniformemente nanopartículas porte pode remover flutuações nas dimensões Contacto Furo estampados em poli (metacrilato de metila) filmes (PMMA) fotossensíveis por feixe de elétrons (E-beam) litografia. O processo envolve afunilamento eletrostática para centro e depósito de nanopartículas em furos de contacto, seguido por refluxo fotorresiste e passos plasma e wet-gravura.
Abstract
Nano-padrões fabricados com ultravioleta extremo (EUV) ou por feixe de elétrons (E-beam) variações inesperadas litografia exibição em tamanho. Esta variação tem sido atribuída a flutuações estatísticas no número de fotões / electrões que chegam num dado nano-região resultantes de tiro-ruído (SN). O SN varia inversamente com a raiz quadrada de um número de fótons / elétrons. Para uma dose fixa, o SN é maior em EUV e e-beam litografias do que para tradicional (193 nm) a litografia óptica. Bottom-up e padronização de cima para baixo abordagens são combinadas para minimizar os efeitos do ruído tiro na padronização nano-buraco. Especificamente, um amino-silano auto-monta surfactante sobre uma bolacha de silício que é subsequentemente spin-revestidos com um filme de 100 nm de um foto-resistente de feixe de electrões com base em PMMA. A exposição ao E-feixe e o desenvolvimento subsequente descobrir a película surfactante subjacente aos fundos dos furos. Mergulhando a bolacha numa suspensão de carga negativa, que se tapou-citrato, 20 nm gnanopartículas de idade (PNB) Depósitos uma partícula por furo. O filme tensioactivo carregado positivamente exposta no orifício electrostaticamente funis a nanopartícula carregada negativamente para o centro de um furo exposto, que fixa permanentemente a posição de registo. Em seguida, por aquecimento perto da temperatura de transição vítrea do polímero fotossensível, o filme fotorresistente reflui e engole as nanopartículas. Esse processo apaga os buracos afetadas pela SN, mas deixa os PNB depositados bloqueado no local por uma forte ligação eletrostática. O tratamento com plasma de oxigénio expõe as PNB por decapagem uma camada fina do material fotosensitivo. Wet-condicionamento dos PNB expostos com uma solução de I2 / KI produz buracos uniformes localizados no centro de entalhes estampados por litografia de feixe de electrões. As experiências apresentadas mostram que a abordagem reduz a variação do tamanho dos furos causados por SN de 35% para menos de 10%. O método estende os limites de padrões de orifícios de contacto transistor para abaixo de 20 nm.
Introduction
O crescimento exponencial do poder computacional, como quantificada pela lei de Moore 1, 2 (1), é o resultado de avanços progressivos em litografia óptica. Nesta técnica de modelação de cima para baixo, a resolução alcançável, R, é dada pela bem conhecida Raleigh teorema 3:

Aqui, λ e NA são o comprimento de onda da luz e abertura numérica, respectivamente. Note-se que NA = η · sinθ, onde η é o índice de refracção do meio entre a lente e a bolacha; θ = tan-1 (d / 2l) para o diâmetro, d, da lente, e a distância, L, entre o centro da lente e a bolacha. Durante os últimos cinquenta anos, a resolução litográfica tem melhorado através da utilização de (a) fonte de luzs, incluindo lasers excimer, com comprimentos de onda UV progressivamente menores; (b) modelos ópticos inteligentes que utilizam máscaras do turno da fase 4; e (c) mais elevada NA. Por exposição ao ar (η = 1), NA é sempre menor que a unidade, mas através da introdução de um líquido com η> 1, 5, tal como água, entre a lente e a bolacha, NA pode ser elevado acima de um, melhorando assim a resolução da litografia de imersão. Atualmente os caminhos viáveis para um nó de 20 nm e além incluem fontes de UV extremos (λ = 13 nm) ou técnicas de padronização através do processamento duplos e quádruplos complexo de um fotorresiste várias camadas 6, 7.
Em escalas nanômetros de comprimento, flutuações estatísticas, causadas por shot-ruído (SN), no número de fótons chegam dentro de uma causa variação nano-região nas dimensões de lithogra padrões diográficas. Estes efeitos são mais pronunciados com a exposição à luz EUV de alta energia e E-feixes, sistemas que necessitam de ordens de grandeza menos fotões / partículas em comparação com o normal oito litografia óptica. Supersensíveis amplificado quimicamente (com uma eficiência quântica> 1) fotorresistentes também introduzir um SN química provocada por uma variação do número de moléculas em fotorreactivos nanoregions expostas 9, 10. Fotorresistentes inferiores sensibilidade que necessitam de exposições mais longas suprimir estes efeitos, mas também reduzem o rendimento.
Na escala molecular, a contribuição para a linha de ponta de rugosidade a partir da distribuição de tamanho molecular inerente aos polímeros fotossensíveis pode ser reduzido pelo uso de resinas fotossensíveis moleculares 11. Uma abordagem que é complementar a este processamento de cima para baixo de nano-padronização é a utilização de métodos de baixo para cima 12,s = "xref"> 13 que dependem especificamente sobre a auto-montagem dirigida (DSA) de polímeros dibloco 14. A capacidade desses processos para dirigir a nucleação e para criar espaçamento não uniforme entre os padrões desejados, tais como furos ou linhas, permanece um desafio. A distribuição de tamanho dos componentes moleculares 15, 16, também limita a escala e produtividade de fabricação de 17, 18. Problemas semelhantes limitar impressão microcontact de nanopartículas em litografia macia 19.
Este artigo apresenta estudos de uma nova abordagem híbrida (Figura 1), que combina o clássico de cima para baixo projeção de litografia com a automontagem eletrostática direcionado para reduzir o efeito da SN rugosidade / line-edge (LER) 20. Carregado positivamente grupos amina em monocamadas auto-montadas (SAM) de N – (2-aminoetil)-11-Amino-undecil-metoxi-silano (AATMS) subjacente à película de PMMA são expostas após o desenvolvimento. O filme fotorresistente carregada negativamente de PMMA electrostaticamente funis de carga negativa nanopartículas de ouro (PNB), tampado com citrato, 21-24 em buracos afetados-SN 25. Re-fluxo do fotorresistente PMMA engole nanopartículas predeposited no filme.
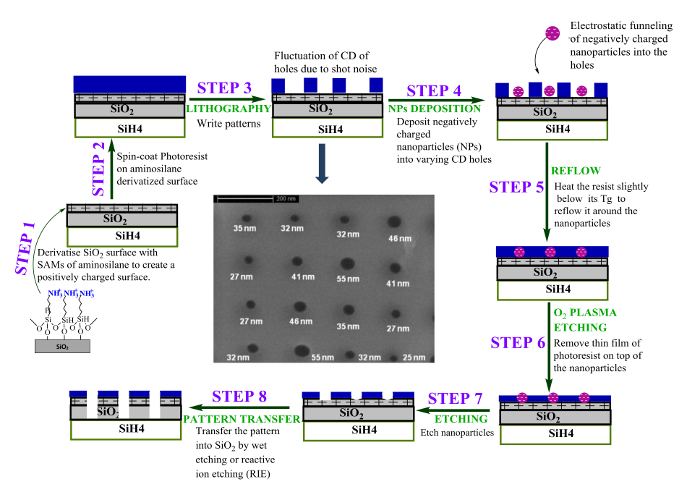
Figura 1: Representação esquemática da estratégia para eliminar os efeitos do shot-ruído e aspereza linha de ponta para o padrão de furos de contato usando NPs de tamanho preciso. Aqui, a dimensão crítica (CD) é o diâmetro desejado dos orifícios. A abordagem (passo 1) começa com a deposição de uma monocamada auto-montada (SAM) da molécula de silano tendo grupos amina carregados positivamente sobre o óxido de surfás de uma pastilha de silício. Em seguida, a litografia de feixe de electrões é usado para padrão de orifícios (Passos 2 e 3) em PMMA filme foto-resistente, a camada de azul, que gera tiro-ruído, tal como ilustrado na Imagem SEM inserir. Litografia expõe grupos amina na parte inferior dos orifícios. Passo 4 implica a deposição em fase aquosa de tamanho controlado, (carga negativa) nanopartículas de ouro cobertas de citrato (PNB) em buracos lithographically estampados utilizando afunilamento eletrostática (EF). No passo 5, o aquecimento da bolacha a 100 ° C, abaixo da temperatura de transição vítrea do PMMA, 110 ° C, faz com que o refluxo do fotorresistente em torno de nanopartículas pré-depositados. Etching sobreposta PMMA com plasma de oxigénio (passo 6) expõe as PNB, e subsequente molhado-condicionante (iodo) das partículas expostas (passo 7) cria orifícios correspondentes ao tamanho das PNB. Quando acoplada com Reactive-ião / molhado-gravar, é possível transferir o padrão de furos no fotorresistente de SiO 2 (passo 8) 31. Réimpresso com a permissão de referência 20. Por favor clique aqui para ver uma versão maior desta figura.
A interacção electrostática entre as cargas opostas e PNB grupos amina sobre o substrato impede o deslocamento das PNB do local de ligação. A etapa de refusão mantém a posição relativa dos PNB, mas apaga os buracos e os efeitos da SN / LER. Plasma / etapas corrosão úmida regenerar buracos que têm o tamanho do PIB. Gravura reativa-ion transfere o seu padrão de SiO 2 camadas hard-máscara. O método baseia-se na utilização de mais uniformemente do que um tamanho nanopartículas nanohole modelado (NH), expressa como o desvio padrão, σ, de tal modo que σ PNB <σ NH. Este relatório centra-se em etapas (4 e 5 descritos na Figura 1), envolvendo a deposição de nanopartículas de dispersão e darefluxo do fotorresistente em torno deles para avaliar as vantagens e limitações do método. Ambos os passos são, em princípio, adaptar a substratos maiores, sem necessidade de grande modificação do fluxo de corrente de produção modernos circuitos integrados em batatas fritas.
Protocol
Representative Results
Discussion
Shot-ruído (SN) em litografia é uma simples consequência de flutuações estatísticas no número de fótons ou partículas (N) que chegam em um determinado nano-região; é inversamente proporcional à raiz quadrada de um número de fotões / partículas:

em que A e R são a área e o tamanho da região exposta, respectivamente. Por exemplo, quando se utiliza um ArF 193 nm (6,4-eV…
Declarações
The authors have nothing to disclose.
Acknowledgements
Intel Corporation financiado este trabalho através de número de concessão 414305, e da Iniciativa Oregon Nanotecnologia e Microtecnologia (ONAMI) forneceu fundos correspondentes. Agradecemos o apoio e aconselhamento de Dr. James Blackwell em todas as fases deste trabalho. Agradecimentos especiais com Drew Beasau e Chelsea Bento de análise das estatísticas de posicionamento de partículas. Agradecemos ao professor Hall para uma leitura cuidadosa do manuscrito e Dr. Kurt Langworthy, da Universidade de Oregon, Eugene, OR, por sua ajuda com litografia de feixe de electrões.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
Referências
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

