प्लाज्मा की मदद से आणविक बीम एन-ध्रुवीय InAlN बाधा उच्च इलेक्ट्रॉन गतिशीलता ट्रांजिस्टर के Epitaxy
Summary
आणविक बीम epitaxy एन-ध्रुवीय InAlN बाधा उच्च इलेक्ट्रॉन गतिशीलता ट्रांजिस्टर (HEMTs) विकसित करने के लिए प्रयोग किया जाता है। 1,750 सेमी 2 / वी ∙ सेकंड के रूप में उच्च गतिशीलता के साथ चिकनी, compositionally सजातीय InAlN परतों और HEMTs में परिणाम वेफर तैयारी का नियंत्रण, परत विकास की स्थिति और epitaxial संरचना।
Abstract
प्लाज्मा की मदद से आणविक बीम epitaxy अच्छी तरह से चिकनी, अचानक उच्च गुणवत्ता वाले उच्च इलेक्ट्रॉन गतिशीलता ट्रांजिस्टर (HEMTs) के लिए आवश्यक इंटरफेस के साथ नाइट्राइड- III पतली फिल्मों और heterostructures की epitaxial विकास के लिए अनुकूल है। एक प्रक्रिया एन-ध्रुवीय InAlN HEMTs के विकास, मे तैयारी और बफर परतों, InAlN बाधा परत, AlN और गण मन interlayers और गण मन चैनल के विकास सहित, के लिए प्रस्तुत किया है। प्रक्रिया के प्रत्येक चरण पर महत्वपूर्ण मुद्दों जैसे गण मन बफर में गा संचय, InAlN compositional एकरूपता पर तापमान की भूमिका, और AlN interlayer के दौरान गा प्रवाह के उपयोग और व्यवधान से पहले गण मन के लिए चैनल विकास बचने के रूप में पहचान कर रहे हैं। Compositionally सजातीय एन-ध्रुवीय InAlN पतली फिल्मों 0.19 एनएम और के रूप में के रूप में कम सतह जड़ मतलब चुकता खुरदरापन के साथ प्रदर्शन कर रहे हैं InAlN आधारित HEMT संरचनाओं एक चादर चार्ज घनत्व के साथ उपकरणों के लिए के रूप में 1,750 सेमी 2 / वी ∙ सेकंड के रूप में उच्च गतिशीलता होने रिपोर्ट कर रहे हैं 1.7 x 10 का13 सेमी -2।
Introduction
आणविक बीम epitaxy (एमबीई) एक बहुमुखी epitaxial पतली फिल्म विकास तकनीक है कि बड़े फिल्म में कम अशुद्धता समावेश सुनिश्चित करने के लिए के रूप में 10 -11 Torr के रूप में कम आधार दबाव के साथ एक अति उच्च निर्वात वातावरण को रोजगार मिला है। epitaxially उगाया परतों की संरचना और विकास दर प्रत्येक बहाव सेल के तापमान, और इस प्रकार विभिन्न स्रोत सामग्री की सुखाया प्रवाह को नियंत्रित करने से निर्धारित होते हैं। नाइट्राइड- III epitaxy, समूह तृतीय-तत्वों (में, अल, गा) आम तौर पर, जबकि सक्रिय नाइट्रोजन (एन *) प्रवाह या तो एक एन 2 प्लाज्मा 1,2 (आरएफ प्लाज्मा द्वारा प्रदान की जाती है बहाव कोशिकाओं द्वारा प्रदान की जाती हैं के मामले में -assisted एमबीई:। PAMBE या RFMBE) या अमोनिया (एनएच 3 -MBE) 3,4 एमबीई विकास कम वृद्धि तापमान और ऐसे metalorganic रासायनिक वाष्प जमाव के रूप में अन्य epitaxial विकास की तकनीक, तेज इंटरफेसियल आकस्मिकता के द्वारा होती है 5 एक योजनाबद्ध दिखाया गया है। चित्रा 1 में।
<pवर्ग = "jove_content">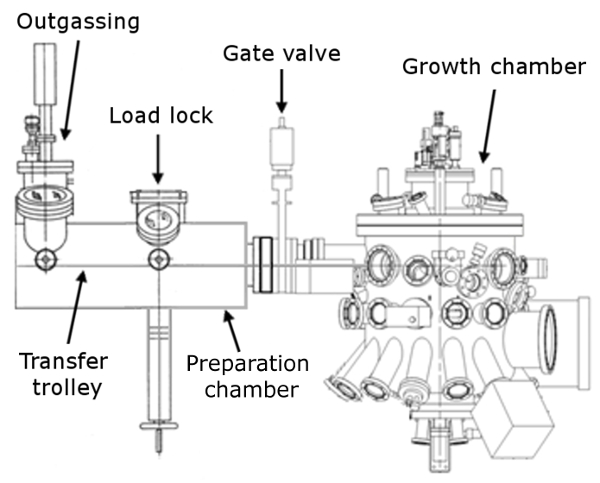
चित्रा 1:।। एमबीई प्रणाली योजनाबद्ध लोड ताला, हस्तांतरण प्रणाली, outgassing स्टेशन और विकास कक्ष दिखा योजनाबद्ध यह आंकड़ा का एक बड़ा संस्करण देखने के लिए यहां क्लिक करें।
तृतीय-nitrides क्रिस्टल झुकाव की एक किस्म के होने substrates पर विकसित किया जा सकता है। सबसे अधिक इस्तेमाल किया उन्मुखीकरण गा-ध्रुवीय सी विमान है, जो बाधा परत, आम तौर पर AlGaN, और गण मन चैनल के बीच ध्रुवीकरण में अंतर का उपयोग करके डोपिंग के बिना एक दो आयामी इलेक्ट्रॉन गैस के गठन की अनुमति देता है। गण मन के विभिन्न गैर ध्रुवीय और अर्द्ध-ध्रुवीय झुकाव क्वांटम कुओं, 6,7 जो भी HEMT आवेदन के लिए इन झुकाव कम वांछनीय बनाता में कम ध्रुवीकरण प्रभाव के कारण Optoelectronics के लिए महत्वपूर्ण ध्यान प्राप्त हुआ हैएनएस। एन-ध्रुवीय उन्मुख उपकरणों पारंपरिक गा-ध्रुवीय उपकरणों पर कई आंतरिक फायदे की वजह से अगली पीढ़ी के उच्च आवृत्ति HEMT ऑपरेशन के लिए आकर्षक हैं। 8 N-ध्रुवीय उपकरणों में बाधा परत जिसके परिणामस्वरूप, के रूप में चित्रा 2 में दिखाया गण मन चैनल के नीचे उगाया जाता है एक प्राकृतिक वापस बाधा में है कि चैनल के electrostatic नियंत्रण एड्स और, लघु चैनल प्रभाव को कम कर देता गण मन चैनल के लिए आसान वर्तमान उपयोग की अनुमति और संपर्क प्रतिरोध को कम करते हुए। बाधा भी चैनल से अलग से नियंत्रित किया जा सकता है ताकि के रूप में चैनल मोटाई उच्च आवृत्ति उपकरणों के लिए नीचे पहुंचा है बाधा डिजाइन चैनल प्रभारी फर्मी स्तर लगाए प्रभाव को खो के लिए क्षतिपूर्ति करने के लिए संशोधित किया जा सकता है।
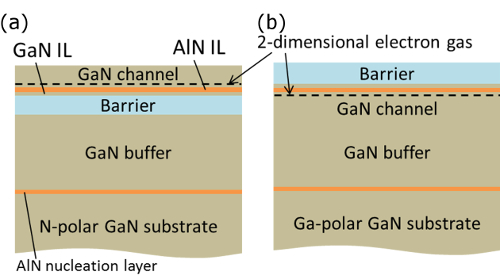
चित्रा 2:। Epitaxial परत योजनाबद्ध (क) एक एन-ध्रुवीय HEMT और compar के लिए (ख) एक गा-ध्रुवीय HEMT की परत संरचनाison। यह आंकड़ा का एक बड़ा संस्करण देखने के लिए यहां क्लिक करें।
उच्च गति में इस्तेमाल HEMTs, उच्च शक्ति एम्पलीफायरों सामान्य रूप से इस प्रकार की उच्च तापीय चालकता का लाभ लेने के हिज्जे गलत substrates पर हो रहे हैं। कम सूत्रण अव्यवस्था घनत्व फ्रीस्टैंडिंग गण मन substrates इलेक्ट्रॉन गतिशीलता, 9 इस प्रकार उच्च आवृत्ति प्रदर्शन में सुधार में सुधार करने के लिए नियोजित किया जा सकता है। एक AlN nucleation परत की वृद्धि के बाद, एक मोटी गण मन बफर स्थानिक HEMT चैनल से regrowth इंटरफेस में अशुद्धियों को अलग किया और बिजली के अलगाव को सुधारने के लिए उगाया जाता है। अन्य III-V सामग्री के विपरीत, गण मन PAMBE की वृद्धि हुई आम तौर पर एक समूह III / वी 1, यानी, धातु युक्त स्थिति, आदेश में एक चिकनी सतह आकृति विज्ञान को प्राप्त करने में 10,11 से अधिक अनुपात के साथ विकास की स्थिति की जरूरत है। एक्स में अल 1- एक्स एन एक बदल रहा हैनाइट्राइड- III HEMTs के लिए देशी बाधा सामग्री, और हाल ही में महत्वपूर्ण ध्यान दिया गया है, क्योंकि यह हो गई जाली एक्स ≈ 0.18 के लिए गण मन के लिए मिलान किया जा सकता है और AlGaN बाधाओं को दो बार चैनल प्रभारी रिश्तेदार होने के कारण इसकी उच्च सहज ध्रुवीकरण से अधिक उत्पन्न कर सकते हैं। 12-15 के विपरीत AlGaN बाधाओं, गा InAlN परतों में में करने के लिए रियायत के तौर पर शामिल करेंगे, इस प्रकार 16 देखभाल सुनिश्चित करने के लिए सतह गा-अमीर गण मन बफर परत वृद्धि और विकास के लिए पहले InAlN बाद अतिरिक्त गा से मुक्त है लिया जाना चाहिए।
सतह पर गा का नियंत्रण एक गा प्रवाह प्रवाह गा-छोटी बूंद गठन के लिए आवश्यक तुलना में थोड़ा कम suppling द्वारा पूरा किया जा सकता है। हालांकि, इस विकास खिड़की छोटा है, और अपर्याप्त गा सतह कवरेज सतह आकृति विज्ञान का कारण होगा पठार / खाई को मान नीचा करने के लिए है, जबकि अतिरिक्त गा गा प्रवाह संचय और स्थूल छोटी बूंद गठन में परिणाम होगा। 17 प्रतिबिंब उच्च ऊर्जा इलेक्ट्रॉन विवर्तन (RHEED) INTENS अल्पसंख्यक गा संचय और desorption पर नजर रखने के लिए इस्तेमाल किया जा सकता है। गा सतह कवरेज RHEED तीव्रता में कमी, और गा बंद करने के बीच कोई अंतराल ने संकेत दिया है (और एन *) बंद और के रूप में 3 चित्र में दिखाया RHEED तीव्रता में वृद्धि प्रारंभिक गा के संचय को इंगित करता है।

चित्रा 3:। RHEED तीव्रता RHEED तीव्रता संकेत RHEED पैटर्न रोटेशन के तहत अधिग्रहण किया ट्रिगर अधिग्रहण का उपयोग करने से मापा साथ गा कवरेज की निगरानी करना। अपर्याप्त गा प्रवाह के दरवाज़े बंद करने के बाद तीव्रता में एक तत्काल वृद्धि ने संकेत दिया है (नहीं दिखाया गया है)। संतृप्त / आदर्श गा कवरेज शटर बंद करने और अचानक RHEED ब्राइटनिंग और अतिरिक्त गा कवरेज प्रारंभिक RHEED ब्राइटनिंग में दोनों एक देरी के साथ ही एक और क्रमिक तीव्रता पूर्ण तीव्रता वसूली में जिसके परिणामस्वरूप वृद्धि की तुलना में अब 60 एस लेने के रूप में देखा में जो देरी ने संकेत दिया है।com / फ़ाइलें / ftp_upload / 54775 / 54775fig3large.jpg "लक्ष्य =" _blank "> यह आंकड़ा का एक बड़ा संस्करण देखने के लिए यहां क्लिक करें।
हासिल करने के लिए उच्च गुणवत्ता PAMBE द्वारा InAlN पार्श्व रचना में उतार-चढ़ाव की उपस्थिति से जटिल है, में अमीर सीमाओं से घिरा अल अमीर डोमेन से मिलकर एक "छत्ते" microstructure में जिसके परिणामस्वरूप। इस microstructure की 18 उन्मूलन 50 के बारे में एक सब्सट्रेट तापमान का उपयोग करके हासिल की है डिग्री सेल्सियस में desorption, एन-ध्रुवीय InAlN के लिए 15,19,20 या लगभग 630 डिग्री सेल्सियस के ऊपर शुरुआत। इस उच्च तापमान वृद्धि के शासन में, में एक्स अल 1- एक्स एन रचना सब्सट्रेट तापमान के एक मजबूत समारोह, उच्च तापमान समावेश में कम है, जिसके परिणामस्वरूप के साथ है। में प्रवाह की भरपाई करने के लिए, वाष्पीकरण के लिए खो दिया है, हालांकि व्यवहार में अधिकतम प्रवाह में प्रवाह में वृद्धि के साथ समावेश दक्षता में कमी के द्वारा सीमित है बढ़ाया जा सकता है। 21 सब्सट्रेट तापमान को कम करने या प्रवाह में वृद्धि, विकास दर बढ़ाने में भी "प्रभाव दफन में", जहां आने वाले अल परमाणुओं के जाल के कारण में रचना बढ़ाने के लिए और यह वाष्पन से रोका जा सकता है के अलावा। 21,22 उच्चतर विकास दर आनुपातिक रूप में और अल प्रवाह को बढ़ाने के द्वारा प्राप्त किया जा सकता है। विकास की स्थिति एन से भरपूर रखने के लिए, एन * के रूप में अच्छी तरह से वृद्धि हुई है, जो आरएफ प्लाज्मा शक्ति को बढ़ाने के द्वारा प्राप्त किया जा सकता है, की आवश्यकता होगी एन 2 प्रवाह की दर बढ़ रही है, प्लाज्मा चैम्बर डिजाइन में सुधार, या एपर्चर प्लेट छेद में वृद्धि घनत्व।
InAlN आधारित HEMTs में अतिरिक्त epitaxial परतों गण मन और AlN interlayers (आईएलएस) और एक गण मन चैनल शामिल हैं। एक AlN आईएल बाधा और चैनल के बीच डाला गतिशीलता μ के साथ ही चैनल चादर चार्ज घनत्व एन एस बढ़ा सकते हैं। गतिशीलता में वृद्धि InAlN बी के साथ इलेक्ट्रॉन लहर समारोह ओवरलैप को कम करने के लिए जिम्मेदार ठहराया हैarrier और बाद में मिश्र धातु बिखरने। 9 AlN आईएल के लिए उच्च गुणवत्ता वाले विकास को सुनिश्चित करने के लिए, गा प्रवाह की एक अतिरिक्त एक surfactant के रूप में कार्य करने के लिए विकास के दौरान आपूर्ति की है। एक गण मन आईएल AlN आईएल और बाधा के बीच किया जा सकता है आगे गतिशीलता में सुधार करने के लिए है, जबकि चैनल प्रभारी को कम करने। गण मन चैनल InAlN बाधा के रूप में ही तापमान पर उगाया जा सकता है, हालांकि बाधा आईएलएस और चैनल से सतत विकास की इजाजत दी। बेहतर गतिशीलता AlN आईएल के बाद विकास के दखल और गण मन चैनल बढ़ रहा से पहले विकास तापमान में वृद्धि से प्राप्त किया गया है। इस मामले में एक सुरक्षात्मक गा सतह कवरेज बीच में गतिशीलता गिरावट को रोकने के दौरान बनाए रखा जाना है।
निम्नलिखित प्रोटोकॉल एन-ध्रुवीय गण मन substrates पर हो InAlN बाधा HEMTs करने के लिए विशेष रूप से लागू होता है। यह सीधे एक 50 एनएम मोटी एन अमीर AlN परत सहित द्वारा सी-ध्रुवीय 4H- या 6H-हिज्जे गलत substrates पर विकास करने के लिए बढ़ाया जा सकता है।
Protocol
Representative Results
Discussion
एक उच्च गुणवत्ता गण मन बफर परत का विकास किसी भी नाइट्राइड- III HEMT में उच्च इलेक्ट्रॉन गतिशीलता को प्राप्त करने के लिए महत्वपूर्ण है। एक एन-ध्रुवीय InAlN HEMT के मामले में, बफर परत विकास की आवश्यकता है कि सभी गा InAlN …
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

