-Plasma ondersteunde Moleculaire bundel epitaxie van N-polaire InAlN-barrière High-elektron-mobiliteit Transistors
Summary
Moleculaire bundel epitaxie wordt gebruikt om N-polar InAlN-barrier high-elektron-mobiliteit transistoren (HEMTs) groeien. Controle van de wafer voorbereiding, laag groeiomstandigheden en epitaxiale structuur resulteert in gladde, compositorisch homogene InAlN lagen en HEMTs die slecht ter been zo hoog als 1750 cm2 / V ∙ sec.
Abstract
-Plasma ondersteunde moleculaire bundel epitaxie is goed geschikt voor de epitaxiale groei van III-nitride dunne films en heterostructuren met gladde, abrupte interfaces nodig voor hoogwaardige high-elektron-mobiliteit transistoren (HEMTs). Een procedure wordt voorgesteld voor de groei van N-polaire InAlN HEMT, waaronder wafer voorbereiding en groei van bufferlagen, de InAlN barrièrelaag, AlN en GaN tussenlagen en de GaN kanaal. Kritieke problemen bij elke stap van de werkwijze worden geïdentificeerd, zoals het vermijden GA ophoping in de GaN buffer, de rol van de temperatuur op InAlN samenstelling homogeniteit en het gebruik van Ga flux tijdens de AlN tussenlaag en de interrupt vóór GaN kanaal groei. Compositorisch homogene N-polaire InAlN dunne films worden gedemonstreerd met een oppervlakte wortel van het gemiddelde kwadraat ruwheid zo laag als 0,19 nm en InAlN-gebaseerde HEMT structuren worden gemeld met mobiliteit zo hoog als 1750 cm2 / V ∙ sec voor apparaten met een vel ladingsdichtheid van 1,7 x 1013 cm -2.
Introduction
Moleculaire bundel epitaxie (MBE) is een veelzijdige epitaxiale dunne film groei techniek die een ultra-hoog vacuüm omgeving telt met base druk zo laag als 10 -11 Torr lage onzuiverheid opname in de volwassen film te waarborgen. De samenstelling en de groei van de epitaxiaal gegroeide lagen worden bepaald door het regelen van de temperatuur van elk effusie cel, en dus de verdampte stroom van de verschillende bronmaterialen. Bij III-nitride epitaxie, de groep III-elementen (In, Al, Ga) worden typisch verschaft door uitstroomcellen terwijl de actieve stikstofatoom (N *) stroom wordt geleverd door hetzij een N2 plasma 1,2 (RF plasma bijgestane MBE. PAMBE of RFMBE) of ammoniak (NH3 -MBE) 3,4 MBE groei wordt gekenmerkt door lagere groeitemperatuur en scherper grensvlak abrupte dan andere epitaxiale technieken, zoals metaal-organische chemische dampafzetting 5 een schematisch weergegeven. in Figuur 1.
<pclass = "jove_content">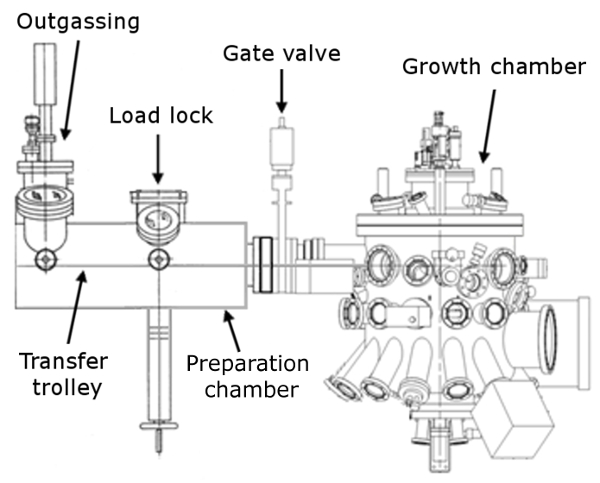
Figuur 1:.. MBE systeem schema Schematische die de vulsluis, transfersysteem, ontgassing station en kweekkamer Klik hier om een grotere versie van deze figuur te bekijken.
III-nitriden worden geteeld op substraten met verschillende kristaloriëntaties. De meest gebruikte oriëntatie is de Ga-polaire c -vlak, die de vorming van een tweedimensionaal elektronengas mogelijk maakt zonder doping door gebruik te maken van het verschil in polarisatie tussen de barrièrelaag, typisch AlGaN en GaN kanaal. Diverse niet-polaire en semi-polaire oriëntaties van GaN hebben veel aandacht voor opto-elektronica gekregen als gevolg van verminderde polarisatie effecten in het quantum putten, 6,7 waardoor ook deze oriëntaties minder wenselijk HEMT applicatioNS. N-polaire georiënteerde inrichtingen zijn aantrekkelijk voor de volgende generatie hoogfrequent HEMT bediening door verschillende intrinsieke voordelen ten opzichte van conventionele Ga-polaire inrichtingen. 8 De barrièrelaag in N-polaire inrichtingen wordt gekweekt onder de GaN kanaal zoals getoond in figuur 2, resulteert in een natuurlijke achtergrond barrière die helpt elektrostatische controle over het kanaal en vermindert korte kanaal effecten, terwijl stroom gemakkelijker toegang tot de GaN kanaal en verminderen contactweerstand. De slagboom kan ook afzonderlijk worden bediend vanaf het kanaal, zodat wanneer het kanaal dikte is verkleind voor hoogfrequente apparatuur de barrière ontwerp kan worden aangepast om te compenseren voor kanaal lading verloren aan Fermi-niveau pinning effecten.
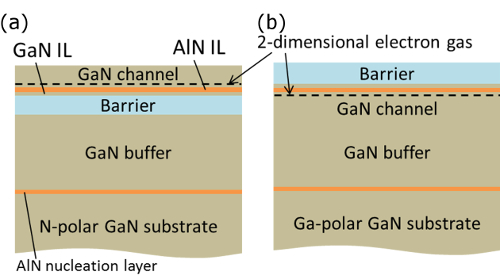
Figuur 2:. Epitaxiale laag schematische laagopbouw van (a) een N-polaire HEMT en (b) een Ga-polaire HEMT voor vergelijIson. Klik hier om een grotere versie van deze figuur te bekijken.
HEMT gebruikt in high-speed worden hoge-vermogensversterkers gewoonlijk bestemd voor SiC substraten te profiteren van de hoge thermische geleidbaarheid van SiC. Threading lage dislocatiedichtheid vrijstaande GaN substraten kunnen worden toegepast om de elektronen mobiliteit, 9 waardoor de hoogfrequente prestatie verbeteren verbeteren. Na de groei van een AlN nucleatielaag wordt een dikke GaN buffer gekweekt ruimtelijk de onzuiverheden te scheiden van de hergroei-interface van de HEMT kanaal en elektrische isolatie te verbeteren. In tegenstelling tot andere III-V materialen, GaN gegroeid PAMBE heeft typisch groeiomstandigheden met een groep-III / V-verhouding groter is dan 1, dat wil zeggen, metaal-rijke omstandigheden, 10,11 om een glad oppervlak morfologie te bereiken. In x Al 1- x N is een alterinheemse barrière materiaal voor III-nitride HEMTs, en heeft veel aandacht gekregen onlangs omdat het uitgegroeid rooster kan worden afgestemd op GaN voor x ≈ 0.18 en kan via het genereren van twee keer het kanaal heffing ten opzichte van AlGaN barrières vanwege zijn hoge spontane polarisatie. In tegenstelling tot 12-15 AlGaN barrières, zal Ga bij voorkeur op te nemen die geldt voor de InAlN lagen, 16 dus zorg moeten worden genomen om ervoor te zorgen dat de ondergrond vrij van overtollige Ga na de Ga-rich GaN bufferlaag groei en voorafgaand aan InAlN groei.
Controle van Ga op het oppervlak kan worden bereikt door een suppling Ga flux iets minder dan de flux vereist voor Ga-druppelvorming. Echter, deze groei venster is klein, en onvoldoende Ga oppervlak dekking zal de oppervlakte morfologie veroorzaken te degraderen naar plateau / geul morfologie terwijl overtollige Ga flux zal resulteren in Georgia accumulatie en macroscopische druppelvorming. 17 Reflectie hoog-energetische elektronen diffractie (RHEED) intens teit kan worden gebruikt om Ga accumulatie en desorptie controleren. Ga oppervlaktebedekking wordt aangegeven door een verlaging van RHEED intensiteit en eventuele vertraging tussen het sluiten van de Ga (en N *) blinden en de aanvankelijke verhoging van RHEED intensiteit geeft accumulatie van Ga, zie figuur 3.

Figuur 3: Monitoring Ga dekking met RHEED intensiteit RHEED intensiteit signaal gemeten van RHEED patroon onder rotatie verkregen met behulp van getriggerde acquisitie.. Onvoldoende Ga flux wordt aangegeven door een onmiddellijke toename in intensiteit na het sluiten van de luiken (niet getoond). Verzadigde / ideale Ga dekking wordt met een vertraging tussen sluiter sluiting en abrupte RHEED en helder overmaat Ga dekking in beschouwd als zowel een vertraging in aanvankelijke RHEED heldermakende en een geleidelijkere intensiteit verbeteren met volle intensiteit herstel duurt langer dan 60 s.com / files / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> Klik hier om een grotere versie van deze figuur te bekijken.
Kwalitatief hoogstaand InAlN door PAMBE wordt gecompliceerd door de aanwezigheid van laterale samenstelling schommelingen, resulterend in een "honingraat" microstructuur bestaande uit Al-rijke domeinen omgeven door In-rijke grenzen. 18 Eliminatie van deze microstructuur wordt bereikt door een substraattemperatuur ongeveer 50 ° C boven het begin van In desorptie, 15,19,20 of ongeveer 630 ° C N-polaire InAlN. In deze hoge temperatuur groei regime, de in x Al 1- x N samenstelling is een sterke functie van de ondergrond temperatuur, met hogere temperaturen leidt tot lagere in oprichting. In de flux kan worden verhoogd als compensatie voor verloren In verdamping, hoewel in de praktijk de maximale flux wordt beperkt door een vermindering opnamedoelmatigheid met toenemende In flux. 21 Naast het verminderen van de substraattemperatuur of verhogen van de flux in het verhogen van de groeisnelheid kan ook de samenstelling stijgen door de "begraven in effect", waarbij inkomende Al atomen val en ter voorkoming van verdamping. 21,22 Higher groei kan worden bereikt door het verhogen van de In en Al flux proportioneel. De groeicondities N-rijk houden, zou de N * moeten ook worden vergroot, hetgeen kan worden bereikt door de RF plasmavermogen, waardoor de N2 stroomsnelheid, verbeteren de plasmakamer ontwerp, of verhoging van het diafragma plaatholte dichtheid.
Extra epitaxiale lagen in InAlN-gebaseerde HEMTs omvatten GaN en AlN tussenlagen (ILS) en een GaN-kanaal. Een AlN IL ingevoegd tussen de barrière en het kanaal kan de mobiliteit μ evenals kanaal sheet ladingsdichtheid n s te verhogen. De toename van de mobiliteit wordt toegeschreven aan het verminderen van elektron golffunctie overlap met de InAlN barrier en daaropvolgende legering verstrooiing. 9 Ter controle hoogwaardige groei van AlN IL wordt een overmaat van Ga flux toegevoerd tijdens de groei om als surfactant. Een GaN IL kan worden gebruikt tussen de AIN IL en belemmering voor de mobiliteit verder te verbeteren terwijl het verminderen van kanaal lading. De GaN-kanaal kan worden geteeld op dezelfde temperatuur als de InAlN barrière, waardoor een continue groei van de barrière hoewel het ILS en kanaal. Betere mobiliteit is verkregen door onderbreking groei na de AlN IL en het verhogen van de groeitemperatuur voor het groeien GaN kanaal. In dit geval heeft een beschermende Ga oppervlaktebedekking tijdens de interrupt mobiliteit straling beschermd worden gehandhaafd.
Het volgende protocol is specifiek van toepassing InAlN-barrière HEMTs gekweekt op N-polaire GaN substraten. Het kan direct worden uitgebreid tot groei op C-polaire 4H of 6H SiC-substraten met een 50 nm dikke AlN N-rijke laag.
Protocol
Representative Results
Discussion
Groei van een hoge kwaliteit GaN bufferlaag dit is nodig om mobiliteit hoge elektronenmobiliteit één III-nitride HEMT. Bij een N-polair InAlN HEMT, wordt de bufferlaag groei bemoeilijkt door de eis dat alle Ga van het oppervlak vóór InAlN groei verwijderen. Er zijn verschillende technieken om deze naast de procedure bereiken hier beschreven, zoals metaal gemoduleerd epitaxie, 27 behulp groeiomstandigheden aan de rand van de tussenliggende Ga dekking en Ga druppeltje accumulatie regime, 28 of al…
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

