assisté par plasma épitaxie par faisceau moléculaire de N-polaire InAlN-barrière Transistors à haute mobilité d'électrons
Summary
Épitaxie par jets moléculaires est utilisé pour pousser N-polaires transistors InAlN-barrière élevée à électrons-mobilité (HEMT). Contrôle de la préparation de la plaquette, les conditions de croissance de la couche et la structure épitaxiale résultats dans lisses, des couches et HEMT de InAlN de composition homogène à mobilité aussi élevée que 1,750 cm 2 / V ∙ sec.
Abstract
épitaxie par faisceau moléculaire assistée par plasma est bien adapté pour la croissance épitaxiale de nitrure III-couches minces et hétérostructures avec lisses, des interfaces abruptes nécessaires à transistors de haute qualité haute-électron-mobilité (HEMT). Une procédure est présentée pour la croissance des HEMT de InAlN N-polaires, y compris la préparation de la plaquette et la croissance des couches tampon, la couche de barrière InAlN, AlN et GaN intercouches et le canal GaN. Les questions critiques à chaque étape du processus sont identifiés, par exemple en évitant l'accumulation Ga dans le tampon GaN, le rôle de la température sur InAlN homogénéité de composition, et l'utilisation de Ga flux pendant la intercouche AIN et la croissance d'interruption avant GaN de canal. Films minces de composition homogène InAlN N-polaire sont démontrées avec la surface racine quadratique moyenne rugosité aussi bas que 0,19 nm et InAlN fondée sur les structures HEMT sont rapportés ayant une mobilité aussi élevée que 1,750 cm 2 / V ∙ s pour les appareils avec une densité de charge de la feuille de 1,7 x 1013 cm -2.
Introduction
Épitaxie par faisceau moléculaire (MBE) est une technique de croissance épitaxiale souple en film mince qui utilise un environnement ultra-vide à des pressions aussi faibles que 10 -11 Torr de base pour assurer une faible incorporation d'impuretés dans le film adulte. Le taux des couches épitaxiées composition et la croissance est déterminée en contrôlant la température de chaque cellule d'effusion, et donc le flux évaporé des divers matériaux de base. Dans le cas du nitrure III épitaxie, du groupe III-éléments (In, Al, Ga) sont typiquement fournis par des cellules d'effusion tandis que l'azote actif (N *) de flux est fournie soit par un plasma de N 2 1,2 (RF plasma MBE assisté par ordinateur. PAMBE ou RFMBE) ou l' ammoniac (NH 3 -MBE) 3,4 croissance MBE se caractérise par des températures de croissance plus faibles et plus nette brusquerie interfaciale que d' autres techniques de croissance épitaxiale telles que organométallique dépôt chimique en phase vapeur 5 Un schéma est représenté. sur la figure 1.
<pclass = "jove_content">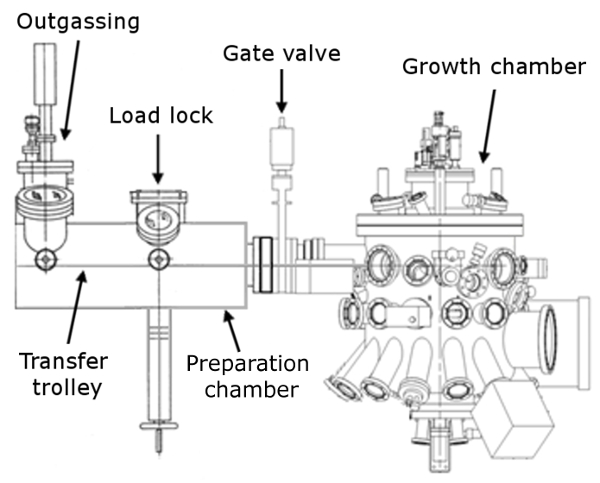
Figure 1:.. Schématique du système MBE Schéma montrant la chambre de sas de chargement, système de transfert, station de dégazage et de croissance S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
III-nitrures peuvent être cultivées sur des substrats possédant une variété d'orientations de cristal. L'orientation la plus couramment utilisée est la -Plane c Ga-polaire, ce qui permet la formation d'un gaz d' électrons bidimensionnel sans dopage en utilisant la différence de polarisation entre la couche barrière, typiquement AlGaN et GaN canal. Divers non-polaire et semi-polaires orientations de GaN ont reçu beaucoup d' attention pour l' optoélectronique en raison des effets de polarisation réduits dans les puits quantiques, 6,7 qui rend également ces orientations moins souhaitables pour HEMT applications. Des dispositifs orientés N-polaires sont intéressantes pour le fonctionnement HEMT à haute fréquence de nouvelle génération en raison de plusieurs avantages intrinsèques par rapport aux dispositifs Ga polaires classiques. 8 La couche barrière dans des dispositifs N-polaires est cultivée sous le canal GaN comme représenté sur la figure 2, ce qui entraîne dans une barrière naturelle arrière qui aide le contrôle électrostatique du canal et réduit les effets de canal court, tout en permettant un accès plus facile en cours sur le canal GaN et de réduire la résistance de contact. La barrière peut également être contrôlé séparément du canal, de sorte que l'épaisseur du canal est réduite pour les appareils à haute fréquence la conception de barrière peut être modifiée pour compenser la charge de canal perdu au niveau de Fermi épinglant effets.
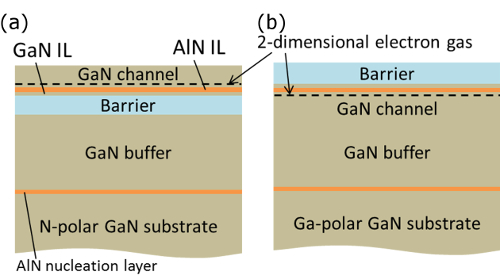
Figure 2: structure (a) un HEMT N-polaire et (b) HEMT un Ga-polaire pour compar couche épitaxiale schématique couche.ison. S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
HEMT utilisés à grande vitesse, les amplificateurs de haute puissance sont normalement cultivées sur des substrats SiC pour tirer parti de la conductivité thermique élevée de SiC. Faible threading dislocations substrats autoportant de densité de GaN peuvent être utilisés pour améliorer la mobilité des électrons, 9 améliorant ainsi les performances à haute fréquence. Après la croissance d'une couche de AlN de nucléation, un tampon de GaN épais est cultivé pour séparer spatialement les impuretés à l'interface de recroissance à partir du canal HEMT et d'améliorer l'isolation électrique. Contrairement à d' autres matériaux III-V, GaN augmenté de PAMBE a besoin typiquement des conditions de croissance avec un rapport du groupe III / V est supérieur à 1, à savoir, les conditions, 10,11 pour parvenir à une morphologie de surface riches en métaux. En x Al 1- x N est un altermatériau barrière native pour HEMT de nitrure III, et a reçu beaucoup d' attention récemment parce qu'il peut être cultivé en treillis adapté à GaN pour x ≈ 0,18 et peut générer plus de deux fois la charge de canal par rapport aux barrières AlGaN en raison de sa haute polarisation spontanée. 12-15 Contrairement barrières AlGaN, Ga incorporeront préférentiellement In en couches InAlN, 16 se soucient doivent donc être prises pour assurer la surface est exempte de l' excès de Ga Ga après la riche croissance de la couche tampon de GaN et avant la croissance InAlN.
Contrôle de Ga sur la surface peut être réalisée par un flux suppling Ga légèrement inférieur au flux nécessaire pour la formation de gouttelettes de Ga. Cependant, cette fenêtre de croissance est faible, et la couverture de surface Ga insuffisante provoquera la morphologie de surface à se dégrader en plateau / tranchée morphologie tout flux Ga excès se traduira par l' accumulation Ga et la formation de gouttelettes macroscopique. 17 Réflexion diffraction d'électrons à haute énergie (RHEED) intens lité peut être utilisé pour contrôler l'accumulation de Ga et de désorption. Couverture de la surface de Ga est indiquée par une diminution de l'intensité RHEED, ainsi que tout décalage entre la fermeture du Ga (et N *) volets et l'augmentation initiale de l'intensité RHEED indique une accumulation de Ga, comme le montre la figure 3.

Figure 3: surveillance de la couverture Ga avec signal d'intensité RHEED intensité RHEED mesurée à partir de motifs RHEED acquis en vertu de rotation à l' aide d' acquisition déclenchée.. Insuffisant flux Ga est indiqué par une augmentation immédiate de l'intensité après la fermeture des volets (non représenté). Saturés / couverture idéale Ga est indiquée par un retard entre la fermeture de l'obturateur et abrupt éclaircissant RHEED et la couverture Ga excès vu à la fois comme un retard dans l'éclaircissement initial RHEED ainsi qu'une augmentation de l'intensité plus progressive résultant dans la récupération de pleine intensité prenant plus de 60 s.com / fichiers / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
Obtenir une haute qualité InAlN par PAMBE est compliquée par la présence de fluctuations de composition latérales, ce qui entraîne une microstructure "nid d'abeille" constitué de domaines riches en Al entourés par des frontières En riches. 18 L' élimination de cette microstructure est réalisée en utilisant une température du substrat d' environ 50 ° C au- dessus du début de la désorption dans, ou 15,19,20 environ 630 ° C pendant InAlN N-polaire. Dans ce régime de croissance à haute température, l'In x Al 1- composition x N est une fonction forte de la température du substrat, avec des températures plus élevées entraînant une diminution de l'incorporation. Le flux Dans peut être augmentée pour compenser Dans perdue par évaporation, bien que dans la pratique le maximum en flux est limitée par une réduction de l'efficacité de l'incorporation de plus en plus en flux. 21 En plus de réduire la température du substrat ou en augmentant le En flux, ce qui augmente le taux de croissance peut également augmenter la composition En raison du piège "En enterrant effet", où entrant Al atomes dans et empêcher l'évaporation. 21,22 supérieur les taux de croissance peuvent être obtenus en augmentant le flux In et Al proportionnellement. Afin de maintenir les conditions de croissance riches en azote, N * devrait être augmentée aussi, ce qui peut être obtenu en augmentant la puissance du plasma RF, ce qui augmente la vitesse d'écoulement de N2, d' améliorer la conception de la chambre à plasma, ou en augmentant le trou de la plaque d'ouverture densité.
couches épitaxiales supplémentaires dans HEMT à base de GaN et InAlN comprennent AIN intercouches (ILS) et un canal de GaN. Un AIN IL inséré entre la barrière et le canal peut augmenter la mobilité μ ainsi que la feuille de canal densité de charge n s. L'augmentation de la mobilité est attribuée à la réduction onde électronique fonction chevauchement avec le InAlN barrier et la diffusion d'alliage ultérieur. 9 Pour assurer une croissance de haute qualité de l'AIN IL, un excès de Ga flux est fourni pendant la croissance d'agir comme un agent tensio – actif. Un GaN IL peut être utilisé entre le AIN IL et de la barrière afin d'améliorer encore la mobilité tout en réduisant la charge de canal. Le canal GaN peut être cultivé à la même température que la barrière InAlN, ce qui permet une croissance continue de la barrière que les ILs et canal. une mobilité améliorée a été obtenue par l'interruption de la croissance après la IL AIN et en augmentant la température de croissance avant la croissance du canal GaN. Dans ce cas, une couverture protectrice de surface Ga doit être maintenue au cours de l'interruption pour empêcher la dégradation de la mobilité.
Le protocole suivant applique spécifiquement à HEMT InAlN-barrière cultivées sur des substrats de GaN N-polaires. Il peut être directement étendue à la croissance sur des substrats en C-polaire 4H- ou 6H-SiC en incluant un nm N riche couche d'AIN 50 d'épaisseur.
Protocol
Representative Results
Discussion
La croissance d'une couche tampon de GaN de haute qualité est essentielle pour parvenir à une mobilité électronique élevée dans tous les HEMT de nitrure III. Dans le cas d'un HEMT InAlN N-polaire, la croissance de la couche tampon est compliquée par la nécessité que tous Ga être retiré de la surface avant la croissance InAlN. Il existe une variété de techniques pour accomplir ceci en plus de la procédure décrite ici, comme épitaxie, 27 modulé en métal en utilisant des conditions de c…
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

