Plasmagestützte Molecular Beam Epitaxy von N-polar InAlN-Barriere Hochelektronenmobilität Transistoren
Summary
Molekularstrahlepitaxie verwendet wird N-polar InAlN-Barriere High-Elektronen-mobility transistors (HEMT) zu wachsen. Die Steuerung der Waferaufbereitung, Schichtwachstumsbedingungen und Epitaxie – Struktur ergibt glatte, homogene kompositorisch InAlN Schichten und HEMTs mit Mobilität so hoch wie 1750 cm 2 / V ∙ sec.
Abstract
Plasma-unterstützte Molekularstrahl-Epitaxie ist gut geeignet für das epitaktische Wachstum von III-Nitrid-Schichten und Heterostrukturen mit glatten, abrupt Schnittstellen für Hochelektronenmobilitätstransistoren hoher Qualität erforderlich (HEMTs). Ein Verfahren wird für das Wachstum von N-polaren InAlN HEMTs präsentiert, einschließlich Wafervorbereitungs und das Wachstum der Pufferschichten, die InAlN Sperrschicht, AlN und GaN-Zwischenschichten und der GaN-Kanal. Kritische Punkte bei jedem Schritt des Verfahrens identifiziert werden, wie beispielsweise die Vermeidung Ga Akkumulation im GaN-Puffer, um die Rolle der Temperatur auf InAlN Zusammensetzungshomogenität und die Verwendung von Ga Flußmittel während der AlN-Zwischenschicht und den Interrupt vor GaN Kanalwachstum. Zusammensetzung homogenen N-polaren InAlN Dünnschichten mit Oberflächen root-mean-squared Rauheit so günstig wie 0,19 nm und zeigte InAlN-basierten HEMT – Strukturen sind für Geräte mit einer Flächenladungsdichte Mobilität so hoch wie 1750 cm 2 / V ∙ sec berichteten, von 1,7 x 1013 cm -2.
Introduction
Molekularstrahlepitaxie (MBE) ist ein vielseitiger Epitaxie – Dünnschicht – Wachstumstechnik , die ein Ultrahochvakuum – Umgebung mit Basisdruck so niedrig wie 10 -11 Torr beschäftigt zu niedrigen Verunreinigungs Einbau in den gewachsenen Film sicherzustellen. Die Zusammensetzung und die Wachstumsgeschwindigkeit der epitaktisch gewachsenen Schichten werden durch Steuern der Temperatur jeder Effusionszelle bestimmt und somit die verdampften Flußmittel der verschiedenen Ausgangsmaterialien. Im Fall von III-Nitrid – Epitaxie, der Gruppe III-Elemente (In, Al, Ga) werden typischerweise durch Effusionszellen vorgesehen ist, während der aktive Stickstoff (N *) Fluss entweder durch ein N 2 -Plasma 1,2 (RF Plasma vorgesehen ist -Assistierte MBE. PAMBE oder RFMBE) oder Ammoniak (NH 3 -MBE) 3,4 MBE Wachstum wird durch niedrigere Wachstumstemperaturen und schärfere Grenzflächen abruptness als andere epitaktische Wachstumstechniken, wie beispielsweise metallorganische chemische Gasphasenabscheidung gekennzeichnet 5A schematisch dargestellt. in Figur 1.
<pclass = "jove_content">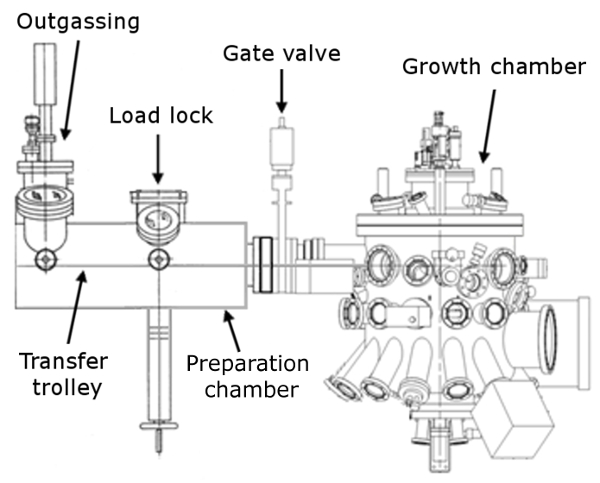
Abbildung 1:.. MBE Systemschema Schematische Darstellung der Ladesperre, Transfersystem, das Ausgasen Station und Wachstumskammer Bitte hier klicken , um eine größere Version dieser Figur zu sehen.
III-Nitriden auf Substraten aufgewachsen werden, um eine Vielzahl von Kristallorientierungen aufweist. Die am häufigsten verwendete Ausrichtung ist die Ga-polaren c -Ebene, die durch Ausnutzung der Differenz in der Polarisation zwischen der Barriereschicht, typischerweise AlGaN und GaN Kanal die Bildung eines zweidimensionalen Elektronengases ohne Dotierung ermöglicht. Verschiedene nicht-polaren und semipolaren Orientierungen von GaN haben erhebliche Aufmerksamkeit für die Optoelektronik aufgrund reduzierter Polarisationseffekte in den Quantentrögen, 6,7 , die auch diese Orientierungen weniger wünschenswert für HEMT applicatio machtns. N-polar orientierte Geräte sind attraktiv für die nächste Generation Hochfrequenz – HEMT Betrieb durch mehrere intrinsische Vorteile gegenüber herkömmlichen Ga-polaren Vorrichtungen. 8 ist die Sperrschicht in N-polaren Geräte unterhalb des GaN Kanal gezüchtet , wie in 2 gezeigt, was in einer natürlichen Barriere zurück hilft, dass elektrostatische Kontrolle des Kanals und Short-Channel-Effekte reduziert, während leichter aktuellen Zugriff auf die GaN-Kanal ermöglicht und Kontaktwiderstand zu reduzieren. Die Barriere kann auch separat von dem Kanal gesteuert werden, so daß, wenn die Kanaldicke nach unten für Hochfrequenzvorrichtungen skaliert wird die Sperr Design modifiziert werden kann, für die Kanalladung zu Ferminiveau Pinning-Effekte verloren zu kompensieren.
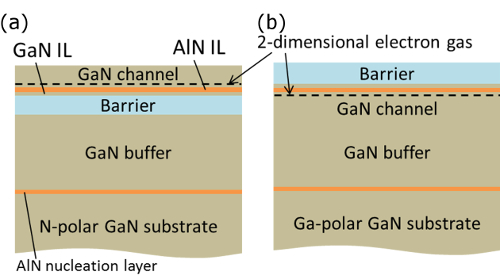
Fig . 2: schematische Epitaxial – Schicht Schichtstruktur von (a) einem N-polaren HEMT und (b) eine Ga-polaren HEMT für comparIson. Bitte hier klicken , um eine größere Version dieser Figur zu sehen.
HEMTs in Hochgeschwindigkeits verwendet werden Hochleistungsverstärker normalerweise auf SiC-Substrate aufgewachsen Vorteil der hohen Wärmeleitfähigkeit von SiC zu nehmen. Niedrige Fadenversetzungsdichte freistehende GaN – Substrate können die Elektronenbeweglichkeit zu verbessern , verwendet werden, 9 so die Hochfrequenzleistung verbessert wird . Nach dem Wachstum einer AlN Kernbildungsschicht wird ein dicker GaN-Puffer bei dem Nachwachsen Schnittstelle vom HEMT Kanal und verbessern die elektrische Isolierung räumlich getrennt um die Verunreinigungen gezüchtet. Im Gegensatz zu anderen III-V – Materialien, durch PAMBE gewachsen GaN benötigt typischerweise Wachstumsbedingungen mit einer Gruppe-III / V – Verhältnis von größer als 1 ist , dh metallreichen Bedingungen, 10,11 , um eine glatte Oberflächenmorphologie zu erreichen. In x Al 1- x N ist ein alternativen Barrierematerial für III-Nitrid – HEMTs, und hat vor kurzem erhebliche Aufmerksamkeit erhalten , weil es Gitter für x ≈ 0,18 bis GaN angepasst angebaut werden kann und über die doppelte Kanalladung relativ zu AlGaN Barrieren aufgrund seiner hohen spontanen Polarisation erzeugen. 15.12 Im Gegensatz zu AlGaN Barrieren, wird Ga bevorzugt an in in InAlN Schichten einzuarbeiten, 16 so darauf geachtet werden , muss die Oberfläche frei ist von überschüssigem Ga nach dem Ga-reiche GaN – Pufferschicht Wachstum und vor InAlN Wachstum zu gewährleisten.
Steuerung von Ga auf der Oberfläche kann für Ga-Tröpfchenbildung erforderlich durch suppling eine Ga Flußmittel geringfügig kleiner als der Fluß erreicht werden. Allerdings ist dieses Wachstum Fenster klein, und eine unzureichende Oberflächenabdeckung Ga wird die Oberflächenmorphologie zu degradieren in Plateau / Graben Morphologie verursachen , während überschüssiges Ga Fluss in Ga Akkumulation und makroskopischen Tropfenbildung führen. 17 Rheed (RHEED) intens keit kann verwendet werden, Ga Akkumulation und Desorption zu überwachen. Ga Oberflächenabdeckung wird durch eine Verringerung der RHEED Intensität angegeben, und jede Verzögerung zwischen den Ga Schließen (und N *) Fensterläden und die anfängliche Anstieg der RHEED Intensität zeigt Anhäufung von Ga, wie in Abbildung 3 dargestellt.

Abbildung 3: Überwachung Ga Abdeckung mit RHEED Intensität RHEED Intensitätssignal gemessen von RHEED Muster unter Rotation mit getriggerten Akquisition erworben.. Unzureichende Ga Flußmittel durch eine sofortige Erhöhung der Intensität angezeigt wird, nachdem die Jalousien zu schließen (nicht gezeigt). Gesättigte / ideal Ga Abdeckung wird durch eine Verzögerung zwischen dem Verschluss Verschluss und abrupte RHEED Aufhellung und überschüssige Ga Abdeckung angegeben in sowohl als in der anfänglichen RHEED Aufhellung einer Verzögerung zu sehen sowie eine allmähliche Intensitätserhöhung in voller Intensität Erholung resultierenden dauert länger als 60 s.com / files / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> Bitte hier klicken, um eine größere Version dieser Figur zu sehen.
Erreichen hoher Qualität durch PAMBE InAlN wird durch das Vorhandensein von seitlichen Zusammensetzung Schwankungen kompliziert, in einer "Bienenwabe" Mikrostruktur führen , bestehend aus Al-reichen Domänen , die durch In-reichen Grenzen umgeben. 18 Elimination dieser Mikrostruktur unter Verwendung einer Substrattemperatur etwa 50 erreicht wird ° C über dem Beginn der Desorption In, 15,19,20 oder ungefähr 630 ° C für N-polar InAlN. In dieser hohen Temperatur Wachstum Regime, x die in Al 1- x N Zusammensetzung eine starke Funktion der Substrattemperatur, bei höheren Temperaturen niedriger Einbau führt. Der im Fluss kann erhöht werden, um zu kompensieren In Verdunstung verloren, obwohl in der Praxis die maximale im Fluss durch eine Reduzierung der Einbaueffizienz begrenzt ist im Fluss mit zunehmenderDarüber hinaus. 21 , die Substrattemperatur oder die Erhöhung der im Fluss zu verringern, die Wachstumsrate zu erhöhen kann auch aufgrund der die In – Zusammensetzung erhöhen "Effekt zu begraben", wo eingehende Al – Atome Falle und verhindern , dass es zu verdampfen. 21,22 Higher Wachstumsraten durch Erhöhung der In und Al Fluß proportional erreicht werden. Um die Wachstumsbedingungen N-rich halten, wird die N * müssten ebenfalls erhöht werden, wodurch die RF Plasmaleistung durch Steigerung erzielt werden kann, die N 2 Durchflussrate steigt, die Verbesserung der Plasmakammer – Design, oder durch Erhöhung der Aperturplatte Loch Dichte.
Zusätzliche Epitaxieschichten in InAlN-basierten HEMTs umfassen GaN und AlN-Zwischenschichten (ILs) und einen GaN-Kanal. Ein AlN – IL zwischen der Barriere und Kanal eingeführt kann Mobilität μ sowie Kanalflächenladungsdichte n s erhöhen. Die Erhöhung der Mobilität wird zur Verringerung der Elektronenwellenfunktion Überlappung mit dem InAlN b zugeschriebenArrier und einen nachfolgenden Legierungsstreuung. 9 hochwertige Wachstum des AlN IL zu gewährleisten, ein Überschuß an Ga Flußmittel während des Wachstums zugeführt , wie einem oberflächenaktiven Mittel zu wirken. Ein GaN IL kann zwischen dem AlN-IL und Barriere zur weiteren Verbesserung der Mobilität bei gleichzeitiger Reduzierung Kanalladung verwendet werden. Der GaN-Kanal kann als InAlN Barriere, so dass ein kontinuierliches Wachstum von der Barriere obwohl die ILs und Kanal bei der gleichen Temperatur gezüchtet werden. Verbesserte Mobilität wurde durch Unterbrechung Wachstum nach dem AlN IL und die Erhöhung der Wachstumstemperatur, bevor das Wachstum des GaN-Kanal erhalten. In diesem Fall ist eine Schutz Ga hat Oberflächenbedeckung während der Unterbrechung zu verhindern Mobilitäts Abbau gehalten werden.
Das folgende Protokoll gilt speziell für InAlN-Barriere HEMTs auf N-polaren GaN-Substraten gewachsen. Es kann direkt, indem man eine 50 nm dicke N-rich AlN-Schicht zu Wachstum auf C-polar 4H- oder 6H-SiC-Substrate erweitert werden.
Protocol
Representative Results
Discussion
Wachstum eines qualitativ hochwertigen GaN-Pufferschicht ist kritisch hohe Elektronenbeweglichkeit in beliebigen III-Nitrid-HEMT zu erreichen. In dem Fall eines N-polar InAlN HEMT ist die Pufferschichtwachstum durch das Erfordernis erschwert, dass alle Ga von der Oberfläche vor dem Wachstum InAlN entfernt werden. Es gibt eine Vielzahl von Techniken , dies zusätzlich zu den hier beschriebenen Verfahren zu erreichen, wie beispielsweise Metall-moduliertes Epitaxie, 27 unter Verwendung von Wachstumsbedingungen …
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

