Plasma-assistert Molecular Beam Epitaxy av N-polar InAlN-barriere Høy elektron-mobilitet Transistorer
Summary
Molekylær bjelke epitaxy brukes til å dyrke N-polare InAlN-barriere høy elektron-mobilitet transistorer (HEMTs). Kontroll av wafer forberedelse, lag vekstvilkår og epitaxial struktur fører til glatte, sammensetnings homogene InAlN lag og HEMTs med mobilitet så høyt som 1750 cm 2 / V ∙ sek.
Abstract
Plasma-assistert molekylær stråle epitaxy er godt egnet for epitaxial vekst av III-nitride tynne filmer og hetero med glatte, brå grensesnitt som kreves for høy kvalitet, høy elektron-mobilitet transistorer (HEMTs). En fremgangsmåte blir presentert for vekst av N-polare InAlN HEMTs, inkludert wafer fremstilling og vekst av buffer lag, InAlN barrierelaget, AlN og Gan mellomlag og Gan kanal. Kritiske problemer ved hvert trinn i prosessen blir identifisert, slik som å unngå Ga opphopning i Gan buffer, rollen av temperatur på InAlN sammensetningshomogeniteten, og bruken av Ga flux i løpet av AlN folien, og avbruddet før Gan kanal vekst. Kompositorisk homogen N-polar InAlN tynne filmer er demonstrert med overflate rot-middel-squared ruhet så lavt som 0,19 nm og InAlN baserte HEMT strukturer er rapportert å ha mobilitet så høyt som 1750 cm 2 / V ∙ sek for enheter med et ark ladningstetthet på 1,7 x 1013 cm -2.
Introduction
Molekylær bjelke epitaxy (MBE) er en allsidig epitaxial tynn film vekst teknikk som benytter en ultra-høy vakuum miljø med grunn trykk så lavt som 10 -11 Torr å sikre lav urenhet innlemmelse i voksen film. Sammensetningen og veksthastigheten til epitaxially dyrket lagene bestemmes ved å styre temperaturen til hver effusjon celle, og således det fordampede fluksen av de forskjellige kildematerialer. I tilfellet av III-nitrid epitaksi, gruppen III-elements (I, Al, Ga) typisk gitt av effusjon celler, mens den aktive nitrogen (N *) fluks som leveres av enten en N-2 plasma 1,2 (RF plasma -assisted MBE:. PAMBE eller RFMBE), eller ammoniakk (NH3 -MBE) 3,4 MBE vekst er karakterisert ved lavere vekst temperaturer og skarpere grenseflate brå enn andre epitaksiale vekst teknikker, slik som metallorganisk kjemisk dampavsetning 5 En skjematisk er vist. i figur 1.
<pclass = "jove_content">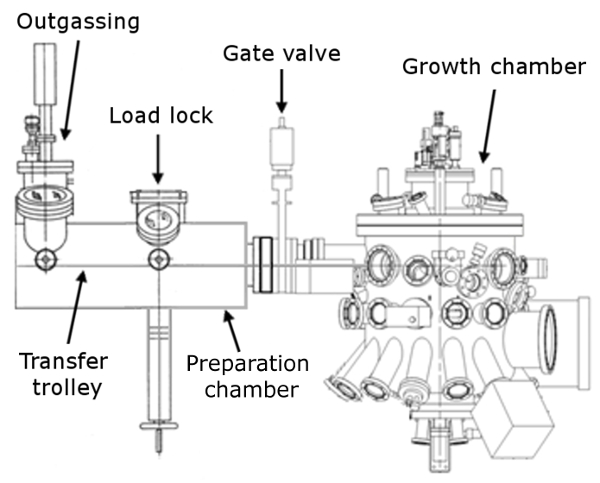
Figur 1:.. MBE system skjematisk Skjematisk viser belastningen lås, overføringssystem, utgassing stasjon og vekstkammeret Klikk her for å se en større versjon av dette tallet.
III-nitrider kan dyrkes på substrater som har en rekke forskjellige krystallorienteringer. Den mest brukte orientering er den Ga-polar c -planet, som tillater dannelsen av en to-dimensjonal elektron gass uten doping ved å utnytte forskjellen i polariseringen mellom barrieresjiktet, typisk AlGaN, og Gan kanal. En rekke ikke-polar og semi-polare orienteringer av Gan har fått betydelig oppmerksomhet for optoelektronikk skyldes reduserte polarisering effekter i kvante brønner, 6,7 noe som også gjør disse orienteringer mindre ønskelig for HEMT applikasjonerns. N-polare orienterte enheter er attraktivt for neste generasjon høyfrekvente HEMT operasjon på grunn av flere iboende fordeler i forhold til konvensjonelle Ga-polare enheter. 8 Barrierelaget i N-polare enheter som er dyrket under Gan kanal som vist på figur 2, noe som resulterer i en naturlig tilbake barriere som hjelpemidler elektrostatisk kontroll av kanalen og reduserer korte kanaleffekter, samtidig som den tillater lettere adgang strøm til Gan kanal og redusere kontaktmotstanden. Barrieren kan også styres separat fra kanalen, slik at når kanalen tykkelse er skalert ned for høyfrekvente enheter barrieren konstruksjon kan endres for å kompensere for kanal ladning tapt til Fermi-nivå låsing effekter.
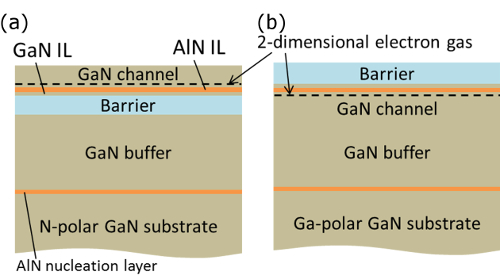
Fig. 2: epitaksiale lag skjematisk lagstruktur av (a) et N-polar HEMT og (b) en Ga-polar HEMT for komparativeIson. Klikk her for å se en større versjon av dette tallet.
HEMTs brukes i høy hastighet, er høy effektforsterkere normalt dyrkes på SiC underlag for å dra nytte av den høye varmeledningsevne av SiC. Lave gjenging dislokasjonstetthet frittstående Gan substrater kan anvendes for å forbedre den elektron mobilitet, 9 og dermed forbedre den høyfrekvente ytelse. Etter veksten av et AlN kjernedannelse lag, er en tykk Gan buffer dyrket til romlig separere forurensningene ved gjenvekst grensesnittet fra HEMT kanalen og bedre elektrisk isolasjon. I motsetning til andre III-V materialer, Gan dyrket ved PAMBE trenger vanligvis vekstbetingelser sammen med et gruppe-III / V-forholdet er større enn 1, dvs. metall-rik forhold, 10,11 for å oppnå en jevn overflatemorfologi. I x Al 1- x N er et alterinnfødte barriere materiale for III-nitride HEMTs, og har fått betydelig oppmerksomhet den siste tiden, fordi det kan dyrkes gitter tilpasset Gan for x ≈ 0,18 og kan generere over dobbelt kanalen kostnad i forhold til AlGaN barrierer på grunn av sin høye spontane polarisering. 12-15 motsetning AlGaN barrierer, vil Ga innlemme fortrinnsvis til in i InAlN lag, 16 bryr seg dermed må tas for å sikre at overflaten er fri for overflødig Ga etter Ga rike Gan buffer lag vekst og før InAlN vekst.
Kontroll av Ga på overflaten kan utføres ved suppling en Ga fluks litt mindre enn den fluks som er nødvendig for Ga-dråpedannelse. Imidlertid er denne vekst vinduet liten og utilstrekkelig Ga overflatedekning vil føre til at overflatemorfologi til å nedbrytes til platå / grøft morfologi, mens overskytende Ga fluks vil resultere i Ga akkumulering og makroskopisk dråpedannelse. 17 Refleksjon høyenergi-elektron diffraksjon (RHEED) intens ligheten kan brukes til å overvåke Ga akkumulering og desorpsjon. Ga overflatedekning er indikert ved en reduksjon i RHEED intensitet, og eventuelle lag mellom lukking av Ga (og N *) skodder og den innledende økning i RHEED intensiteten indikerer akkumulering av Ga, som vist i figur 3.

Figur 3: Overvåking Ga dekning med RHEED intensitet RHEED intensitetssignal målt fra RHEED mønster anskaffet under rotasjon ved hjelp utløste oppkjøpet.. Utilstrekkelig Ga fluks er angitt med en umiddelbar økning i intensitet etter stengetid skodder (ikke vist). Mettet / ideell Ga dekningen er angitt med en forsinkelse mellom lukker lukke og brå RHEED lysere og overskudd av Ga dekning i sett på som både en forsinkelse i innledende RHEED lysgjøring, så vel som en mer gradvis økning intensiteten som resulterer i full intensitet utvinning tar lengre enn 60 sek.com / filer / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> Klikk her for å se en større versjon av dette tallet.
Å oppnå høy kvalitet InAlN ved PAMBE kompliseres ved nærværet av svingninger laterale sammensetning, noe som resulterer i en "honeycomb" mikrostruktur som består av Al-rike domener som er omgitt av In-rike grenser. 18 Eliminering av denne mikrostruktur oppnås ved å bruke et substrat temperatur omtrent 50 ° C over den begynnende desorbsjon i, 15,19,20 eller ca. 630 ° C i N-polar InAlN. I denne høy temperatur vekst regime, In x Al 1- x N sammensetning er en sterk funksjon av overflatetemperatur, med høyere temperaturer resulterer i lavere i innlemmelse. In fluks kan økes for å kompensere for In tapt til fordampning, selv om i praksis den maksimale I fluksen begrenses av en reduksjon av inkorporering effektivitet med økning i forandring. 21 I tillegg til å redusere overflatetemperaturen eller øke i fluks, noe som øker veksthastigheten kan også øke i sammensetning på grunn av den "Etter begrave effekt", hvor innkommende Al-atomer felle I og hindre den fra å fordampe. 21,22 Høyere vekstrater kan oppnås ved å øke i og Al flux proporsjonalt. For å holde vekstbetingelser N-rik, ville N * må økes også, noe som kan oppnås ved å øke RF-plasma-strøm, noe som øker N2-strømningshastighet, bedre plasmakammeret utforming, eller ved å øke hullplaten hullet tetthet.
Andre epitaxial lagene i InAlN-baserte HEMTs inkluderer Gan og AlN mellomlag (ILS) og en Gan kanal. En AlN IL innsatt mellom barrieren og kanalen kan øke mobiliteten μ samt kanal ark ladningstetthet n s. Økningen i mobilitet er knyttet til å redusere elektronbølgefunksjonen overlapper med den InAlN barrier og påfølgende legering spredning. 9 For å sikre høy kvalitet på veksten av AlN IL, blir et overskudd av Ga flussmiddel tilført under vekst for å virke som et overflateaktivt middel. En Gan IL kan brukes mellom AIN IL og barriere for å ytterligere forbedre mobiliteten samtidig redusere kanal kostnad. Den GAN kanal kan dyrkes ved den samme temperatur som den InAlN barrieren, slik at kontinuerlig vekst fra barriere skjønt ILS og kanal. Forbedret bevegelighet er oppnådd ved å avbryte vekst etter AlN IL og øke veksttemperaturen før dyrking av Gan kanalen. I dette tilfellet er en beskyttende Ga overflatedekning må bli opprettholdt i løpet av avbruddet for å forhindre degradering mobilitet.
Følgende protokoll gjelder spesielt InAlN-barriere HEMTs dyrket på N-polare Gan underlag. Det kan være direkte utvides til vekst på C-polar 4H-6H-SiC eller substrater ved å inkludere en 50 nm tykk N-rik AIN sjiktet.
Protocol
Representative Results
Discussion
Vekst av høy kvalitet Gan buffer lag er avgjørende for å oppnå høy elektron mobilitet i enhver III-nitrid HEMT. I tilfelle av en N-polar InAlN HEMT er laget vekst buffer komplisert ved det krav at alt Ga kan fjernes fra overflaten før InAlN vekst. Det finnes en rekke teknikker for å oppnå dette, i tillegg til fremgangsmåten som beskrives her, for eksempel metall-modulert epitaksi, 27 ved hjelp av vekstbetingelser ved kanten av den mellomliggende Ga dekning og Ga dråpe akkumulering regime, 28</s…
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

