Asistida por plasma Molecular Beam epitaxia de N-polar InAlN de barrera de transistores de alta movilidad de electrones
Summary
epitaxia de haces moleculares se utiliza para producir transistores InAlN barreras de alta movilidad de electrones-N-polares (HEMT). De control de la preparación de la oblea, condiciones de crecimiento y estructura de capa epitaxial resultados en capas InAlN lisas, de composición homogénea y HEMTs con movilidad tan alto como 1.750 cm2 / V ∙ seg.
Abstract
epitaxia de haz molecular asistido por plasma es muy adecuado para el crecimiento epitaxial de películas y heteroestructuras delgadas de nitruro III con interfaces lisas, abruptos necesarios para la alta calidad transistores de alta movilidad de electrones (HEMT). Un procedimiento se presenta para el crecimiento de HEMTs InAlN N-polares, incluyendo la preparación de la oblea y el crecimiento de las capas tampón, la capa de barrera InAlN, AlN y de GaN de capas encapsuladas y el canal de GaN. Se identifican los problemas críticos en cada paso del proceso, tales como evitar la acumulación de Ga en el tampón de GaN, el papel de la temperatura en InAlN homogeneidad de composición, y el uso de flujo de Ga en la capa intermedia de AIN y el crecimiento antes de GaN canal de interrupción. Películas delgadas a composición homogénea InAlN N-polar se demuestran con rugosidad superficial raíz media cuadrada tan bajo como 0,19 nm y InAlN-basan son reportados estructuras HEMT que tiene la movilidad tan alto como 1.750 cm2 / V ∙ s para los dispositivos con una densidad de hoja de cargos de 1,7 x 1013 cm -2.
Introduction
Epitaxia de haces moleculares (MBE) es una técnica de crecimiento de película delgada epitaxial versátil que emplea un ambiente ultra-alto vacío con presiones de base tan bajas como 10 -11 Torr para asegurar una baja incorporación de impurezas en la película adulta. La composición y la tasa de crecimiento de las capas obtenidas por crecimiento epitaxial se determina mediante el control de la temperatura de cada célula de efusión, y por lo tanto el flujo evaporada de los diversos materiales de base. En el caso de epitaxia III-nitruro, del grupo III-elementos (In, Al, Ga) se proporcionan típicamente por las células de efusión mientras que el nitrógeno activo (N *) de flujo se proporciona por cualquiera de un plasma de 1,2 (plasma RF N 2 MBE -assisted:. PAMBE o RFMBE) o el amoníaco (NH3 -MBE) 3,4 MBE crecimiento se caracteriza por temperaturas de crecimiento más bajas y más cortante interfacial brusquedad que otras técnicas de crecimiento epitaxial, tales como deposición de vapor químico organometálico 5 se muestra un esquema. en la Figura 1.
<pclass = "jove_content">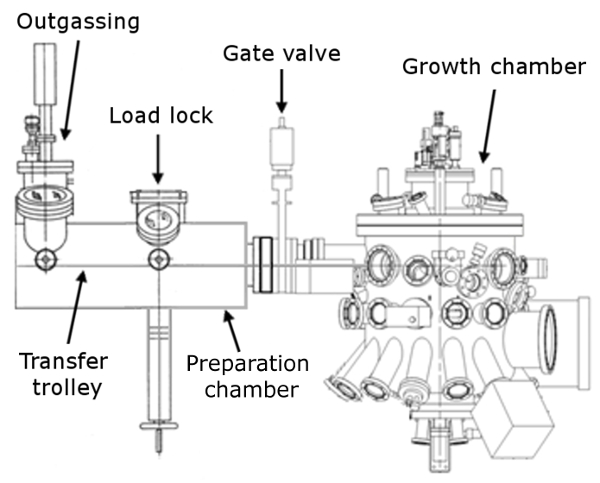
Figura 1:.. Esquema del sistema de MBE Esquema que muestra la cámara de bloqueo de carga, sistema de transferencia, la estación de desgasificación y el crecimiento Haga clic aquí para ver una versión más grande de esta figura.
III-nitruros se pueden crecer en sustratos que tienen una variedad de orientaciones de cristal. La orientación más comúnmente utilizado es el un plano c Ga-polar, lo que permite la formación de un gas de electrones bidimensional sin dopaje mediante la utilización de la diferencia de polarización entre la capa de barrera, típicamente AlGaN, y el canal de GaN. Varios no polar y semi-polares orientaciones de GaN han recibido mucha atención de la optoelectrónica, debido a la reducción de los efectos de polarización en los pozos cuánticos, 6,7, que también hace que estas orientaciones menos deseable para applicatio HEMTns. Dispositivos orientados N-polares son atractivos para el funcionamiento HEMT de alta frecuencia de próxima generación debido a varias ventajas intrínsecas más de los dispositivos de Ga-polares convencionales. 8 La capa de barrera en dispositivos N-polares se cultiva bajo el canal de GaN como se muestra en la Figura 2, lo que resulta en una barrera natural que volver Control del SIDA electrostática del canal y reduce los efectos de canal corto, al tiempo que permite un acceso más fácil actual al canal GaN y la reducción de la resistencia de contacto. La barrera también se puede controlar por separado del canal, de modo que a medida que el espesor del canal es reducido para los dispositivos de alta frecuencia el diseño de barrera puede ser modificado para compensar la carga del canal perdido a Fermi efectos de nivel fijación.
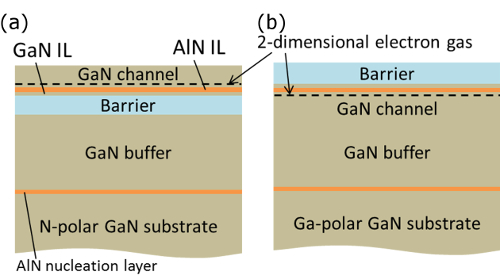
Figura 2:. Epitaxial capa esquemática estructura de capas de (a) un HEMT N-polar y (b) un HEMT Ga-polar para comparIson. Por favor, haga clic aquí para ver una versión más grande de esta figura.
HEMTs utilizados en alta velocidad, amplificadores de alta potencia normalmente se cultivan en sustratos de SiC para tomar ventaja de la alta conductividad térmica de SiC. Threading dislocación sustratos de baja densidad independiente de GaN se pueden emplear para mejorar la movilidad de los electrones, 9 mejorando así el rendimiento de alta frecuencia. Tras el crecimiento de una capa de AlN nucleación, un tampón de GaN de espesor se cultiva para separar espacialmente las impurezas en la superficie de nuevo crecimiento del canal HEMT y mejorar el aislamiento eléctrico. A diferencia de otros materiales III-V, GaN crecido por PAMBE normalmente necesita condiciones de crecimiento con una relación de grupo-III / V mayor que 1, es decir, condiciones ricas en metales, 10,11 a fin de alcanzar una morfología de superficie lisa. En x Al x 1- N es un altermaterial de barrera nativo para HEMTs de nitruro III, y ha recibido mucha atención recientemente debido a que puede ser adaptado a crecido celosía de GaN para x ≈ 0,18 y puede generar más del doble de la carga de canal en relación con las barreras AlGaN debido a su alta polarización espontánea. A diferencia de 12-15 barreras AlGaN, Ga incorporarán preferentemente a a en capas InAlN, 16 por lo tanto se debe tener cuidado para asegurar que la superficie esté libre de exceso de Ga Ga después del crecimiento con alto coeficiente de amortiguación capa de GaN y antes de que el crecimiento InAlN.
El control de Ga en la superficie se puede lograr por suppling un flujo Ga ligeramente menor que el flujo necesario para la formación Ga-gotas. Sin embargo, esta ventana crecimiento es pequeño, y la insuficiente cobertura de la superficie Ga hará que la morfología de la superficie de degradar en la morfología de meseta / zanja mientras que el exceso de flujo de Ga dará lugar a la acumulación de Ga y la formación de gotas macroscópica. Difracción de electrones de alta energía 17 de reflexión (RHEED) intens dad se puede utilizar para controlar la acumulación de Ga y desorción. Cobertura de la superficie Ga se indica por una reducción en la intensidad RHEED, y cualquier retraso entre el cierre de la Ga (y N *) persianas y el aumento inicial de la intensidad RHEED indica acumulación de Ga, como se muestra en la Figura 3.

Figura 3: Monitoreo de la cobertura Ga con señal de intensidad RHEED intensidad RHEED medido desde el patrón RHEED adquirido en virtud de la rotación mediante la adquisición disparada.. flujo insuficiente Ga se indica por un aumento inmediato de la intensidad después de cerrar las persianas (no mostrado). la cobertura saturada / ideales Ga se indica mediante un retardo entre el cierre de obturación y la abrupta brillo RHEED y el exceso de cobertura de Ga en la vista tanto como un retraso en el brillo inicial RHEED, así como un aumento de la intensidad más gradual que resulta en la recuperación plena intensidad tomando más tiempo de 60 s.com / archivos / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> Haga clic aquí para ver una versión más grande de esta figura.
El logro de alta calidad InAlN por PAMBE se complica por la presencia de las fluctuaciones de la composición laterales, lo que resulta en una microestructura "nido de abeja" que consiste en dominios de Al-ricos rodeados por límites In-ricos. 18 Eliminación de esta microestructura se consigue mediante el uso de una temperatura de sustrato de 50 ° C por encima de la aparición de los En desorción, 15,19,20 o aproximadamente 630 ° C para InAlN N-polar. En este régimen de crecimiento de alta temperatura, la x Al x 1- composición N es una fuerte función de la temperatura del sustrato, con temperaturas más altas resulta en un menor en la incorporación. El flujo en se puede aumentar para compensar En pierde por evaporación, aunque en la práctica el máximo en el flujo está limitado por una reducción de la eficacia de incorporación con el aumento en el flujo de. 21 Además de reducir la temperatura del sustrato o el aumento de la en flujo, el aumento de la tasa de crecimiento también puede aumentar la composición A su debido a la trampa "En efecto enterrar", donde entrante Al átomos en y evitar que se evapore. 21,22 Superior las tasas de crecimiento se puede lograr mediante el aumento del flujo en y al proporcionalmente. Para mantener las condiciones de crecimiento rico en N, necesitaría el N * que aumentar, así, que se puede lograr mediante el aumento de la potencia de plasma de RF, el aumento de la velocidad de flujo de N 2, mejorar el diseño cámara de plasma, o el aumento del orificio de la placa de abertura densidad.
capas epitaxiales adicionales en HEMTs basados en GaN y InAlN incluyen AlN intercalares (ILS) y un canal de GaN. Un AlN IL inserta entre la barrera y el canal puede aumentar μ movilidad, así como la hoja canal de densidad de carga n s. El aumento de la movilidad se atribuye a la reducción de función de onda de electrones superposición con la InAlN bArrier y posterior dispersión de la aleación. 9 Para garantizar un crecimiento de alta calidad de la IL AlN, un exceso de flujo de Ga se suministra durante el crecimiento para actuar como un agente tensioactivo. A GaN IL se puede utilizar entre el AlN IL y de barrera para mejorar aún más la movilidad al tiempo que reduce la carga de canal. El canal de GaN se puede cultivar en la misma temperatura que la barrera InAlN, permitiendo el crecimiento continuo de la barrera cuando los líquidos iónicos y canal. Mejora de la movilidad se ha obtenido mediante la interrupción de crecimiento después de que el AlN IL y el aumento de la temperatura de crecimiento antes de crecer el canal de GaN. En este caso una cobertura protectora de la superficie Ga tiene que ser mantenido durante la interrupción para evitar la degradación de la movilidad.
El siguiente protocolo se aplica específicamente a HEMTs InAlN-barrera cultivadas sobre sustratos de GaN N-polares. Se puede extender directamente al crecimiento sobre sustratos C-polar 4H- o 6H-SiC mediante la inclusión de una capa de AlN 50 nm de espesor N-rico.
Protocol
Representative Results
Discussion
El crecimiento de una capa tampón de GaN de alta calidad es fundamental para el logro de alta movilidad de electrones en cualquier HEMT III-nitruro. En el caso de un N-polar InAlN HEMT, el crecimiento de la capa tampón se complica por el requisito de que todos Ga ser retirado de la superficie antes de crecimiento InAlN. Hay una variedad de técnicas para lograr esto además con el procedimiento descrito aquí, tales como la epitaxia, 27 de metal modulada usando condiciones de crecimiento en el borde de la c…
Declarações
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
Referências
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

