Metallassisterad elektrokemisk nanoimprintning av porösa och fasta kiselplattor
Summary
Ett protokoll för metallassisterad kemisk prägling av 3D-mikroskalefunktioner med sub-20 nm formnoggrannhet i fasta och porösa kiselplattor presenteras.
Abstract
Metallassisterad elektrokemisk prägling (Mac-Imprint) är en kombination av metallassisterad kemisk etsning (MACE) och nanoimprintlitografi som kan direkt mönstra 3D-mikro- och nanoskalafunktioner i monokristallin grupp IV (t.ex. Si) och III-V (t.ex. GaAs) halvledare utan behov av offermallar och litografiska steg. Under denna process tas en återanvändbar stämpel belagd med en ädelmetallkatalysator i kontakt med en Si-skiva i närvaro av en blandning av fluorvätesyra (HF) och väteperoxid (H2O2), vilket leder till selektiv etsning av Si vid kontaktgränssnittet för metall-halvledare. I detta protokoll diskuterar vi de stämpel- och substratberedningsmetoder som tillämpas i två Mac-Imprint-konfigurationer: (1) Porous Si Mac-Imprint med en solid katalysator; och (2) Solid Si Mac-Imprint med en porös katalysator. Denna process är hög genomströmning och kan centimeterskala parallella mönster med sub-20 nm upplösning. Det ger också låg defekttäthet och stor yta mönstrar i en enda operation och kringgår behovet av torr etsning såsom djup reaktiv jon etsning (DRIE).
Introduction
Tredimensionell mikro- och nanoskala mönstring och texturisering av halvledare möjliggör många tillämpningar inom olika områden, såsom optoelektronik1,2, fotonik3, antireflektiva ytor4, superhydrofobiska och självrengörande ytor5,6 bland andra. Prototyper och massproducerande 3D- och hierarkiska mönster har framgångsrikt uppnåtts för polymera filmer genom mjuk litografi och nanoimprintinglitografi med upplösning under 20 nm. Överföring av sådana 3D-polymermönster till Si kräver dock etsningsselektivitet hos ett maskmönster under reaktiv jonetsning och begränsar därmed bildförhållandet och inducerar formförvrängningar och ytjämnhet på grund av uddande effekter7,8.
En ny metod som kallas Mac-Imprint har uppnåtts för parallell och direkt mönstra av porösa9 och fasta Si wafers10,11 samt solida GaAs wafers12,13,14. Mac-Imprint är en kontaktbaserad våt etsningsteknik som kräver kontakt mellan substrat och en ädel metallbelagd stämpel som har 3D-funktioner i närvaro av en etsningslösning (ES) bestående av HF och en oxidant (t.ex. H2O2 när det gäller Si Mac-Imprint). Under etsningen uppstår två reaktioner samtidigt15,16: en katodisk reaktion (dvs. H2O2-reduktionen vid ädelmetallen, under vilken positiva laddningsbärare [hål] genereras och därefter injiceras i Si17) och en anodisk reaktion (dvs. Si-upplösning, under vilken hålen konsumeras). Efter tillräckligt med tid i kontakt etsas stämpelns 3D-funktioner in i Si-skivan. Mac-Imprint har många fördelar jämfört med konventionella litografiska metoder, såsom hög genomströmning, kompatibilitet med roll-to-plate och roll-to-roll-plattformar, amorfa, mono- och polykristallina Si- och III-V halvledare. Mac-Imprint-stämplar kan återanvändas flera gånger. Dessutom kan metoden leverera en upplösning på sub-20 nm etsning som är kompatibel med samtida direktskrivningsmetoder.
Nyckeln till att uppnå högåtergivningsprägling är diffusionsvägen till etsningsfronten (dvs. kontaktgränssnitt mellan katalysator och substrat). Arbetet i Azeredo et al.9 visade först att ES-diffusion är möjliggjort genom ett poröst Si-nätverk. Torralba et al.18, rapporterade att för att realisera solid Si Mac-Imprint aktiveras ES-diffusionen genom en porös katalysator. Bastide et al.19 och Sharstniou et al.20 undersökte vidare katalysatorns porositetspåverkan på ES diffusion. Således har begreppet Mac-Imprint testats i tre konfigurationer med distinkta diffusionsvägar.
I den första konfigurationen är katalysatorn och substratet fasta, vilket inte ger någon initial diffusionsväg. Bristen på reaktant diffusion leder till en sekundär reaktion under prägling som bildar ett lager av porösa Si på substratet runt kanten av katalysator-Si-gränssnittet. Reaktanterna töms därefter, och reaktionen stannar, vilket resulterar i ingen urskiljbar mönsteröverföringsåtergivning mellan stämpeln och substratet. I den andra och tredje konfigurationen aktiveras diffusionsvägarna genom porösa nätverk som införs antingen i substratet (dvs. porösa Si) eller i katalysatorn (dvs. poröst guld) och hög mönsteröverföringsnoggrannhet uppnås. Masstransporten genom porösa material spelar således en avgörande roll för att möjliggöra spridning av reaktanter och reaktionsprodukter till och från kontaktgränssnittet9,18,19,20. Ett schema över alla tre konfigurationerna visas i bild 1.
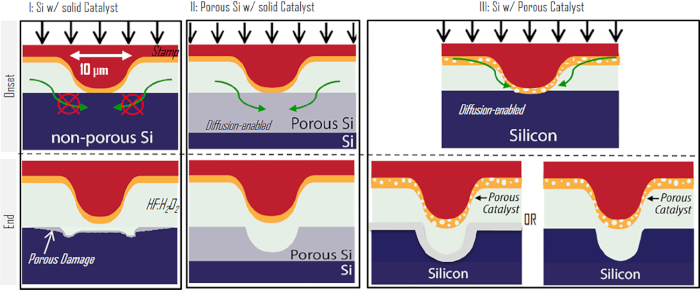
Bild 1: Scheman för Mac-Imprint-konfigurationer. Denna siffra belyser porösa materials roll för att möjliggöra diffusion av reagerande arter genom substratet (dvs. fall II: porösa Si) eller i stämpeln (dvs. fall III: katalysator tunnfilm av poröst guld). Klicka här för att se en större version av den här figuren.
I detta dokument diskuteras Mac-Imprint-processen noggrant, inklusive frimärksberedning och substratförbehandling tillsammans med Mac-Imprint själv. Substratförbehandlingssektionen inom protokollet inkluderar Si wafer-rengöring och Si wafer-mönstring med torr etsning och substratanodisering (valfritt). Vidare är en stämpelberedningssektion indelad i flera procedurer: 1) PDMS replika formning av Si master mögel; 2) UV-nanoimprinting av ett fotoresistskikt för att överföra PDMS-mönstret; och 3) katalytisk skiktdeposition via magnetronsputtering följt av dealloying (valfritt). Slutligen, i Mac-Imprint-avsnittet presenteras Mac-Imprint-installationen tillsammans med Mac-Imprint-resultaten (dvs. Si yta 3D-hierarkisk mönstra) .
Protocol
Representative Results
Discussion
Mac-Imprint-stämplar och prepatterned Si-chips (p-typ, [100] orientering, 1-10 Ohm∙cm) förbereddes enligt avsnitt 1 respektive 2 i protokollet. Mac-Imprint av prepatterned Si chip med frimärken som innehåller 3D hierarkiska mönster utfördes enligt avsnitt 3 i protokollet (figur 9). Som visas i figur 9a tillämpades olika konfigurationer av Mac-Imprint: solid Si med solid Au (vänster), porös Si med solid Au (mitten)9</…
Declarações
The authors have nothing to disclose.
Acknowledgements
Vi erkänner Dr. Keng Hsu (University of Louisville) för insikter om detta arbete; University of Illinois Frederick Seitz Laboratory och, till minne av detta, medarbetare Scott Maclaren; Arizona delstatsuniversitet LeRoy Eyring centrerar för solid statlig vetenskap; och Science Foundation Arizona under Bis grove Scholars Award.
Materials
| Acetone, >99.5%, ACS reagent | Sigma-Aldrich | 67-64-1 | CAUTION, chemical |
| Ammonium fluoride, >98%, ACS grade | Sigma-Aldrich | 12125-01-8 | CAUTION, hazardous |
| Ammonium hydroxide solution, 28-30%, ACS reagent | Sigma-Aldrich | 1336-21-6 | CAUTION, hazardous |
| AZ 400K developer | Microchemicals | AZ 400K | CAUTION, chemical |
| BenchMark 800 Etch | Axic | BenchMark 800 | Reactive ion etching |
| Chromium target, 2" x 0.125", 99.95% purity | ACI alloys | ADM0913 | Magnetron sputter chromium target |
| CTF 12 | Carbolite Gero | C12075-700-208SN | Tube furnace |
| Desiccator | Fisher scientific Chemglass life sciences | CG122611 | Desiccator |
| F6T5/BLB | Eiko | F6T5/BLB 6W | UV bulb |
| Gold target, 2" x 0.125", 99.99% purity | ACI alloys | N/A | Magnetron sputter gold target |
| Hotplate KW-4AH | Chemat tecnologie | KW-4AH | Leveled hotplate with uniform temperature profile |
| Hydrofluoric acid, 48%, ACS reagent | Sigma-Aldrich | 7664-39-3 | CAUTION, extremly hazardous |
| Hydrogen peroxide, 30%, ACS reagent | Fisher Chemical | 7722-84-1 | CAUTION, hazardous |
| Isopropyl alcohol, >99.5%, ACS reagent | LabChem | 67-63-0 | CAUTION, chemical |
| MLP-50 | Transducer Techniques | MLP-50 | Load cell |
| Nitric acid, 70%, ACS grade | SAFC | 7697-37-2 | CAUTION, hazardous |
| NSC-3000 | Nano-master | NSC-3000 | Magnetron sputter |
| Potassium hydroxide, 45%, Certified | Fisher Chemical | 1310-58-3 | CAUTION, chemical |
| Rocker 800 vacuum pump, 110V/60Hz | Rocker | 1240043 | Oil-free vacuum pump |
| Silicon master mold | NILT | SMLA_V1 | Silicon chip with pattern |
| Silicon wafers, prime grade | University wafer | 783 | Si wafer |
| Silver target, 2" x 0.125", 99.99% purity | ACI alloys | HER2318 | Magnetron sputter silver target |
| SP-300 | BioLogic | SP-300 | Potentiostat |
| SPIN 150i | Spincoating | SPIN 150i | Spin coater |
| SPR 200-7.0 positive photoresist | Microchem | SPR 220-7.0 | CAUTION, chemical |
| Stirring hotplate | Thermo scientific Cimarec+ | SP88857100 | General purpose hotplate |
| SU-8 2015 negative photoresist | Microchem | SU-8 2015 | CAUTION, chemical |
| SYLGARD 184 Silicone elastomere kit | DOW | 4019862 | CAUTION, chemical |
| T-LSR150B | Zaber Technologies | T-LSR150B-KT04U | Motorized linear stage |
| Trichloro(1H,1H,2H,2H-perfluorooctyl)silane (PFOCS), 97% | Sigma-Aldrich | 78560-45-9 | CAUTION, hazardous |
Referências
- Ning, H., et al. Transfer-Printing of Tunable Porous Silicon Microcavities with Embedded Emitters. ACS Photonics. 1 (11), 1144-1150 (2014).
- Hirschman, K. D., Tsybeskov, L., Duttagupta, S. P., Fauchet, P. M. Silicon-based light emitting devices integrated into microelectronic circuits. Nature. 384, 338-341 (1996).
- Cho, J., et al. Nanoscale Origami for 3D Optics. Small. 7 (14), 1943-1948 (2011).
- Azeredo, B. P., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305-225312 (2013).
- Lin, C., Tsai, M., Wei, W., Lai, K., He, J. Packaging Glass with a Hierarchically Nanostructured Surface: a universal method to achieve selfcleaning omnidirectional solar cells. ACS Nano. 10 (1), 549-555 (2016).
- Park, K. C., et al. Nanotextured Silica Surfaces with Robust Superhydrophobicity and Omnidirectional Broadband Supertransmissivity. ACS Nano. 6 (5), 3789-3799 (2012).
- Kim, J., Joy, D. C., Lee, S. Controlling resist thickness and etch depth for fabrication of 3D structures in electron-beam grayscale lithography. Microelectronics Engineering. 84 (12), 2859-2864 (2007).
- Deng, S., Zhang, Y., Jiang, S., Lu, M. Fabrication of three-dimensional silicon structure with smooth curved surfaces. Journal of Micro/Nanolithography, MEMS, and MOEMS. 15 (3), 0345031-0345036 (2016).
- Azeredo, B. P., Lin, Y., Avagyan, A., Sivaguru, M., Hsu, K. Direct Imprinting of Porous Silicon via Metal-Assisted Chemical Etching. Advanced Functional Materials. 26 (17), 2929-2939 (2016).
- Azeredo, B., Hsu, K., Ferreira, P. M. Direct Electrochemical Imprinting of Sinusoidal Linear Gratings into Silicon. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-6 (2016).
- Li, H., Niu, J., Wang, G., Wang, E., Xie, C. Direct Production of Silicon Nanostructures with Electrochemical Nanoimprinting. ACS Applied Electronic Materials. 1 (7), 1070-1075 (2019).
- Kim, K., Ki, B., Choi, K., Lee, S., Oh, J. Resist-Free Direct Stamp Imprinting of GaAs via Metal-Assisted Chemical Etching. ACS Applied Materials & Interfaces. 11 (14), 13574-13580 (2019).
- Zhang, J., et al. Contact electrification induced interfacial reactions and direct electrochemical nanoimprint lithography in n-type gallium arsenate wafer. Chemical Science. 8, 2407-2412 (2017).
- Zhan, D., et al. Electrochemical micro/nano-machining: principles and practices. Chemical Society Reviews. 46 (5), 1526-1544 (2017).
- Li, X., Bohn, P. W. Metal-assisted chemical etching in HF / H2O2 produces porous silicon. Applied Physics Letters. 77 (16), 2572-2574 (2000).
- Chartier, C., Bastide, S., Levy-Clement, C. Metal-assisted chemical etching of silicon in HF – H2O2. Electrochimica Acta. 53, 5509-5516 (2008).
- Chattopadhyay, S., Li, X., Bohn, P. W. In-plane control of morphology and tunable photoluminescence in porous silicon produced by metal-assisted electroless chemical etching. Journal of Applied Physics. 91 (9), 6134-6140 (2002).
- Torralba, E., et al. 3D patterning of silicon by contact etching with anodically biased nanoporous gold electrodes. Electrochemistry Communications. 76, 79-82 (2017).
- Bastide, S., et al. 3D Patterning of Si by Contact Etching With Nanoporous Metals. Frontiers in Chemistry. 7, 1-13 (2019).
- Sharstniou, A., Niauzorau, S., Ferreira, P. M., Azeredo, B. P. Electrochemical nanoimprinting of silicon. Proceedings of the National Academy of Sciences. 116 (21), 10264-10269 (2019).
- Niauzorau, S., Ferreira, P., Azeredo, B. Synthesis of Porous Noble Metal Films with Tunable Porosity by Timed Dealloying. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-4 (2018).
- Geyer, N., et al. Model for the Mass Transport During Metal-Assisted Chemical Etching with Contiguous Metal Films As Catalysts. The Journal of Physical Chemistry C. 116 (24), 13446-13451 (2012).
- Li, L., Liu, Y., Zhao, X., Lin, Z., Wong, C. Uniform Vertical Trench Etching on Silicon with High Aspect Ratio by Metal-Assisted Chemical Etching Using Nanoporous Catalysts. ACS Applied Materials and Interfaces. 6 (1), 575-584 (2014).

