Proof-of-Concept for gass-entrapping membraner avledet fra vann-loving SiO2/Si/SiO2 Wafers for grønn avsalting
Summary
Presentert her er en trinnvis protokoll for å realisere gass-entrapping membraner (GEMs) fra SiO2/ Si wafers ved hjelp av integrert krets mikrofabrikasjon teknologi. Når silika-GEMer er nedsenket i vann, er inntrenging av vann forhindret, til tross for den vannelskende sammensetningen av silika.
Abstract
Avsalting gjennom direkte kontaktmembrandestillasjon (DCMD) utnytter vannavvisende membraner til robust å skille motstrømmer av varmt og salt sjøvann fra kaldt og rent vann, slik at bare rent vanndamp kan passere gjennom. For å oppnå denne prestasjonen er kommersielle DCMD membraner avledet fra eller belagt med vannavvisende perfluorokarboner som polytetrafluoretylen (PTFE) og polyvinylidendifluorid (PVDF). Bruken av perfluorkarboner er imidlertid begrenset på grunn av deres høye kostnader, ikke-biologisk nedbrytbarhet og sårbarhet for tøffe driftsforhold. Avduket her er en ny klasse av membraner referert til som gass-entrapping membraner (GEMs) som kan robust fange luft ved nedsenking i vann. Gems oppnå denne funksjonen ved deres mikrostruktur i stedet for deres kjemiske make-up. Dette arbeidet demonstrerer et konseptbevis for GEMs ved hjelp av egenfukting siO2/Si/SiO2 wafers som modellsystem; kontaktvinkelen på SiO2 er θo ‰ 40°. Silika-GEMer hadde 300 μm lange sylindriske porer hvis diameter på (2 μm lange) innløps- og utløpsregioner var betydelig mindre; denne geometrisk dismiske strukturen, med 90° svinger ved viker og uttak, er kjent som “reentrant microtexture”. Mikrofabrikasjonsprotokollen for silika-GEMer innebærer design, fotolitografi, kromsputtering og isotropisk og anisotropisk etsning. Til tross for den vannelskende naturen av silika, trenger vann ikke forstyrre silika-GEMer på nedsenking. Faktisk, de robust fange luft under vann og holde den intakt selv etter seks uker (> 106 sekunder). På den annen side silikamembraner med enkle sylindriske porer spontant imbibe vann (< 1 s). Disse funnene fremhever potensialet i GEMs-arkitekturen for separasjonsprosesser. Mens valget av SiO2/Si/SiO2 wafers for GEMs er begrenset til å demonstrere konseptbeviset, forventes det at protokollene og konseptene som presenteres her, vil fremme den rasjonelle utformingen av skalerbare GEMer ved hjelp av rimelige felles materialer for avsalting og utover.
Introduction
Etter hvert som stresset på vann/mat/energi/miljøressurser eskalerer, er det nødvendig med grønnere teknologier og materialer for avsalting1,2. I denne sammenheng kan direkte kontaktmembrandestillasjon (DCMD) prosess utnytte soltermisk energi eller avfall industriell varme for vannavsalting3,4. DCMD utnytter vannavvisende membraner for å skille motstrømmende strømmer av varmt sjøvann og kaldt deionisert vann, slik at bare rent vanndamp kan transportere over fra den varme til kalde siden5,6,7,8,9. Kommersielle DCMD membraner nesten utelukkende utnytte perfluorokarboner på grunn av deres vannavstøtende, preget av den indre kontaktvinkelen av vann, θo ‰ 110°10. Men perfluorkarboner er dyre, og de blir skadet ved forhøyede temperaturer11 og ved hard kjemisk rengjøring12,13. Deres ikke-biologisk nedbrytbarhet reiser også miljøhensyn14. Dermed har nye materialer for DCMD blitt utforsket, for eksempel polypropylen15,karbon nanorør16,og organosilica17, sammen med variasjoner av prosessen, for eksempel interfacial oppvarming18 og photovoltaic-MD19. Likevel har alle materialer som er undersøkt for DCMD-membraner så langt, vært iboende vannavstøtende, preget av θo ≥ 90° for vann).
Her er en protokoll beskrevet for å utnytte vannelskende (hydrofile) materialer mot å oppnå funksjonen til vannavvisende DCMD membraner dvs. Mot konseptbevisdemonstrasjonen brukes dobbeltsidigpolerte silisiumwafere med silikalag (2 μm tykke) på begge sider (Henholdsvis SiO2/Si/SiO2; 2 μm/300 μm/2 μm). Mikrofabrikasjonsprosesser brukes for å oppnå gassinntroppingsmembraner (GEMs), som utnytter en bestemt arkitektur for å hindre at væsker kommer inn i porene uavhengig av overflatekjemi.
Inspirasjonen til GEMs arkitektur stammer fra springtails (Collembola), jord-bolig sekskantpods hvis neglebånd inneholder sopp-formet mønstre20,21,og sjø-skatere (Halobates germanus), insekter som bor i det åpne havet som har soppformet hår på kroppen22,23. Overflatearkitekturen, sammen med naturlig utskillede voks, gir disse insektene “super” vannavstøtende, preget av tilsynelatende kontaktvinkler for vann (θr ≥ 150°)24. Som et resultat, i hviletilstand, er sjøløpere i hovedsak flytende i luft på sjøluftsgrensesnittet22,25. Hvis nedsenket i vann, de umiddelbart fange et lag med luft rundt kroppen (også kjent som plastron), som letter respirasjon og oppdrift20,23. Inspirert av springtails viste Kim og medarbeidere at silikaoverflater med arrayer av soppformede søyler kan avvise dråper av væsker med lave overflatespenninger26. Dette var en bemerkelsesverdig oppdagelse; Om enn, ble det funnet at den flytende avstøtende av disse overflatene kunne gå tapt katastrofalt gjennom lokaliserte defekter eller grenser27,28. For å løse dette problemet, forskere mikrofabrikkert silika overflater med hulrom hvis diameter på vikene var brått mindre (dvs. med en 90 ° sving) enn resten av hulrommet27. Disse funksjonene er også kjent som “reentrant” kanter, og hulrommene er heretter referert til som “reentrant hulrom”.
Reentrant hulrom robust fange luft ved kontakt med flytende dråper eller ved nedsenking27. Ytelsen til hulrom i forskjellige former (sirkulær, firkantet og sekskantet), profiler (reentrant og dobbelt reentrant), og skarphet av hjørner i forhold til stabiliteten av fanget luft over tid har blitt sammenlignet29. Det har blitt funnet at sirkulære reentrant hulrom er den mest optimale i form av deres robusthet for luftentrapment under fukting væsker og kompleksiteten forbundet med produksjon. Det har også blitt vist at iboende fukting av materialer med reentrant hulrom kan fange luft ved nedsenking i fuktevæsker, og dermed oppnå funksjonen av omnifobe overflater. Basert på denne kroppen av arbeid27,28,29,30 og tidligere erfaring med DCMD31, bestemte vi oss for å lage membraner som har porer med reentrant inlets og utsalgssteder. Det var tenkt at en slik membran kunne fange luft ved nedsenking i fuktevæsker på grunn av sin mikrotekstur, noe som gir opphav til ideen om GEMs.
Vurder en membran laget av et hydrofilt materiale bestående av enkle sylindriske porer: Når den er nedsenket i vann, vil denne membranen imbibe vann spontant (Figur 1A,B) nå den fullt fylte, eller Wenzel tilstand32. På den annen side, hvis porenes innløp og utsalg har reentrantprofiler (f.eks. “T”-formet), kan de forhindre at fuktvæsken trenger inn i poren og entrapluft inne, noe som fører til Cassie tilstander33 (Figur 1C,D). Når luften er fanget inne i poren, vil den ytterligere forhindre flytende inntrenging på grunn av trykkperioden og lav løselighet i vann over tid34,35.
Et slikt system vil sakte gå fra Cassie til Wenzel tilstand, og kinetikken i denne prosessen kan justeres av porens form, størrelse og profil, damptrykk av væsken, og løselighet av fanget luft i væsken29,34,36. Forskere har vært i stand til å realisere GEMs ved hjelp av silisium wafers og polymethylmetakrylat ark som test substrater, og proof-of-concept applikasjoner for DCMD i en kryss-flow konfigurasjon har blitt demonstrert37. Her presenteres en detaljert mikrofabrikasjonsprotokoll for generering av silika-GEMer, som starter med polerte silisiumwafere med silikalag (2 μm tykke) på begge sider (SiO2/Si/SiO2; henholdsvis 2 μm/300 μm/2 μm). Også evnen til silika-GEMs å fange luft under vann vurderes ved hjelp av en spesialbygd trykkcelle og konfokal mikroskopi.
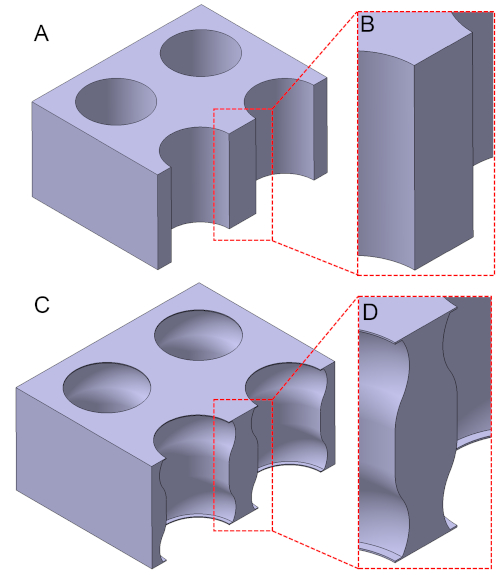
Figur 1: Skjematisk representasjon av en membran med enkle sylindriske porer (A,B) og en med reentrant porer (C,D). I motsetning til de enkle sylindriske porene blir de reentrant porene kraftig bredere etter inntak/uttak, og det er denne diskontinuiteten (eller reentrantkantene) som hindrer væsker i å trenge inn i porene. Vennligst klikk her for å vise en større versjon av dette tallet.
Spesielt beskriver denne delen mikrofabrikasjonsprotokollen for carving arrays av porer med reentrant inlets og uttak ved hjelp av dobbeltsidigpolerte silisium wafers som er 300 μm tykk (p-dopet, orientering, 4″ diameter, 2 μm tykke termisk dyrkede oksidlag på begge sider). Dette omtales heretter som SiO2(2 μm)/Si(300 μm)/SiO2(2 μm) (figur 2).

Figur 2: Flytskjema notering viktige trinn involvert i mikrofabrikasjon av silika-GEMer. Vennligst klikk her for å vise en større versjon av dette tallet.
Protocol
Representative Results
Discussion
Dette arbeidet presenterer design og fabrikasjon av silika-GEMer, de første DCMD-membranene avledet fra hydrofile materialer. Mikrofabrikasjon med SiO2/Si-systemet gir enorm fleksibilitet til å skape mikroteksturer for å teste kreative ideer. Selvfølgelig er omfanget av dette arbeidet begrenset til konseptbeviset for GEMs, fordi SiO2/ Si / SiO2 wafers og cleanroom mikrofabrikasjonprotokoller er upraktiske for avsaltingsmembraner.
Det bør bemerkes at selv om GEMs arkitektur kan forhindre inntrenging av vann ved nedsenking når den indre kontaktvinkelen er θo ≥ 40°, mislykkes denne strategien hvis overflaten er gjort superhydrofile. For eksempel, etter eksponering for oksygenplasma, utviser silikaoverflater θo ‰ 5°, og disse silika-GEMene mister luft som er festet inne i porene spontant som bobler, fordi den flytende menisken ikke lenger er festet på reentrant kantene. Imidlertid bør vanlig plast, som polyvinylalkohol (θo ‰ 51°) og poly(etylentomtalat) (θo ‰ 72°), være mottagelig for denne tilnærmingen. Dermed kan designprinsipper lært av silika-GEMer skaleres opp ved hjelp av 3D-utskrift44, additiv produksjon45,lasermikromaskinering46og CNC fresing37, etc.
Deretter diskuteres noen viktige aspekter ved mikrofabrikasjon av silika-GEMer, noe som krever spesiell oppmerksomhet. Manuell ryggjustering (avsnitt 8) av funksjonene skal utføres med så mye forsiktighet som mulig for å oppnå vertikalt justerte porer. Forskyvninger kan føre til pore-hals, og i verste fall kan feiljusteringen føre til bare hulrom på hver side (ingen porer). Dermed foreslås det å bruke multiskala justeringsmerker, med det minste justeringsmerket minst fire ganger mindre enn porediameteren.
Under etsning av silikalaget med C4F8 og O2 (trinn 10.1), kan tidligere bruk (dvs. renslighet) av reaksjonskammeret påvirke etsningshastigheter. Dette er på grunn av tilstedeværelsen av forurensninger i reaksjonskammeret, en vanlig forekomst i delte brukerfasiliteter som universiteter. Dermed anbefales det at dette trinnet utføres først på en dummy wafer for å sikre at systemet er rent og stabilt. Det anbefales også å bruke korte perioder for etsing (f.eks. ikke mer enn 5 min mens du overvåker tykkelsen på silikalaget ved hjelp av reflektor). For eksempel, hvis det tar 16 min å fjerne et 2 μm SiO2 lag fra en SiO2/ Si / SiO2 wafer, bør etsningsprosessen deles inn i fire trinn bestående av tre 5 minutter sykluser etterfulgt av reflektor, og en 1 min (valgfritt) etsningtrinn, basert på refleksjonsresultatene.
For å bevare silikaredeltakerfunksjonene under Bosch-prosessen som brukes til å etse silisiumlaget (trinn 10,4), er det avgjørende at en kromhard maske brukes. Bosch-prosessen innebærer avsetning av C4F8 for å sikre den anisotropiske profilen. Men over lange etsing sykluser, dette laget kan bli svært tykk og vanskelig å fjerne. Dermed anbefales det at Bosch-prosessen ikke skal kjøres i mer enn ~ 200 sykluser, og det bør etterfølges av piranha rengjøring. Det har også blitt observert at lange sykluser med dyp etsing også redusere tykkelsen på silikalaget, til tross for tilstedeværelsen av et krom hard maske.
De fleste tørre etsing verktøy ikke klarer å oppnå romlig ensartethet i form av etsning priser. Dermed kan funksjonene som er oppnådd i midten av en SiO2/ Si / SiO2 wafer ikke være de samme som de på grensen til wafer. Her ble høy kvalitet funksjoner realisert i sentrum av 4 “wafers, og prøver ble periodisk observert under et mikroskop. I tilfelle at noen regioner er etset mer enn andre, bør wafer brytes i stykker som bør etses separat.
Denne fabrikasjonsprotokollen kan brukes på SiO2/Si/SiO2 wafers av enhver tykkelse; Men, et tykkere lag betyr at et høyere antall etsing sykluser er nødvendig. Det foreslås å bruke silisium wafers av <300 μm tykkelse, så lenge dette ikke kompromittere renispes mekaniske integritet under håndtering og karakterisering.
Disclosures
The authors have nothing to disclose.
Acknowledgements
H.M. anerkjenner finansiering fra Kong Abdullah University of Science and Technology under BAS/1/1070-01-01 og KAUST tilgang til nanofabrikasjon kjerne lab fasiliteter.
Materials
| 3D Printer | BCN3D | 020.180510.3103 | BCN3D Sigma 3D printer for printing test module with PLA (polylactic acid) filament. |
| Acetone | BASF | ||
| AZ-5214 E photoresist | Merck | ||
| AZ-726 MIF developer | Merck | ||
| Chrome Etchant | MicroChemicals | TechniEtch Cr01 | To remove chromium from silicon wafer and mask |
| Conductivity Meter | Hanna | HI98192 | To measure conductivity of pure water during leak testing. |
| Confocal microscope | Zeiss | ZEISS LSM 710 | For fluorescence imaging of water. |
| Contact Aligner | EVG | EVG6200 | Mask aligner |
| Deep ICP-RIE | Oxford Instruments | Plasmalab system100 | |
| DI water | |||
| Direct writer | Heidelberg Instruments | µPG501 direct-writing system | UV exposure |
| Food Dye | Kroger | Green food dye to label salty water. | |
| Glass Petri dish | VWR | ||
| HMDS vapor prime | Yield Engineering systems | ||
| Hot plate | Cost effective equipments | Model 1300 | |
| Hydrogen peroxide 30% | VWR chemicals | To prepare piranha solution. | |
| Imaris software | Bitplane | Version 8 | Postprocess confocal microscopy images |
| Nitrogen gas | |||
| Optical surface profiler | Zygo | Zygo newview 7300 | |
| Photomask | Nanofilm | 5-inch soda lime glass mask | |
| Profilometer | Veeco | Detak 8 | Stylus profilometer |
| Reactive Sputter | Equipment Support Company Ltd | Chromium sputtering | |
| Reactive-Ion Etching (RIE) | Oxford Instruments | Plasmalab system100 | |
| Reflectometer | Nanometrics | Nanospec 6100 | To check remaining oxide layer thickness. |
| Rhodamine B | Merck | 81-88-9 | Dye for imaging water meniscus under confocal microscope. |
| SEM stub | Electron Microscopy Sciences | ||
| SEM-Quanta 3D | FEI | Quanta 3D FEG Dual Beam (SEM/FIB) | |
| Silicon wafer | Silicon Valley Microelectronics | Double side polished, 4" diamater, 300 µm thickness, 2 µm thick oxide layer, p-doped, <100> orientation. | |
| Sodium Chloride | Merck | 7647-14-5 | For preparing NaCl solution |
| Sonicator | Branson | 1510 | |
| Spin coater | Headway Research,Inc. | ||
| Spin dryer | MicroProcess | Avenger Ultra Pure 6 | Spin drying in Nitrogen environment. |
| Sputter | Quorum Technologies | Q150T S | Iridium sputter for SEM. |
| Sulfuric acid 96% | Technic | 764-93-9 | To prepare piranha solution. |
| Tanner EDA L-Edit software | Tanner EDA, Inc. | For designing photomask | |
| Tweezers | Excelta | ||
| UV Cure | Tamarack Scientific Co. Inc. | PRX-2000-20 | For flood exposure of wafer and photomask |
| Vaccum oven | Thermo Scientific | 13-258-13 | Lindberg/Blue M |
| Wet bench | JST Manufacturing Inc. | 17391-015-00 | Wet bench used for piranha cleaning |
References
- Fisher, J. B., et al. The future of evapotranspiration: Global requirements for ecosystem functioning, carbon and climate feedbacks, agricultural management, and water resources. Water Resources Research. 53 (4), 2618-2626 (2017).
- Deshmukh, A., et al. Membrane distillation at the water-energy nexus: limits, opportunities, and challenges. Energy & Environmental Science. 11 (5), 1177-1196 (2018).
- Ali, A., Tufa, R. A., Macedonio, F., Curcio, E., Drioli, E. Membrane technology in renewable-energy-driven desalination. Renewable and Sustainable Energy Reviews. 81, 1-21 (2018).
- Ghaffour, N., et al. Renewable energy-driven innovative energy-efficient desalination technologies. Applied Energy. 136, 1155-1165 (2014).
- Chen, J., et al. Recovery of dilute aqueous butanol by membrane vapor extraction with dodecane or mesitylene. Journal of Membrane Science. 528, 103-111 (2017).
- Wang, P., Chung, T. -. S. Recent advances in membrane distillation processes: Membrane development, configuration design and application exploring. Journal of Membrane Science. 474, 39-56 (2015).
- Khayet, M. Membranes and theoretical modeling of membrane distillation: A review. Advances in Colloid and Interface Science. 164 (1-2), 56-88 (2011).
- Drioli, E., Ali, A., Macedonio, F. Membrane distillation: Recent developments and perspectives. Desalination. 356, 56-84 (2015).
- Souhaimi, M. K., Matsuura, T. . Membrane Distillation. 1st edn. , (2011).
- Janssen, D., De Palma, R., Verlaak, S., Heremans, P., Dehaen, W. Static solvent contact angle measurements, surface free energy and wettability determination of various self-assembled monolayers on silicon dioxide. Thin Solid Films. 515 (4), 1433-1438 (2006).
- Hendren, Z. D., Brant, J., Wiesner, M. R. Surface modification of nanostructured ceramic membranes for direct contact membrane distillation. Journal of Membrane Science. 331 (1-2), 1-10 (2009).
- Verho, T., et al. Mechanically Durable Superhydrophobic Surfaces. Advanced Materials. 23, 673-678 (2011).
- Boinovich, L., Emelyanenko, A. M., Pashinin, A. S. Analysis of Long-Term Durability of Superhydrophobic Properties under Continuous Contact with Water. ACS Applied Materials & Interfaces. 2 (6), 1754-1758 (2010).
- Lindstrom, A. B., Strynar, M. J., Libelo, E. L. Polyfluorinated compounds: past, present, and future. Environmental Science & Technology. 45 (19), 7954-7961 (2011).
- Gryta, M. Influence of polypropylene membrane surface porosity on the performance of membrane distillation process. Journal of Membrane Science. 287 (1), 67-78 (2007).
- An, A. K., et al. Enhanced vapor transport in membrane distillation via functionalized carbon nanotubes anchored into electrospun nanofibres. Scientific Reports. 7, (2017).
- Hammami, M. A., et al. Engineering Hydrophobic Organosilica Nanoparticle-Doped Nanofibers for Enhanced and Fouling Resistant Membrane Distillation. ACS Applied Materials & Interfaces. 9 (2), 1737-1745 (2017).
- Shi, Y., et al. A 3D Photothermal Structure toward Improved Energy Efficiency in Solar Steam Generation. Joule. 2 (6), 1171-1186 (2018).
- Wang, W., et al. Simultaneous production of fresh water and electricity via multistage solar photovoltaic membrane distillation. Nature Communications. 10 (1), 3012 (2019).
- Hensel, R., Neinhuis, C., Werner, C. The springtail cuticle as a blueprint for omniphobic surfaces. Chemical Society Reviews. 45 (2), 323-341 (2016).
- Helbig, R., Nickerl, J., Neinhuis, C., Werner, C. Smart Skin Patterns Protect Springtails. PLoS ONE. 6 (9), 25105 (2011).
- Andersen, N. M., Cheng, L. The marine insect Halobates (Heteroptera: Gerridae): biology, adaptations, distribution, and phylogeny. Oceanography and Marine biology: an Annual Review. 42, 119-180 (2004).
- Cheng, L. Marine and Freshwater Skaters: Differences in Surface Fine Structures. Nature. 242, 132 (1973).
- Gao, X., Jiang, L. Water-repellent legs of water striders. Nature. 432 (7013), 36 (2004).
- Golovin, K. B., Gose, J., Perlin, M., Ceccio, S. L., Tuteja, A. Bioinspired surfaces for turbulent drag reduction. Philosophical Transactions of the Royal Society A – Mathematical Physical and Engineering Sciences. 374 (2073), (2016).
- Liu, T. Y., Kim, C. J. Turning a surface superrepellent even to completely wetting liquids. Science. 346 (6213), 1096-1100 (2014).
- Domingues, E. M., Arunachalam, S., Mishra, H. Doubly Reentrant Cavities Prevent Catastrophic Wetting Transitions on Intrinsically Wetting Surfaces. ACS Applied Materials & Interfaces. 9 (25), 21532-21538 (2017).
- Arunachalam, S., Das, R., Nauruzbayeva, J., Domingues, E. M., Mishra, H. Assessing omniphobicity by immersion. Journal of Colloid and Interface Science. 534, 156-162 (2019).
- Domingues, E. M., Arunachalam, S., Nauruzbayeva, J., Mishra, H. Biomimetic coating-free surfaces for long-term entrapment of air under wetting liquids. Nature Communications. 9 (1), 3606 (2018).
- Gonzalez-Avila, S. R., Nguyen, D. M., Arunachalam, S., Domingues, E. M., Mishra, H., Ohl, C. D. Mitigating cavitation erosion using biomimetic gas-entrapping microtextured surfaces. Science Advances. , (2020).
- Subramanian, N., et al. Evaluating the potential of superhydrophobic nanoporous alumina membranes for direct contact membrane distillation. Journal of Colloid and Interface Science. 533, 723-732 (2019).
- Wenzel, R. N. Resistance of solid surface to wetting by water. Industrial and Engineering Chemistry. 28 (8), 7 (1936).
- Cassie, A. B. D., Baxter, S. Wettability of porous surfaces. Transactions of the Faraday Society. 40, 0546-0550 (1944).
- Kaufman, Y., et al. Simple-to-Apply Wetting Model to Predict Thermodynamically Stable and Metastable Contact Angles on Textured/Rough/Patterned Surfaces. The Journal of Physical Chemistry C. 121 (10), 5642-5656 (2017).
- Mishra, H., et al. Time-Dependent Wetting Behavior of PDMS Surfaces with Bioinspired, Hierarchical Structures. ACS Applied Materials & Interfaces. 8 (12), 8168-8174 (2016).
- Seo, D., et al. Rates of cavity filling by liquids. Proceedings of the National Academy of Sciences. , (2018).
- Das, R., Arunachalam, S., Ahmad, Z., Manalastas, E., Mishra, H. Bio-inspired gas-entrapping membranes (GEMs) derived from common water-wet materials for green desalination. Journal of Membrane Science. 588, 117185 (2019).
- Tanner Research. . Manual, L.-E.U. , (1996).
- Xu, M. C., Sun, G. U., Kim, C. J. Infinite Lifetime of Underwater Superhydrophobic States. Physical Review Letters. 113 (13), (2014).
- Arunachalam, S., Domingues, E. M., Das, R., Nauruzbayeva, J., Buttner, U., Syed, A., Mishra, H. Rendering SiO2/Si Surfaces Omniphobic by Carving Gas-Entrapping Microtextures Comprising Reentrant and Doubly Reentrant Cavities or Pillars. Journal of Visualized Experiments. , e60403 (2020).
- Dean, J. A. . Lange’s Handbook of Chemistry. , (1999).
- Yu, J. K., Mitrovic, S., Tham, D., Varghese, J., Heath, J. R. Reduction of thermal conductivity in phononic nanomesh structures. Nature Nanotechnology. 5 (10), 718-721 (2010).
- Mishra, H., et al. Thermomechanical and Thermal Contact Characteristics of Bismuth Telluride Films Electrodeposited on Carbon Nanotube Arrays. Advanced Materials. 21 (42), 4280 (2009).
- Liu, X., et al. 3D Printing of Bioinspired Liquid Superrepellent Structures. Advanced Materials. , 1800103 (2018).
- Jafari, R., Cloutier, C., Allahdini, A., Momen, G. Recent progress and challenges with 3D printing of patterned hydrophobic and superhydrophobic surfaces. The International Journal of Advanced Manufacturing Technology. , 1-14 (2019).
- Vorobyev, A., Guo, C. Multifunctional surfaces produced by femtosecond laser pulses. Journal of Applied Physics. 117 (3), 033103 (2015).

