Metaalondersteunde elektrochemische nano-afdruk van poreuze en vaste siliciumwafers
Summary
Een protocol voor metaalondersteunde chemische inprenting van 3D-microschaalkenmerken met vormnauwkeurigheid van minder dan 20 nm in vaste en poreuze siliciumwafers wordt gepresenteerd.
Abstract
Metaalondersteunde elektrochemische inprenting (Mac-Imprint) is een combinatie van metaalondersteunde chemische etsen (MACE) en nanoimprintlithografie die in staat is om 3D-micro- en nanoschaalkenmerken in monokristallijne groep IV (bijv. Si) en III-V (bijv. GaAs) halfgeleiders direct te modelleren zonder de noodzaak van opofferingssjablonen en lithografische stappen. Tijdens dit proces wordt een herbruikbare stempel bedekt met een edelmetaalkatalysator in contact gebracht met een Si-wafer in aanwezigheid van een fluorwaterstofzuur (HF) en waterstofperoxide (H2O2) mengsel, wat leidt tot het selectief etsen van Si op het metaal-halfgeleidercontactinterface. In dit protocol bespreken we de stempel- en substraatvoorbereidingsmethoden die worden toegepast in twee Mac-Imprint-configuraties: (1) Poreuze Si Mac-Imprint met een vaste katalysator; en (2) Solid Si Mac-Imprint met een poreuze katalysator. Dit proces heeft een hoge doorvoersnelheid en is in staat tot parallelle patronen op centimeterschaal met een resolutie van minder dan 20 nm. Het biedt ook een lage defectdichtheid en grote gebiedspatronen in een enkele bewerking en omzeilt de noodzaak van droog etsen zoals diepe reactieve ionenets (DRIE).
Introduction
Driedimensionale micro- en nanoschaalpatronen en texturisatie van halfgeleiders maken tal van toepassingen op verschillende gebieden mogelijk, zoals opto-elektronica1,2, fotonica3, antireflecterende oppervlakken4, superhydrofobe en zelfreinigende oppervlakken5,6. Prototyping en massaproductie van 3D- en hiërarchische patronen is met succes bereikt voor polymere films door zachte lithografie en nanoimprinting lithografie met een resolutie van minder dan 20 nm. Het overbrengen van dergelijke 3D-polymere patronen naar Si vereist echter de etsselectiviteit van een maskerpatroon tijdens reactief ionenetsen en beperkt dus de beeldverhouding en induceert vormvervormingen en oppervlakteruwheid als gevolg van sint-jakobsschelpen7,8.
Een nieuwe methode genaamd Mac-Imprint is bereikt voor parallelle en directe patronen van poreuze9 en vaste Si wafers10,11 en massieve GaAs wafers12,13,14. Mac-Imprint is een op contact gebaseerde natte etstechniek die contact vereist tussen substraat en een edelmetaal-gecoate stempel met 3D-kenmerken in de aanwezigheid van een etsoplossing (ES) bestaande uit HF en een oxidant (bijv. H2O2 in het geval van Si Mac-Imprint). Tijdens het etsen treden twee reacties tegelijkertijd op15,16: een kathodische reactie (d.w.z. de H2O2-reductie bij het edelmetaal, waarbij positieve ladingsdragers [gaten] worden gegenereerd en vervolgens in Si17 worden geïnjecteerd) en een anodische reactie (d.w.z. Si-oplossing, waarbij de gaten worden verbruikt). Na voldoende tijd in contact worden de 3D-kenmerken van de stempel in de Si-wafer geëtst. Mac-Imprint heeft tal van voordelen ten opzichte van conventionele lithografische methoden, zoals hoge doorvoer, compatibiliteit met roll-to-plate en roll-to-roll platforms, amorfe, mono- en polykristallijne Si- en III-V halfgeleiders. Mac-Imprint stempels kunnen meerdere keren worden hergebruikt. Bovendien kan de methode een etsresolutie van minder dan 20 nm leveren die compatibel is met hedendaagse directe schrijfmethoden.
De sleutel tot het bereiken van high-fidelity imprinting is de diffusieroute naar het etsfront (d.w.z. contactinterface tussen katalysator en substraat). Het werk van Azeredo et al.9 toonde eerst aan dat ES-diffusie mogelijk wordt gemaakt door een poreus Si-netwerk. Torralba et al.18, meldden dat om vaste Si Mac-Imprint te realiseren de ES-diffusie mogelijk wordt gemaakt door een poreuze katalysator. Bastide et al.19 en Sharstniou et al.20 onderzochten verder de invloed van de katalysatorporositeit op ES-diffusie. Zo is het concept van Mac-Imprint getest in drie configuraties met verschillende diffusieroutes.
In de eerste configuratie zijn de katalysator en het substraat vast, waardoor er geen initiële diffusieroute is. Het ontbreken van reactantiffusie leidt tot een secundaire reactie tijdens het inprenten die een laag poreuze Si vormt op het substraat rond de rand van de katalysator-Si-interface. De reactanten raken vervolgens uitgeput en de reactie stopt, wat resulteert in geen waarneembare patroonoverdrachtsgetrouwheid tussen de stempel en het substraat. In de tweede en derde configuratie worden de diffusieroutes mogelijk gemaakt door poreuze netwerken die in het substraat (d.w.z. poreuze Si) of in de katalysator (d.w.z. poreus goud) worden geïntroduceerd en wordt een hoge patroonoverdrachtsnauwkeurigheid bereikt. Het massatransport door poreuze materialen speelt dus een cruciale rol bij het mogelijk maken van de diffusie van reactanten en reactieproducten van en naar het contactinterface9,18,19,20. Een schema van alle drie de configuraties is weergegeven in figuur 1.
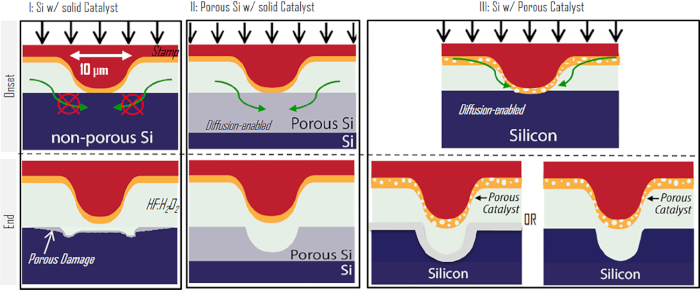
Figuur 1: Schema’s van Mac-Imprint configuraties. Deze figuur benadrukt de rol van poreuze materialen bij het mogelijk maken van de diffusie van reagerende soorten door het substraat (d.w.z. geval II: poreuze Si) of in de stempel (d.w.z. geval III: katalysator dunne film gemaakt van poreus goud). Klik hier om een grotere versie van deze figuur te bekijken.
In dit artikel wordt het Mac-Imprint-proces grondig besproken, inclusief stempelvoorbereiding en substraatvoorbehandeling samen met Mac-Imprint zelf. De substraatvoorbehandelingssectie binnen het protocol omvat Si-waferreiniging en Si-waferpatronen met droge etsen en substraatanodisatie (optioneel). Verder is een sectie voor het voorbereiden van stempels onderverdeeld in verschillende procedures: 1) PDMS replica molding van Si master mold; 2) UV-nano-afdruk van een fotoresistente laag om het PDMS-patroon over te brengen; en 3) katalytische laagafzetting via magnetron sputteren gevolgd door dealloying (optioneel). Ten slotte wordt in het gedeelte Mac-Imprint de Mac-Imprint-configuratie samen met de Mac-Imprint-resultaten (d.w.z. Si surface 3D hiërarchische patronen) gepresenteerd.
Protocol
Representative Results
Discussion
Mac-Imprint stempels en voorgepatterde Si chips (p-type, [100] oriëntatie, 1-10 Ohm∙cm) werden bereid volgens respectievelijk secties 1 en 2 van het protocol. De Mac-Imprint van voorgepatterde Si-chip met stempels met 3D-hiërarchische patronen werd uitgevoerd volgens sectie 3 van het protocol (figuur 9). Zoals te zien is in figuur 9a, werden verschillende configuraties van Mac-Imprint toegepast: massief Si met massief Au (links), poreus Si m…
Divulgazioni
The authors have nothing to disclose.
Acknowledgements
We erkennen Dr. Keng Hsu (Universiteit van Louisville) voor inzichten met betrekking tot dit werk; Frederick Seitz Laboratory van de Universiteit van Illinois en, in memoriam, staflid Scott Maclaren; Arizona State University’s LeRoy Eyring Center for Solid State Science; en de Science Foundation Arizona onder de Bis grove Scholars Award.
Materials
| Acetone, >99.5%, ACS reagent | Sigma-Aldrich | 67-64-1 | CAUTION, chemical |
| Ammonium fluoride, >98%, ACS grade | Sigma-Aldrich | 12125-01-8 | CAUTION, hazardous |
| Ammonium hydroxide solution, 28-30%, ACS reagent | Sigma-Aldrich | 1336-21-6 | CAUTION, hazardous |
| AZ 400K developer | Microchemicals | AZ 400K | CAUTION, chemical |
| BenchMark 800 Etch | Axic | BenchMark 800 | Reactive ion etching |
| Chromium target, 2" x 0.125", 99.95% purity | ACI alloys | ADM0913 | Magnetron sputter chromium target |
| CTF 12 | Carbolite Gero | C12075-700-208SN | Tube furnace |
| Desiccator | Fisher scientific Chemglass life sciences | CG122611 | Desiccator |
| F6T5/BLB | Eiko | F6T5/BLB 6W | UV bulb |
| Gold target, 2" x 0.125", 99.99% purity | ACI alloys | N/A | Magnetron sputter gold target |
| Hotplate KW-4AH | Chemat tecnologie | KW-4AH | Leveled hotplate with uniform temperature profile |
| Hydrofluoric acid, 48%, ACS reagent | Sigma-Aldrich | 7664-39-3 | CAUTION, extremly hazardous |
| Hydrogen peroxide, 30%, ACS reagent | Fisher Chemical | 7722-84-1 | CAUTION, hazardous |
| Isopropyl alcohol, >99.5%, ACS reagent | LabChem | 67-63-0 | CAUTION, chemical |
| MLP-50 | Transducer Techniques | MLP-50 | Load cell |
| Nitric acid, 70%, ACS grade | SAFC | 7697-37-2 | CAUTION, hazardous |
| NSC-3000 | Nano-master | NSC-3000 | Magnetron sputter |
| Potassium hydroxide, 45%, Certified | Fisher Chemical | 1310-58-3 | CAUTION, chemical |
| Rocker 800 vacuum pump, 110V/60Hz | Rocker | 1240043 | Oil-free vacuum pump |
| Silicon master mold | NILT | SMLA_V1 | Silicon chip with pattern |
| Silicon wafers, prime grade | University wafer | 783 | Si wafer |
| Silver target, 2" x 0.125", 99.99% purity | ACI alloys | HER2318 | Magnetron sputter silver target |
| SP-300 | BioLogic | SP-300 | Potentiostat |
| SPIN 150i | Spincoating | SPIN 150i | Spin coater |
| SPR 200-7.0 positive photoresist | Microchem | SPR 220-7.0 | CAUTION, chemical |
| Stirring hotplate | Thermo scientific Cimarec+ | SP88857100 | General purpose hotplate |
| SU-8 2015 negative photoresist | Microchem | SU-8 2015 | CAUTION, chemical |
| SYLGARD 184 Silicone elastomere kit | DOW | 4019862 | CAUTION, chemical |
| T-LSR150B | Zaber Technologies | T-LSR150B-KT04U | Motorized linear stage |
| Trichloro(1H,1H,2H,2H-perfluorooctyl)silane (PFOCS), 97% | Sigma-Aldrich | 78560-45-9 | CAUTION, hazardous |
Riferimenti
- Ning, H., et al. Transfer-Printing of Tunable Porous Silicon Microcavities with Embedded Emitters. ACS Photonics. 1 (11), 1144-1150 (2014).
- Hirschman, K. D., Tsybeskov, L., Duttagupta, S. P., Fauchet, P. M. Silicon-based light emitting devices integrated into microelectronic circuits. Nature. 384, 338-341 (1996).
- Cho, J., et al. Nanoscale Origami for 3D Optics. Small. 7 (14), 1943-1948 (2011).
- Azeredo, B. P., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305-225312 (2013).
- Lin, C., Tsai, M., Wei, W., Lai, K., He, J. Packaging Glass with a Hierarchically Nanostructured Surface: a universal method to achieve selfcleaning omnidirectional solar cells. ACS Nano. 10 (1), 549-555 (2016).
- Park, K. C., et al. Nanotextured Silica Surfaces with Robust Superhydrophobicity and Omnidirectional Broadband Supertransmissivity. ACS Nano. 6 (5), 3789-3799 (2012).
- Kim, J., Joy, D. C., Lee, S. Controlling resist thickness and etch depth for fabrication of 3D structures in electron-beam grayscale lithography. Microelectronics Engineering. 84 (12), 2859-2864 (2007).
- Deng, S., Zhang, Y., Jiang, S., Lu, M. Fabrication of three-dimensional silicon structure with smooth curved surfaces. Journal of Micro/Nanolithography, MEMS, and MOEMS. 15 (3), 0345031-0345036 (2016).
- Azeredo, B. P., Lin, Y., Avagyan, A., Sivaguru, M., Hsu, K. Direct Imprinting of Porous Silicon via Metal-Assisted Chemical Etching. Advanced Functional Materials. 26 (17), 2929-2939 (2016).
- Azeredo, B., Hsu, K., Ferreira, P. M. Direct Electrochemical Imprinting of Sinusoidal Linear Gratings into Silicon. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-6 (2016).
- Li, H., Niu, J., Wang, G., Wang, E., Xie, C. Direct Production of Silicon Nanostructures with Electrochemical Nanoimprinting. ACS Applied Electronic Materials. 1 (7), 1070-1075 (2019).
- Kim, K., Ki, B., Choi, K., Lee, S., Oh, J. Resist-Free Direct Stamp Imprinting of GaAs via Metal-Assisted Chemical Etching. ACS Applied Materials & Interfaces. 11 (14), 13574-13580 (2019).
- Zhang, J., et al. Contact electrification induced interfacial reactions and direct electrochemical nanoimprint lithography in n-type gallium arsenate wafer. Chemical Science. 8, 2407-2412 (2017).
- Zhan, D., et al. Electrochemical micro/nano-machining: principles and practices. Chemical Society Reviews. 46 (5), 1526-1544 (2017).
- Li, X., Bohn, P. W. Metal-assisted chemical etching in HF / H2O2 produces porous silicon. Applied Physics Letters. 77 (16), 2572-2574 (2000).
- Chartier, C., Bastide, S., Levy-Clement, C. Metal-assisted chemical etching of silicon in HF – H2O2. Electrochimica Acta. 53, 5509-5516 (2008).
- Chattopadhyay, S., Li, X., Bohn, P. W. In-plane control of morphology and tunable photoluminescence in porous silicon produced by metal-assisted electroless chemical etching. Journal of Applied Physics. 91 (9), 6134-6140 (2002).
- Torralba, E., et al. 3D patterning of silicon by contact etching with anodically biased nanoporous gold electrodes. Electrochemistry Communications. 76, 79-82 (2017).
- Bastide, S., et al. 3D Patterning of Si by Contact Etching With Nanoporous Metals. Frontiers in Chemistry. 7, 1-13 (2019).
- Sharstniou, A., Niauzorau, S., Ferreira, P. M., Azeredo, B. P. Electrochemical nanoimprinting of silicon. Proceedings of the National Academy of Sciences. 116 (21), 10264-10269 (2019).
- Niauzorau, S., Ferreira, P., Azeredo, B. Synthesis of Porous Noble Metal Films with Tunable Porosity by Timed Dealloying. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-4 (2018).
- Geyer, N., et al. Model for the Mass Transport During Metal-Assisted Chemical Etching with Contiguous Metal Films As Catalysts. The Journal of Physical Chemistry C. 116 (24), 13446-13451 (2012).
- Li, L., Liu, Y., Zhao, X., Lin, Z., Wong, C. Uniform Vertical Trench Etching on Silicon with High Aspect Ratio by Metal-Assisted Chemical Etching Using Nanoporous Catalysts. ACS Applied Materials and Interfaces. 6 (1), 575-584 (2014).

