Beam Epitaxy המולקולרית בסיוע פלזמה של N-קוטבי InAlN-מחסום טרנזיסטורים-ניידות גבוהה-אלקטרון
Summary
epitaxy קרן המולקולרי משמש לגדול טרנזיסטורים N-קוטביים InAlN-המחסום גבוהה-אלקטרון-ניידות (HEMTs). פיקוח על הכנת הרקיק, תנאי גידול שכבה ומבנה epitaxial תוצאות בשכבות InAlN חלקות, הומוגנית בעלי רכב HEMTs עם ניידות גבוהה ככל 1,750 סנטימטר 2 / V ∙ שניות.
Abstract
הפלזמה בסיוע epitaxy קרן המולקולרית הוא גם מתאים את צמיחת epitaxial של סרטי heterostructures דקים III-ניטריד עם ממשקים חלקים, פתאומיים הנדרשים טרנזיסטורים איכותי גבוהת אלקטרונים ניידים (HEMTs). הליך מוצג לצמיחת HEMTs InAlN N-קוטבי, כולל הכנת רקיק וצמיחה של שכבות חיץ, שכבת מחסום InAlN, interlayers AlN וגאן וערוץ גן. בעיות קריטיות בכל שלב של התהליך מזוהים, כגון הימנעות הצטברות Ga למאגר הגן, לתפקיד טמפרטורה על ההומוגניות הלחנת InAlN, ושימוש שטף Ga במהלך interlayer AlN ואת צמיחת ערוץ הפסיקה לפני הגן. בעלי הרכב סרטים דקים הומוגנית N-הקוטבית InAlN מודגמים עם משטח שורש ממוצע בריבוע חספוס נמוך כמו 0.19 ננומטר InAlN מבוסס מבני HEMT מדווחים שיש ניידות גבוהה ככל 1,750 סנטימטר 2 / V ∙ שנייה עבור מכשירים עם צפיפות מטען גיליון של 1.7 x 1013 ס"מ -2.
Introduction
Epitaxy קרן מולקולרית (MBE) הוא טכניקת צמיחת סרט הדק epitaxial צד מעסיקת סביבת ואקום גבוה במיוחד עם לחצי בסיס נמוכים כמו 10 -11 Torr כדי להבטיח התאגדות טומאה נמוכה בסרט המבוגר. שיעור הרכב והצמיחה של ההשכבות גדלו epitaxially נקבע על ידי שליטה על הטמפרטורה של כל תא השתפכות, וכך שטף Evaporated של חומרי המקור השונים. במקרה של epitaxy III-ניטריד, הקבוצה III-אלמנטים (ב, אל, Ga) ניתנים בדרך כלל על ידי תאים השתפכות בעוד חנקן פעיל השטף (N *) מסופק על ידי בין כאדם פלזמה N 2 1,2 (פלזמה RF MBE -assisted:. PAMBE או RFMBE) או אמוניה (NH 3 -MBE) צמיחת MBE 3,4 מתאפיינת בטמפרטורות צמיחה נמוכות פתאומיות interfacial חד יותר טכניקות צמיחת epitaxial אחרות, כגון שיקוע כימי metalorganic 5 סכימטי מוצג. באיור 1.
<pclass = "jove_content">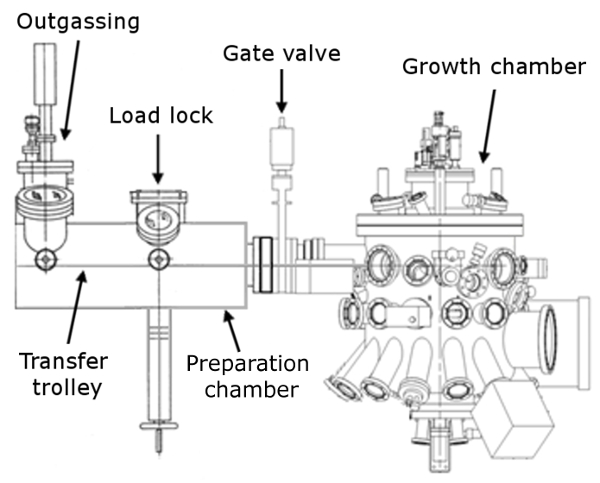
איור 1:.. סכימת מערכת MBE סכמטי המציג את מנעול עומס, מערכת העברה, outgassing תחנה וצמיחה קאמרי אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
III-nitrides ניתן לגדל על מצעים בכך שיש להם מגוון של אוריינטציות קריסטל. האורינטציה הנפוצה ביותר היא -plane ג Ga-קוטבי, אשר מאפשר ההיווצרות של גז אלקטרונים דו-ממדי ללא סימום על ידי ניצול פרש הקיטוב בין שכבת המחסום, בדרך כלל AlGaN, וערוץ הגן. שונים קוטבי למחצה הקוטב אוריינטציות של גן זכו לתשומת לב משמעותית עבור אופטו בשל תופעות קיטוב מופחת בארות הקוונטים, 6,7 אשר גם עושה אוריינטציות אלה פחות רצוי הרשמות HEMTננו-שניות. מכשירי N-קוטביים אורינטציה הם אטרקטיביים עבור מבצע HEMT הדור הבא בתדירות גבוהה בשל מספר יתרונות מהותיים על פני מכשירי Ga-קוטביים קונבנציונליים. 8 שכבת מכשול מכשירי N-קוטביים הוא גדל מתחת ערוץ GaN כפי שמוצגות באיור 2, וכתוצאה מכך בתוך מחסום טבעי בחזרה המסייע בקרה אלקטרוסטטיים של הערוץ ומפחית תופעות ערוץ קצרים, תוך מתן אפשרות גישה נוכחית קלה יותר לערוץ הגן והפחתת התנגדות קשר. המכשול יכול גם להיות נשלט בנפרד מהערוץ, כך שככל עובי הערוץ scaled למטה למכשירים בתדר גבוה בעיצוב המכשול יכול להיות שונה כדי לפצות על תשלום ערוץ הפסיד פרמו תופעות מצמידות רמה.
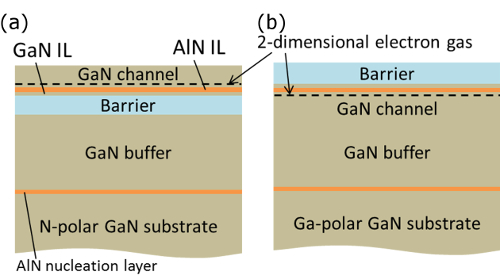
איור 2:. סכמטי שכבת Epitaxial מבנה שכבה של (א) HEMT N-קוטבי (ב) HEMT Ga-קוטבי עבור comparison. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
HEMTs המשמש במהירות גבוהה, מגברי הספק גבוה בדרך כלל גדלים על מצעי SiC כדי לנצל את מוליכות תרמית הגבוהות של SiC. גן מצעים בודד צפיפות פריקה השחלה נמוך יכול להיות מועסק על מנת לשפר את ניידות אלקטרונים, 9 ובכך לשפר את הביצועים בתדירות גבוהה. בעקבות צמיחה של שכבת נוקלאציה AlN, חיץ גן עבה הוא גדל להפריד בין זיהומים מרחבית על הממשק לצמיחה מחודשת מערוץ HEMT ולשפר בידוד חשמלי. בניגוד חומרי III-V אחרים, גן גדל PAMBE בדרך כלל צריך תנאי גידול עם יחס קבוצה-III / V גדול מ -1, כלומר, תנאי מתכת-עשירה, 10,11 כדי להשיג מורפולוגיה משטח חלק. בשנת x אל 1- x N הוא האלטרחומר מחסום מקורי עבור HEMTs III-ניטריד, וקבל תשומת לב משמעותית לאחרונה, כי זה יכול להיות מבוגר סריג מתאים גן עבור x ≈ 0.18 ויכול ליצור יותר מפי שתיים ביחס תשלום ערוץ לחסמי AlGaN הקיטוב הספונטני הגבוה המגיע לה. 12-15 בניגוד מחסומי AlGaN, Ga ישלבו מועדף בשינה בשכבות InAlN, 16 ובכך יש להקפיד על מנת להבטיח את פני השטח ללא עודף Ga לאחר צמיחת שכבת חיץ Ga-עשירה גן לפני צמיחת InAlN.
פיקוח על Ga על פני השטח ניתן להשיג על ידי suppling שטף Ga מעט פחות מ השטף הנדרש להיווצרות Ga-טיפה. עם זאת, חלון צמיחה זה הוא קטן, כיסוי שטח Ga מספיק יגרום מורפולוגיה המשטח להשפיל לתוך מורפולוגיה רמה / יעלה בעוד שטף Ga עודף יגרום הצטברות Ga ואת היווצרות טיפת מקרוסקופית. 17 עקיפת השתקפות אנרגיה גבוהה אלקטרונים (RHEED) intens ניתן להשתמש ity לפקח הצטברות desorption Ga. כיסוי שטח Ga מותווה על ידי הפחתה בעוצמת RHEED, וכל בפיגור בין סגירת Ga (ו- N *) תריסים והגידול הראשוני בעוצמת RHEED מציין הצטברות של Ga, כפי שמוצג באיור 3.

איור 3: ניטור כיסוי Ga בעצמת RHEED עוצמת אות RHEED נמדדה מדפוס RHEED שנרכש במסגרת סיבוב באמצעות רכישה מאולצת.. Ga שטף מספיק מותווה על ידי גידול מיידי עוצמת לאחר סגירת התריסים (לא מוצג). רוויים / כיסוי Ga האידיאלי הוא הצביע על ידי עיכוב בין סגר תריס התבהרות RHEED פתאומי כיסוי Ga עודף נתפסת הן עיכוב התבהרות ראשונית RHEED וכן עלייה בעוצמה הדרגתית יותר וכתוצאה מכך התאוששות בעוצמה מלאה לוקח יותר מ -60 שניות.com / קבצים / ftp_upload / 54,775 / 54775fig3large.jpg "target =" _ blank "> לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
השג איכות גבוהה InAlN ידי PAMBE מסתבכת בשל הנוכחות של תנודות רכב לרוחב, וכתוצאה מכך מייקרו "חלת דבש" מורכב תחומים אל-עשירים מוקפים גבולות In-עשירים. 18 ביעור מייקרו זו מושג באמצעות טמפרטורת מצע על 50 מעלות צלזיוס מעל תחילת desorption ב, 15,19,20 או כ -630 מעלות צלזיוס במשך InAlN N-קוטבי. במשטר צמיחה בטמפרטורה גבוהה זו, ב- x אל 1- רכב x N הוא פונקציה חזקה של טמפרטורת מצע, עם טמפרטורות גבוהות יותר וכתוצאה מכך נמוך ב התאגדות. השטף ב ניתן להגדיל כדי לפצות ב הפסיד אידוי, למרות שבפועל הוא מקסימלית השטף היא מוגבלת על ידי הקטנת יעילות התאגדות עם הגדלת השטף21. בנוסף להפחתת טמפרטורת המצע או הגדלת שטף, גברת קצב הצמיחה גם יכול להגדיל את הרכב בשינה בשל "לקבור השפעה", שבו נכנס אל אטומי המלכודת ולמנוע ממנו מתאדה. 21,22 גבוהה שיעורי צמיחה יכולים להיות מושגת על ידי הגדלת השטף ואל יחסים. כדי לשמור על מצב גידול עשיר N, * N היה צריך להיות גדל גם כן, אשר יכולה להיות מושגת על ידי הגדלת כוח פלזמה RF, הגברת קצב זרימת N 2, שיפור עיצוב תא פלזמה, או הגדלת החור צלחת הצמצם צְפִיפוּת.
שכבות epitaxial נוספות HEMTs המבוסס InAlN כוללות interlayers הגן AlN (ILs) ויעלה גן. AlN IL מוכנס בין המכשול לבין הערוץ יכול להגדיל μ ניידות כמו גם של n צפיפות מטען ערוץ גיליון. הגידול נייד מיוחס להפחתת חפיפת פונקצית גל של אלקטרון עם b InAlNarrier ופיזור סגסוגת שלאחר מכן. 9 כדי להבטיח צמיחה באיכות גבוהה של IL AlN, עודף של השטף Ga מסופק במהלך הצמיחה לפעול בתור פעילי שטח. IL גן יכול לשמש בין IL AlN והמכשולים שניצבים בפני לקדם ולשפר את הניידות תוך הפחתת תשלום הערוץ. ערוץ הגן ניתן לגדל באותה הטמפרטורה כמו מכשול InAlN, המאפשר צמיחה מתמשכת מהמחסום למרות ILs והערוצים. ניידות משופרת התקבלה על ידי להפריע לצמיחה לאחר IL AlN והגדלת טמפרטורת הצמיחה לפני הגוברת בערוץ הגן. במקרה זה כיסוי משטח Ga מגן צריך להישמר במהלך הפסיקה כדי למנוע שפלה ניידות.
הפרוטוקול הבא מתייחס באופן ספציפי HEMTs InAlN-המחסום גדל על גן מצעי N-קוטביים. זה יכול להתארך ישירות לצמיחה על מצעי C-קוטבי 4H- או 6H-SiC על ידי כולל שכבת AlN N-עשירה עבה 50 ננומטר.
Protocol
Representative Results
Discussion
צמיחתה של שכבת חיץ גן באיכות גבוהה היא קריטית להשגת ניידות אלקטרונים גבוהה בכל HEMT III-ניטריד. במקרה של HEMT InAlN N-קוטבי, צמיחת שכבת החיץ מסתבכת בשל הדרישה כי כל Ga להסירו מפני השטח לפני צמיחת InAlN. יש מגוון של טכניקות כדי להשיג תוספת זו כדי ההליך המתואר כאן, כגון epitaxy מתכת-מווס?…
Disclosures
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
References
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

