ננו-הדפסה אלקטרוכימית בסיוע מתכת של ופלים נקבוביים ומוצקים מסיליקון
Summary
פרוטוקול להטבעה כימית בסיוע מתכת של תכונות מיקרו-קנה מידה תלת-ממדיות עם דיוק בצורת תת-20 ננומטר לתוך ופלים סיליקון מוצקים ונקבוביים מוצג.
Abstract
הטבעה אלקטרוכימית בסיוע מתכת (Mac-Imprint) היא שילוב של חריטה כימית בסיוע מתכת (MACE) וליטוגרפיה ננו-הדפסה המסוגלת לכוון את התבניות התלת-ממדיות של תכונות מיקרו וננומטריות בקבוצה המונוקריסטלינית IV (לדוגמה, Si) ו- III-V (למשל, GaAs) מוליכים למחצה ללא צורך בתבניות הקרבה ובשלבים ליטוגרפיים. במהלך תהליך זה, חותמת לשימוש חוזר מצופה זרז מתכת אצילי הוא בא במגע עם רקיק Si בנוכחות חומצה הידרופלואורית (HF) ומי חמצן (H2O2) תערובת, מה שמוביל לתחריט סלקטיבי של Si בממשק המגע מתכת מוליכים למחצה. בפרוטוקול זה, אנו דנים בשיטות הכנת הבולים והמצעים המיושמים בשתי תצורות Mac-Imprint: (1) Porous Si Mac-Imprint עם זרז מוצק; ו -(2) מוצק סי מק-חותם עם זרז נקבובי. תהליך זה הוא תפוקה גבוהה והוא מסוגל דפוס מקביל בקנה מידה סנטימטר עם רזולוציה מתחת 20 ננומטר. הוא גם מספק צפיפות פגמים נמוכה ודפוסי שטח גדולים בפעולה אחת ועוקף את הצורך בתחריט יבש כגון תחריט יונים תגובתי עמוק (DRIE).
Introduction
דפוסי מיקרו-קנה מידה תלת-ממדיים וטקסטורציה של מוליכים למחצה מאפשרים יישומים רבים בתחומים שונים, כגון optoelectronics1,2, פוטוניקה3, משטחים אנטי-רפלקסיביים4, משטחים הידרופוביים סופר, ומשטחי ניקוי עצמי 5,6 בין היתר. אב טיפוס והפקת מסה של דפוסים תלת-ממדיים והיררכיים הושג בהצלחה עבור סרטים פולימריים על ידי ליטוגרפיה רכה וליטוגרפיה ננו-הדפסה עם רזולוציה של תת-20 ננומטר. עם זאת, העברת דפוסים פולימריים תלת-ממדיים כאלה לתוך Si דורשת סלקטיביות תחריט של תבנית מסכה במהלך תחריט יון תגובתי ובכך מגבילה את יחס הגובה-רוחב, וגורמת לעיוותי צורה וחספוס פני השטח עקב אפקטים שוליים7,8.
שיטה חדשה בשם Mac-Imprint הושגה עבור דפוס מקביל וישיר של נקבובי9 מוצק Si ופלים10,11, כמו גם ופלים GaAs מוצק12,13,14. Mac-Imprint היא טכניקת תחריט רטובה המבוססת על מגע הדורשת מגע בין מצע לבין חותמת מצופה מתכת אצילית בעלת תכונות תלת-ממדיות בנוכחות תמיסת תחריט (ES) המורכבת מ- HF ומחמצן (למשל, H2O2 במקרה של Si Mac-Imprint). במהלך החריטה, שתי תגובות מתרחשות בו זמנית 15,16: תגובה קתודית (כלומר, הפחתת H2O2 במתכת האצילית, שבמהלכה נוצרים נשאי מטען חיובי [חורים] ולאחר מכן מוזרקים ל- Si17) ותגובה אנודית (כלומר, פירוק Si, שבמהלכו החורים נצרכים). לאחר זמן מספיק במגע, תכונות התלת-ממד של החותמת חקוקות בופל Si. ל-Mac-Imprint יתרונות רבים על פני שיטות ליטוגרפיות קונבנציונליות, כגון תפוקה גבוהה, תאימות לפלטפורמות רול-לצלחת ו-Roll-to-roll, אמורפיות, מונו-פוליקריסטליניות Si ו-III-V מוליכים למחצה. ניתן לעשות שימוש חוזר בבולים של Mac-Imprint מספר פעמים. בנוסף, השיטה יכולה לספק רזולוציית תחריט תת-20 ננומטר התואמת לשיטות כתיבה ישירה עכשוויות.
המפתח להשגת הטבעה באיכות גבוהה הוא מסלול הדיפוזיה לחזית החריטה (כלומר, ממשק מגע בין זרז למצע). העבודה של אזרדו ואח ‘ 9 הוכיחה לראשונה כי דיפוזיה ES מופעלת באמצעות רשת Si נקבובי. Torralba et al.18, דיווח כי על מנת לממש מוצק Si Mac-Imprint דיפוזיה ES מופעלת באמצעות זרז נקבובי. Bastide et al.19 ו Sharstniou et al.20 חקרו עוד יותר את השפעת נקבוביות הזרז על דיפוזיה ES. לכן, הרעיון של Mac-Imprint נבדק בשלוש תצורות עם מסלולי דיפוזיה ברורים.
בתצורה הראשונה, הזרז והמצע מוצקים, ואינם מספקים מסלול דיפוזיה ראשוני. חוסר דיפוזיה מגיבה מוביל לתגובה משנית במהלך ההטבעה היוצרת שכבה של Si נקבובי על המצע סביב קצה ממשק הזרז-Si. המגיבים מתרוקנים לאחר מכן, והתגובה נפסקת, וכתוצאה מכך לא ניתן להבחין בנאמנות העברת דפוס בין החותמת למצע. בתצורות השנייה והשלישית, מסלולי הדיפוזיה מופעלים באמצעות רשתות נקבוביות המוצגות או במצע (כלומר, Si נקבובי) או בזרז (כלומר, זהב נקבובי) ודיוק העברת דפוס גבוה מושגת. לפיכך, הובלת ההמונים באמצעות חומרים נקבוביים ממלאת תפקיד קריטי בהפעלת פיזור המגיבים ומוצרי התגובה אל ממשק המגע והרחק ממנו 9,18,19,20. באיור 1 מוצג סכמטית של כל שלוש התצורות.
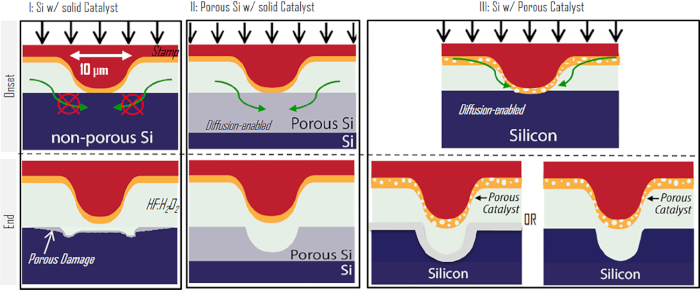
איור 1: שרטוטים של תצורות Mac-Imprint. נתון זה מדגיש את תפקידם של חומרים נקבוביים לאפשר פיזור של מינים מגיבים דרך המצע (כלומר, מקרה II: נקבובי Si) או בחותמת (כלומר, מקרה III: סרט דק זרז עשוי זהב נקבובי). לחץ כאן כדי להציג גירסה גדולה יותר של איור זה.
במאמר זה, תהליך Mac-Imprint נדון ביסודיות, כולל הכנת בולים וטיפול מקדים מצע יחד עם Mac-Imprint עצמו. סעיף טרום הטיפול במצע בפרוטוקול כולל ניקוי סי וופל ודוגמת סי וופל סי עם תחריט יבש ואנודיזציה של מצע (אופציונלי). כמו כן, סעיף הכנת בולים מחולק למספר הליכים: 1) דפוס העתק PDMS של עובש מאסטר Si; 2) ננו-הדפס UV של שכבה פוטורזיסטית על מנת להעביר את תבנית ה- PDMS; ו-3) תצהיר שכבות קטליטי באמצעות קשירת מגנטרון ואחריו עסקה (אופציונלי). לבסוף, בסעיף Mac-Imprint ההתקנה Mac-Imprint יחד עם תוצאות Mac-Imprint (כלומר, Si פני השטח 3D דפוס הירארכי) מוצג.
Protocol
Representative Results
Discussion
בולי Mac-Imprint ושבבי Si משוטרים מראש (סוג p, [100] אוריינטציה, 1-10 Ohm∙cm) הוכנו על פי סעיפים 1 ו -2 של הפרוטוקול, בהתאמה. ה-Mac-Imprint של שבב Si משוטח מראש עם בולים המכילים דפוסים היררכיים תלת-ממדיים בוצעה על פי סעיף 3 של הפרוטוקול (איור 9). כפי שניתן לראות באיור 9a, תצורו…
Divulgations
The authors have nothing to disclose.
Acknowledgements
אנו מודים לד”ר קנג הסו (אוניברסיטת לואיוויל) לתובנות לגבי עבודה זו; מעבדת פרדריק סייץ של אוניברסיטת אילינוי, ולזכרונו, חבר הסגל סקוט מקלארן; מרכז לירוי איירינג למדעי המדינה המוצקה באוניברסיטת אריזונה; וקרן המדע אריזונה תחת פרס חוקרי ביס גרוב.
Materials
| Acetone, >99.5%, ACS reagent | Sigma-Aldrich | 67-64-1 | CAUTION, chemical |
| Ammonium fluoride, >98%, ACS grade | Sigma-Aldrich | 12125-01-8 | CAUTION, hazardous |
| Ammonium hydroxide solution, 28-30%, ACS reagent | Sigma-Aldrich | 1336-21-6 | CAUTION, hazardous |
| AZ 400K developer | Microchemicals | AZ 400K | CAUTION, chemical |
| BenchMark 800 Etch | Axic | BenchMark 800 | Reactive ion etching |
| Chromium target, 2" x 0.125", 99.95% purity | ACI alloys | ADM0913 | Magnetron sputter chromium target |
| CTF 12 | Carbolite Gero | C12075-700-208SN | Tube furnace |
| Desiccator | Fisher scientific Chemglass life sciences | CG122611 | Desiccator |
| F6T5/BLB | Eiko | F6T5/BLB 6W | UV bulb |
| Gold target, 2" x 0.125", 99.99% purity | ACI alloys | N/A | Magnetron sputter gold target |
| Hotplate KW-4AH | Chemat tecnologie | KW-4AH | Leveled hotplate with uniform temperature profile |
| Hydrofluoric acid, 48%, ACS reagent | Sigma-Aldrich | 7664-39-3 | CAUTION, extremly hazardous |
| Hydrogen peroxide, 30%, ACS reagent | Fisher Chemical | 7722-84-1 | CAUTION, hazardous |
| Isopropyl alcohol, >99.5%, ACS reagent | LabChem | 67-63-0 | CAUTION, chemical |
| MLP-50 | Transducer Techniques | MLP-50 | Load cell |
| Nitric acid, 70%, ACS grade | SAFC | 7697-37-2 | CAUTION, hazardous |
| NSC-3000 | Nano-master | NSC-3000 | Magnetron sputter |
| Potassium hydroxide, 45%, Certified | Fisher Chemical | 1310-58-3 | CAUTION, chemical |
| Rocker 800 vacuum pump, 110V/60Hz | Rocker | 1240043 | Oil-free vacuum pump |
| Silicon master mold | NILT | SMLA_V1 | Silicon chip with pattern |
| Silicon wafers, prime grade | University wafer | 783 | Si wafer |
| Silver target, 2" x 0.125", 99.99% purity | ACI alloys | HER2318 | Magnetron sputter silver target |
| SP-300 | BioLogic | SP-300 | Potentiostat |
| SPIN 150i | Spincoating | SPIN 150i | Spin coater |
| SPR 200-7.0 positive photoresist | Microchem | SPR 220-7.0 | CAUTION, chemical |
| Stirring hotplate | Thermo scientific Cimarec+ | SP88857100 | General purpose hotplate |
| SU-8 2015 negative photoresist | Microchem | SU-8 2015 | CAUTION, chemical |
| SYLGARD 184 Silicone elastomere kit | DOW | 4019862 | CAUTION, chemical |
| T-LSR150B | Zaber Technologies | T-LSR150B-KT04U | Motorized linear stage |
| Trichloro(1H,1H,2H,2H-perfluorooctyl)silane (PFOCS), 97% | Sigma-Aldrich | 78560-45-9 | CAUTION, hazardous |
References
- Ning, H., et al. Transfer-Printing of Tunable Porous Silicon Microcavities with Embedded Emitters. ACS Photonics. 1 (11), 1144-1150 (2014).
- Hirschman, K. D., Tsybeskov, L., Duttagupta, S. P., Fauchet, P. M. Silicon-based light emitting devices integrated into microelectronic circuits. Nature. 384, 338-341 (1996).
- Cho, J., et al. Nanoscale Origami for 3D Optics. Small. 7 (14), 1943-1948 (2011).
- Azeredo, B. P., et al. Silicon nanowires with controlled sidewall profile and roughness fabricated by thin-film dewetting and metal-assisted chemical etching. Nanotechnology. 24 (22), 225305-225312 (2013).
- Lin, C., Tsai, M., Wei, W., Lai, K., He, J. Packaging Glass with a Hierarchically Nanostructured Surface: a universal method to achieve selfcleaning omnidirectional solar cells. ACS Nano. 10 (1), 549-555 (2016).
- Park, K. C., et al. Nanotextured Silica Surfaces with Robust Superhydrophobicity and Omnidirectional Broadband Supertransmissivity. ACS Nano. 6 (5), 3789-3799 (2012).
- Kim, J., Joy, D. C., Lee, S. Controlling resist thickness and etch depth for fabrication of 3D structures in electron-beam grayscale lithography. Microelectronics Engineering. 84 (12), 2859-2864 (2007).
- Deng, S., Zhang, Y., Jiang, S., Lu, M. Fabrication of three-dimensional silicon structure with smooth curved surfaces. Journal of Micro/Nanolithography, MEMS, and MOEMS. 15 (3), 0345031-0345036 (2016).
- Azeredo, B. P., Lin, Y., Avagyan, A., Sivaguru, M., Hsu, K. Direct Imprinting of Porous Silicon via Metal-Assisted Chemical Etching. Advanced Functional Materials. 26 (17), 2929-2939 (2016).
- Azeredo, B., Hsu, K., Ferreira, P. M. Direct Electrochemical Imprinting of Sinusoidal Linear Gratings into Silicon. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-6 (2016).
- Li, H., Niu, J., Wang, G., Wang, E., Xie, C. Direct Production of Silicon Nanostructures with Electrochemical Nanoimprinting. ACS Applied Electronic Materials. 1 (7), 1070-1075 (2019).
- Kim, K., Ki, B., Choi, K., Lee, S., Oh, J. Resist-Free Direct Stamp Imprinting of GaAs via Metal-Assisted Chemical Etching. ACS Applied Materials & Interfaces. 11 (14), 13574-13580 (2019).
- Zhang, J., et al. Contact electrification induced interfacial reactions and direct electrochemical nanoimprint lithography in n-type gallium arsenate wafer. Chemical Science. 8, 2407-2412 (2017).
- Zhan, D., et al. Electrochemical micro/nano-machining: principles and practices. Chemical Society Reviews. 46 (5), 1526-1544 (2017).
- Li, X., Bohn, P. W. Metal-assisted chemical etching in HF / H2O2 produces porous silicon. Applied Physics Letters. 77 (16), 2572-2574 (2000).
- Chartier, C., Bastide, S., Levy-Clement, C. Metal-assisted chemical etching of silicon in HF – H2O2. Electrochimica Acta. 53, 5509-5516 (2008).
- Chattopadhyay, S., Li, X., Bohn, P. W. In-plane control of morphology and tunable photoluminescence in porous silicon produced by metal-assisted electroless chemical etching. Journal of Applied Physics. 91 (9), 6134-6140 (2002).
- Torralba, E., et al. 3D patterning of silicon by contact etching with anodically biased nanoporous gold electrodes. Electrochemistry Communications. 76, 79-82 (2017).
- Bastide, S., et al. 3D Patterning of Si by Contact Etching With Nanoporous Metals. Frontiers in Chemistry. 7, 1-13 (2019).
- Sharstniou, A., Niauzorau, S., Ferreira, P. M., Azeredo, B. P. Electrochemical nanoimprinting of silicon. Proceedings of the National Academy of Sciences. 116 (21), 10264-10269 (2019).
- Niauzorau, S., Ferreira, P., Azeredo, B. Synthesis of Porous Noble Metal Films with Tunable Porosity by Timed Dealloying. The American Society of Mechanical Engineers – International Manufacturing Science and Engineering Conference. , 1-4 (2018).
- Geyer, N., et al. Model for the Mass Transport During Metal-Assisted Chemical Etching with Contiguous Metal Films As Catalysts. The Journal of Physical Chemistry C. 116 (24), 13446-13451 (2012).
- Li, L., Liu, Y., Zhao, X., Lin, Z., Wong, C. Uniform Vertical Trench Etching on Silicon with High Aspect Ratio by Metal-Assisted Chemical Etching Using Nanoporous Catalysts. ACS Applied Materials and Interfaces. 6 (1), 575-584 (2014).

