שימוש של חלקיקים של הקורבן להסיר את ההשפעות של Shot-רעש חורים לתקשר מפוברק על ידי E-הקורה ליתוגרפיה
Summary
באופן אחיד חלקיקים בגודל יכולים להסיר תנודות בממדי קשר חור בדוגמת פולי (methacrylate מתיל) (PMMA) סרטי photoresist על ידי קרן אלקטרונים (E-beam) ליתוגרפיה. התהליך כרוך תיעול אלקטרוסטטית חלקיקים במרכז הפקדה חורה קשר, ואחריו הזרמה מחדש photoresist ו פלזמה וצעדים רטוב-תחריט.
Abstract
ננו-תבניות מפוברקות עם אולטרה סגול קיצוני (EUV) או קרן אלקטרונים (E-beam) וריאציות בלתי צפויות תערוכה ליתוגרפיה בגודל. וריאציה זו יוחסה תנודות סטטיסטיות במספר פוטונים / אלקטרוני הגעתו א-באזור ננו נתון נובע ירה לרעש (SN). את המספר הסידורי משתנה ביחס הפוך לשורש הריבועי של מספר הפוטונים / אלקטרונים. עבור במינון קבוע, SN הוא גדול lithographies EUV ו- E-הקרן מאשר מסורתית (193 ננומטר) ליתוגרפיה אופטית. מלמטה למעלה וגישות דפוסים מלמעלה למטה משולבות כדי למזער את ההשפעות של רעש נורה דפוסי ננו-חור. באופן ספציפי, א-מרכיבה עצמית פעילה שטח אמינו-silane על פרוסות סיליקון כי הוא לאחר מכן ספין מצופה עם סרט 100 ננומטר של photoresist E-קרן PMMA מבוססת. חשיפת E-קורה ואת ההתפתחות שלאחר מכן לחשוף את הסרט פעיל שטח הבסיסי בתחתיות החורות. טובלים את פרוסות להשעיית, ציטרט הכתיר טעונים שלילית, 20 ננומטר gחלקיקים ישנים (תל"ג) פיקדונות חלקיק אחד לכל חור. הסרט הפעיל השטח הטעון החשוף באופן חיובי החור אלקטרוסטטי מתעל את ננו-החלקיקים הטעונים השלילית למרכז חור חשוף, אשר לצמיתות מתקן את הרישום מיקומית. לאחר מכן, על ידי חימום ליד מעבר זכוכית הטמפרטורה של פולימר photoresist, סרט photoresist reflows ואת בולעת החלקיקים. תהליך זה מוחק את החורים מושפעים SN אבל משאיר את GNPs שהופקד נעול במקום על ידי אלקטרוסטטית חזקה מחייבת. טיפול עם פלזמה חמצן חושף את GNPs ידי חריטה של שכבה דקה של photoresist. Wet-תחריט GNPs החשוף עם תמיסה של לי 2 / KI מניב חורים אחידים הממוקמים במרכז החריצים בדוגמת ידי ליתוגרפיה-אלומת E. הניסויים שהוצגו עולה כי הגישה מפחיתה את השוני בין גודל חורים שנגרמו על ידי SN מ -35% אל מתחת ל 10%. השיטה מרחיבה את גבולות דפוסים של חורי קשר טרנזיסטור אל מתחת ל 20 ננומטר.
Introduction
הגידול המעריכי בשלטון חישובית, כמו לכימות על ידי חוק מור 1, 2 (1), היא תוצאה של התקדמות הדרגתית ליתוגרפיה אופטית. בטכניקת דפוסים מלמעלה למטה זה, החלטת השגה, R, ניתן על ידי משפט ראלי ידוע 3:

הנה, λ ו NA הם גל אור צמצם מספרי, בהתאמה. שים לב NA = η · sinθ, שבו η הוא מקדם השבירה של התווך בין העדשה ואת פרוסות; θ = tan -1 (ד / 2L) עבור הקוטר, ד, של העדשה, ואת המרחק, l, בין מרכז העדשה ואת הפרוסות. במהלך חמישים השנים האחרונות, ההחלטה ליתוגרפיות השתפרה באמצעות (א) מקור אורs, כולל לייזרים excimer, עם אורכי גל UV קטנים יותר ויותר; (ב) עיצובים אופטיים חכמים העסקת שלב משמרת מסכות 4; ו- (ג) גבוה NA. להשגת חשיפה באוויר (η = 1), אנ-איי היא תמיד פחות אחדים, אלא על ידי החדרת נוזל עם η> 1, כגון מים 5, בין העדשה ואת פרוסות, יכול להיות מורם NA מעל 1, ובכך לשפר את הרזולוציה של ליתוגרפיה טבילה. נכון לעכשיו נתיבי קיימא צומת 20 ננומטר ומעבר כוללים מקורות UV קיצוניים (λ = 13 ננומטר) או טכניקות דפוסים באמצעות עיבוד כפול מרובע מורכב של photoresist רב שכבתי 6, 7.
בקני מידה באורך ננומטר, תנודות סטטיסטיות, הנגרמת על ידי זריקה לרעש (SN), במספר הפוטונים המגיעים בתוך וריאציה הגורם ננו באזור בממדי lithogra דפוסי phic. תופעות אלה בולטות יותר עם חשיפה לאור EUV אנרגיה גבוהה ו- E-קורות, מערכות שצריכות הזמנות של פוטונים פחות גודל / חלקיקים לעומת ליתוגרפיה 8 אופטית רגילה. רגיש במיוחד מוגבר כימי (עם יעילות קוונטית> 1) photoresists גם להציג SN כימי שגרם וריאציה במספר מולקולות photoreactive ב nanoregions החשוף 9, 10. photoresists רגישות נמוכה שצריכים חשיפות כבר לדכא את ההשפעות הללו, אבל הם גם להפחית את התפוקה.
על בקנה מידה מולקולרי, התרומה קו קצה חיספוס מהפצת גודל מולקולרי אינהרנטי פולימרים photoresist עשוי להיות מופחת על ידי שימוש מתנגד מולקולרית 11. הלך מחשבה זה, הוא משלים עיבוד מלמעלה למטה של דפוסי ננו היא השימוש בשיטות מלמטה למעלה 12,s = "Xref"> 13 המסתמכים באופן ספציפי על הרכבה עצמית מכוונת (DSA) של פולימרים diblock 14. היכולת של תהליכים אלה לכוון נוקלאציה ליצור ריווח לא אחיד בין דפוסים רצויים, כגון חורים או קווים, נותרת מאתגרת. התפלגות הגודל של רכיבים מולקולריים 15, 16 גם מגבילה את היקף תשואה של ייצור 17, 18. בעיות דומות להגביל הדפסת microcontact של חלקיקים ליתוגרפיה רך 19.
מאמר זה מציג מחקרים של גישה היברידית חדשה (איור 1), המשלבת את ליתוגרפיה ההקרנה מלמעלה למטה הקלסית עם הרכבה עצמית מכוון אלקטרוסטטי כדי לצמצם את ההשפעה של חספוס SN / קו-קצה (הימלר) 20. מטען חשמלי חיובי קבוצות האמינו על משטחים עצמיים התאסף (Sams) של N – (2-aminoethyl)-11-אמינו-undecyl-methoxy-silane (AATMS) שבבסיס הסרט PMMA נחשפים לאחר פיתוח. סרט photoresist הטעון השלילי של PMMA אלקטרוסטטי משפכי טעונת חלקיקי זהב שלילי (GNPs), כתרים עם ציטרט, 21 – 24 לחורים SN-מושפע 25. Re-זרימה של photoresist PMMA בולעת חלקיקים predeposited בסרט.
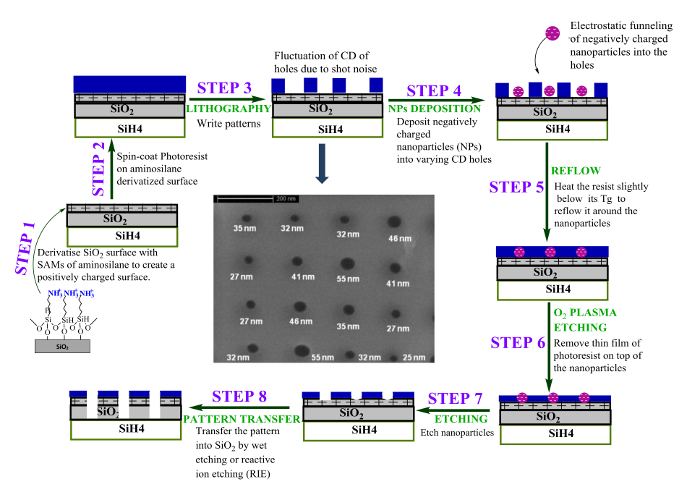
איור 1: ייצוג סכמטי של האסטרטגיה להסיר את ההשפעות של רעש ירייה וחספוס קו-קצה עבור הדפוסים של חורי קשר באמצעות צירופים של גודל מדויק. הנה, את הממד הביקורתי (CD) הוא בקוטר הרצוי של החורים. הגישה (שלב 1) מתחילה עם הפקדה בשכבה עצמית התאסף (SAM) של מולקולת silane נושאה קבוצות אמין בעלי מטען חשמלי חיובי על גלי התחמוצתאס של פרוסות סיליקון. לאחר מכן, ליתוגרפיה E-הקרן משמשת תבנית החורה (שלבי 2 ו -3) בסרטו photoresist PMMA, השכבה הכחולה, אשר מייצר רעש ירייה, כפי שמודגם תמונת שיבוץ SEM. ליתוגרפיה חושפת קבוצות אמינות בתחתית החורה. שלב 4 כרוך בתצהיר השלב המימי של גודל-נשלט, כתרים-ציטראט חלקיקי זהב (מטען שלילי) (GNPs) חורים בדוגמת lithographically באמצעות תיעול אלקטרוסטטית (EF). בשלב 5, חימום רקיק 100 ° C, מתחת לטמפרטורה מעבר הזכוכית של PMMA, 110 ° C, גורם הזרמה מחדש של photoresist סביב חלקיקים מראש שהופקד. תחריט מעולף PMMA עם פלזמת חמצן (שלב 6) חושף את GNPs, ורטוב תחריט עקב (יוד) של החלקיקים החשופים (שלב 7) יוצר חורים המתאים לגודל של GNPs. כאשר מצמידים עם תגובתי-ion / רטוב-תחריט, אפשר להעביר את דפוס חור photoresist כדי SiO 2 (שלב 8) 31. מִחָדָשׁמודפס באישור התייחסות 20. אנא לחץ כאן כדי לצפות בגרסה גדולה יותר של דמות זו.
האינטראקציה אלקטרוסטטית בין GNPs ו"חורים וקבוצות אמינות על פני המצע מונעת התזוזה של GNPs מאתר המחייב. צעד ההזרמה מחדש שומר על המיקום היחסי של GNPs אבל מוחק את החורים ואת ההשפעות של SN / הימלר. פלזמה / צעדי תחריט רטובים להתחדש חורים שיש להם את הגודל של התל"ג. תחריט תגובתי יון מעביר הדפוס שלהם SiO 2 שכבות קשה מסכה. השיטה מסתמכת על שימוש יותר אחיד חלקיקים בגודל מאשר nanohole בדוגמת (NH), כפי שבאה לידי ביטוי בסטיית התקן, σ, כך σ התל"ג <σ NH. דוח זה מתמקד צעדים (4 ו -5 המתוארים באיור 1) מעורבים בתצהיר של חלקיקים מן הפיזור ואתהזרמה מחדש של photoresist סביבם להעריך את היתרונות והמגבלות של השיטה. שני השלבים הללו, באופן עקרוני, ניתן להרחבה עד מצעים גדולים, אין צורך שינוי נרחב של הזרימה הנוכחית של ייצור מעגלים משולבים מודרניים על שבבי.
Protocol
Representative Results
Discussion
Shot-רעש (SN) ליתוגרפיה הוא תוצאה פשוטה של תנודות סטטיסטיות במספר הפוטונים או חלקיקים (N) המגיעים בתוך ננו-אזור נתון; זה עומד ביחס הפוך לשורש הריבועי של מספר הפוטונים / חלקיקים:

Disclosures
The authors have nothing to disclose.
Acknowledgements
אינטל מימנה את העבודה הזאת דרך מספר מענק 414,305, ויוזמת ננוטכנולוגיה מיקרוטכנולוגיה אורגון (אונמי) העמידה משאבים תואמים. אנו בתודה להכיר תמיכה וייעוץ של ד"ר ג'יימס בלקוול בכל שלבי העבודה הזאת. תודה מיוחדת הדרים Beasau וצ'לסי בנדיקטוס לניתוח נתונים סטטיסטיים מיצוב חלקיקים. אנו מודים פרופ 'הול עבור קריאה זהירה של כתב היד וד"ר קורט Langworthy, באוניברסיטת אורגון, יוג'ין, OR, על עזרתו עם ליתוגרפיה E-הקורה.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

