El uso de nanopartículas de sacrificio para eliminar los efectos del ruido de disparo en orificios de contacto fabricadas por haz de electrones de litografía
Summary
Uniformemente nanopartículas de tamaño pueden eliminar las fluctuaciones en contacto dimensiones de los orificios estampados en poli (metacrilato de metilo) (PMMA películas) fotorresistentes por haz de electrones (haz de electrones) litografía. El proceso implica la canalización electrostática para el centro y cerca de depósito nanopartículas en orificios de contacto, seguido de reflujo fotoprotector y los pasos del plasma y de grabado en húmedo.
Abstract
Las nano-patrones fabricados con luz ultravioleta extrema (EUV) o por haz de electrones (haz de electrones) litografía exhiben variaciones inesperadas en tamaño. Esta variación se ha atribuido a fluctuaciones estadísticas en el número de fotones / electrones que llegan a un nano-región determinada derivada de disparo-ruido (SN). El SN varía inversamente a la raíz cuadrada de un número de fotones / electrones. Para una dosis fija, el SN es mayor en EUV y de rayos E litografías que para los tradicionales (193 nm) litografía óptica. enfoques de abajo arriba y de arriba hacia abajo de modelado se combinan para minimizar los efectos de ruido de disparo en los patrones de nano-agujero. Específicamente, un amino-silano tensioactivos auto-ensambla en una oblea de silicio que está posteriormente mediante revestimiento por centrifugación con una película de 100 nm de un fotorresistente E-beam basado en PMMA. La exposición al haz de electrones y el posterior desarrollo descubrir la película de tensioactivo subyacente en el fondo de los agujeros. Sumergiendo la oblea en una suspensión de carga negativa, citrato límite máximo, 20 nm gnanopartículas de edad (PNB) los depósitos de una partícula por el agujero. La película tensioactivo cargado positivamente expuesta en el agujero embudos electrostáticamente la nanopartícula cargada negativamente al centro de un agujero expuesto, que fija de forma permanente el registro de posición. A continuación, mediante calentamiento cerca de la temperatura de transición vítrea del polímero de resina fotosensible, la película de resina fotosensible y reflujos envuelve a las nanopartículas. Este proceso borra los agujeros afectados por SN, pero deja los PNB depositados bajo llave en su lugar por una fuerte unión electrostática. El tratamiento con plasma de oxígeno expone los PNB por ataque químico una capa fina de la resina fotosensible. Wet-grabado los PNB expuestas con una solución de I2 / KI produce agujeros uniformes ubicados en el centro de muescas estampadas mediante litografía por haz de electrones. Los experimentos presentados muestran que el enfoque reduce la variación en el tamaño de los agujeros causados por SN de 35% a menos del 10%. El método se extiende de los límites de modelado de orificios de contacto transistor hasta por debajo de 20 nm.
Introduction
El crecimiento exponencial de la potencia de cálculo, tal como se cuantifica por la ley de Moore 1, 2 (1), es un resultado de los avances progresivos en la litografía óptica. En esta técnica de modelado de arriba hacia abajo, la resolución alcanzable, R, viene dada por el conocido teorema de Raleigh 3:

Aquí, λ y NA son la longitud de onda de la luz y la apertura numérica, respectivamente. Tenga en cuenta que NA = η · sinθ, donde η es el índice de refracción del medio entre la lente y la oblea; θ = tan -1 (d / 2 l) para el diámetro, d, de la lente, y la distancia, l, entre el centro de la lente y la oblea. Durante los últimos cincuenta años, la resolución litográfica ha mejorado a través del uso de (a) la fuente de luzs, incluyendo láseres excimer, con longitudes de onda UV progresivamente más pequeños; (b) Los diseños ópticos inteligentes que emplean máscaras de desplazamiento de fase 4; y (c) mayor NA. Para la exposición en el aire (η = 1), NA es siempre menor que la unidad, pero con la introducción de un líquido con η> 1, tal como agua 5, entre la lente y la oblea, NA puede ser elevado por encima de 1, lo que mejora la resolución de litografía de inmersión. Actualmente caminos viables a un nodo de 20 nm y más allá incluyen fuentes de UV extremas (λ = 13 nm) o técnicas de modelado utilizando procesamiento dobles y cuádruples complejo de un fotoprotector de varias capas 6, 7.
A escalas de nanómetros de longitud, fluctuaciones estadísticas, causadas por ruido de disparo (SN), en el número de fotones que llegan dentro de una variación de causa nano-región en las dimensiones de lithogra patrones to s grá fico. Estos efectos son más pronunciados con la exposición a la luz EUV de alta energía y haces E, sistemas que necesitan órdenes de magnitud menor número de fotones / partículas en comparación con la litografía óptica normal de 8. Supersensible amplificado químicamente (con un rendimiento cuántico> 1) las resinas fotosensibles también introducen un SN química causada por una variación en el número de moléculas fotorreactivos en nanoregions expuestas 9, 10. Bajar las resinas fotosensibles de sensibilidad que necesitan exposiciones más largas suprimen estos efectos, sino que también reducen el rendimiento.
En la escala molecular, la contribución a la línea de borde rugosidad de la distribución del tamaño molecular inherentes a los polímeros de resina fotosensible puede reducirse mediante el uso resiste moleculares 11. Un enfoque que es complementaria a este procesamiento de arriba hacia abajo de la nano-patrón es el uso de métodos de abajo hacia arriba 12,s = "xref"> 13 que se basan específicamente en el autoensamblaje dirigido (DSA) de polímeros de dos bloques 14. La capacidad de estos procesos para dirigir la nucleación y para crear separación no uniforme entre los patrones deseados, tales como agujeros o líneas, sigue siendo un reto. La distribución del tamaño de los componentes moleculares de 15, 16 también limita la escala y el rendimiento de la fabricación 17, 18. Problemas similares limitan la impresión por microcontacto de las nanopartículas en la litografía blanda 19.
Este trabajo presenta los estudios de un nuevo enfoque híbrido (Figura 1) que combina la litografía de proyección de arriba hacia abajo clásico con auto-ensamblaje dirigido de forma electrostática para reducir el efecto de la rugosidad SN / línea de borde (LER) 20. Con carga positiva grupos amina en monocapas autoensambladas (SAM) de N – (2-aminoetil)-11-Amino-undecilo-metoxi-silano (AATMS) que se basa la película de PMMA están expuestos después del desarrollo. La película de resina fotosensible cargada negativamente de PMMA electrostáticamente embudos de carga negativa nanopartículas de oro (PNB), coronados con citrato, 21 – 24 en los agujeros 25 SN afectadas. Re-flujo de la resina fotosensible PMMA envuelve nanopartículas predepositada en la película.
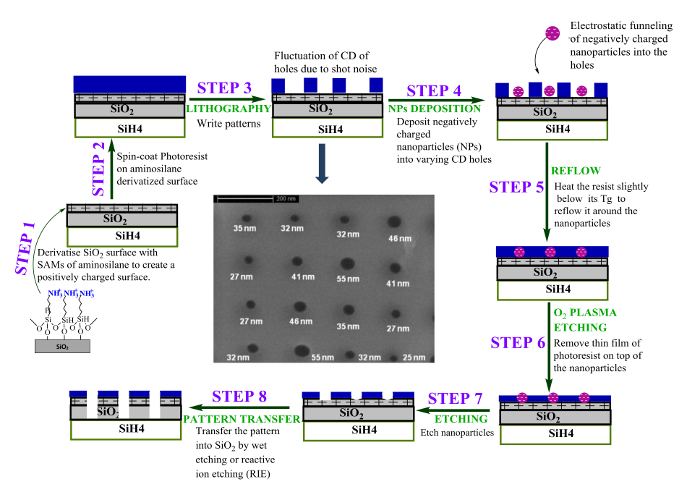
Figura 1: Representación esquemática de la estrategia para eliminar los efectos del ruido de disparo y la rugosidad del borde de línea para el patrón de agujeros de contacto utilizando NPs de tamaño preciso. Aquí, la dimensión crítica (CD) es el diámetro deseado de los agujeros. El enfoque (paso 1) comienza con la deposición de una capa monomolecular auto-ensamblada (SAM) de la molécula de silano que lleva grupos amina de carga positiva en el surf óxidoas de una oblea de silicio. A continuación, la litografía de haz de electrones se utiliza para patrón de los orificios (pasos 2 y 3) en PMMA película fotorresistente, la capa azul, lo que genera ruido de disparo, como se ilustra la imagen de la inserción en SEM. Litografía expone grupos amina en la parte inferior de los agujeros. Paso 4 implica la deposición en fase acuosa de tamaño controlado, (con carga negativa) nanopartículas de oro de citrato-tope (PNB) en los agujeros por litografía estampadas utilizando canalización electrostática (EF). En el paso 5, el calentamiento de la oblea a 100 ° C, por debajo de la temperatura de transición vítrea del PMMA, 110 ° C, hace que el reflujo de la resina fotosensible alrededor de nanopartículas depositados previamente. Aguafuerte superpone PMMA con plasma de oxígeno (paso 6) expone los PNB, y el posterior ataque químico húmedo (yodo) de las partículas expuestas (paso 7) crea agujeros correspondientes al tamaño de los PNB. Cuando se combina con reactivo de iones / húmedo de grabado, es posible transferir el patrón de agujeros en la fotoprotección de SiO 2 (etapa 8) 31. Reimpreso con el permiso de referencia 20. Haga clic aquí para ver una versión más grande de esta figura.
La interacción electrostática entre los PNB de carga opuesta y grupos amina sobre el sustrato impide el desplazamiento de los PNB del sitio de unión. El paso de reflujo mantiene la posición relativa de los PNB pero borra los agujeros y los efectos de la SN / LER. De plasma / pasos grabado húmedo regeneran agujeros que tienen el tamaño de la PNB. -Grabado por iones reactivos transfiere su patrón de SiO2 capas de máscara dura. El método se basa en el uso de más uniformemente las nanopartículas de tamaño de un nanohole modelado (NH), expresada como la desviación estándar, σ, de manera que σ PNB <σ NH. Este informe se centra en los pasos (4 y 5 descritos en la Figura 1) que supongan la deposición de nanopartículas de dispersión y lareflujo de la fotoprotección alrededor de ellos para evaluar las ventajas y limitaciones del método. Ambas etapas son, en principio, escalable para sustratos más grandes, que no requiere de una amplia modificación del flujo de corriente de la producción de circuitos integrados modernos en los chips.
Protocol
Representative Results
Discussion
Shot-ruido (SN) en la litografía es una simple consecuencia de las fluctuaciones estadísticas en el número de fotones o partículas (N) que llegan a un nano-región determinada; es inversamente proporcional a la raíz cuadrada de un número de fotones / partículas:

donde A y R son el área y el tamaño de la región expuesta, respectivamente. Por ejemplo, cuando se utiliza un ArF …
Disclosures
The authors have nothing to disclose.
Acknowledgements
Intel Corporation financió este trabajo a través de la subvención número 414.305, y la Iniciativa de Nanotecnología y Micro Oregon (ONAMI) proporcionó fondos de contrapartida. Agradecemos el apoyo y el asesoramiento del Dr. James Blackwell en todas las fases de este trabajo. Un agradecimiento especial a dibujó Beasau y Chelsea Benedict para el análisis de las estadísticas de posicionamiento de partículas. Agradecemos al profesor Hall para una lectura cuidadosa del manuscrito y el Dr. Kurt Langworthy, de la Universidad de Oregon, Eugene, Oregón, por su ayuda con la litografía por haz de electrones.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

