犠牲ナノ粒子の使用は、電子ビームリソグラフィにより作製したコンタクトホール内にショットノイズの影響を除去します
Summary
均一なサイズのナノ粒子は、電子ビーム(Eビーム)リソグラフィによりポリパターニングコンタクトホール寸法の変動(メチルメタクリレート)(PMMA)フォトレジスト膜を除去することができます。プロセスは、フォトレジストのリフロー及びプラズマ・湿式エッチング工程に続いて、コンタクトホール内にナノ粒子を中心と堆積する静漏斗を含みます。
Abstract
極端紫外線(EUV)または電子ビーム(Eビーム)リソグラフィーを呈するサイズの予期しない変形例で製造ナノパターン。この変化は、ショットノイズ(SN)から生じる所与のナノ領域に到達した光子/電子の数の統計的変動に起因しています。 SNは、光子/電子の数の平方根に反比例して変化します。固定用量の場合、SNは、伝統的な(193 nm)の光リソグラフィのためのよりEUVや電子ビームリソグラフィーの方が大きいです。ボトムアップおよびトップダウンパターニングアプローチは、ナノホールパターン形成におけるショットノイズの影響を最小化するために組み合わされます。具体的には、その後にPMMAベースの電子ビームレジストの100nmの膜をスピンコートされたシリコンウェハ上にアミノシラン界面活性剤自己集合。電子ビームとその後の発展への曝露は、穴の底部に下地の界面活性剤のフィルムを発見します。負に帯電し、クエン酸をかぶった、20 nmのグラムの懸濁液中にウェハを浸漬古いナノ粒子(GNP)預金穴あたり1粒。穴にさらさ正に帯電した界面活性剤フィルムは、静電的に恒久的な位置レジストリを修正さらさ穴の中心までの負に帯電したナノ粒子を集中します。次に、フォトレジストポリマーのガラス転移温度近くに加熱することにより、フォトレジスト膜をリフローし、ナノ粒子を飲み込みます。このプロセスは、SNによって影響を受ける穴を消去しますが、結合、強い静電によって所定の位置にロックされて堆積したGNPを残します。酸素プラズマを用いた処理は、フォトレジストの薄層をエッチングしたGNPを露出させます。 I 2 / KI溶液で露光されたGNPをウェットエッチング電子ビームリソグラフィによってパターニングくぼみの中心に位置し、均一な孔を生じます。提示された実験アプローチは、35%から10%未満までSNによって生じる孔のサイズのばらつきを低減することを示しています。この方法は、20 nm以下の、トランジスタのコンタクトホールのパターン形成限界を拡張します。
Introduction
計算能力の指数関数的な成長は、ムーアの法則1、2(1)によって定量化として、光リソグラフィにおける進行進歩の結果です。このトップダウンパターニング技術では、達成可能な解像度は、Rは 、よく知られているローリー定理3によって与えられます。

ここで、λ及びNAは、それぞれ、光波長及び開口数です。 ηは、レンズとウエハとの間の媒質の屈折率NAこと=η・sinθとし 、注意してください。レンズとウェハの中心との間のθ=日焼け-1(D / 2リットル )の直径のために、D、レンズの、距離、L、。最後の50年間で、リソグラフィの解像度は、(a)は、光源の使用により改善されました徐々に小さくUV波長を有するエキシマレーザ、などの、。 (b)は、位相シフトマスク4を用いた巧妙な光学設計。そして(c)高NA。空気中の露光用(η= 1)、NAは常に団結未満であるが、液体を導入することにより、 η> 1と、水5等は、レンズとウェハとの間に、NAにより液浸リソグラフィの解像度を向上させる、1より上に上昇することができます。現在、実行可能なパス20-nmノードへの以降は、多層フォトレジスト6、7の複雑な二重と四重処理を使用して、極端なUV光源(λ= 13 nm)のまたはパターニング技術が含まれます。
lithograの寸法のナノ領域原因変動内に到着する光子の数のショットノイズ(SN)によって引き起こされるナノメートル長さスケール、統計的な変動、で PHICパターン。これらの効果は、通常の光リソグラフィ8に比べて大きさが少ないフォトン/粒子の注文を必要とするシステム、高エネルギーのEUV光とE-ビームへの曝露でより顕著です。高感度化学増幅(量子効率で> 1)フォトレジストはまた、露出したナノ領域9、10で光反応性分子の数の変動によって引き起こされる化学SNをご紹介します。長い露出を必要とするより低い感度のフォトレジストは、これらの影響を抑制し、彼らはまた、スループットが低下します。
分子スケールで、フォトレジストのポリマーに固有の分子サイズ分布からの寄与ラインエッジラフネスする分子レジスト11を使用することによって低減することができます。ナノパターニングこのトップダウン処理に相補的なアプローチは、ボトムアップ方法12を使用することですジブロックポリマー14の有向自己集合(DSA)に特異的に依存しているS = "外部参照"> 13。核生成を指示すると、そのような穴や線などの所望のパターンとの間の不均一な間隔を作成するために、これらのプロセスの能力が、困難なままです。分子成分15,16のサイズ分布も規模と製造17、18の収率を制限します。同様の問題は、ソフトリソグラフィー19中のナノ粒子のマイクロコンタクト印刷を制限します。
本論文では、SN /ラインエッジラフネス(LER)20の影響を低減するために静電的に導か自己組織化と古典的なトップダウンの投影リソグラフィを組み合わせた新しいハイブリッドアプローチ( 図1)の研究を提示します。 Nの自己組織化単分子膜(SAM)上の正に荷電したアミン基- (2-アミノエチル)PMMAフィルムの基礎となる-11-アミノウンメトキシシラン(AATMS)現像後に公開されています。 SN-影響を受け穴25内に24 – PMMAの負に帯電したフォトレジスト膜を静電的に負に、21をクエン酸でキャップされた金ナノ粒子(のGNP)を、荷電漏斗。再フローPMMAフォトレジストの膜中に事前に堆積ナノ粒子を飲み込みます。
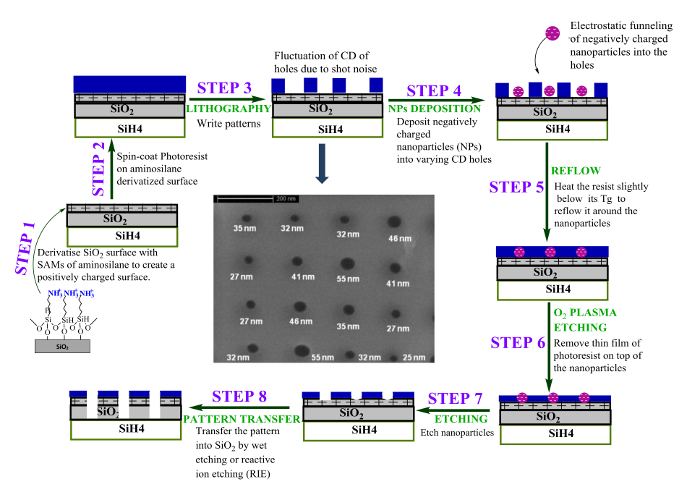
図1: 戦略の概略図は、正確なサイズのNPを用いたコンタクトホールのパターニングのためのショットノイズやラインエッジラフネスの影響を除去します。ここで、限界寸法(CD)は、孔の所望の直径です。アプローチ(ステップ1)は、酸化サーフィンに正に帯電したアミン基を有するシラン分子の自己組織化単分子膜(SAM)を堆積させることから始まりますシリコンウエハのエース。次に、Eビームリソグラフィは、パターンに穴使用される(ステップ2,3)はめ込みSEM画像に示すように、ショットノイズを発生PMMAフォトレジスト膜、青色層です。リソグラフィは、穴の底にアミン基を露出させます。ステップ4は、制御されたサイズ、静電漏斗(EF)を使用して、リソグラフィでパターン穴にクエン酸をかぶった(負に帯電した)金ナノ粒子(のGNP)の水相堆積を伴います。ステップ5において、100℃までウエハを加熱、PMMAのガラス転移温度は、110℃未満、予め堆積ナノ粒子の周囲にフォトレジストのリフローを生じさせます。エッチングが露出した粒子の酸素プラズマ(ステップ6)のGNPを公開し、その後ウェットエッチング(ヨウ素)(ステップ7)でPMMAを重ねたGNPの大きさに対応する穴を作成します。反応性イオン/ウェットエッチングを用いて結合されたとき、SiO 2(ステップ8)31にフォトレジストの穴のパターンを転写することが可能です。リ参照20からの許可を得て印刷。 この図の拡大版をご覧になるにはこちらをクリックしてください。
基板上の反対に荷電したGNPとアミン基との間の静電相互作用は、結合部位からのGNPのずれを防ぐことができます。リフロー工程は、のGNPの相対的な位置を維持するが、正孔とSN / LERの影響を消去します。プラズマ/ウェットエッチング工程は、GNPの大きさを有する穴を再生します。反応性イオンエッチングは、SiO 2ハードマスク層にそのパターンを転写します。この方法は、パターニングされたナノホール(NH)より均一なサイズのナノ粒子を使用に依存している、σ、標準偏差として表さなどGNPσ<NHσいます。このレポートでは、分散およびからのナノ粒子の堆積を伴う( 図1で説明した図4、図5)のステップに焦点を当ててこの方法の利点と限界を評価するために、彼らの周りのフォトレジストのリフロー。両方の手順は、チップ上の最新の集積回路の製造の電流の流れのない大規模な変更を必要としない、原則的に、より大きな基板にスケーラブルです。
Protocol
Representative Results
Discussion
リソグラフィにおけるショットノイズ(SN)指定されたナノ領域に到着する光子または粒子(N)の数の統計的変動の単純な結果です。それは光子/粒子数の平方根に反比例します。

Aおよびrは 、それぞれの領域と露光領域のサイズがどこにいます。パターン50 nmの孔へのArF 193-NM(6.4 eV)でエキシ…
Disclosures
The authors have nothing to disclose.
Acknowledgements
インテルコーポレーションは、認可番号414305を介して、この作業に資金を提供し、オレゴン州ナノテクノロジーとマイクロテクノロジー・イニシアティブ(ONAMI)が一致する資金を提供しました。我々は感謝して、この作業のすべての段階で博士ジェームズ・ブラックウェルのサポートやアドバイスを認めます。特別な感謝は、粒子の位置の統計情報を分析するためのドリューBeasauとチェルシーベネディクトに行きます。我々は、電子ビームリソグラフィと彼の助けのために、オレゴン州ユージーンの大学で、原稿を注意深く読むための教授ホール博士クルトLangworthyに感謝し、OR。
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

