Utilisation de sacrificielles Nanoparticules pour éliminer les effets de Shot-bruit dans les trous de contact fabriquées par E-beam Lithography
Summary
Uniformément nanoparticules de taille peuvent éliminer les fluctuations de contact avec les dimensions des trous à motifs en poly (méthacrylate de méthyle) films (PMMA) de résine photosensible par faisceau d'électrons (E-beam) lithographie. Le procédé consiste à entonnoir électrostatique centre et de dépôt des nanoparticules dans des trous de contact, suivie par photoresist refusion et étapes PLASMA et gravure humide.
Abstract
Nano-modèles fabriqués avec extrême ultraviolet (EUV) ou par faisceau d'électrons (E-beam) lithographie présentent des variations inattendues de la taille. Cette variation a été attribuée à des fluctuations statistiques du nombre de photons / électrons arrivant à une nano-région donnée résultant de tir-bruit (SN). Le SN varie inversement à la racine carrée d'un nombre de photons / électrons. Pour une dose fixe, le SN est plus importante en EUV et E-beam Lithographies que pour (193 nm) lithographie optique traditionnelle. Bottom-up et top-down patterning approches sont combinées pour minimiser les effets du bruit de grenaille dans les nano-trous patterning. Plus précisément, un amino-silane tensio-autoassemble sur une tranche de silicium qui est ensuite enduite par centrifugation avec un film de 100 nm d'un photoresist par faisceau d'électrons à base de PMMA. L'exposition à l'E-faisceau et le développement ultérieur découvrir le film tensioactif sous-jacent au fond des trous. Tremper la plaquette dans une suspension de charge négative, citrate-capped, 20 nm ganciennes nanoparticules (PNB) des dépôts d'une particule par trou. Le film exposé tensioactif chargé positivement dans le trou entonnoirs électrostatiquement la nanoparticule chargée négativement au centre d'un trou exposé, qui fixe de façon permanente le registre de position. Ensuite, par chauffage à proximité de la température de transition vitreuse du polymère de résine photosensible, le film de résine photosensible et submerge repositionne les nanoparticules. Ce processus efface les trous touchés par SN, mais laisse les PNB déposés verrouillés en place par une forte électrostatique de liaison. Le traitement par plasma d'oxygène expose les PNB par gravure d'une couche mince de la résine photosensible. Gravure humide PNB exposée avec une solution de KI I 2 / on obtient des trous uniformes situés au centre des empreintes modelées par lithographie par faisceau d' électrons. Les expériences présentées montrent que l'approche réduit la variation de la taille des trous causés par SN de 35% à moins de 10%. La méthode étend les limites de mise en forme de trous transistor de contact au-dessous de 20 nm.
Introduction
La croissance exponentielle de la puissance de calcul, telle que quantifiée par la loi de Moore 1, 2 (1), est le résultat d'avancées progressives dans la lithographie optique. Dans cette technique de mise en forme de haut en bas, la résolution réalisable, R, est donnée par le théorème Raleigh bien connu 3:

Ici, λ et NA sont la longueur d' onde de la lumière et l' ouverture numérique, respectivement. On notera que NA = η · sin, où η est l'indice de réfraction du milieu entre la lentille et la plaquette; θ = tan -1 (d / 2L) pour le diamètre d de la lentille, et la distance, L, entre le centre de la lentille et la plaquette. Au cours des cinquante dernières années, la résolution lithographique est améliorée grâce à l'utilisation de (a) source de lumières, y compris les lasers Excimer, avec progressivement plus petites longueurs d'onde UV; (b) des conceptions optiques intelligents utilisant des masques à décalage de phase 4; et (c) de plus de NA. Pour l' exposition à l' air (η = 1), NA est toujours inférieur à l' unité, mais en introduisant un liquide avec η> 1, 5 tel que l' eau, entre la lentille et la plaquette, NA peut être élevée au- dessus de 1, améliorant ainsi la résolution de la lithographie par immersion. Actuellement des chemins viables à un nœud de 20 nm et au – delà comprennent des sources UV extrêmes (λ = 13 nm) ou des techniques de mise en forme en utilisant le traitement double et quadruple complexe d'une résine photosensible multicouche 6, 7.
À l'échelle du nanomètre de longueur, les fluctuations statistiques, causées par le tir-bruit (SN), dans le nombre de photons qui arrivent dans une cause variation nano-région dans les dimensions de lithogra motifs phiques. Ces effets sont plus prononcés à l' exposition à haute énergie EUV lumière et E-poutres, les systèmes qui ont besoin d' ordres de grandeur moins photons / particules par rapport à la lithographie optique normale 8. Hypersensible chimiquement amplifié (avec un rendement quantique> 1) photoréserves introduisent également un SN chimique provoquée par une variation du nombre de molécules dans la photoréactive nanoregions exposées 9, 10. photoresists de sensibilité plus faibles qui ont besoin d'une exposition plus longue suppriment ces effets, mais ils réduisent aussi le débit.
Sur l'échelle moléculaire, la contribution à la ligne-rugosité de bord de la distribution de taille moléculaire inhérente aux polymères photosensibles peuvent être réduits en utilisant résiste moléculaire 11. Une approche qui est complémentaire à ce traitement de haut en bas de la nano-structuration est l'utilisation de méthodes ascendantes 12,s = "xref"> 13 qui reposent précisément sur l'auto-assemblage dirigé (DSA) des polymères diblocs 14. La capacité de ces procédés afin de diriger nucléation et de créer un espacement non uniforme entre les motifs souhaités, tels que des trous ou des lignes, reste difficile. La distribution de la taille des composants moléculaires 15, 16 limite également la taille et le rendement de fabrication 17, 18. Des problèmes similaires limitent l' impression par microcontact de nanoparticules dans la lithographie douce 19.
Ce document présente des études d'une nouvelle approche hybride (Figure 1) qui combine le haut vers le bas projection lithographie avec dirigé électrostatiquement auto-assemblage pour réduire l'effet de la SN / line-rugosité de bord (LER) 20. Une charge positive des groupes amine sur des monocouches auto-assemblées (SAMS) de N – (2-aminoéthyl)-11-Amino-undécyl-méthoxy-silane (AATMS) sous-jacente du film PMMA sont exposées après le développement. Le film de résine photosensible chargée négativement de PMMA électrostatiquement chargé négativement entonnoirs des nanoparticules d' or (PNB), coiffés avec du citrate, 21 – 24 dans des trous de SN-25 affecté. Refusion de la résine PMMA engloutit les nanoparticules déposé au préalable dans le film.
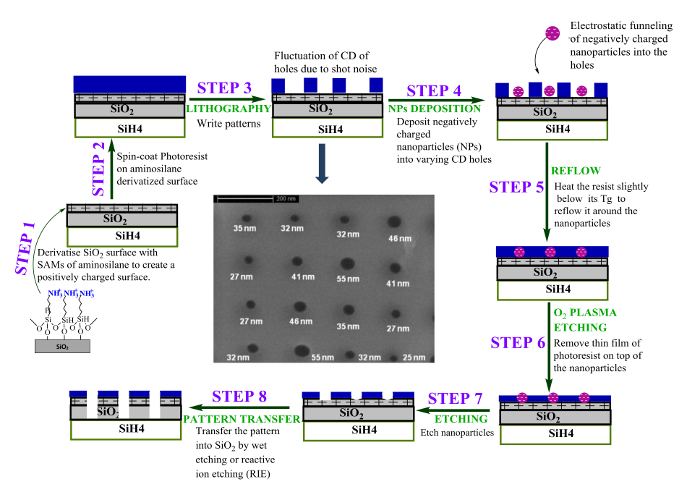
Figure 1: Représentation schématique de la stratégie visant à éliminer les effets du plan-bruit et line-rugosité de bord pour le motif de trous de contact en utilisant les IP de taille précise. Ici, la dimension critique (CD) est le diamètre désiré des trous. L'approche (étape 1) commence par le dépôt d'une monocouche auto-assemblée (SAM) de molécule de silane portant des groupes aminés chargés positivement sur les vagues d'oxydeace d'une plaquette de silicium. Ensuite, la lithographie par faisceau d'électrons est utilisé pour modèle les trous (étapes 2 et 3) dans le film de résine photosensible PMMA, la couche bleue, qui génère coup-bruit, comme illustré dans l'image en médaillon SEM. Lithography expose des groupes amine au fond des trous. Étape 4 entraîne le dépôt en phase aqueuse de taille contrôlée, (chargés négativement) des nanoparticules d'or de citrate-capped (GNPS) dans les trous lithographier utilisant entonnoir électrostatique (EF). A l'étape 5, le chauffage de la tranche à 100 ° C, en dessous de la température de transition vitreuse du PMMA, 110 ° C, provoque la refusion de la résine photosensible autour de nanoparticules déjà déposée. Gravure couvrit PMMA avec un plasma d'oxygène (étape 6) expose les PNB, et gravure humide ultérieure (iode) des particules exposées (étape 7) crée des trous correspondant à la taille du PNB. Couplé avec ionique réactive / gravure humide, il est possible de transférer le motif de trou dans la résine photosensible à SiO 2 (étape 8) 31. Réimprimé avec la permission de la référence 20. S'il vous plaît cliquer ici pour voir une version plus grande de cette figure.
L'interaction électrostatique entre les charges opposées PNB et les groupes amine sur le substrat empêche le déplacement du PNB du site de liaison. L'étape de refusion maintient la position relative du PNB, mais efface les trous et les effets de la SN / LER. étapes de gravure humide Plasma / régénèrent les trous qui ont la taille du PNB. Gravure ionique réactive transfère leur motif à SiO 2 Les couches hard-masque. La méthode repose sur l' utilisation plus uniforme des nanoparticules de taille qu'un nanotrou motif (NH), exprimée comme l'écart type, σ, de telle sorte que σ PNB <σ NH. Ce rapport se concentre sur les étapes (4 et 5 décrites dans la figure 1) impliquant le dépôt de nanoparticules de la dispersion et de larefusion de la résine autour d'eux pour évaluer les avantages et les limites de la méthode. Les deux étapes sont, en principe, extensible de substrats plus grands, ce qui nécessite aucune modification complète de l'écoulement du courant de production de circuits intégrés sur des puces modernes.
Protocol
Representative Results
Discussion
Shot-bruit (SN) en lithographie est une simple conséquence des fluctuations statistiques du nombre de photons ou particules (N) arrivant dans un nano-région donnée; elle est inversement proportionnelle à la racine carrée d'un nombre de photons / particules:

où A et R sont la surface et la taille de la zone exposée, respectivement. Par exemple, lorsqu'on utilise un…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Intel Corporation a financé ce travail par numéro de subvention 414305, et l'Initiative de nanotechnologie et de Microtechnique Oregon (ONAMI) a fourni des fonds de contrepartie. Nous reconnaissons avec gratitude le soutien et les conseils du Dr James Blackwell dans toutes les phases de ce travail. Des remerciements spéciaux vont à Drew Beasau et Chelsea Benoît pour l'analyse des statistiques de positionnement des particules. Nous remercions professeur Hall pour une lecture attentive du manuscrit et le Dr Kurt Langworthy, à l'Université de l'Oregon, Eugene, OR, pour son aide avec la lithographie par faisceau d'électrons.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

