बलि का उपयोग नैनोकणों ई-बीम लिथोग्राफी द्वारा गढ़े संपर्क छेद में शॉट-शोर के प्रभाव को दूर करने के लिए
Summary
समान आकार नैनोकणों संपर्क छेद पाली (मिथाइल methacrylate) में नमूनों आयाम (PMMA) photoresist फिल्मों इलेक्ट्रॉन बीम (ई-बीम) लिथोग्राफी द्वारा में उतार-चढ़ाव को दूर कर सकते हैं। प्रक्रिया संपर्क छेद में केंद्र और जमा नैनोकणों, photoresist reflow और प्लाज्मा और गीला नक़्क़ाशी कदम के द्वारा पीछा करने के लिए इलेक्ट्रोस्टैटिक funneling शामिल है।
Abstract
नैनो पैटर्न चरम पराबैंगनी (EUV) या इलेक्ट्रॉन बीम (ई-बीम) आकार में लिथोग्राफी प्रदर्शनी अप्रत्याशित बदलाव के साथ गढ़े। इस बदलाव फोटॉनों / इलेक्ट्रॉनों एक दिया नैनो क्षेत्र शॉट-शोर (एस एन) से उत्पन्न होने पर पहुंचने की संख्या में सांख्यिकीय उतार-चढ़ाव के लिए जिम्मेदार ठहराया गया है। एसएन फोटॉनों / इलेक्ट्रॉनों की एक संख्या का वर्गमूल के व्युत्क्रमानुपाती बदलता रहता है। एक निश्चित खुराक के लिए, एसएन पारंपरिक (193 एनएम) ऑप्टिकल लिथोग्राफी के लिए की तुलना EUV और ई-किरण lithographies में बड़ा है। नीचे से ऊपर और ऊपर से नीचे patterning दृष्टिकोण नैनो छेद patterning में गोली मार दी शोर के प्रभाव को कम करने के लिए संयुक्त रहे हैं। विशेष रूप से, एक सिलिकॉन वेफर पर एक एमिनो silane surfactant स्वयं assembles कि बाद में एक PMMA-आधारित ई-किरण photoresist की एक 100 एनएम फिल्म के साथ स्पिन लेपित है। ई-बीम और बाद के विकास के संपर्क में छेद के नीचे में अंतर्निहित surfactant फिल्म को उजागर। नकारात्मक आरोप लगाया, साइट्रेट से ढकी, 20 एनएम जी के निलंबन में वेफर की सूईवर्ष नैनोकणों (जीएनपी) जमा छेद प्रति एक कण। उजागर छेद में सकारात्मक आरोप लगाया surfactant फिल्म electrostatically एक उजागर छेद है, जो स्थायी रूप से स्थितीय रजिस्ट्री फिक्स की केंद्र के लिए नकारात्मक आरोप लगाया nanoparticle funnels। अगले, photoresist बहुलक का गिलास संक्रमण तापमान के पास गर्म करके, photoresist फिल्म reflows और नैनोकणों समाई है। इस प्रक्रिया के छेद एस.एन. से प्रभावित मिटा देता है, लेकिन मजबूत इलेक्ट्रोस्टैटिक बंधन से घर में बंद जमा GNPs छोड़ देता है। ऑक्सीजन प्लाज्मा के साथ उपचार photoresist की एक पतली परत नक़्क़ाशी द्वारा GNPs को उजागर करता है। मेरे पास 2 का एक समाधान के साथ गीले-नक़्क़ाशी उजागर GNPs / KI वर्दी ई-बीम लिथोग्राफी द्वारा नमूनों indentations के केंद्र में स्थित छेद अर्जित करता है। प्रयोगों चलता है कि दृष्टिकोण 10% से नीचे करने के लिए 35% से एसएन की वजह से छेद के आकार में भिन्नता को कम कर देता प्रस्तुत किया। विधि नीचे 20 एनएम ट्रांजिस्टर संपर्क छेद के patterning सीमा फैली हुई है।
Introduction
कम्प्यूटेशनल क्षमता में तेजी से विकास, के रूप में मूर के नियम 1, 2 (1) द्वारा मात्रा, ऑप्टिकल लिथोग्राफी में प्रगतिशील अग्रिमों का परिणाम है। यह ऊपर से नीचे patterning तकनीक, प्राप्त संकल्प, आर में, जाने-माने रॉली प्रमेय 3 द्वारा दिया जाता है:

इधर, λ और एनए प्रकाश तरंग दैर्ध्य और संख्यात्मक एपर्चर, क्रमशः रहे हैं। ध्यान दें कि एनए = η · sinθ, जहां η लेंस और वेफर के बीच माध्यम का अपवर्तनांक है; θ = तन -1 (डी / 2L) व्यास के लिए, डी, लेंस की, और दूरी, एल, लेंस और वेफर के केंद्र के बीच। पिछले पचास वर्षों में, पत्थर के छापे संकल्प (क) प्रकाश स्रोत के उपयोग के माध्यम से सुधार हुआ हैएस, excimer लेजर, उत्तरोत्तर छोटे यूवी तरंग दैर्ध्य के साथ शामिल हैं; (ख) चतुर ऑप्टिकल डिजाइन चरण पारी मास्क 4 रोजगार; और (ग) उच्च एनए। हवा (η = 1) में जोखिम के लिए, एनए हमेशा कम एकता से है, लेकिन एक तरल शुरू करने से है इस तरह के पानी के रूप में 5 η> 1,, लेंस और वेफर के बीच के साथ, एनए 1 ऊपर उठाया जा सकता है, जिससे विसर्जन लिथोग्राफी के संकल्प में सुधार। वर्तमान में एक 20 एनएम नोड के लिए व्यवहार्य रास्तों और परे चरम यूवी स्रोतों (λ = 13 एनएम) या patterning तकनीक एक बहुपरती photoresist 6, 7 के जटिल डबल और चौगुनी संसाधन का उपयोग भी शामिल है।
नैनोमीटर लंबाई तराजू, सांख्यिकीय उतार-चढ़ाव, शॉट-शोर (एस एन) की वजह से, lithogra के आयामों में एक नैनो क्षेत्र कारण परिवर्तन के भीतर पहुंचने फोटॉनों की संख्या में हैं पर phic पैटर्न। इन प्रभावों को उच्च ऊर्जा EUV प्रकाश और ई-मुस्कराते हुए, प्रणाली की जरूरत है कि परिमाण कम फोटॉनों / कणों के आदेश सामान्य ऑप्टिकल लिथोग्राफी 8 की तुलना करने के लिए जोखिम के साथ और अधिक स्पष्ट कर रहे हैं। अति सूक्ष्मग्राही रासायनिक प्रवर्धित (एक क्वांटम दक्षता के साथ> 1) photoresists भी एक रासायनिक photoreactive अणुओं की संख्या में परिवर्तन की वजह से एसएन उजागर nanoregions 9 में लागू करने, 10। कम संवेदनशीलता photoresists कि अब निवेश की जरूरत है इन प्रभावों को दबाने, लेकिन वे भी throughput कम।
आणविक स्तर पर, योगदान आणविक आकार के वितरण photoresist पॉलिमर के लिए निहित से लाइन-किनारे करने के लिए तैयार नहीं खुरदरापन आणविक 11 का उपयोग करके कम किया जा सकता है। एक दृष्टिकोण है कि नैनो की patterning यह ऊपर से नीचे प्रसंस्करण के लिए पूरक है, नीचे से ऊपर तरीकों 12 का इस्तेमाल होता हैएस = "xref"> 13 कि diblock पॉलिमर 14 का निर्देश दिया आत्म विधानसभा (डीएसए) पर विशेष रूप से निर्भर हैं। केंद्रक को निर्देशित करने के लिए और इस तरह के छेद या लाइनों के रूप में वांछित पैटर्न के बीच गैर वर्दी रिक्ति बनाने के लिए इन प्रक्रियाओं की क्षमता, चुनौती बनी हुई है। आणविक घटकों 15 के आकार के वितरण, 16 भी पैमाने पर और निर्माण 17, 18 की उपज को सीमित करता है। इसी प्रकार की समस्याओं नरम लिथोग्राफी 19 में नैनोकणों के microcontact मुद्रण की सीमा।
यह पत्र एक नई संकर दृष्टिकोण (चित्रा 1) कि electrostatically निर्देशित विधानसभा स्वयं के साथ क्लासिक ऊपर से नीचे प्रक्षेपण लिथोग्राफी जोड़ती एसएन / लाइन बढ़त खुरदरापन (LER) 20 के प्रभाव को कम करने के लिए के अध्ययन प्रस्तुत करता है। (2-aminoethyl) – सकारात्मक आत्म इकट्ठे monolayers एन की (SAMs) पर amine समूहों का आरोप लगाया-11 अमीनो undecyl-methoxy-silane (AATMS) PMMA फिल्म अंतर्निहित विकास के बाद सामने आ रहे हैं। एसएन प्रभावित छेद 25 में 24 – PMMA की नकारात्मक आरोप लगाया photoresist फिल्म electrostatically नकारात्मक, सोने के नैनोकणों (GNPs), साइट्रेट के साथ छाया आरोप लगाया funnels 21। पुनः प्रवाह PMMA photoresist की फिल्म में predeposited नैनोकणों समाई है।
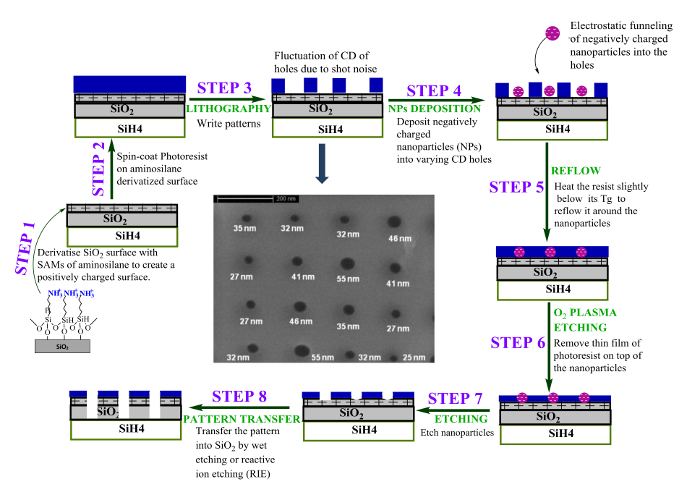
चित्रा 1: रणनीति की योजनाबद्ध प्रतिनिधित्व सटीक आकार के एनपीएस का उपयोग कर संपर्क छेद के patterning के लिए शॉट शोर और लाइन किनारे खुरदरापन के प्रभाव को दूर करने के लिए। इधर, महत्वपूर्ण आयाम (सीडी) छेद के वांछित व्यास है। दृष्टिकोण (चरण 1) silane अणु के एक आत्म इकट्ठे monolayer (एसएएम) ऑक्साइड सर्फ पर असर सकारात्मक आरोप लगाया amine समूहों जमा करने के साथ शुरू होता हैएक सिलिकॉन वेफर का इक्का। इसके बाद, ई-बीम लिथोग्राफी पैटर्न के लिए छेद प्रयोग किया जाता है (चरण 2 और 3) PMMA photoresist फिल्म, नीले रंग की परत, के रूप में इनसेट SEM छवि में सचित्र है, जो शॉट-शोर उत्पन्न करता है। लिथोग्राफी छेद के नीचे amine समूहों को उजागर करता है। चरण 4 नियंत्रित आकार, साइट्रेट से ढकी (नकारात्मक आरोप लगाया) इलेक्ट्रोस्टैटिक funneling (एफई) का उपयोग कर पत्थर के छापे से छापने से नमूनों छेद में सोने के नैनोकणों (GNPs) के जलीय चरण बयान पर जोर देता। चरण 5, 100 डिग्री सेल्सियस तक गर्म करने वेफर, PMMA, 110 डिग्री सेल्सियस के कांच संक्रमण तापमान नीचे में, चारों ओर पूर्व जमा नैनोकणों photoresist की reflow का कारण बनता है। नक़्क़ाशी उजागर कणों की ऑक्सीजन प्लाज्मा (चरण 6) GNPs को उजागर करता है, और बाद में गीला नक़्क़ाशी (आयोडीन) (चरण 7) के साथ PMMA मढ़ा GNPs के आकार के लिए इसी छेद बनाता है। जब प्रतिक्रियाशील आयन / गीला नक़्क़ाशी के साथ युग्मित, यह 2 Sio (चरण 8), 31 को photoresist में छेद पैटर्न हस्तांतरण करने के लिए संभव है। फिर सेसंदर्भ 20 से अनुमति के साथ छपी। यह आंकड़ा का एक बड़ा संस्करण देखने के लिए यहां क्लिक करें।
oppositely आरोप लगाया GNPs और सब्सट्रेट पर अमाइन समूहों के बीच बातचीत इलेक्ट्रोस्टैटिक बाध्यकारी साइट से GNPs के विस्थापन से बचाता है। reflow कदम GNPs के रिश्तेदार स्थान रखता है लेकिन छेद और एस.एन. / LER के प्रभाव को मिटा देता है। प्लाज्मा / गीला नक़्क़ाशी कदम छेद सकल घरेलू उत्पाद का आकार है कि पुनर्जन्म। रिएक्टिव आयन नक़्क़ाशी 2 Sio हार्ड मुखौटा परतों को अपने पैटर्न हस्तांतरण। विधि एक नमूनों nanohole (एनएच) की तुलना में अधिक समान आकार नैनोकणों के प्रयोग पर निर्भर करता है, मानक विचलन के रूप में व्यक्त σ, इस तरह के सकल घरेलू उत्पाद σ <राष्ट्रीय राजमार्ग σ है। इस रिपोर्ट में यह कदम (4 और 5 चित्रा 1 में वर्णित) फैलाव और से नैनोकणों के बयान को शामिल करने पर केंद्रितउनके आसपास photoresist की reflow फायदे और विधि की सीमाओं का आकलन करने के लिए। दोनों चरणों के लिए सिद्धांत रूप में कर रहे हैं, बड़े substrates के लिए स्केलेबल, चिप्स पर आधुनिक एकीकृत सर्किट के उत्पादन के वर्तमान प्रवाह का कोई व्यापक संशोधन की जरूरत पड़ेगी।
Protocol
Representative Results
Discussion
शॉट-शोर (एस एन) लिथोग्राफी में फोटॉनों या कणों (एन) के एक दिया नैनो-क्षेत्र में पहुंचने की संख्या में सांख्यिकीय उतार-चढ़ाव का एक सरल परिणाम है; यह व्युत्क्रमानुपाती फोटॉनों / कणों की एक संख्या का वर्गमू?…
Disclosures
The authors have nothing to disclose.
Acknowledgements
इंटेल कॉर्पोरेशन अनुदान संख्या 414305 के माध्यम से इस काम वित्त पोषित है, और ओरेगन नैनो और Microtechnology पहल (ONAMI) मिलान धनराशि प्रदान की। हम कृतज्ञता इस काम के सभी चरणों में समर्थन और डॉ जेम्स ब्लैकवेल की सलाह स्वीकार करते हैं। विशेष धन्यवाद कण स्थिति के आँकड़ों का विश्लेषण करने के लिए आकर्षित किया Beasau और चेल्सी बेनेडिक्ट के लिए जाना। हम पांडुलिपि और डॉ कर्ट Langworthy के एक सावधान पढ़ने के लिए प्रोफेसर हॉल धन्यवाद ओरेगन, यूजीन विश्वविद्यालय में, या, ई-बीम लिथोग्राफी के साथ उनकी मदद के लिए।
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

