Использование жертвенной наночастицами для устранения эффекта дробового шума в контактных отверстий сфабриковано E-лучевую литографию
Summary
Равномерно наночастицы размером могут удалить колебания размеров контактных отверстий узорчатых в поли (метилметакрилата) (ПММА) фоторезиста пленок электронным пучком (E-луч) литографии. Процесс включает в себя электростатический утекают к центру наночастиц и вкладами в контактные отверстия, а затем фоторезиста оплавления и плазмохимических и мокрого травления шаги.
Abstract
Нано-модели изготовлены с особой ультрафиолета (EUV) или электронно-лучевым (E-луч) литография экспоната неожиданные вариации в размерах. Это изменение было обусловлено статистическими флуктуациями числа фотонов / электронов, приходящих в данной области нано-вытекающих из дробового шума (SN). SN изменяется обратно пропорционально квадратному корню из числа фотонов / электронов. При фиксированной дозе, то SN в EUV и электронно-лучевой литографии больше, чем для традиционного (193 нм) оптической литографии. Снизу вверх и сверху вниз подходы паттерна объединены, чтобы свести к минимуму влияние дробового шума в нано-луночного кучность. В частности, амино-силана поверхностно-активное вещество самособирается на кремниевой пластине, которая впоследствии спин-покрытием с толщиной 100 нм пленкой из ПММА на основе электронно-лучевой фоторезиста. Воздействие электронного пучка и последующего развития раскрыть основную пленку поверхностно-активного вещества на дне отверстия. Погружение пластины в суспензии отрицательно заряженной, цитрат шапками, 20 нм гстарые наночастицы (ВНП) отложения одной частицы на одно отверстие. Открытую положительно заряженные пленки поверхностно-активного вещества в отверстии электростатически воронок отрицательно заряженную наночастицу к центру открытой дыры, которая постоянно фиксирует позиционную реестра. Далее, при нагревании вблизи температуры стеклования полимера фоторезиста, пленки фоторезиста перекомпоновке и поглотит наночастицы. Этот процесс стирает отверстия, пострадавших от SN, но оставляет осажденные ГНПС запертые на месте с помощью сильного электростатического связывания. Лечение с помощью кислородной плазмы подвергает ГНПС травлением тонким слоем фоторезиста. Влажное травление оголенные ГНПС раствором I 2 / KI дает равномерные отверстия , расположенные в центре углублений узорчатых по E-лучевой литографии. Эксперименты показывают, что представленный подход уменьшает изменение размеров отверстий, вызванных SN от 35% до менее 10%. Метод расширяет границы структурирование транзистора контактных отверстий до уровня ниже 20 нм.
Introduction
Экспоненциальный рост вычислительной мощности, так как количественно по закону Мура 1, 2 (1), является результатом прогрессивных достижений в области оптической литографии. В этом сверху вниз методом структуризации, достижимой разрешение, R, дается известной теоремы Raleigh 3:

Здесь λ и NA являются длина волны света и числовой апертуры соответственно. Заметим , что NA = η · sinθ, где η – показатель преломления среды между линзой и пластиной; θ = загар -1 (d / 2L) для диаметра, д, линзы, и расстояние, л, между центром линзы и пластины. За последние пятьдесят лет, литографических разрешение улучшилось за счет использования (а) источник светаs, в том числе эксимерных лазеров, с постепенно уменьшающимися длинами волн УФ; (б) умный оптических конструкций с применением фазового сдвига маски 4; и (с) выше NA. Для экспозиции в воздухе (п = 1), Н. А. всегда меньше единицы, но путем введения жидкости при п> 1, такой как вода 5, между линзой и пластиной, NA может быть поднята выше 1, тем самым улучшая разрешение иммерсионной литографии. В настоящее время жизнеспособные пути к узлу 20 нм и за его пределами , относятся экстремальные источники УФ (λ = 13 нм) или методы формирования паттерна , используя сложный двойной и четверной обработку многослойной фоторезиста 6, 7.
При нанометровых масштабах длины, статистические флуктуации, вызванные дробового шума (SN), в число фотонов, приходящих в причины изменения нано-области в размерах lithogra ФКМС узоры. Эти эффекты более выражены при воздействии EUV света высоких энергий и электронных пучков, систем , которые требуют порядка меньше фотонов / частиц по сравнению с обычной оптической литографии 8. Сверхчувствительный химически усиливается (с квантовой эффективностью> 1) фоторезистов также ввести химический SN , вызванное изменением числа молекул фотореакционноспособными в облученных нанообластях 9, 10. Более низкие фоторезистов чувствительности, которые требуют более длительных экспозиций подавить эти эффекты, но они также снижают пропускную способность.
На молекулярном уровне, вклад в линии прямой край шероховатости от распределения молекулярного размера , присущей фоторезиста полимеров может быть уменьшено с помощью молекулярных резистов 11. Подход , который является дополнением к этой сверху вниз обработка нано-структурирование является использование восходящих методов 12,s = "Xref"> 13 , которые опираются именно на направленной самосборки (АДС) из диблок полимеров 14. Способность этих процессов, чтобы направлять зародышеобразование и создавать неравномерный интервал между желаемыми узорами, например, отверстия или линии, остается сложной. Распределение по размерам молекул компонентов 15, 16 также ограничивает масштаб и выход изготовления 17, 18. Подобные проблемы ограничивают микроконтактной печати наночастиц в мягкой литографии 19.
В данной статье представлены исследования нового гибридного подхода (рисунок 1) , который сочетает в себе классическую сверху вниз проекционной литографии с электростатическим направленной самосборки , чтобы уменьшить влияние SN / линейного края шероховатости (LER) 20. Положительно заряженные аминогруппы на самоорганизующихся монослоев (Sams) из N – (2-аминоэтил)-11-Амино-ундецил-метокси-силан (AATMS), лежащий в основе пленки ПММА подвергаются после разработки. Отрицательно заряженный фоторезиста пленка ПММА электростатически воронок отрицательно заряженные наночастицы золота (ВНП), блокированы цитрат, 21 – 24 в отверстия 25 SN пострадавших. Re-поток фоторезиста ПММА поглотит predeposited наночастиц в пленке.
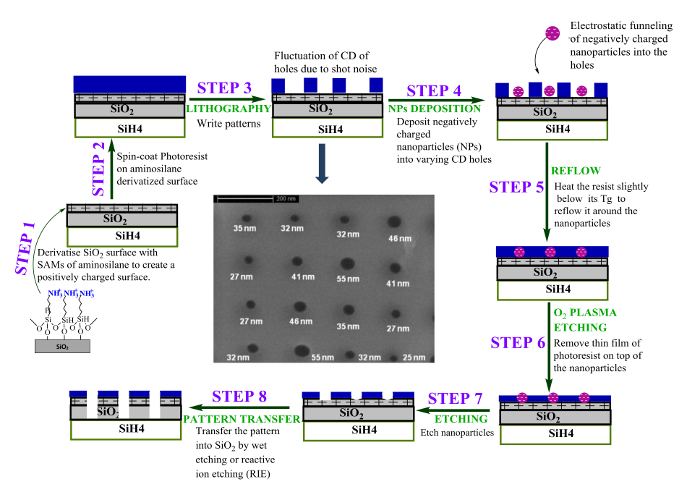
Рисунок 1: Схематическое изображение стратегии для устранения последствий дробового шума и линии края шероховатости для паттернировании контактных отверстий с использованием NPS от точного размера. Здесь, критический размер (CD) является желаемый диаметр отверстий. Подход (стадия 1) начинается с нанесения самоорганизующуюся монослой (SAM) молекулы силана, несущий положительно заряженные аминогруппы на оксиде прибоетуз кремниевой пластины. Далее, E-лучевой литографии используется для рисунка отверстий (шаги 2 и 3) в фоторезиста пленки ПММА, синего слоя, который генерирует дробового шума, как показано на вложенном SEM изображения. Литография подвергает аминогруппы в нижней части отверстий. Шаг 4 влечет за собой водную фазу осаждения контролируемого размера, цитрат шапками (отрицательно заряженных) наночастиц золота (ГНПС) в литографически узорчатые отверстия с помощью электростатического туннельный (EF). На шаге 5 нагревание пластины до 100 ° C, ниже температуры стеклования ПММА, 110 ° С, приводит к оплавления фоторезиста вокруг предварительно депонированы наночастиц. Травление накладными ПММА с кислородной плазмой (стадия 6) обнажает ГНПС и последующего мокрого травления (йод) облученных частиц (этап 7) создает отверстия, соответствующие размеру ВНП. В сочетании с реактивно-ионного / влажного травления, можно передать шаблон отверстия в фоторезиста на SiO 2 (этап 8) 31. репечатается с разрешения автора из ссылки 20. Пожалуйста , нажмите здесь , чтобы посмотреть увеличенную версию этой фигуры.
Электростатическое взаимодействие между противоположно заряженными и ВНП аминных групп на подложке предотвращает смещение ВНП из сайта связывания. Этап оплавления сохраняет относительное расположение, но стирает ВНП отверстия и эффекты SN / МПУ. Плазменные / мокрые шаги травления регенерации отверстий, которые имеют размер валового национального продукта. Реактивный-ионного травления передает их структуры на SiO 2 трудно маскирующих слоев. Метод основан на использовании более равномерно , чем наночастицы размером штриховкой нанодырки (NH), выраженное как стандартное отклонение, σ, такая , что σ ВНП <σ NH. Настоящий отчет посвящен шагам (4 и 5 , описанных на рисунке 1) с участием осаждения наночастиц из дисперсии иоплавления фоторезиста вокруг них, чтобы оценить преимущества и ограничения метода. Оба шага, в принципе, масштабируемый до больших подложек, не требующих существенной модификации текущего потока производства современных интегральных схем на чипах.
Protocol
Representative Results
Discussion
Дробового шума (SN) в литографии является простым следствием статистических флуктуаций числа фотонов или частиц (N), поступающих в данной области нано-; она обратно пропорциональна корню квадратному из числа фотонов / частиц:

Disclosures
The authors have nothing to disclose.
Acknowledgements
Корпорация Intel профинансировал эту работу через грант числа 414305 и нанотехнологиям и Микротехнология Инициатива Oregon (Онами) при условии, соответствующие средства. Мы выражаем глубокую признательность за поддержку и советы доктора Джеймса Blackwell на всех этапах этой работы. Особая благодарность Дрю Beasau и Челси Бенедикт для анализа статистики позиционирования частиц. Мы благодарим профессора Холла за внимательное прочтение рукописи и д-р Курт Лангворти, в Университете штата Орегон, Юджин, Орегон, за его помощь с электронно-лучевой литографии.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

