Användning av offerNanoPartiklar att ta bort effekterna av Shot-brus i kontakt Hål tillverkas genom elektronstrålelitografi
Summary
Enhetlig storlek nanopartiklar kan ta bort svängningar i kontakt håldimensioner mönstrade i poly (metylmetakrylat) (PMMA) fotoresistfilmer från elektronstråle (E-stråle) litografi. Processen omfattar elektro kanalisera till centrum och inlåningsnanopartiklar i kontakt hål, följt av fotoresist återflöde och plasma och våt-etsningsstegen.
Abstract
Nano mönster tillverkade med extrem ultraviolett (EUV) eller elektronstråle (E-stråle) litografi uppvisar oväntade variationer i storlek. Denna variation har tillskrivits statistiska fluktuationer i antalet fotoner / elektroner som anländer vid en given nano-regionen som härrör från skott-brus (SN). SN varierar omvänt mot kvadratroten av ett antal fotoner / elektroner. För en fast dosering, är SN större i EUV och E-beam litografier än för traditionella (193 nm) optisk litografi. Bottom-up och top-down mönstring metoder kombineras för att minimera effekterna av hagelbrus i nano-håls mönstring. Specifikt, en amino-silan ytaktiva själv monterar på en kiselskiva som därefter spinnbelades med en 100 nm film av en PMMA-baserad elektronstråle fotoresist. Exponering för elektronstråle och den efterföljande utvecklingen avslöja den underliggande ytaktiv film vid bottnarna av hålen. Doppa skivan i en suspension av negativt laddad, citrat-tak, 20 nm ggamla nanopartiklar (BNP) insättningar en partikel per hål. Den exponerade positivt laddad ytaktiv film i hålet trattar elektrostatiskt den negativt laddade nanopartikeln till centrum av en exponerad hål, som är permanent fixerar positions registret. Nästa, genom uppvärmning nära glasövergångstemperaturen för fotoresist-polymer, återflöden fotoresistfilmen och uppslukar de nanopartiklar. Denna process raderar drabbats av SN hål men lämnar de deponerade BNI låsta på plats av en stark elektrostatisk bindning. Behandling med syrgasplasma exponerar BNI genom etsning av ett tunt skikt av fotoresisten. Våt-etsa de exponerade BNI med en lösning av I2 / KI ger likformiga hål placerade i mitten av fördjupningar mönstrade vid E-strålelitografi. Experimenten presenterade visar att metoden minskar variationen i storleken på hålen som orsakas av SN från 35% till under 10%. Metoden utvidgar mönstrings gränserna för transistorn kontakthål till under 20 nm.
Introduction
Den exponentiella tillväxten i beräkningskraft, som kvantifieras av Moores lag 1, 2 (1), är ett resultat av progressiva framsteg inom optisk litografi. I detta top-down mönsterteknik, den uppnåeliga upplösningen R, ges av den välkända Raleigh sats 3:

Här, λ och NA är ljusets våglängd och numerisk öppning, respektive. Notera att NA = η · sinθ, där η är brytningsindex för mediet mellan linsen och skivan; θ = tan -1 (d / 2l) för diametern, d, hos linsen, och avståndet, L, mellan centrum av linsen och skivan. Under de senaste femtio åren har litografiska upplösning förbättras genom användning av (a) ljuskällas, inklusive excimerlasrar, med allt mindre UV-våglängder; (b) smarta optiska mönster som utnyttjar fas-skift masker 4; och (c) högre NA. För exponering i luft (η = 1), är NA alltid mindre än ett, men genom att införa en vätska med η> 1, såsom vatten 5, mellan linsen och skivan kan NA höjas över ett, vilket förbättrar upplösningen av nedsänkning litografi. För närvarande livskraftiga vägar till en 20-nm nod och utanför inkluderar extrema UV-källor (λ = 13 nm) eller mönster tekniker med komplicerade dubbel och fyrdubbla bearbetning av en flerskiktad fotoresist 6, 7.
På nanometer-längdskalor, statistiska fluktuationer, som orsakas av shot-noise (SN), i antalet fotoner anländer inom en nano-region orsaka variation i dimensionerna hos lithogra phic mönster. Dessa effekter är mer uttalad med exponering för hög energi EUV ljus och E-balkar, system som behöver storleksordningar färre fotoner / partiklar jämfört med normal optisk litografi 8. Supersensitive kemiskt amplifierade (med en kvantverkningsgrad> 1) fotoresister introducerar också en kemisk SN som orsakas av en variation i antalet fotoreaktiva molekyler i exponerade nanoregions 9, 10. Lägre känslighet fotoresister som behöver längre exponeringar trycka dessa effekter, men också minska genomströmning.
På molekylär nivå, att bidraget linje-kant strävhet från molekylstorleksfördelning inneboende fotoresisten polymererna kan minskas genom att använda molekylära resister 11. Ett tillvägagångssätt som är komplementär till denna top-down bearbetning av nano mönstring är användningen av bottom-up metoder 12,s = "xref"> 13 som förlitar sig specifikt på den riktade självorganisering (DSA) av disegmentpolymerer 14. Förmågan hos dessa processer att styra kärnbildning och för att skapa icke-likformigt mellanrum mellan önskade mönster, såsom hål eller linjer, förblir utmanande. Storleksfördelningen av molekylära komponenter 15, 16 begränsar också omfattningen och utbytet av tillverkningen 17, 18. Liknande problem begränsa mikrokontakttryckning av nanopartiklar i mjuk litografi 19.
Detta dokument visar studier av en ny hybrid strategi (Figur 1) som kombinerar den klassiska top-down projektionslitografi med elektro riktade självorganisering att minska effekten av SN / linje kant ojämnhet (LER) 20. Positivt laddade amingrupper om själv monterade monolager (SAMS) av N – (2-aminoetyl)-11-Amino-undecyl-metoxi-silan (AATMS) ligger till grund för PMMA-film exponeras efter framkallning. Den negativt laddade fotoresistfilmen av PMMA elektro trattar negativt laddade guldnanopartiklar (BNI), utjämnade med citrat, 21-24 i SN drabbade hål 25. Re-flödet av PMMA fotoresist uppslukar predeposited nanopartiklar i filmen.
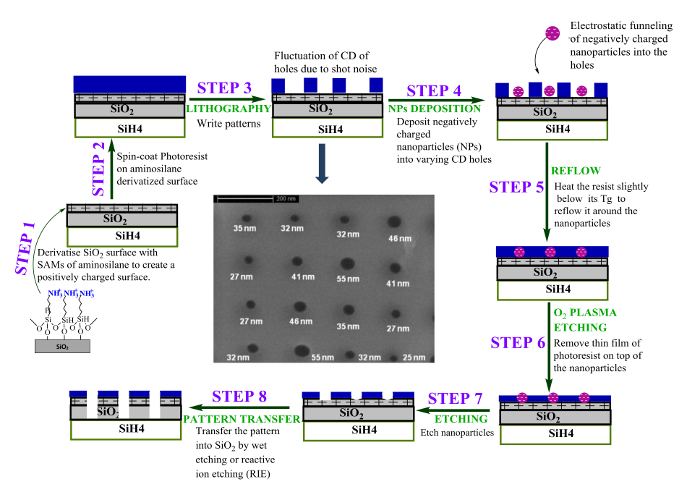
Figur 1: Schematisk bild av strategin för att undanröja verkningarna av skott-brus och linje kant ojämnhet för mönstring av kontakt hål med NP av exakt storlek. Här, är den kritiska dimensionen (CD) den önskade diametern av hålen. Det tillvägagångssätt (steg 1) börjar med avsättning av ett självmonterat monoskikt (SAM) av silanmolekylen bärande positivt laddade amingrupper på oxid surfess en kiselskiva. Därefter Elektronstrålelitografi används för att mönstra hålen (steg 2 och 3) i PMMA fotoresistfilmen, det blå skiktet, som genererar skott brus, som visas i den infällda SEM-bild. Litografi exponerar amingrupper på botten av hålen. Steg 4 innebär vattenfasen avsättningen av kontrollerad storlek, citrat-tak (negativt laddade) guldnanopartiklar (BNI) i litografiskt mönstrade hål med elektrotratt (EF). I steg 5, upphettning av rånet till 100 ° C, under glasövergångstemperaturen för PMMA, 110 ° C, orsakar återflöde av fotoresist runt deponerats i förväg nanopartiklar. Etsning överdrog PMMA med syreplasma (steg 6) exponerar BNI, och efterföljande våtetsning (jod) av de exponerade partiklarna (steg 7) skapar hål motsvarande storleken på BNI. När den kombineras med reaktiv jon / våtetsning, är det möjligt att överföra hålmönstret i fotoresisten till SiO 2 (steg 8) 31. Retryckt med tillstånd från referens 20. Klicka här för att se en större version av denna siffra.
Den elektrostatiska interaktionen mellan de motsatt laddade BNI och amingrupper på substratet förhindrar förskjutningen av BNI från bindningsstället. Reflow steg upprätthåller den relativa placeringen av BNI, men raderar hålen och effekterna av SN / LER. Plasma / våtetsning steg regenerera hål som har storleken på BNP. Reaktiv jonetsning överför deras mönster till SiO 2 hårt maskeringslager. Metoden bygger på att använda mer enhetlig storlek nanopartiklar än en mönstrad nanohole (NH), uttryckt som standardavvikelse, σ, så att σ BNP <σ NH. Denna rapport fokuserar på steg (4 och 5 som beskrivs i figur 1) som omfattar deponering av nanopartiklar från spridning ochåterflöde av fotoresisten runt dem för att bedöma fördelarna och begränsningarna hos metoden. Båda stegen är i princip skalbar till större substrat, som inte kräver någon omfattande modifikation av strömflödet för att producera moderna integrerade kretsar på chips.
Protocol
Representative Results
Discussion
Shot-brus (SN) i litografi är en enkel följd av statistiska fluktuationer i antalet fotoner eller partiklar (N) som anländer i en viss nano region; det är omvänt proportionell mot kvadratroten av ett antal fotoner / partiklar:

där A och R är området och storleken på det exponerade området, respektive. Till exempel, vid användning av en ArF 193-nm (6,4-eV) excimerlaser till m…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Intel Corporation finansierat detta arbete genom licensnummer 414.305, och Oregon Nanotechnology och mikro Initiative (ONAMI) gav motsvarande medel. Vi erkänner tacksamt stöd och råd av Dr James Blackwell i alla faser av detta arbete. Ett särskilt tack går till Drew Beasau och Chelsea Benedict för att analysera partikelpositionerings statistik. Vi tackar professor Hall för en noggrann läsning av manuskriptet och Dr. Kurt Langworthy, vid University of Oregon, Eugene, OR, för hans hjälp med elektronstrålelitografi.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

