Plasma-assistita Molecular Beam Epitaxy di N-polare InAlN-barriera transistori ad alta mobilità di elettroni
Summary
epitassia a fascio molecolare viene utilizzato per far crescere i transistor InAlN barriere ad alta elettrone-mobilità N-polari (HEMT). Controllo della preparazione di wafer, condizioni di crescita di livello e di struttura epitassiale risultati in lisce, strati InAlN compositivo omogenei e HEMT con mobilità più in alto 1.750 centimetri 2 / V ∙ sec.
Abstract
epitassia a fascio molecolare del plasma-assistita è adatto per la crescita epitassiale di III-nitruro di film sottili e eterostrutture con interfacce bruschi lisce richiesti per transistori ad alta elettrone-mobilità di alta qualità (HEMT). Una procedura è presentato per la crescita di HEMT InAlN N-polari, compresa la preparazione e la crescita di strati tampone, lo strato barriera InAlN, AlN e GaN interstrati e il canale GaN wafer. Criticità in ogni fase del processo sono identificati, ad esempio evitando l'accumulo Ga nel buffer GaN, il ruolo della temperatura sulla InAlN omogeneità compositiva, e l'uso di flusso Ga durante l'intercalare AlN e l'interruzione della crescita del canale prima GaN. Film sottili della composizione omogenea InAlN N-polare sono dimostrati con superficie di root-mean-squared rugosità a partire da 0,19 nm e InAlN basati su strutture HEMT sono riferito di aver avuto la mobilità più in alto 1.750 centimetri 2 / V ∙ sec per dispositivi con una densità di carica scheda 1,7 x 1013 cm -2.
Introduction
Epitassia a fascio molecolare (MBE) è una tecnica di crescita epitassiale versatile sottile pellicola che si avvale di un ambiente ultra-alto vuoto con pressioni di base a partire da 10 -11 Torr per garantire bassa incorporazione di impurità nel film cresciuto. Il tasso di composizione e di crescita degli strati cresciuti epitassialmente sono determinati controllando la temperatura di ogni cella di effusione, e quindi il flusso evaporato dei vari materiali di base. Nel caso di III-nitruro epitassia, il gruppo III-elementi (A, Al, Ga) sono tipicamente forniti da celle di effusione mentre l'azoto attivo (N *) flusso è fornita attraverso un N 2 plasma 1,2 (plasma RF MBE-assistita:. PAMBE o RFMBE) o ammoniaca (NH 3 -MBE) 3,4 crescita MBE è caratterizzato da temperature di crescita più basse e più tagliente repentinità interfacciale rispetto ad altre tecniche di crescita epitassiale, come la deposizione di vapore chimico metallorganica 5 è indicata una schematica. in figura 1.
<pclass = "jove_content">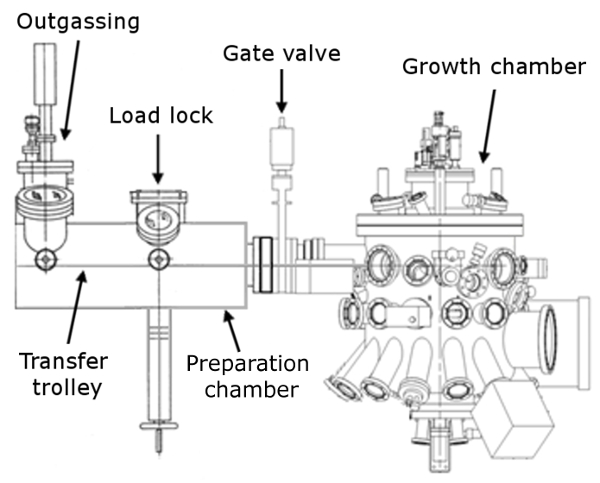
Figura 1:.. Sistema di MBE schematico schematica che mostra la camera di bloccaggio del carico, sistema di trasferimento, la stazione di degassamento e la crescita Cliccate qui per vedere una versione più grande di questa figura.
III-nitruri possono essere coltivate su substrati aventi una varietà di orientamenti cristallo. L'orientamento più comunemente usato è il Ga-polare c -Plane, che permette la formazione di un gas di elettroni bidimensionale senza doping utilizzando la differenza di polarizzazione fra lo strato di barriera, tipicamente AlGaN, e il canale GaN. Vari non polare e semi-polari orientamenti di Gan hanno ricevuto notevole attenzione per l'optoelettronica a causa di effetti di polarizzazione ridotte nelle pozzi quantici, 6,7 che rende questi orientamenti meno desiderabile anche per HEMT applications. Dispositivi orientati N-polari sono attraenti per il funzionamento HEMT alta frequenza prossima generazione a causa di diversi vantaggi intrinseci rispetto ai dispositivi Ga-polari convenzionali. 8 Lo strato di barriera nei dispositivi N-polari viene coltivato sotto il canale GaN come mostrato in figura 2, risulta in una barriera posteriore naturale che aiuta il controllo elettrostatico del canale e riduce gli effetti di canale corto, pur consentendo un più facile accesso corrente al canale di GaN e ridurre la resistenza di contatto. La barriera può anche essere controllato separatamente dal canale, in modo che lo spessore canale viene ridotta per dispositivi ad alta frequenza progettazione barriera può essere modificato per compensare la carica canale perso Fermi livello pinning effetti.
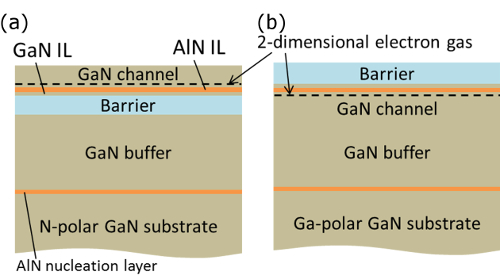
Figura 2:. Epitassiale livello schematico la struttura di strato di (a) un HEMT N-polare e (b) un HEMT Ga-polare comparIson. Clicca qui per vedere una versione più grande di questa figura.
HEMT utilizzati in alta velocità, amplificatori ad alta potenza sono normalmente coltivate su substrati di SiC per sfruttare l'elevata conducibilità termica del SiC. Filettatura dislocazione substrati a bassa densità autoportante GaN possono essere impiegati per migliorare la mobilità degli elettroni, 9 migliorando così le prestazioni ad alta frequenza. Dopo la crescita di uno strato di AlN nucleazione, un buffer GaN spessore viene coltivato per separare spazialmente le impurità all'interfaccia ricrescita dal canale HEMT e migliorare l'isolamento elettrico. A differenza di altri materiali III-V, GaN cresciuti PAMBE genere necessita condizioni di crescita con un rapporto gruppo-III / V maggiore di 1, cioè condizioni ricche di metalli, 10,11 per ottenere una morfologia superficie liscia. In x Al 1- x N è un altermateriale barriera nativo per HEMT III-nitruro, ed ha ricevuto notevole attenzione da poco, perché può essere coltivata reticolo abbinato al GaN per x ≈ 0,18 e in grado di generare oltre due volte la carica di canale relativo alle barriere AlGaN grazie alla sua elevata polarizzazione spontanea. 12-15 differenza barriere AlGaN, Ga incorporeranno preferenzialmente a in a strati InAlN, 16 cura quindi devono essere prese per assicurare la superficie sia priva di eccessi Ga dopo il Ga-ricchi crescita dello strato tampone GaN e prima la crescita InAlN.
Controllo di Ga sulla superficie può essere realizzato se fornirà un flusso Ga leggermente minore del flusso necessario per la formazione Ga-goccia. Tuttavia, questa finestra di crescita è piccolo, e insufficiente copertura della superficie Ga farà sì che la morfologia di superficie di degradare in plateau / trincea morfologia mentre Ga flusso in eccesso si tradurrà in accumulo Ga e la formazione di goccioline macroscopica. 17 Riflessione diffrazione elettronica ad alta energia (RHEED) intens lità può essere utilizzato per monitorare l'accumulo Ga e desorbimento. Riempimento di superficie Ga è indicata da una riduzione dell'intensità RHEED e ogni ritardo tra la chiusura del Ga (e N *) persiane e l'aumento iniziale di intensità RHEED indica accumulo di Ga, come mostrato in figura 3.

Figura 3: Monitoraggio copertura Ga con il segnale di intensità RHEED intensità RHEED misurata dal modello RHEED acquisite in rotazione mediante acquisizione innescata.. flusso Ga insufficiente è indicata da un immediato aumento di intensità dopo chiusura delle tapparelle (non mostrato). Saturo copertura Ga / ideale è indicato da un ritardo tra la chiusura dell'otturatore e brusco brillantatura RHEED e la copertura Ga eccesso considerato sia un ritardo iniziale di luminosità RHEED nonché un aumento di intensità più graduale conseguente ripresa piena intensità più tempo di 60 s.com / file / ftp_upload / 54775 / 54775fig3large.jpg "target =" _ blank "> Clicca qui per vedere una versione più grande di questa figura.
Il raggiungimento di alta qualità InAlN da PAMBE è complicata dalla presenza di fluttuazioni composizione laterali, con un conseguente microstruttura "nido d'ape" costituito da domini Al-ricchi circondate da confini In-rich. 18 Eliminazione della microstruttura è ottenuto utilizzando una temperatura del substrato di circa 50 ° C sopra la comparsa di In desorbimento, 15,19,20 o circa 630 ° C per InAlN N-polare. In questo regime di crescita ad alta temperatura, l'in X Al 1- composizione x N è una forte funzione di temperatura del substrato, con temperature più elevate con conseguente minore In incorporazione. Il flusso In può essere aumentata per compensare In persa per evaporazione, anche se in pratica la massima In flusso è limitato da una riduzione dell'efficienza di incorporazione all'aumentare In flux. 21 Oltre a ridurre la temperatura del substrato o aumentando la in movimento, aumentando il tasso di crescita può anche aumentare la composizione Nella causa trappola "In effetti seppellire", dove in entrata Al atomi e impedirgli di evaporazione. 21,22 Higher tassi di crescita possono essere realizzati aumentando la In e al flusso proporzionalmente. Per mantenere le condizioni di crescita N-ricca, la N * dovrebbe essere aumentata come pure, che può essere ottenuto aumentando la potenza RF al plasma, aumentando la velocità di flusso di N 2, migliorare la progettazione camera plasma, o aumentando il foro della piastra di apertura densità.
Ulteriori strati epitassiali in HEMT InAlN basati includono Gan e AlN intercalari (ILS) e un canale GaN. Un AlN IL inserito tra la barriera e il canale può aumentare μ mobilità così come foglio canale densità di carica n s. L'aumento della mobilità è attribuito alla riduzione della funzione d'onda dell'elettrone sovrapposizione con la InAlN BArrier e successiva dispersione in lega. 9 Per garantire la crescita di alta qualità del AlN IL, un eccesso di flusso Ga è fornito durante la crescita di agire come un tensioattivo. Un GaN IL può essere utilizzato tra il AlN IL e barriera per migliorare ulteriormente la mobilità riducendo carica canale. Il canale GaN può coltivare alla stessa temperatura come la barriera InAlN, permettendo la crescita continua dalla barriera se ILS e canale. mobilità migliorato è stato ottenuto interrompendo crescita dopo l'AlN IL e aumentando la temperatura di crescita prima di crescere canale GaN. In questo caso una copertura protettiva superficiale Ga deve essere mantenuto durante l'interrupt per evitare la degradazione della mobilità.
Il seguente protocollo vale in particolare per HEMT InAlN di barriere architettoniche e cresciuti su substrati GaN N-polari. Può essere esteso direttamente alla crescita su substrati C-polare 4H- o 6H-SiC, includendo un nm strato di nitruro di alluminio N-ricchi di spessore 50.
Protocol
Representative Results
Discussion
Crescita di uno strato tampone GaN alta qualità è fondamentale per ottenere elevata mobilità elettronica in qualsiasi HEMT III-nitruro. Nel caso di un N-polare InAlN HEMT, la crescita dello strato tampone è complicata dal requisito che tutti Ga essere rimosso dalla superficie prima crescita InAlN. Ci sono una varietà di tecniche per ottenere questo in aggiunta al procedimento qui descritti, come metallo modulato epitassia, 27 utilizzando condizioni di crescita sul bordo della copertura intermedia Ga e Ga…
Disclosures
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
References
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

