N極性のInAlNバリア高電子移動度トランジスタのプラズマ支援分子線エピタキシ
Summary
分子線エピタキシーは、N極性のInAlNバリア高電子移動度トランジスタ(HEMTの)を成長させるために使用されます。 1,750 cm 2の/ V∙秒という高い移動度を有する滑らかな、組成的に均質のInAlN層とのHEMTのウエハ製剤の制御、層の成長条件とエピタキシャル構造をもたらします。
Abstract
プラズマ支援分子線エピタキシーは、高品質の高電子移動度トランジスタ(HEMTの)ために必要な滑らかな、急峻界面でIII族窒化物薄膜とヘテロ構造のエピタキシャル成長に適しています。手順は、ウェハ製造と緩衝層、InAlNを障壁層はAlNとGaNの中間層とGaNチャネルの成長を含むN極性のInAlNのHEMTの成長のために提示されています。プロセスの各ステップでの重要な問題は、このようなのGa GaNバッファへの蓄積、InAlNを組成均一性に及ぼす温度の役割、とAlN中間層と前GaNチャネル成長への割り込み中のGaフラックスの使用を避けるように、識別されます。組成的均質N極性のInAlN薄膜は0.19 nmと低表面二乗平均平方根粗さで実証され、のInAlN系HEMT構造は、シート電荷密度を有するデバイスのために1,750 cm 2の/ V∙秒という高い移動度を有すると報告されています1.7×10の13センチメートル-2。
Introduction
分子線エピタキシー(MBE)が成長膜中の低不純物混入を確実にするために10 -11トルという低いベース圧力に超高真空環境を使用する多用途のエピタキシャル薄膜成長技術です。エピタキシャル成長層の組成及び成長速度は、各噴散セルの温度、および様々な原料の、従って蒸発フラックスを制御することによって決定されます。活性窒素(N *)フラックスのいずれかN 2プラズマ1,2-(RFプラズマによって設けられているIII族窒化物のエピタキシャル成長の場合には、III族元素(で、AlやGaを)は、典型的には流出セルによって提供されます-assisted MBE:PAMBEまたはRFMBE)又はアンモニア(NH 3 -MBE)-3,4- MBE成長は、より低い成長温度や、有機金属化学気相堆積のような他のエピタキシャル成長手法、よりシャープな界面急峻性によって特徴付けられる5概略図が示されています。 図1インチ
<pクラス= "jove_content">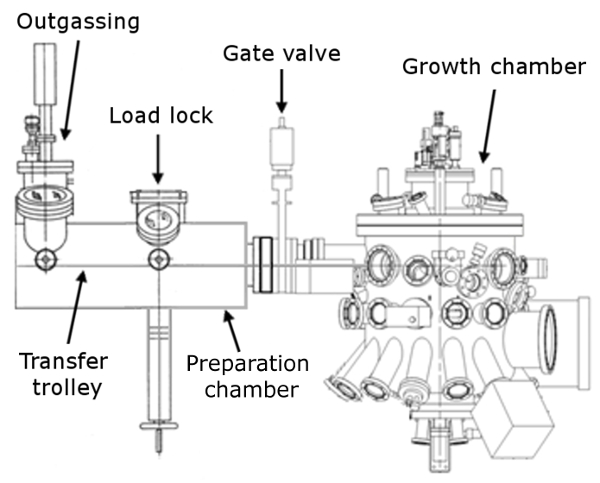
図1:MBEシステムの概略的なロードロック、搬送システム、ガス放出ステーションと成長室を模式的に示す。この図の拡大版をご覧になるにはこちらをクリックしてください。
III族窒化物結晶方位の多様を有する基板上に成長させることができます。最も一般的に使用される方向は、バリア層、典型的にはAlGaNから、及びGaNチャネル間の偏光の差を利用してドーピングすることなく、二次元電子ガスを形成することができるGa極性のC -planeあります。 GaNの非極性様々なおよび半極性の向きが原因また、HEMTのアプリケーション情報のために、これらの向きはあまり望ましくなり6,7量子井戸、で減少偏光効果にオプトエレクトロニクスのための重要な注目を集めていますナノ秒。 N極性配向デバイス起因従来のGa極性デバイスに比べていくつかの固有の利点を次世代の高周波HEMTの動作のために魅力的である。 図2に示すように8 N極デバイスでのバリア層が得られ、GaNチャネルの下に成長させますチャネルの静電制御を補助し、GaNチャネルに簡単に現在のアクセスを可能にし、接触抵抗を低減しつつ、短チャネル効果を減少させる天然の背面障壁です。チャネルの厚さが、高周波デバイス用縮小されるバリア設計はフェルミレベルピニング効果により失われたチャネル電荷を補償するように修正することができるように、バリアはまた、チャンネルとは別に制御することができます。
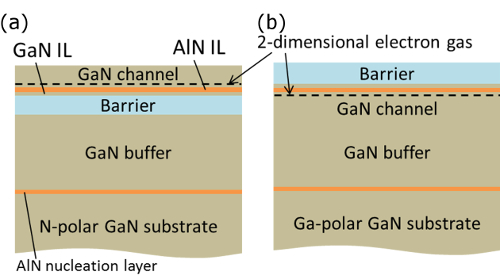
図2:比較例のための(a)は N極HEMT及び(b)は Ga極性HEMTのエピタキシャル層の概略的な層構造ISON。 この図の拡大版をご覧になるにはこちらをクリックしてください。
高速で使用したHEMTは、高電力増幅器は、通常、SiCの高い熱伝導性を利用するためにSiC基板上に成長させます。低貫通転位密度のGaN自立基板9従って、高周波性能を向上させる、電子移動度を向上させるために使用することができます。 AlN核生成層の成長に続いて、厚いGaNバッファは、空間的にHEMTのチャネルから再成長界面の不純物を分離し、電気的分離を改善するために成長させます。他のIII-V材料とは異なり、PAMBEによって成長させたGaNは、典型的には、平滑な表面形態を達成するために、1よりも大きなグループIII / V比、 即ち 、金属リッチな条件、10,11と成長条件を必要とします。 xはアル1- X Nは、ALTERですネイティブバリアIII族窒化物HEMTのための材料、およびそれが格子は、x≈0.18のためのGaNに整合し、その高い自発分極によるのAlGaN障壁に2倍以上のチャネル電荷の相対を生成することができます成長させることができるため、最近大きな注目を受けている。12月15日とは異なり、 AlGaN障壁は、Gaが16は、このように表面がGaリッチGaNバッファ層の成長前のInAlNの成長の後に過剰のGaの自由であることを確認するために注意しなければなりません、のInAlN層にInに優先的に組み込む予定。
表面上のGaの制御は、Gaを液滴形成のために必要な磁束よりもわずかに小さいGaフラックスを補給することによって達成することができます。しかし、この成長窓が小さく、不十分なGaの表面被覆率は、過剰のGaフラックスはジョージア蓄積および巨視的な液滴の形成をもたらすであろうしながら表面モフォロジーがプラトー/トレンチ形態に低下します。17、反射高エネルギー電子回折(RHEED)INTENS性は、Gaの蓄積および脱着を監視するために使用することができます。 GAの表面被覆率は、RHEED強度の減少、及びGaを閉じるとの間の遅れによって示され(かつN *)シャッターおよび図3に示すようにRHEED強度の最初の増加は、GAの蓄積を示しています。

図3:トリガ取込みを用いて回転下で取得されRHEEDパターンから測定したRHEED強度 RHEED強度信号とGaのカバレッジを監視します 。不十分Gaフラックスはシャッター(図示せず)を閉じた後に強度の即時の増加によって示されます。飽和/理想的なGaのカバレッジがシャッターの閉鎖と突然のRHEED増白と初期のRHEED光沢の遅れだけでなく、より長い60秒を取って最大強度の回復が得られ、より緩やかな強度増加の両方として見に過剰のGaカバレッジ間の遅延によって示されています。コム/ファイル/ ftp_upload / 54775 / 54775fig3large.jpg "ターゲット=" _空白 ">この図の拡大版をご覧になるにはこちらをクリックしてください。
PAMBEによってInAlNを実現高品質で豊富な境界によって囲まれたAlリッチドメインからなる「ハニカム」微細構造が得られ、横組成変動の存在によって複雑になる。この微細構造の18除去は、約50の基板温度を使用することによって達成されますN極性のInAlNのために脱着の発症、15,19,20または約630℃以上のC°。この高温成長レジームでは、中のXのAl 1-×N個の組成物は、取り込みに低い結果として、より高い温度で、基板温度の強い関数です。フラックスは、実際には、磁束の最大フラックスが増加して取り込み効率の低下によって制限されるが、蒸発によって失わに補償するために増加させることができます基板温度を低下させるか、フラックスの増加、成長速度も起因」効果を埋め込むには、「にIn組成を増加させることができる増大に加えて21、着信Al原子トラップ内と蒸発を防ぐ。21,22高いです成長率は比例で及びAlフラックスを増加させることによって達成することができます。 Nリッチ成長条件を維持するために、N *は、N 2の流量を増加させるプラズマチャンバの設計を改善する、または開口プレート穴を増やす、RFプラズマ電力を増加させることによって達成することができるだけでなく大きくする必要があります密度。
InAlNベースのHEMTで追加のエピタキシャル層は、GaNとAlN中間層(ILS)とGaNチャネルが含まれます。バリアとチャネルとの間に挿入されたAlN ILは、移動度μだけでなく、チャネルシート電荷密度のn 秒を増やすことができます 。移動度の増加は、InAlNをBの電子波動関数の重なりを低減することに起因しますarrierとその後の合金散乱。9のAlN ILの高品質な成長を確保するためには、Gaフラックスの過剰な界面活性剤として機能するように成長中に供給されています。 GaN系ILは、チャネル電荷を低減しつつ、さらに移動度を向上させるためのAlN ILとバリアの間で使用することができます。 GaNチャネルは、イオン液体と、チャネルしかしバリアの継続的な成長を可能にするのInAlNバリアと同じ温度で成長させることができます。改善された移動度は、AlN IL後に成長を中断し、GaNチャネルを成長する前に成長温度を増加させることにより得られました。この場合、保護のGa表面被覆率は、移動度の低下を防ぐために、割り込みの間、維持されなければなりません。
以下のプロトコルは、N極性GaN基板上に成長させたのInAlNバリアのHEMTに特異的に適用されます。これは、直接に50nm厚NリッチAlN層を含むことにより、C-極性4H-または6H-SiCの基板上での成長に拡張することができます。
Protocol
Representative Results
Discussion
高品質のGaNバッファ層の成長は、任意のIII族窒化物HEMTに高い電子移動度を達成するために重要です。 N極性のInAlN HEMTの場合には、バッファ層の成長は、全てのGa前のInAlNの成長表面から除去することが必要条件によって複雑になります。金属変調エピタキシー、27は中間のGaカバレッジとGa液滴蓄積レジーム、28の縁部に成長条件を使用して、または連続的なN *を可能に…
Disclosures
The authors have nothing to disclose.
Acknowledgements
The authors thank Mr. Neil Green for assistance with sample preparation. This work was supported by the Office of Naval Research under funding from Dr. P. Maki. MTH was supported by a National Research Council Postdoctoral Fellowship.
Materials
| Freestanding N-polar GaN wafer | Kyma | 10 mm x 10 mm | |
| C-polar SiC wafer | Cree | W4TRE0R-L600 | 3 inch diameter |
| Microelectronics grade acetone | Fischer Scientific | A18-4 | |
| Microelectronics grade isoproponal | J.T. Baker | 9079-05/JT9079-5 | |
| Al source material (6N5 pure) | UMC | ALR62060I | |
| Ga source material (7N pure) | UMC | GA701 | |
| In source material (7N pure) | UMC | IN750 | |
| ULSI N2 source gas (6N pure) | Matheson Tri-gas | G2659906D | |
| PRO-75 MBE system | OmicronScientia |
References
- Hughes, W. C., et al. Molecular beam epitaxy growth and properties of GaN films on GaN/SiC substrates. J. Vac. Sci. Technol., B. 13 (4), 1571-1577 (1995).
- McSkimming, B. M., Wu, F., Huault, T., Chaix, C., Speck, J. S. Plasma assisted molecular beam epitaxy of GaN with growth rates 2.6 µm/hr. J. Cryst. Growth. 386, 168-174 (2014).
- Grandjean, N., Massies, J., Leroux, M. Nitridation of sapphire. Effect on the optical properties of GaN epitaxial overlayers. Appl. Phys. Lett. 69 (14), 2071-2073 (1996).
- Corrion, A. L., Wu, F., Speck, J. S. Growth regimes during homoepitaxial growth of GaN by ammonia molecular beam epitaxy. J. Appl. Phys. 112 (5), 054903 (2012).
- Mazumder, B., et al. Atom probe analysis of AlN interlayers in AlGaN/AlN/GaN heterostructures. Appl. Phys. Lett. 102 (11), 111603 (2013).
- Feezell, D. F., Speck, J. S., DenBaars, S. P., Nakamura, S. Semipolar (2021) InGaN/GaN Light-Emitting Diodes for High-Efficiency Solid State Lighting. J. Disp. Technol. 9 (4), (2013).
- Hardy, M. T., et al. True Green Semipolar InGaN-Based Laser Diodes Beyond Critical Thickness Limits Using Limited Area Epitaxy. J. Appl. Phys. 114 (18), 183101 (2013).
- Wong, M. H., et al. N-polar GaN epitaxy and high electron mobility transistors. Semicond. Sci. Technol. 28 (7), 074009 (2013).
- Hardy, M. T., et al. Charge control in N-polar InAlN high-electron-mobility transistors grown by plasma-assisted molecular beam epitaxy. J. Vac. Sci. Technol., B. 33 (6), 061207 (2015).
- Piquette, E. C., Bridger, P. M., Beach, R. A., McGill, T. C. Effect of Buffer Layer and III/V Ratio on the Surface Morphology of GaN Grown by MBE. Symposium G ‘-‘ GaN and Related Alloys. , (1998).
- Tarsa, E. J., et al. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy. J. Appl. Phys. 82 (11), 5472-5479 (1997).
- Kuzmik, J. Power electronics on InAlN/(In)GaN: Prospect for a record performance. IEEE Electron Device Lett. 22 (11), 510-512 (2001).
- Fernández-Garrido, S., Gačević, &. #. 3. 8. 1. ;., Calleja, E. A comprehensive diagram to grow InAlN alloys by plasma-assisted molecular beam epitaxy. Appl. Phys. Lett. 93 (19), 191907 (2008).
- Katzer, D. S., et al. Molecular beam epitaxy of InAlN∕GaN heterostructures for high electron mobility transistors. J. Vac. Sci. Technol., B. 23 (3), 1204-1208 (2005).
- Kaun, S. W., et al. GaN-based high-electron-mobility transistor structures with homogeneous lattice-matched InAlN barriers grown by plasma-assisted molecular beam epitaxy. Semicond. Sci. Technol. 29 (4), 045011 (2014).
- Hoke, W. E., Torabi, A., Mosca, J. J., Kennedy, T. D. Thermodynamic analysis of cation incorporation during molecular beam epitaxy of nitride films using metal-rich growth conditions. J. Vac. Sci. Technol., B. 25 (3), 978-982 (2007).
- Koblmüller, G., Reurings, F., Tuomisto, F., Speck, J. S. Influence of Ga/N ratio on morphology, vacancies, and electrical transport in GaN grown by molecular beam epitaxy at high temperature. Appl. Phys. Lett. 97 (19), 191915 (2010).
- Zhou, L., Smith, D. J., McCartney, M. R., Katzer, D. S., Storm, D. F. Observation of vertical honeycomb structure in InAlN∕GaN heterostructures due to lateral phase separation. Appl. Phys. Lett. 90 (8), 081917 (2007).
- Ahmadi, E., et al. Elimination of columnar microstructure in N-face InAlN, lattice-matched to GaN, grown by plasma-assisted molecular beam epitaxy in the N-rich regime. Appl. Phys. Lett. 104 (7), 072107 (2014).
- Hardy, M. T., et al. Morphological and microstructural stability of N-polar InAlN thin films grown on free-standing GaN substrates by molecular beam epitaxy. J. Vac. Sci. Technol., A. 34 (2), 021512 (2016).
- Hardy, M. T., et al. Indium incorporation dynamics in N-polar InAlN thin films grown by plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 245, (2015).
- Leszczynski, M., et al. Indium incorporation into InGaN and InAlN layers grown by metalorganic vapor phase epitaxy. J. Cryst. Growth. 318 (1), 496-499 (2011).
- Storm, D. F., et al. Ultrathin-barrier AlN/GaN heterostructures grown by rf plasma-assisted molecular beam epitaxy on freestanding GaN substrates. J. Cryst. Growth. 380, 14-17 (2013).
- Storm, D. F., Katzer, D. S., Meyer, D. J., Binari, S. C. Oxygen incorporation in homoepitaxial N-polar GaN grown by radio frequency-plasma assisted molecular beam epitaxy: Mitigation and modeling. J. Appl. Phys. 112 (1), 013507 (2012).
- Storm, D. F., et al. Effect of interfacial oxygen on the microstructure of MBE-grown homoepitaxial N-polar. J. Cryst. Growth. 409, 14 (2014).
- Meyer, D. J., et al. High Electron Velocity Submicrometer AlN/GaN MOS-HEMTs on Freestanding GaN Substrates. IEEE Electron Device Lett. 34, 199 (2013).
- Moseley, M., Billingsley, D., Henderson, W., Trybus, E., Doolittle, W. A. Transient atomic behavior and surface kinetics of GaN. J. Appl. Phys. 106 (1), 014905 (2009).
- Koblmüller, G., et al. Ga Adlayer Governed Surface Defect Evolution of (0001)GaN Films Grown by Plasma-Assisted Molecular Beam Epitaxy. Jpn. J. Appl. Phys. 44 (28), L906-L908 (2005).
- Poblenz, C., Waltereit, P., Speck, J. S. Uniformity and control of surface morphology during growth of GaN by molecular beam epitaxy. J. Vac. Sci. Technol., B. 23 (4), 1379-1385 (2005).

