Atomair traceerbaar Nanostructuur Fabrication
Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
Nanotechnologie belangrijker in diverse arena, het begrijpen van de structuur gevormd steeds belangrijker, met name in gebieden van lithografie en elektronica. Om het belang te benadrukken van metrologie op nanoschaal, specifiek op schalen onder de 10 nm, dient te worden opgemerkt dat een variatie in functie grootte van slechts 1 nm wijst op een fractionele variatie ten minste 10%. Deze variatie kan aanzienlijke gevolgen hebben voor de prestaties van het apparaat en het materiaal karakter 1,2 hebben -. 4 Gebruik synthetische methoden, kan heel precies gevormd individuele kenmerken, zoals quantum dots of andere complexe moleculen worden vervaardigd, 2,5,6 maar meestal ontbreekt dezelfde nauwkeurigheid in functie plaatsing en oriëntatie, ondanks het werk dat naar het verbeteren van de grootte en plaatsing controle. Dit document toont een benadering voor het vervaardigen van nanostructuren met vrijwel atoomgrootte precisie en Atoom in functie plaatsing enmet atomaire metrologie in functie plaatsing. De atomaire precisie van Scanning Tunneling Microscope (STM) geïnduceerde waterstof Depassivation Lithography (HDL) zijn atomair precieze patronen met chemisch gevoelige contrast gevormd op een oppervlak. Selectieve Atomic Layer Deposition (ALD) zijn dan een harde oxidemateriaal in de gevormde gebieden met Reactive Ion Etching (RIE) uiteindelijk het overbrengen van het patroon in het bulkmateriaal, zoals schematisch getoond in figuur 1. De combinatie van de zeer precieze HDL werkwijze de norm ALD en RIE processen resulteert in een flexibele manier om nanostructuren te produceren op een oppervlak met willekeurige vorm en positionering.
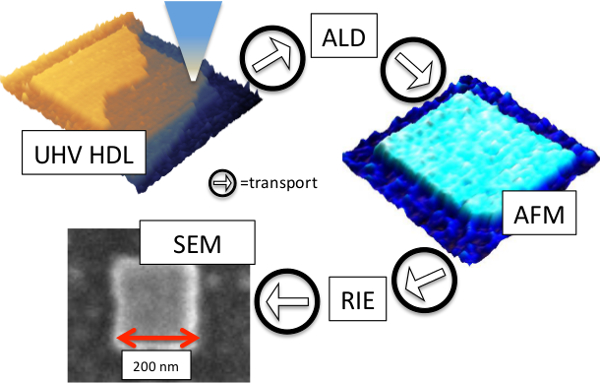
Figuur 1. Primaire Nanofabrication processtappen. Als voorbeeld, 200 nm x 200 nm vierkant weergegeven. Elke omcirkelde pijl markeert een stap van weersinvloeden en tERVOER tussen sites. Na UHV sample prep, wordt het monster patroon met UHV HDL gevolgd door STM metrologie (linksboven). ALD wordt vervolgens uitgevoerd, gevolgd door AFM metrologie (rechts). RIE draagt de patronen in de Si (100), gevolgd door de SEM metrologie (linksonder). Klik hier om een grotere versie van deze figuur te bekijken.
De meest nauwkeurige lithografie actuele omvat gewoonlijk gescande probetechnieken specifiek STM-gebaseerde patronen waarbij atomaire resolutie patroon en functionalisering is aangetoond voor vele toepassingen. 7 Eerder heeft atom manipulatie geproduceerd nanostructuren met ongekende nauwkeurigheid door individuele atomen als bouwstenen, 8 , 9,10 maar de vereiste cryogene omstandigheden en dus nanostructuren ontbrak lange termijn robuustheid. RT atoom manipulatie door verwijdering van waterstofatomen van het oppervlak is getoond, specifically HDL. 11,12,13 HDL belooft nieuwe klassen van elektronische en andere componenten op basis ruimtelijke lokalisatie van contrast oppervlak mogelijk. Met HDL ongewijzigde verschillende architecturen apparaat mogelijk inclusief bungelende binding draden of logische bouwstenen. 14,15,16 Naast het leveren van elektrische contrast, HDL kan chemische contrast op het oppervlak waar de passiverende laag H is verwijderd voeren, inderdaad een sjabloon voor verdere chemische modificatie. Deze chemische modificatie is aangetoond op silicium en andere oppervlakken, met selectiviteit voor depositie van metalen, isolatoren 17, 18 en zelfs halfgeleiders. 16,19 Elk van deze voorbeelden produceert twee dimensionale structuren, zodat andere verwerkingsstappen worden gebruikt om waar zij drie dimensionale structuren met de atomair opgelost controle beloofd door HDL. Eerder heeft dit vereiste herhaalde patronen, 19,20,21 gloeien, 22 </sup> of minder goed opgelost processen zoals tip-gebaseerde e-beam geïnduceerde depositie. 23
Vergelijkbaar met elektronenbundel lithografie, HDL gebruikt een gelokaliseerde stroom van elektronen bloot een resist. Verschillende gelijkenissen bestaan, zoals het vermogen om multi-mode lithografie voeren met variabele spotgrootte en patroonvorming efficiency. 24 De ware kracht van HDL voort uit hoe het verschilt van e-beam lithografie. Ten eerste, de resist in HDL is een monolaag van atomaire waterstof zodat weerstaan blootstelling wordt een digitaal proces; de resist atoom of wel of niet aanwezig is. 25 Aangezien het H-atoom plaatsing overeenkomt met de onderliggende Si (100) rooster HDL proces kan een atomair nauwkeurig proces, hoewel moet worden opgemerkt dat in dit document het HDL heeft nanometer precisie in tegenstelling tot het hebben van atomaire perfectie en is dus niet digitaal in dit geval. Aangezien de elektronenbron HDL zich lokaal op het oppervlak de verschillende wijzen van STM te vergemakkelijken beidenthroughput optimalisatie evenals foutcontrole. Bij tip-sample vooroordelen hieronder ~ 4,5 V, kan lithografie worden uitgevoerd op het enkel atoom niveau met atomaire precisie, bekend als atomair Precise mode (AP-modus). In tegenstelling, op vooroordelen boven ~ 7 V, elektronen worden rechtstreeks uitgezonden vanuit de tip om het monster met brede lijnbreedten en hoge depassivation efficiëntie, hier bekend als Field Emission mode (FE-modus). HDL doorvoersnelheden kan vervolgens worden geoptimaliseerd door zorgvuldige combinatie van beide modes, hoewel de totale doorvoersnelheid klein blijven ten opzichte van e-beam lithografie met patroonvorming tot 1 um 2 / minuut mogelijk. Wanneer de voorspanning is omgekeerd, zodat het monster wordt bij ~ -2,25 V, elektronen tunnel van het monster naar de punt met extreem lage depassivation efficiency, waardoor aldus inspectie van de atomaire structuur van het oppervlak zowel voor foutcorrectie en atomaire schaal metrologie .
Dit nanostructuur fabricageproces figuur 1 </strong> begint met een UHV-HDL stap, zoals hierboven beschreven. Na HDL wordt het monster afblazen, waarna de gevormde gebieden wordt verzadigd met water, vormen van een dunne (bijvoorbeeld ~ 1 monolaag) SiO 2 lagen. 26 Na het transport, het monster in een ALD kamer voor depositie van ingevoegd titaniumoxide (TiO 2), met een dikte ongeveer 2-3 nm here gedeponeerd, zoals gemeten met AFM en XPS. 27 Aangezien de titania reactie hangt af van een water verzadiging van het oppervlak, dit proces kan ondanks atmosfeer belichting waarbij het oppervlak verzadigd met water . Vervolgens de ALD maskerpatroon overbrengen in de bulk van het monster werd geëtst met behulp RIE zodat 20 nm Si wordt verwijderd, met de etsdiepte bepaald door AFM en SEM. Om metrologie stappen vergemakkelijken wordt een Si (100) wafer patroon met een rooster van lijnen die zijn ontworpen zichtbaar na UHV bereiding door een lange werkafstand optische microscoop, AFM bovenaanzicht optische beeldvorming enlage vergroting bovenaanzicht SEM beeldvorming. Om u te helpen identificeren van de nanoschaal structuren, zijn 1 micrometer 2 serpentine patronen (SERP) patroon op de monsters met de meest geïsoleerde nanopatronen zich op vaste locaties ten opzichte van de SERPs.
Deze combinatie van HDL, selectieve ALD en RIE kan een belangrijk proces voor nanostructuur vervaardiging, en omvat een atomaire schaal metrologie als een natuurlijk bijproduct van het proces. Hieronder wij een gedetailleerde beschrijving van de stappen die tot sub-10 nm nanostructuren fabriceren Si (100) via HDL, selectieve ALD en RIE. Aangenomen wordt dat men bedreven in elk van deze processen, maar informatie zal worden opgenomen in verband met hoe de verschillende processen. Bijzondere aandacht zal worden gegeven aan die onverwachte moeilijkheden ervaren door de auteurs om dezelfde moeilijkheden te voorkomen, in het bijzonder met betrekking tot vervoer en metrologie.
Protocol
Representative Results
Discussion
Het uitvoeren metrologie van de hierboven beschreven nanostructuren vereist het vermogen om de tip positionering tijdens HDL en patroonlocatie op andere instrumenten zoals AFM en SEM overbruggen. In tegenstelling tot andere goed ontwikkelde patroon gereedschappen met hoge resolutie voor positiecodering zoals elektronenbundel lithografie, de HDL hier uitgevoerd werd met een STM niet goed onder controle grove positionering, zodat extra positie identificatieprotocollen werden gebruikt, zoals getoond in figuur 3</st…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Dit werk werd ondersteund door een contract van DARPA (N66001-08-C-2040) en door een subsidie van de Emerging Technology Fund van de staat Texas. De auteurs willen graag Jiyoung Kim, Greg Mordi, Angela Azcatl en Tom Scharf erkennen voor hun bijdragen in verband met selectieve atomic layer deposition, evenals Wallace Martin en Gordon Pollock voor ex-situ monster verwerking.
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

