La fabricación de nanoestructuras Atómicamente trazable
Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
Como la nanotecnología se vuelve más importante en una amplia variedad de escenarios, la comprensión de las estructuras que se está formando gana importancia, sobre todo en los campos de la litografía y la electrónica. Para enfatizar la importancia de la metrología a escala nanométrica, específicamente a escalas inferiores a 10 nm, cabe señalar que una variación en el tamaño de la característica de sólo el 1 nm indica una variación fraccional al menos 10%. Esta variación puede tener implicaciones importantes para el rendimiento del dispositivo y el carácter material de 1,2 -. 4 Utilizando métodos de síntesis, las características individuales de manera muy precisa formados como puntos cuánticos u otras moléculas complejas pueden ser fabricados, 2,5,6 pero por lo general carecen de la misma precisión en la colocación de características y orientación, a pesar del trabajo para mejorar el tamaño y la colocación de control. Este trabajo demuestra un enfoque para la fabricación de nanoestructuras con cerca de precisión tamaño atómico y la precisión en la colocación atómica característica, así comocon la metrología atómica en la colocación función. Uso de la precisión atómica de Scanning Tunneling Microscope (STM) de hidrógeno inducida Despasivación Litografía (HDL), los patrones atómicamente precisos con contraste químicamente sensibles se forman sobre una superficie. La deposición de capa atómica selectivo (ALD), entonces se aplica un material de óxido duro en las áreas estampadas, con Reactive Ion Etching (RIE) en última instancia, la transferencia de los patrones en el material a granel, como se muestra esquemáticamente en la Figura 1. Combinando el proceso de HDL de alta precisión con la norma ALD y RIE procesa los resultados en un método flexible para producir nanoestructuras sobre una superficie con forma arbitraria y posicionamiento.
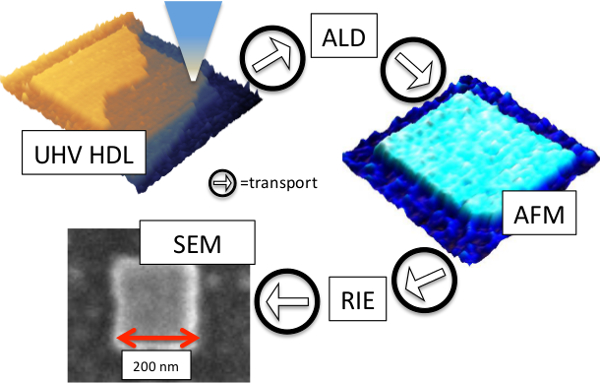
Figura 1. nanofabricación Primaria pasos del proceso. Como un ejemplo, un cuadrado x 200 nm 200 nm se muestra. Cada flecha círculo indica un paso de exposición atmosférica y tRANSPORTE entre sitios. Después de UHV preparación de muestras, la muestra se modela usando UHV HDL seguido de STM metrología (arriba a la izquierda). ALD se realiza a continuación, seguido por AFM metrología (derecha). RIE transfiere los patrones en Si (100), seguido por SEM metrología (abajo a la izquierda). Por favor, haga clic aquí para ver una versión más grande de esta figura.
La litografía más precisa hasta la fecha por lo general implica técnicas de sonda escaneadas, patrones específicamente basada en STM donde resolución atómica patrón y funcionalización se ha demostrado para muchas aplicaciones. 7 nanoestructuras Anteriormente, manipulación átomo ha producido con la máxima precisión mediante el uso de átomos individuales como bloques de construcción, 8 , 9,10 pero las nanoestructuras necesarias condiciones criogénicas y por lo tanto carecían de largo plazo robustez. Manipulación átomo de RT por eliminación de átomos de hidrógeno de la superficie se ha demostrado, specificalLy HDL. 11,12,13 HDL promete permitir nuevas clases de dispositivos electrónicos y otras basadas en la localización espacial de contraste superficie. Uso de HDL sin más procesamiento, varias arquitecturas de dispositivos son posibles incluyendo colgando cables de bonos o dispositivos lógicos. 14,15,16 Además de proporcionar contraste eléctrica, HDL puede introducir contraste químico en la superficie donde se ha eliminado la capa de pasivación H, en efecto crear una plantilla para su posterior modificación química. Esta modificación química ha sido demostrada en el silicio y otras superficies, mostrando selectividad por la deposición de metales, 17 aisladores, 18 y semiconductores incluso. 16,19 Cada uno de estos ejemplos produce dos estructuras tridimensionales, por lo que otras etapas de procesamiento debe ser utilizado para producir verdadera tres estructuras tridimensionales con el control resuelto atómicamente prometido por HDL. Anteriormente, esto ha requerido patrón repetido, 19,20,21 recocido, 22 </sup> o menos bien resuelto procesos como el haz de electrones a base de punta deposición inducida. 23
Similar a la litografía por haz de electrones, HDL utiliza un flujo de electrones localizados para exponer una resisten. Existen varias similitudes tales como la capacidad para realizar multi-modo de litografía con tamaño de punto variable y eficiencia patrones. 24 Sin embargo, el verdadero poder de HDL surge de qué se diferencia de la litografía por haz de electrones. En primer lugar, el resistir en HDL es una monocapa de hidrógeno atómico de modo que resisten la exposición se convierte en un proceso digital; el átomo de resistir que se aplica o no está presente. 25 Desde la colocación átomo de H corresponde a la de Si subyacente (100) celosía proceso HDL puede ser un proceso atómicamente precisa, aunque debe tenerse en cuenta que en este trabajo el HDL tiene una precisión nanométrica como en lugar de tener la perfección atómico y por lo tanto no es digital en este caso. Desde la fuente de electrones en HDL es local a la superficie, los diversos modos de funcionamiento STM facilitar tantooptimización de rendimiento, así como la comprobación de errores. En sesgos punta de la muestra por debajo de ~ 4,5 V, la litografía se puede realizar en el nivel átomo individual con precisión atómica, conocido como modo preciso (modo AP) Atómicamente. Por el contrario, en los prejuicios anteriores ~ 7 V, los electrones son emitidos directamente desde la punta hasta la muestra con anchuras de línea de ancho y altas eficiencias de despasivación, conocidos aquí como el modo de emisión de campo (modo FE). Caudales de HDL pueden entonces ser optimizadas por cuidadosa combinación de estos dos modos, a pesar de los caudales globales siguen siendo pequeño en relación a e-beam litografía con modelar hasta 1 m 2 / minuto posible. Cuando el sesgo se invierte de modo que la muestra se mantiene a ~ -2.25 V, los electrones túnel desde la muestra a la punta con muy baja eficiencia despasivación, permitiendo de este modo la inspección de la estructura atómica de la superficie tanto para la corrección de errores y para la metrología escala atómica .
Este proceso de fabricación nanoestructura muestra en la Figura 1 </strong> comienza con un paso UHV-HDL, como se describe anteriormente. Después de HDL, la muestra se ventila a la atmósfera, en cuyo momento las áreas estampadas se saturan con agua, formando una delgada (es decir, ~ 1 monocapa) SiO 2 capa. 26 Después del transporte, la muestra se introduce en una cámara de ALD para la deposición de titania (TiO 2), con espesores de alrededor de 2-3 nm deposita aquí, medida por AFM y. XPS 27 Puesto que la reacción de óxido de titanio depende de una saturación de agua de la superficie, este proceso es posible a pesar de la exposición atmósfera que satura la superficie con agua . A continuación, para transferir el patrón de máscara ALD en la masa de la muestra fue grabado usando RIE de modo que se elimina 20 nm de Si, con la profundidad de ataque determinado por AFM y SEM. A fin de facilitar los pasos de metrología, una (100) de la oblea de Si se modela con una rejilla de líneas que están diseñados para ser visible después de la preparación UHV por un microscopio óptico de larga distancia de trabajo, formación de imágenes ópticas AFM vista en planta, ybajo magnificación plan de visión de imágenes SEM. Para ayudar a identificar las estructuras a nanoescala, los patrones de 1 m 2 de serpentina (SERPs) se modelan en las muestras con las nanopatrones más aisladas situadas en ubicaciones fijas en relación con los SERPs.
Esta combinación de HDL, ALD selectiva, y RIE puede ser un proceso importante para la fabricación de nanoestructuras, y que incluye un metrología escala atómica como un subproducto natural del proceso. A continuación, incluimos una descripción detallada de los pasos necesarios para fabricar-10 sub nanoestructuras nm en Si (100) utilizando el HDL, ALD selectiva y RIE. Se supone que uno es experto en cada uno de estos procesos, pero la información se incluirá relacionada a la manera de integrar los diversos procesos. Se prestará especial atención a aquellas dificultades inesperadas experimentados por los autores con el fin de evitar que las mismas dificultades, especialmente en relación con el transporte y la metrología.
Protocol
Representative Results
Discussion
Realización de la metrología en las nanoestructuras descritos anteriormente requiere la capacidad de tender un puente sobre el posicionamiento de punta durante el HDL y el patrón de localización usando otras herramientas como AFM y SEM. En contraste con otras herramientas de modelado bien desarrollados con codificación de posición de alta resolución tales como la litografía por haz de electrones, la HDL realizado aquí se realizó con un STM sin posicionamiento grueso bien controlada, por lo que se utiliza…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Este trabajo fue apoyado por un contrato de DARPA (N66001-08-C-2040) y por una subvención del Fondo de Tecnologías Emergentes del Estado de Texas. Los autores desean reconocer Jiyoung Kim, Greg Mordi, Angela Azcatl, y Tom Scharf por sus contribuciones relacionadas con selectiva deposición de capas atómicas, así como Wallace Martin y Gordon Pollock para el procesamiento de muestras ex situ.
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

