Atomik İzlenebilir Nanoyapı İmalatı
Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
Nanoteknoloji yapılarını anlamak arenalarda, geniş bir yelpazede daha önemli hale geldikçe, özellikle litografi ve elektronik alanlarında, önem kazanmaktadır oluşturulmuştur. Özellikle 10 nm altındaki ölçeklerde, nano metroloji önemini vurgulamak için, sadece 1 nm özelliği büyüklüğünde bir varyasyonu fraksiyonel varyasyon en az% 10 olduğunu gösterir işaret edilmelidir. Bu varyasyon cihaz performansı ve malzeme karakter için önemli etkileri olabilir 1,2 -. 4 sentetik yöntemler kullanarak, örneğin kuantum noktaları veya diğer kompleks moleküller olarak çok hassas oluşan bireysel özellikler 2,5,6, fabrikasyon ama genellikle aynı hassasiyeti eksik olabilir boyut ve yerleştirme kontrolü geliştirmeye yönelik çalışmalarına rağmen özellik yerleştirme ve oryantasyon içinde. Bu kağıt yakın atomik boyut hassasiyeti ve özellik yerleştirme atomik hassas nano imalatı, yanı sıra bir yaklaşım gösteriyorözellik yerleştirme atom metroloji ile. Tarama tünel Mikroskobu (STM) neden olduğu hidrojen Depassivation Taşbaskı (HDL) atomik hassas kullanarak, kimyasal olarak duyarlı kontrast atomik hassas desenler bir yüzey üzerinde oluşturulur. Şekil 1 'de şematik olarak gösterildiği gibi selektif Biriktirme Layer Atom (ALD) daha sonra, tepkisel iyonla hakketme (RIE) nihai yığın malzemeye desenleri aktarılması ile, desenli alanlarda sert oksit malzeme uygulanır. Standardı ile son derece hassas HDL işlemi birleştiren ALD ve RIE esnek bir yöntem ile sonuçlanır rasgele şekil ve konumlandırma bir yüzey üzerine nano üretmek için işler.
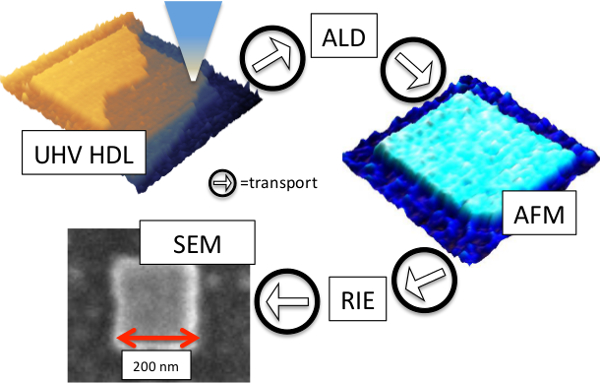
1. İlköğretim nanofabrikasyon Süreç Adımları Şekil. Bir örnek olarak, 200 nm x 200 mil kare gösterilmektedir. Her bir daire içine ok atmosfer koşullarında ve t aşamasını göstermektedirsiteler arasında ransport. UHV örnek hazırlık sonra, numune STM metroloji (sol üst) izledi UHV HDL kullanılarak desenli. ALD sonra AFM metroloji (sağda), ardından gerçekleştirilir. RIE SEM metroloji ardından Si (100), içine desenleri aktarır (sol altta). Bu rakamın büyük halini görmek için lütfen buraya tıklayınız.
Bugüne kadar en hassas litografi, genellikle taranmış prob teknikleri, atomik çözünürlükte desen ve işlevsel bir çok uygulama için gösterilmiştir, özellikle STM tabanlı model oluşturmanın içerir. büyük bir hassasiyetle 7, daha önce, atom manipülasyon üretti nano yapı taşları, 8 bireysel atomuna kullanılarak , 9,10 ancak böylece kriyojenik koşullar gereklidir ve nanoyapılar uzun vadeli sağlamlığını yoksundu. Yüzeyinden hidrojen atomunun ayrılmasıyla RT atomu manipülasyon specifical gösterilmiştirly HDL. 11,12,13 HDL yüzey kontrast mekansal lokalizasyonu dayalı elektronik ve diğer cihazlar, yeni sınıflar sağlamak için vaat ediyor. Daha fazla işleme tabi tutulmadan HDL'yi kullanarak, çeşitli cihaz mimarileri bağ telleri veya mantık cihazları sarkan dahil mümkündür. 14,15,16 Ayrıca elektrik kontrast sağlayarak, aslında, pasifleştirme H katmanı kaldırıldı yüzeyde kimyasal kontrast tanıtabilirsiniz HDL başkaca kimyasal modifikasyon için bir şablon oluşturma. Bu kimyasal modifikasyon metaller, 17 izolatörler, 18 ve hatta yarı iletkenler çökelmesi için seçicilik gösteren, silikon ve diğer yüzeyler üzerinde gösterilmiştir. 16,19 Bu örneklerin her birinin doğru üretmek için kullanılan gereken iki boyutlu bir yapı, bu nedenle diğer işlem adımlarını üreten üç HDL tarafından vaat atomik çözüldü kontrolü ile boyutlu yapılar. Daha önce, bu gerekli olan tekrarlanan desenlendirme, 19,20,21 tavlama, 22 </suBu tür uç tabanlı e-ışın kaynaklı birikimi olarak daha az p> ya çözülmüş süreçler. 23
E-ışın litografi benzer HDL bir karşı ortaya çıkarmak için bir elektron lokalize akı kullanır. Birkaç benzerlikler değişken nokta büyüklüğü ve desenlendirme verimliliği ile multi-mode litografi gerçekleştirmek için kapasite gibi mevcut. 24 Ancak, HDL'nin gerçek gücü e-ışın litografi farklıdır nasıl doğar. Birincisi, HDL direnen o poz dijital süreç haline karşı bu kadar atomik hidrojenin bir tek tabaka ise; atom ya da mevcut değilse ya da karşı. 25 H atomu yerleştirme (100) HDL süreci atomik hassas bir süreç olabilir kafes yatan Si karşılık bu yana, bu yazıda HDL nanometre hassasiyet olarak sahip olduğunu belirtmek gerekir, ancak Bu şekilde atomik mükemmellik sahiptir ve karşı bu durumda bir dijital değildir. HDL elektron kaynağı yüzeyine yerel olduğundan, STM çeşitli çalışma modları hem kolaylaştıranverim optimizasyonu yanı sıra hata kontrolü. ~ 4.5 V altında ucu-örnek önyargıları anda, litografi atomik hassas modu (AP modunda) olarak bilinen atom hassas, tek atom düzeyinde yapılabilir. Buna karşılık, ~ 7 V üzerinde önyargıları de, elektronlar Field Emission modu (FE modu) olarak bilinen geniş Burada Çizgi genişlikleri ve yüksek depassivation verimlilikleri ile örnek ucu doğrudan yayılır. Genel çıktılar mümkün 1 mikron 2 / dakikaya kadar desenlendirme ile litografi-ışın e küçük akrabası kalsa da HDL çıktılar, sonra bu iki mod dikkatli kombinasyonu ile optimize edilebilir. Önyargı ve böylece ters edildiğinde numune böylece hata düzeltme ve atomik ölçek metroloji hem yüzey atom yapısı denetlenmesine izin, son derece düşük depassivation verimliliği ile ucu örnek -2,25 V, elektronlar tünelin ~ tutulur .
Şekil 1 'de gösterilen bu nano üretim süreci </stronyukarıda tarif edildiği gibi gr> bir UHV HDL adımla başlar. HDL takip ederek, numune (örneğin, yaklaşık 1 tek katmanlı) SiO2 katmanı. Taşıma sonra 26, örnek çökelmesi için bir ALD odasına yerleştirilen bir ince oluşturan, model verilmiş alanlar, su ile, doymuş hale bu süre içinde, atmosfere boşaltılır AFM ve XPS. 27 titanyum Reaksiyon yüzeyinin bir su doygunluğu bağlıdır yana ile ölçüldüğünde 2-3 mil burada biriken kalınlıklarda titanya (TiO2), bu işlem, yüzeyi su ile satüre bir atmosfer tabi olmasına rağmen mümkündür . Daha sonra, AFM ve SEM ile belirlendi aşındırma derinliği ile, örnek Si 20 mil kaldırılır, böylece rie kullanılarak kazınmış olan toplu olarak ALD maske deseni aktarmak için kullanılır. Metroloji adımlarını kolaylaştırmak amacıyla, bir Si (100) gofret, uzun çalışma mesafesi optik mikroskop, AFM plan görünümü optik görüntüleme ile UHV hazırlıktan sonra görünür olacak şekilde tasarlanmıştır çizgilerin bir ızgara ile desenli, veDüşük büyütme planı manzaralı SEM görüntüleme. Nanoölçekli yapılarını belirlemek yardımcı olmak için, 1 mikron 2 serpantin desen (SERPs) SERPs göre sabit konumlarda bulunan en izole nanopatterns ile numunelerin üzerine desenli.
HDL, seçmeli ALD ve RIE bu kombinasyonu nano imalatı için önemli bir işlem olabilir ve bu sürecinin doğal bir yan ürünü olarak bir atom ölçekli metroloji içerir. Aşağıda, Si HDL, seçici ALD ve Rie kullanarak (100) alt 10 nm nano imal etmek katılan adımların ayrıntılı bir açıklamasını içerir. Bu bir bu işlemlerin her uzman olduğu kabul edilmektedir, ancak bu bilgiler, çeşitli işlemleri nasıl entegre ilgili dahil edilecektir. Özellikle vurgu, aynı zorlukları önlemek amacıyla yazarlar tarafından yaşanan bu beklenmedik zorluklar verilen özellikle ulaşım ve metroloji ile ilgili olacaktır.
Protocol
Representative Results
Discussion
Yukarıda tarif edilen nanoyapılarda üzerinde metroloji gerçekleştirme gibi AFM ve SEM gibi diğer araçları kullanarak HDL ve desen konumu sırasında uç konumlandırma köprü yeteneği gerektirir. Şekil 3'te gösterildiği gibi, e-ışını litografi gibi yüksek çözünürlüklü pozisyonu kodlama ile diğer gelişmiş desen araçlarının tersine olarak, burada gerçekleştirilen HDL, bu yüzden ekstra pozisyon tanımlaması protokoller kullanılmıştır, iyi kontrol edilen kaba konuml…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Bu eser DARPA (N66001-08-C-2040) bir Sözleşmede ve Texas Eyaleti Gelişen Teknoloji Fonu bir hibe ile desteklenmiştir. Yazarlar seçici atom tabakası birikimi ile ilgili katkıları, hem de ex-situ numune işleme Wallace Martin ve Gordon Pollock için Jiyoung Kim, Greg mordi Angela Azcatl ve Tom SCHARF kabul etmek istiyorum.
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

