Summary
We report a protocol for combining the atomic metrology of the Scanning Tunneling Microscope for surface patterning with selective Atomic Layer Deposition and Reactive Ion Etching. Using a robust process involving numerous atmospheric exposures and transport, 3D nanostructures with atomic metrology are fabricated.
Abstract
Reducing the scale of etched nanostructures below the 10 nm range eventually will require an atomic scale understanding of the entire fabrication process being used in order to maintain exquisite control over both feature size and feature density. Here, we demonstrate a method for tracking atomically resolved and controlled structures from initial template definition through final nanostructure metrology, opening up a pathway for top-down atomic control over nanofabrication. Hydrogen depassivation lithography is the first step of the nanoscale fabrication process followed by selective atomic layer deposition of up to 2.8 nm of titania to make a nanoscale etch mask. Contrast with the background is shown, indicating different mechanisms for growth on the desired patterns and on the H passivated background. The patterns are then transferred into the bulk using reactive ion etching to form 20 nm tall nanostructures with linewidths down to ~6 nm. To illustrate the limitations of this process, arrays of holes and lines are fabricated. The various nanofabrication process steps are performed at disparate locations, so process integration is discussed. Related issues are discussed including using fiducial marks for finding nanostructures on a macroscopic sample and protecting the chemically reactive patterned Si(100)-H surface against degradation due to atmospheric exposure.
Introduction
Som nanoteknologi blir mer viktig i et bredt spekter av arenaer, forstå strukturene som dannes stadig viktigere, spesielt i felt av litografi og elektronikk. For å understreke viktigheten av Justervesenet på nanonivå, spesielt på vekter under 10 nm, bør det påpekes at en variasjon i funksjon størrelse på bare 1 nm indikerer en brøk variasjon på minst 10%. Denne variasjonen kan ha betydelige konsekvenser for enheten ytelse og vesentlig karakter 1,2 -. 4 Bruke syntetiske metoder, kan meget presist dannet enkelte funksjoner som kvanteprikker eller andre komplekse molekyler være fabrikkert, 2,5,6 men generelt mangler den samme presisjon funksjon plassering og orientering, til tross for arbeidet mot å forbedre størrelse og plassering kontroll. Dette papiret demonstrerer en tilnærming for å fabrikkere nanostrukturer med nær atomstørrelse presisjon og atom presisjon i funksjon plassering, samtmed atom metrologi i funksjonen plassering. Bruke atom presisjonen Scanning tunneling mikroskop (STM) indusert Hydrogen depassivation Litografi (HDL), er atomically nøyaktige mønstre med kjemisk sensitive kontrast dannet på en overflate. Selektiv atomlag avsetning (ALD) gjelder da en hard oksydmateriale i mønstrede områder, med ioneetsning (RIE) til slutt overføring av mønstre i massegodset, slik som vist skjematisk i figur 1. Ved å kombinere det meget presis HDL prosess med standard ALD og RIE prosesser resulterer i en fleksibel fremgangsmåte for å fremstille nanostrukturer på en overflate med vilkårlig form og plassering.
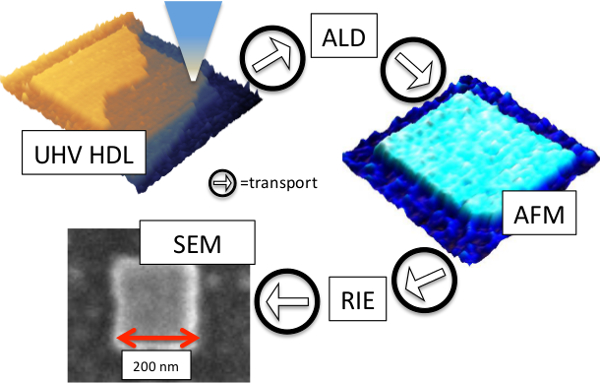
Figur 1. Primær Nanofabrication prosesstrinn. Som et eksempel, et 200 nm x 200 nm kvadrat er vist. Hver sirkel indikerer pilen et trinn for værpåvirkning og transport mellom områder. Etter UHV prøven prep blir prøven mønstrede hjelp UHV HDL fulgt av STM metrologi (øverst til venstre). ALD utføres deretter, fulgt av AFM metrologi (til høyre). RIE overfører mønstre i Si (100), etterfulgt av SEM metrologi (nederst til venstre). Klikk her for å se en større versjon av dette tallet.
Den mest presise litografi oppdatert innebærer vanligvis skannede probe teknikker, spesielt STM-basert mønster der atom oppløsning mønster og funksjon er påvist i mange applikasjoner. 7 Tidligere har atom manipulasjon produsert nanostrukturer med ultimate presisjon ved hjelp av individuelle atomer som byggeklosser, 8 , 9,10 men nanostrukturer som kreves kryogeniske forhold og dermed manglet langsiktig robusthet. RT atom manipulering av fjerning av hydrogenatomer fra overflaten har blitt vist, specifically HDL. 11,12,13 HDL lover å muliggjøre nye klasser av elektroniske og andre anordninger basert på den romlige lokalisering av overflate kontrast. Ved hjelp av HDL uten ytterligere behandling, forskjellige enhets arkitekturer er mulig, inkludert dingler båndetråder eller logiske enheter. 14,15,16 I tillegg til å tilveiebringe elektrisk kontrast, HDL kan innføre kjemisk kontrast på overflaten hvor det passiverende sjiktet H er fjernet i virkeligheten lage en mal for ytterligere kjemisk modifikasjon. Denne kjemiske modifikasjon er blitt demonstrert på silisium og andre overflater, som viser selektivitet for avsetning av metaller, 17, isolatorer 18 og til og med halvledere. 16,19 Hvert av disse eksemplene frembringer to dimensjonale strukturer, slik at andre behandlingstrinn må brukes for å fremstille ekte tre dimensjonale strukturer med atomically løst kontroll lovet av HDL. Tidligere har dette krevde gjentatt mønster, 19,20,21 gløding, 22 </sup> eller mindre godt løst prosesser som tip-baserte e-bjelke indusert deponering. 23
Ligner på e-beam litografi, bruker HDL en lokalisert fluks av elektroner for å avsløre en motstå. Flere likheter eksisterer slik som evnen til å utføre multi-modus litografi med variabel spot størrelse og mønster effektivitet. 24 Men den sanne kraft av HDL oppstår fra hvordan det skiller seg fra e-beam litografi. Først resisten i HDL er et monolag av atomisk hydrogen, slik at motstå eksponering blir en digital prosess; resisten atomet enten er eller ikke er til stede. 25 Siden H-atom plassering svarer til den underliggende Si (100) gitter HDL-prosessen kan være en atomisk nøyaktig prosess, selv om det bør bemerkes at i dette papiret HDL har nanometerpresisjon som motsetning til å ha atom fullkommenhet og således ikke er digitalt i dette tilfellet. Siden elektronkilden i HDL er lokalt opp til overflaten, de forskjellige moduser av STM drift lette bådegjennomstrømming optimalisering samt feilsjekking. På tip-prøven skjevheter under ~ 4,5 V, kan litografi utføres på enkelt atom nivå med atom presisjon, kjent som atomically Presis mode (AP-modus). I motsetning til dette, ved forspenner oven ~ 7 V, blir elektroner som utsendes direkte fra spissen til prøven med brede linjebredder og høy effektivitet depassivation, kjent her som feltavgi modus (FE-modus). HDL-hastigheter kan deretter optimaliseres ved omhyggelig kombinasjon av disse to modi, selv om de samlede gjennomstrømnings forblir liten i forhold til e-beam lithography med mønstring opp til omkring 1 pm 2 / minutt mulig. Når forspenningen blir reversert, slik at prøven holdes ved ~ -2,25 V, elektroner tunnel fra prøven til spissen med ekstremt lav depassivation effektivitet, og således tillate inspeksjon av atomstrukturen til overflaten både for feilkorreksjon og for atommålestokk metrology .
Dette nanostrukturen fabrikasjon prosessen vist i figur 1 </strong> starter med en UHV-HDL trinn, som beskrevet ovenfor. Etter HDL blir prøven ventilert til atmosfære, på hvilket tidspunkt de mønstrede områder blir mettet med vann, danner en tynn (dvs. ~ 1 monolag) SiO to lag. 26 Etter transport blir prøven satt inn i en ALD kammer for avsetning av titanoksid (TiO2), med tykkelser i størrelsesorden 2-3 nm avsatt her, som målt ved AFM og XPS. 27 Siden titandioksyd reaksjonen avhenger av en vannmetning på overflaten, er denne prosessen er mulig til tross for eksponering mot atmosfæren som metter overflaten med vann . Deretter for å overføre ALD maskemønster i hovedmassen prøven ble etset ved bruk av RIE slik at 20 nm av Si er fjernet, med etsedybden bestemmes av AFM og SEM. For å lette metrologi trinn, er en Si (100) wafer mønstret med et rutenett av linjene som er designet for å være synlig etter UHV utarbeidelse av en lang arbeidsavstand optisk mikroskop, AFM plan-view optisk imaging, oglav forstørrelse plan-view SEM bildebehandling. Å bidra til å identifisere nanoskala strukturer, er en mikrometer to serpentin mønstre (SERPs) mønstret på prøvene med de mest isolerte nanopatterns plassert på faste steder i forhold til søkemotorer.
Denne kombinasjonen av HDL, selektiv ALD, og RIE kan være en viktig prosess for fabrikasjon nanostrukturen, og det omfatter en atommålestokk metrologi som et naturlig biprodukt av prosessen. Nedenfor har vi en detaljert beskrivelse av trinnene involvert for å dikte sub-10 nm nanostrukturer i Si (100) ved hjelp av HDL, selektiv ALD, og RIE. Det antas at en er dyktig i hver av disse fremgangsmåter, men informasjonen vil bli inkludert relatert til å integrere de ulike prosessene. Særlig vekt vil bli gitt til de uventede vanskeligheter som oppleves av forfatterne for å hindre de samme problemene, spesielt knyttet til transport og metrologi.
Protocol
Representative Results
Discussion
Utføre metrologi på nanostrukturer som er beskrevet ovenfor krever evne til å bygge bro spissen posisjonering under HDL og mønster plassering ved hjelp av andre verktøy som AFM og SEM. I motsetning til andre velutviklede mønstrings verktøy med høy oppløsning stilling koding som e-beam litografi, ble HDL utført her utført med en STM uten godt kontrollert grovinnstilling, slik at ekstra posisjonsidentifikasjons protokollene ble anvendt, slik som vist i figur 3 . Først blir en lang brennvidde m…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Dette arbeidet ble støttet av en kontrakt fra DARPA (N66001-08-C-2040) og av en bevilgning fra Emerging Technology Fund i delstaten Texas. Forfatterne ønsker å takke Jiyoung Kim, Greg Mordi, Angela Azcatl, og Tom Scharf for deres bidrag knyttet til selektiv atomic layer deponering, samt Wallace Martin og Gordon Pollock for ex-situ utvalgets behandling.
Materials
| Si Wafer | VA Semiconductor | P type (Boron) Si<100> +/- 2 degrees, 280 mm +/- 25 mm thick, 0.01-0.02 ohm-cm | |
| Ta foil | Alfa Aesar | 335 | 0.025mm (0.001in) thick, 99.997% (metals basis) |
| Methanol | Alfa Aesar | 19393 | Semiconductor Grade, 99.9% |
| 2-Propanol | Alfa Aesar | 19397 | Semiconductor Grade, 99.5% |
| Acetone | Alfa Aesar | 19392 | Semiconductor Grade, 99.5% |
| Argon | Praxair | Ultra high purity (grade 5.0) | |
| Deionized water | Millipore | Milli-Q Water Purification System | >18 MW resistance water produced on demand. |
| TiCl4 | Sigma Aldrigh | 254312 | ≥99.995% trace metals basis |
| O2 | Matheson | G2182101 | Research Grade |
| SF6 | Matheson | G2658922 | Ultra high purity (grade 4.7) |
| Blue Medium Tack Roll | Semiconductor Equipment Corporation | 18074 | Thickness 75 um / .003” Length 200 M / 660’ |
References
- Yoffe, A. D. Low-dimensional systems: quantum size effects and electronic properties of semiconductor microcrystallites (zero-dimensional systems) and some quasi-two-dimensional systems. Adv. in Phy. 42 (2), 173-262 (1993).
- Alivisatos, A. P. Semiconductor Clusters, Nanocrystals, and Quantum Dots. Science. 271 (5251), 933-937 (1996).
- Craighead, H. G. Nanoelectromechanical Systems. Science. 290 (5496), 1532-1535 (2000).
- Dai, M. D., Kim, C. -. W., Eom, K. Finite size effect on nanomechanical mass detection: the role of surface elasticity. Nanotechnology. 22 (26), 265502 (2011).
- Personick, M., Mirkin, C. Making sense of the mayhem behind shape control in the synthesis of gold nanoparticles. J. Am. Chem. Soc. 135 (C), 18238-18247 (2013).
- Rothemund, P. W. K., Ekani-Nkodo, A., et al. Design and Characterization of Programmable DNA. Nanotubes. J. Am. Chem. Soc. 26, 16344-16353 (2004).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W. Silicon-based molecular nanotechnology. Nanotechnology. 11 (2), 70-76 (2000).
- Eigler, D. M., Schweizer, E. K. Positioning single atoms with a scanning tunnelling microscope. Nature. 344, 524-526 (1990).
- Heinrich, A. J., Lutz, C. P., Gupta, J. A., Eigler, D. M. Molecular cascades. Science. 298, 1381-1387 (2002).
- Crommie, M. F., Lutz, C. P., Eigler, D. M. Confinement of Electrons to Quantum Corrals on a Metal Surface. Science. 262 (5131), 218-220 (1993).
- Shen, T. -. C., Wang, C., et al. Atomic-Scale Desorption Through Electronic and Vibrational Excitation Mechanisms. Science. 268, 1590-1592 (1995).
- Randall, J. N., Lyding, J. W., et al. Atomic precision lithography on Si. J. Vac. Sci. Tech. B. 27 (6), 2764-2768 (2009).
- Tong, X., Wolkow, R. A. Electron-induced H atom desorption patterns created with a scanning tunneling microscope: Implications for controlled atomic-scale patterning on H-Si(100). Surf. Sci. 600 (16), L199-L203 (2006).
- Hitosugi, T., Hashizume, T., et al. Scanning Tunneling Spectroscopy of Dangling-Bond Wires Fabricated on the Si(100)-2×1-H Surface. Jap. J. App. Phys, Pt 2 2. 36 (3B), L361-L364 (1997).
- Bird, C. F., Fisher, A. J., Bowler, D. R. Soliton effects in dangling-bond wires on Si(001). Phys. Rev B. 68, 115318 (2003).
- Wolkow, R. A., Livadaru, L., et al. . Beyond-CMOS Electronics. , 1-28 (2013).
- Lyding, J. W., Shen, T. -. C., Hubacek, J. S., Tucker, J. R., Abeln, G. C. Nanoscale patterning and oxidation of H-passivated Si(100)-2×1 surfaces with an ultrahigh vacuum scanning tunneling microscope. App. Phys. Lett. 64 (15), 2010-2012 (1994).
- Lyding, J. W., Shen, T. -. C., Abeln, G. C., Wang, C., Tucker, J. R. Nanoscale patterning and selective chemistry of silicon surfaces by ultrahigh-vacuum scanning tunneling microscopy. Nanotechnology. 7, 128-133 (1996).
- Owen, J. H. G., Ballard, J., Randall, J. N., Alexander, J., Von Ehr, J. R. Patterned Atomic Layer Epitaxy of Si / Si(001):H. J. Vac. Sci. Tech. B. 29 (6), 06F201 (2011).
- Goh, K. E. J., Chen, S., Xu, H., Ballard, J., Randall, J. N., Ehr, J. R. Von Using patterned H-resist for controlled three-dimensional growth of nanostructures. App. Phys. Lett. 98 (16), 163102 (2011).
- Ye, W., Peña Martin, P. Direct writing of sub-5 nm hafnium diboride metallic nanostructures. ACS Nano. 4 (11), 6818-6824 (2010).
- Brien, J. L., Schofield, S. R., et al. Scanning tunnelling microscope fabrication of arrays of phosphorus atom qubits for a silicon quantum computer. Smart. 11 (5), 741-748 (2002).
- Van Oven, J. C., Berwald, F., Berggren, K. K., Kruit, P., Hagen, C. W. Electron-beam-induced deposition of 3-nm-half-pitch patterns on bulk Si. J. Vac. Sci. Tech. B. 29 (6), 06F305 (2011).
- Ballard, J. B., Sisson, T. W., et al. Multimode hydrogen depassivation lithography: A method for optimizing atomically precise write times. J. Vac. Sci. Tech. B. 31 (6), 06FC01 (2013).
- Randall, J. N., Ballard, J. B., et al. Atomic precision patterning on Si: An opportunity for a digitized process. Microelec. Eng. 87 (5-8), 955-958 (2010).
- Perrine, K. A., Teplyakov, A. V. Reactivity of selectively terminated single crystal silicon surfaces. Chem. Soc. Rev. 39 (8), 3256-3274 (2010).
- McDonnell, S., Longo, R. C., et al. Controlling the Atomic Layer Deposition of Titanium Dioxide on Silicon: Dependence on Surface Termination. The J. Phys. Chem. C. 117 (39), 20250-20259 (2013).
- Kane, D. F. Plasma cleaning of metal surfaces. J. Vac. Sci. Tech. 11 (3), 567 (1974).
- Hersam, M. C., Guisinger, N. P., Lyding, J. W., Thompson, D. S., Moore, J. S. Atomic-level study of the robustness of the Si(100)-2×1:H surface following exposure to ambient conditions. App. Phys. Lett. 78 (7), 886-888 (2001).
- Agostino, R., Flamm, D. L. Plasma etching of Si and SiO2 in SF6–O2 mixtures. J. App. Phys. 52 (1), 162 (1981).
- Longo, R. C., McDonnell, S., et al. Selectivity of metal oxide atomic layer deposition on hydrogen terminated and oxidized Si(001)-(2×1) surface. J. Vac. Sci Tech. B. 32 (3), 03D112 (2014).
- Ruess, F. J., Oberbeck, L., et al. The use of etched registration markers to make four-terminal electrical contacts to STM-patterned nanostructures. Nanotechnology. 16 (10), 2446-2449 (2005).
- Ruess, F. J., Pok, W., et al. Realization of Atomically Controlled Dopant Devices in Silicon. Small. 3 (4), 563-567 (2007).
- Li, K., Namboodiri, P., et al. Controlled formation of atomic step morphology on micropatterned Si (100). J. Vac. Sci. Tech. B. 29 (4), 041806 (2011).
- Ballard, J. B., Owen, J. H. G., et al. Pattern transfer of hydrogen depassivation lithography patterns into silicon with atomically traceable placement and size control. Journal of Vacuum Science and Technology B. 32 (4), 041804 (2014).
- Gusev, E. P., Cabral, C., Copel, M., D’Emic, C., Gribelyuk, M. U ltrathin HfO 2 films grown on silicon by atomic layer deposition for advanced gate dielectrics applications. Microelectronic Engineering. 69, 145-151 (2003).

