استخدام الهدى النانوية لإزالة آثار طلقة الضوضاء في ثقوب الاتصال اختلقتها E-شعاع الطباعة الحجرية
Summary
موحد النانوية الحجم يمكن إزالة التقلبات في أبعاد الاتصال حفرة نمط في بولي (ميتاكريليت الميثيل) أفلام (PMMA) مقاومة للضوء عن طريق شعاع الالكترون (شعاع E) الطباعة الحجرية. وتنطوي العملية على مجازاته كهرباء لمركز ودائع النانوية في ثقوب الاتصال، تليها إنحسر مقاومة للضوء والخطوات البلازما والرطب الحفر.
Abstract
متعدد الأنماط نانو ملفقة مع الأشعة فوق البنفسجية الشديد (فوق البنفسجي) أو شعاع الإلكترون (E-شعاع) الطباعة الحجرية معرض التغيرات غير المتوقعة في حجم. ويعزى هذا الاختلاف إلى تقلبات إحصائية في عدد الفوتونات / الإلكترونات التوصل إلى نانو منطقة معينة الناشئة من النار الضوضاء (SN). وSN يختلف عكسيا مع الجذر التربيعي لعدد من الفوتونات / الإلكترونات. لجرعة ثابتة، وSN هو أكبر في فوق البنفسجي وE-شعاع lithographies من ل(193 نانومتر) الطباعة الحجرية الضوئية التقليدية. يتم الجمع بين من أسفل إلى أعلى والزخرفة من أعلى إلى أسفل النهج للحد من آثار الضوضاء النار في الزخرفة نانو حفرة. على وجه التحديد، وأميني سيلاني السطحي تجميع الذاتي على رقاقة السيليكون التي تدور في وقت لاحق المغلفة مع فيلم 100 نيوتن متر من مقاوم الضوء شعاع E أساس PMMA. التعرض لشعاع E وتطور لاحق كشف الفيلم بالسطح الكامنة في قيعان من الثقوب. غمس رقاقة في تعليق سالبة الشحنة، وتوج سترات، 20 نانومتر زالنانوية القديمة (GNP) ودائع جسيم واحد في حفرة. يتعرض موجبة فيلم السطحي في حفرة مسارات تحويل كهربية على جسيمات متناهية الصغر سالبة الشحنة إلى وسط حفرة مكشوفة، الذي يحدد بشكل دائم التسجيل الموضعية. بعد ذلك، عن طريق التسخين بالقرب من درجة حرارة التحول الزجاجي من البوليمر مقاومة للضوء، الفيلم مقاومة للضوء إعادة تدفق ويجتاح النانوية. هذه العملية تقوم بمسح الثقوب تتأثر SN لكن يترك الناتج القومي الإجمالي المودعة في مكان مغلق من قبل كهرباء قوية ملزمة. العلاج مع البلازما الأكسجين تكشف الناتج القومي الإجمالي من الحفر طبقة رقيقة من مقاومة للضوء. الرطب فإن النقش الناتج القومي الإجمالي تتعرض بمحلول مكون من أنا 2 / KI ينتج الثقوب موحدة تقع في وسط المسافات البادئة نمط بواسطة البريد شعاع الطباعة الحجرية. قدمت التجارب تظهر أن النهج يقلل من التباين في حجم الثقوب التي تسببها SN من 35٪ إلى أقل من 10٪. يمتد أسلوب حدود الزخرفة من الثقوب الترانزستور اتصال لأقل من 20 نانومتر.
Introduction
النمو المتسارع في السلطة الحسابية، كما كميا بواسطة قانون مور 1 و 2 (1)، هو نتيجة للإنجازات تقدمية في الطباعة الحجرية الضوئية. في هذه التقنية الزخرفة من أعلى إلى أسفل، والقرار قابل للتحقيق، R، تعطى من قبل المعروفة رالي نظرية 3:

هنا، λ وNA هي طول الموجة الضوء والفتحة العددية، على التوالي. لاحظ أن NA = η · sinθ، حيث η هو مؤشر الانكسار من الوسط بين العدسة والرقاقة. θ = تان -1 (د / 2L) لقطر، د، العدسة، والمسافة، ل، بين مركز العدسة والرقاقة. على مدى السنوات الخمسين الماضية، تحسنت قرار معدني من خلال استخدام (أ) مصدر الضوءالصورة، بما في ذلك أشعة الليزر الهيجان، مع موجات الأشعة فوق البنفسجية أصغر تدريجيا. (ب) تصاميم بصرية ذكية تستخدم أقنعة مرحلة التحول 4؛ و (ج) أعلى NA. لتعرض في (η = 1) الهواء، NA هو دائما أقل من وحدة وطنية، ولكن عن طريق إدخال السائل مع η> 1، مثل المياه 5، بين العدسة ويفر، NA يمكن أن تكون مرتفعة أعلى من 1، وبالتالي تحسين القرار من الطباعة الحجرية الغمر. مسارات قابلة للحياة إلى عقدة 20 نانومتر وخارجها وتشمل حاليا مصادر الأشعة فوق البنفسجية القصوى (λ = 13 نانومتر) أو تقنيات الزخرفة باستخدام معالجة مزدوجة ورباعية معقدة من مقاومة للضوء متعدد الطبقات 6 و 7.
في موازين نانومتر طول، وتقلبات الإحصائية، والناجمة عن النار الضوضاء (SN)، في عدد من الفوتونات وصوله ضمن سبب الاختلاف نانو المنطقة في أبعاد lithogra أنماط phic. وهذه الآثار هي أكثر وضوحا مع التعرض للضوء فوق البنفسجي ذات الطاقة العالية وأشعة E، الأنظمة التي تحتاج أوامر من حجم أقل الفوتونات / الجزيئات مقارنة مع الطباعة الحجرية الضوئية العادية 8. مفرط الحساسية تضخيم كيميائيا (مع كفاءة الكم> 1) مقاومات الضوء أيضا إدخال وSN الكيميائية الناجمة عن الاختلاف في عدد الجزيئات photoreactive في nanoregions تتعرض 9 و 10. أقل مقاومات الضوء الحساسية التي تحتاج إلى التعرض أطول قمع هذه الآثار، ولكنها أيضا تقليل الإنتاجية.
على المستوى الجزيئي، وربما يتم تخفيض باستخدام المقاومات الجزيئية 11 مساهمة في خط حافة خشونة من توزيع حجم الجزيئية الكامنة للبوليمرات مقاومة للضوء. وهذا نهج مكمل لهذه المعالجة من أعلى إلى أسفل النانو الزخرفة هو استخدام أساليب من أسفل إلى أعلى 12،الصورة = "XREF"> 13 التي تعتمد بشكل خاص على إخراج التجميع الذاتي (DSA) من البوليمرات diblock 14. قدرة هذه العمليات لتوجيه التنوي وخلق تباعد غير موحدة بين أنماط المطلوب، مثل الثقوب أو خطوط، لا يزال تحديا. توزيع حجم المكونات الجزيئية 15، 16 يحد أيضا على نطاق والعائد من تصنيع 17، 18. مشاكل مماثلة تحد microcontact الطباعة النانوية في الطباعة الحجرية الناعمة (19).
تقدم هذه الورقة دراسات نهج الهجين الجديد (الشكل 1) التي تجمع بين أعلى إلى أسفل إسقاط الطباعة الحجرية التقليدية مع توجه كهربية التجميع الذاتي للحد من تأثير SN / خط حافة خشونة (لير) 20. موجبة مجموعات أمين على تجميعها النفس الطبقات الوحيدة (صواريخ سام) ن – (2-aminoethyl)ويتعرض -11-أمينو-undecyl-ميثوكسي سيلاني (AATMS) الكامنة وراء الفيلم PMMA بعد التطوير. الفيلم مقاومة للضوء سالبة الشحنة من PMMA كهربية مداخل سلبا تهمة الجسيمات النانوية الذهبية (الناتج القومي الإجمالي)، وتوج مع سترات، 21-24 في ثقوب المتضررة SN 25. إعادة تدفق مقاومة للضوء PMMA يجتاح النانوية predeposited في الفيلم.
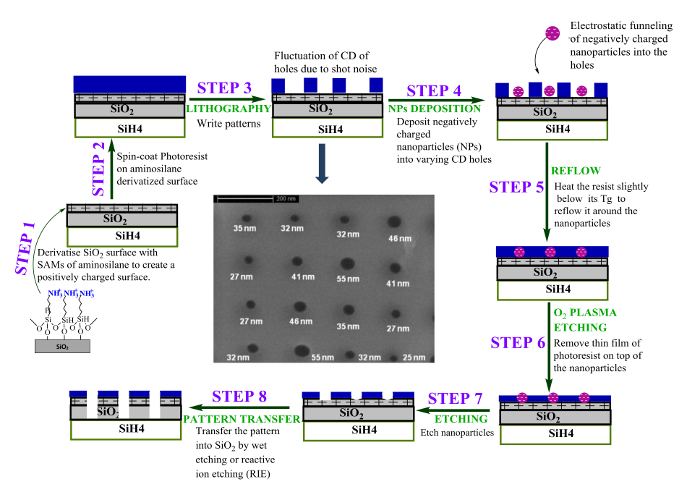
الشكل 1: تمثيل تخطيطي للاستراتيجية لإزالة آثار طلقة الضوضاء وخط حافة خشونة لالزخرفة من الثقوب الاتصال باستخدام مصادر القدرة النووية من حجم الدقيق. هنا، والبعد الحاسم (CD) هو القطر المطلوب من الثقوب. النهج (الخطوة 1) يبدأ إيداع أحادي الطبقة الذاتي تجميعها (SAM) من جزيء سيلاني تحمل مجموعات أمين موجبة على الأمواج أكسيدالآس رقاقة السيليكون. بعد ذلك، يتم استخدام شعاع E الطباعة الحجرية إلى نمط الثقوب (الخطوات 2 و 3) في PMMA فيلم مقاومة للضوء، وطبقة زرقاء، الذي يولد النار الضوضاء، كما هو موضح في أقحم SEM صورة. الطباعة الحجرية تكشف المجموعات أمين في الجزء السفلي من الثقوب. الخطوة 4 تستلزم مرحلة الترسيب المائي لسيطرة الحجم، المغطاة سترات (سالبة الشحنة) جزيئات الذهب (الناتج القومي الإجمالي) في الثقوب منقوشة lithographically باستخدام مجازاته كهرباء (EF). في الخطوة 5، تسخين ويفر إلى 100 درجة مئوية، وأقل درجة حرارة التحول الزجاجي من PMMA، 110 درجة مئوية، يسبب إنحسر من مقاوم الضوء حول الجسيمات النانوية أودعت مسبقا. النقش مضافين PMMA مع البلازما الأكسجين (الخطوة 6) يفضح الناتج القومي الإجمالي، ولاحق الرطب الحفر (اليود) من الجسيمات يتعرض (الخطوة 7) يخلق الثقوب المقابلة لحجم الناتج القومي الإجمالي. عندما يقترن مع رد الفعل ايون / الرطب الحفر، فمن الممكن لنقل نمط ثقب في الواقي الضوئي للشافي 2 (الخطوة 8) 31. إعادةطبع بإذن من المرجع 20. الرجاء انقر هنا لعرض نسخة أكبر من هذا الرقم.
التفاعل الكهربائي بين الناتج القومي الإجمالي اتهم معاكس ومجموعات أمين على الركيزة يمنع النزوح من الناتج القومي الإجمالي من موقع ملزم. تحتفظ الخطوة إنحسر الموقع النسبي من الناتج القومي الإجمالي ولكن يمحو الثقوب وآثار SN / لير. بلازما / خطوات النقش الرطب تتجدد الثقوب التي لديها حجم الناتج القومي الإجمالي. رد الفعل ايون النقش بتحويل نمط لشافي 2 طبقات بجد قناع. والطريقة تعتمد على استخدام أكثر توحيدا النانوية الحجم من nanohole نمط (NH)، كما أعرب عن الانحراف المعياري، σ، بحيث σ الناتج القومي الإجمالي <σ NH. ويركز هذا التقرير على الخطوات (4 و 5 هو موضح في الشكل رقم 1) التي تنطوي على ترسب الجسيمات النانوية من التشتت وإنحسر من مقاومة للضوء من حولهم لتقييم مزايا وقيود هذه الطريقة. كلا الخطوات هي، من حيث المبدأ، قابلة للركائز أكبر، لا تتطلب تعديلات واسعة النطاق في التدفق الحالي للإنتاج الدوائر المتكاملة الحديثة على رقائق.
Protocol
Representative Results
Discussion
لقطة الضوضاء (SN) في الطباعة الحجرية هو نتيجة بسيطة من التقلبات الإحصائية في عدد من الفوتونات أو الجسيمات (N) وصوله الى نانو منطقة معينة. فمن يتناسب عكسيا مع الجذر التربيعي لعدد من الفوتونات / الجسيمات:
<img alt="المعادلة 3" src="/files/ftp_upload/545…
Disclosures
The authors have nothing to disclose.
Acknowledgements
بتمويل شركة إنتل هذا العمل من خلال منحة رقم 414305، ومبادرة تقنية النانو والتكنولوجيات الدقيقة ولاية أوريغون (ONAMI) قدمت الأموال مطابقة. نحن الامتنان الدعم والمشورة للدكتور جيمس بلاكويل في جميع مراحل هذا العمل. شكر خاص إلى درو Beasau وتشيلسي بنديكت السادس عشر لتحليل إحصاءات الجسيمات المواقع. نشكر الأستاذ قاعة للقراءة متأنية للمخطوطة والدكتور كورت Langworthy، في جامعة ولاية أوريغون، يوجين، OR، لمساعدته مع شعاع E الطباعة الحجرية.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

