Die Verwendung von Aufopferungs Nanopartikel zu entfernen, die Auswirkungen von Shot-Rauschen in Kontaktlöchern Vorgefertigte durch Elektronenstrahl-Lithografie
Summary
Einheitlicher Größe Nanopartikel können in Poly (methylmethacrylat) (PMMA) Photoresistfilme durch Elektronenstrahl (E-Strahl) Lithographie gemustert Schwankungen in Kontaktlochabmessungen entfernen. Das Verfahren beinhaltet die elektrostatische funnelling zum Zentrum und Ablagerung Nanopartikel in Kontaktlöchern, gefolgt von Photoresist-Reflow-und plasma- und Nassätzen Schritte.
Abstract
Nano-Muster hergestellt mit extrem ultravioletten (EUV) oder Elektronenstrahl (E-Strahl) Lithografie zeigen unerwartete Variationen in der Größe. Diese Variation wurde auf statistische Schwankungen in der Anzahl der Photonen / Elektronen bei einer bestimmten Nanobereich vom Schrotrauschen (SN) auftretenden ankommen zurückzuführen. Die SN variiert invers mit der Quadratwurzel aus einer Anzahl von Photonen / Elektronen. Bei einer festen Dosierung ist die SN größer in der EUV-und E-Beam-Lithografien als bei herkömmlichen (193 nm) optische Lithographie. Bottom-up und Top-down-Musterbildungsverfahren kombiniert werden, um die Effekte von Schrotrauschen in Nano-Lochmusterbildung zu minimieren. Insbesondere wird ein Amino-Silan-Tensid durch Selbstorganisation auf einem Siliziumwafer, die anschließend aufgeschleudert wird mit einem 100 nm-Film aus einem PMMA-basierten E-beam Photoresist. Exposition gegenüber dem E-Strahl und der nachfolgenden Entwicklung enthüllen die zugrunde liegende Tensidfilm an den Böden der Löcher. Eintauchen des Wafers in einer Suspension von negativ geladenen, Citrat-capped, 20 nm galte Nanopartikel (BSP) Einlagen ein Teilchen pro Loch. Der belichtete positiv geladenen oberflächenaktiven Folie in das Loch elektrostatisch Trichtern der negativ geladenen Nanoteilchen an der Mitte eines belichteten Lochs, die permanent die Positionsregistrierungs fixiert. Als nächstes wird durch Erhitzen in der Nähe der Glasübergangstemperatur des Photoresistpolymer, verfließt der Photoresistfilm und verschlingt die Nanopartikel. Dieser Vorgang löscht die von SN betroffen Löcher lässt aber die eingerastet abgelagert GNPs durch starke elektrostatische Bindung. Die Behandlung mit Sauerstoffplasma macht die GNPs durch eine dünne Schicht des Photolacks geätzt wird. Naß-Ätzen der freigelegten GNPs mit einer Lösung von I 2 / KI ergibt in der Mitte der Vertiefungen durch E-Strahl – Lithographie gemustert angeordnet einheitliche Löcher. Die Experimente zeigen, dargestellt, dass der Ansatz die Variation in der Größe der Löcher reduziert, die durch SN von 35% auf unter 10%. Das Verfahren verlängert die Strukturierungsgrenzen des Transistors Kontaktlöcher auf unter 20 nm.
Introduction
Das exponentielle Wachstum in Rechenleistung, als 1 von Moores Gesetz quantifiziert, 2 (1), ist ein Ergebnis der fortschreitenden Fortschritte in der optischen Lithographie. In diesem Top-down – Strukturierungstechnik, die erreichbare Auflösung R wird von dem bekannten Raleigh Satz 3 gegeben:

Hier λ und NA sind die Lichtwellenlänge und der numerischen Apertur, respectively. Man beachte , daß NA = sin & theta; · η, wobei η der Brechungsindex des Mediums zwischen der Linse und dem Wafer; θ = tan -1 (d / 2 l) für den Durchmesser, d, der Linse und der Abstand L zwischen der Mitte der Linse und dem Wafer. In den letzten fünfzig Jahren hat die lithographische Auflösung durch die Verwendung von verbesserten (a) Lichtquelles, einschließlich Excimer-Lasern, mit zunehmend kleineren UV-Wellenlängen; (b) geschickte optische Designs unter Verwendung von Phasenverschiebungsmasken 4; und (c) höhere NA. Für die Belichtung in Luft (η = 1), ist NA immer kleiner als eins, aber durch Einführen einer Flüssigkeit mit η> 1, beispielsweise Wasser 5, zwischen der Linse und dem Wafer kann NA über 1 erhöht werden, wodurch die Auflösung des Eintauchens Lithographie zu verbessern. Derzeit tragfähige Wege zu einem 20-nm – Knoten und darüber hinaus sind extreme UV – Quellen (λ = 13 nm) oder Strukturierungsverfahren unter Verwendung komplexer Doppel- und Vierer Verarbeitung eines mehrschichtigen Photoresist 6, 7.
In Nanometer-Längenskalen, statistischen Schwankungen, hervorgerufen durch Schrotrauschen (SN), in der Anzahl von Photonen innerhalb einer Nanobereich Ursache Variation in den Dimensionen des lithogra ankommen phische Muster. Diese Effekte sind noch ausgeprägter bei Exposition gegenüber hochenergetischer EUV Licht und E-Strahlen, Systemen , die 8 Grßenordnungen weniger Photonen / Teilchen im Vergleich zu normalen optischen Lithographie benötigen. Supersensitive chemisch verstärkte (mit einem Quantenwirkungsgrad> 1) Photoresists einzuführen auch eine SN chemischen durch eine Variation in der Anzahl der photoreaktiven Moleküle in exponierten nanoregions verursacht 9, 10. Niedrigere Empfindlichkeit Photolacke, die längere Belichtungszeiten benötigen unterdrücken diese Effekte, sondern sie reduzieren auch den Durchsatz.
Auf molekularer Ebene zu der Beitrag Line-Kantenrauigkeit von der molekularen Größenverteilung , die zu den Photoresist – Polymere , die durch Verwendung von Molekular Resists 11 reduziert werden kann. Ein Ansatz, der zu diesem Top-down – Verarbeitung von Nanostrukturierung ist die Verwendung von Bottom-up – Verfahren komplementäres 12,s = "xref"> 13 , die 14 speziell auf die Selbstorganisation (DSA) von Diblockpolymeren verlassen. Die Fähigkeit dieser Verfahren Nukleation zu lenken und zu ungleichmäßigen Abstand zwischen gewünschten Mustern, wie Bohrungen oder Leitungen zu schaffen, bleibt eine Herausforderung. Die Größenverteilung der molekularen Komponenten 15, 16 begrenzt auch das Ausmaß und die Ausbeute der Herstellung 17, 18. Ähnliche Probleme begrenzen Mikrokontaktdruck von Nanopartikeln in Weich – Lithographie 19.
Dieser Beitrag stellt Untersuchungen eines neuen Hybrid – Ansatz (Abbildung 1), die die klassischen Top-Down – Projektionslithografie mit elektrostatisch Selbstorganisation kombiniert die Wirkung von SN / Line-Kantenrauigkeit (LER) 20 zu reduzieren. Positiv Amingruppen auf selbstorganisierte Monoschichten (SAMs) von N berechnet – (2-aminoethyl)-11-Amino-Undecyl-methoxy-Silan (AATMS), um die PMMA-Film zugrunde liegen, sind nach der Entwicklung ausgesetzt. Die negativ geladenen Photoresist – Film aus PMMA elektrostatisch Trichter negativ Goldnanopartikel (GNPs), mit einer Kappe bedeckt mit Citrat geladen, 21-24 in SN betroffenen Löcher 25. Re-flow des PMMA Photoresist verschlingt zuvor abgeschiedenen Nanopartikel in dem Film.
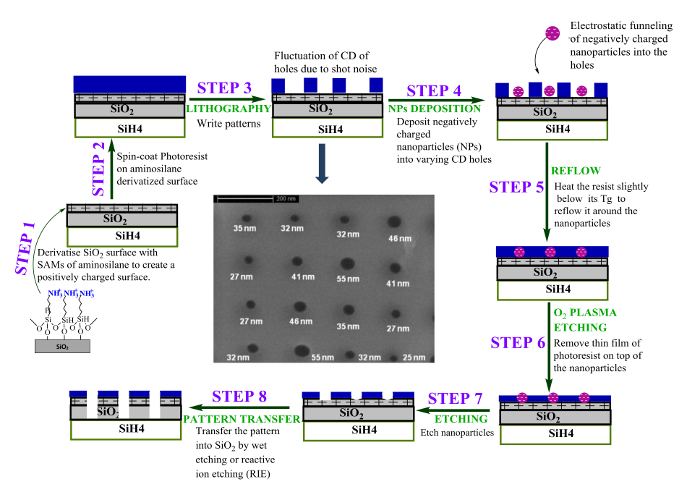
Abbildung 1: Schematische Darstellung der Strategie , um die Auswirkungen von Schrotrauschen und Linien Kantenrauigkeit für die Strukturierung von Kontaktlöchern mit NPs genaue Größe zu entfernen. Hier ist die kritische Dimension (CD) ist der gewünschte Durchmesser der Löcher. Der Ansatz (Schritt 1) beginnt mit einer selbstorganisierten Monoschicht (SAM) von Silan-Molekül Ablagern positiv geladene Aminogruppen auf dem Oxid Surflagerace eines Silizium-Wafers. Als nächstes wird die Löcher Muster Elektronenstrahllithographie verwendet (Schritte 2 und 3) in PMMA Photoresistfilm, der blauen Schicht, die Schrotrauschen erzeugt, wie in der eingesetzten SEM-Bild dargestellt. Lithographie belichtet Amingruppen an der Unterseite der Löcher. Schritt 4 beinhaltet die wässrige Phasenabscheidung von kontrollierter Größe, Citrat-capped (negativ geladene) Goldnanopartikel (GNPs) in lithographisch gemusterten Löcher unter Verwendung elektrostatischer funnelling (EF). In Schritt 5 Erwärmen des Wafers auf 100 ° C, unterhalb der Glasübergangstemperatur des PMMA, 110 ° C, bewirkt, daß das Aufschmelzen des Photoresist rund vorher entnommenes Nanopartikeln. Ätzen überlagert PMMA mit Sauerstoffplasma (Schritt 6) macht die GNPs und anschließende Nassätzen (Iod) der freigelegten Partikel (Schritt 7) erzeugt Löcher zu der Größe der GNPs entspricht. Gekoppelt mit reaktiven Ionen / Nassätzen, ist es möglich , die Lochmuster in dem Photoresist zu SiO 2 (Schritt 8) 31 zu übertragen. Regedruckt mit Genehmigung aus Lit. 20. Bitte klicken Sie hier , um eine größere Version dieser Figur zu sehen.
Die elektrostatische Wechselwirkung zwischen den entgegengesetzt geladenen GNPs und Amingruppen auf dem Substrat verhindert, dass die Verschiebung der GNPs von der Bindungsstelle. Der Reflow-Schritt hält die relative Anordnung der GNPs sondern löscht die Löcher und die Auswirkungen von SN / LER. Plasma- / Nassätzen Schritte regenerieren Löcher, die die Größe des BSP haben. Reaktives Ionenätzen überträgt ihr Muster zu SiO 2 Hartmaskenschichten. Das Verfahren beruht auf Verwendung von gleichmäßiger Größe Nanopartikel als eine gemusterte nanohole (NH), ausgedrückt als die Standardabweichung, σ, derart , daß σ GNP <σ NH. Dieser Bericht konzentriert sich auf die Schritte (4 und 5 in Abbildung 1 beschrieben) , um die Ablagerung von Nanopartikeln aus Dispersion beteiligt und dieAufschmelzen des Photoresist um sie herum die Vorteile und Grenzen des Verfahrens zu beurteilen. Beide Schritte sind im Prinzip skalierbar auf größeren Substraten, erfordern keine umfangreiche Änderung des Stromflusses von modernen integrierten Schaltungen auf Chips zu erzeugen.
Protocol
Representative Results
Discussion
Schrotrauschen (SN) in der Lithographie ist eine einfache Folge von statistischen Schwankungen in der Anzahl der Photonen oder Partikel (N) in einem gegebenen Nanobereich ankommen; Sie ist umgekehrt proportional zur Quadratwurzel aus einer Anzahl von Photonen / Teilchen:

wobei A und r sind der Bereich und die Größe des belichteten Bereiches, respectively. Beispielsweise bei Verwendu…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Intel Corporation finanziert diese Arbeit durch Grant-Nummer 414305 und der Oregon Nano- und Mikro Initiative (ONAMI) vorgesehen entsprechende Mittel. Wir danken für die Unterstützung und Beratung von Dr. James Blackwell in allen Phasen dieser Arbeit. Besonderer Dank geht an Drew Beasau und Chelsea Benedikt für die Analyse von Partikel Positionierung Statistiken. Wir danken Professor Halle für eine sorgfältige Lektüre des Manuskripts und Dr. Kurt Langworthy, an der University of Oregon, Eugene, OR, für seine Hilfe bei E-Strahl-Lithographie.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

