Het gebruik van Offer Nanodeeltjes te verwijderen van de effecten van Shot-noise in contact Gaten vervaardigd door E-lithografie
Summary
Uniforme grootte nanodeeltjes kunnen schommelingen in contact gat afmetingen patroon in poly (methyl methacrylaat) (PMMA) fotolakfilms door elektronenstraal (E-beam) lithografie te verwijderen. Het proces omvat elektrostatische trechtervorming naar het centrum en deposito nanodeeltjes in contact gaten, gevolgd door fotoresist reflow en plasma- en nat-etsen stappen.
Abstract
Nano-patronen gefabriceerd met extreem ultraviolet (EUV) of electron-beam (E-beam) lithografie vertonen onverwachte verschillen in grootte. Deze variatie is toegeschreven aan statistische fluctuaties in het aantal fotonen / elektronen komen tot een bepaalde nano-regio gevolg van opname-noise (SN). De SN omgekeerd evenredig met de vierkantswortel van een aantal fotonen / elektronen. Voor een vaste dosering, de SN is groter in EUV en E-beam lithografieën dan voor de traditionele (193 nm) optische lithografie. Bottom-up en top-down patroonvorming benaderingen worden gecombineerd om de effecten van geschoten geluid in nano-hole patronen te minimaliseren. Specifiek een amino-silaan surfactant zichzelf assembleert op een siliciumwafel die vervolgens roterend bedekken met een 100 nm film van een PMMA-basis E-beam fotoresist. Blootstelling aan de E-balk en de latere ontwikkeling onthullen de onderliggende oppervlakte-film bij de bodem van de gaten. Dompelen van de wafer in een opschorting van de negatief geladen, citraat afgedekt, 20 nm goude nanodeeltjes (BNP) deposito één deeltje per hole. De blootgestelde positief geladen oppervlakteactieve film in het gat trechters elektrostatisch de negatief geladen nanodeeltjes op het centrum van een gaatje, die permanent worden de positionele registratie. Vervolgens, door verwarmen bij de glasovergangstemperatuur van het fotoresist polymeer, de fotolaklaag doorloopt en overspoelt de nanodeeltjes. Dit proces wist de gaten beïnvloed door SN, maar laat het afgezette BNP plaats vergrendeld door sterke elektrostatische binding. Behandeling met zuurstofplasma blootstelt het BNP door etsen een dun laagje fotoresist. Nat-etsen van de belichte BNP met een oplossing van I2 / KI levert uniforme gaten in het midden van inkepingen gevormd door elektronenbundel lithografie. De experimenten laten dus zien dat de aanpak vermindert de variatie in de grootte van de gaten door SN van 35% tot minder dan 10%. De werkwijze breidt de patroonvorming grenzen van transistor contactgaten tot beneden 20 nm.
Introduction
De exponentiële groei van rekenkracht, zoals gekwantificeerd door de wet van Moore 1, 2 (1), is het resultaat van geleidelijke vooruitgang in optische lithografie. In deze top-down patroon techniek, de haalbare resolutie, R, wordt gegeven door de bekende Raleigh stelling 3:

Hier, λ en NA zijn het licht golflengte en numerieke lensopening, respectievelijk. NB NB = η · sinθ, waarbij η de brekingsindex van het medium tussen de lens en de wafer; θ = tan -1 (d / 2l) voor de diameter d van de lens, en de afstand L tussen het midden van de lens en de wafer. De afgelopen vijftig jaar heeft de lithografische resolutie verbeterd door het gebruik van (a) lichtbrons, waaronder excimer lasers met steeds kleinere UV golflengten; (b) slimme optische ontwerpen gebruik faseverschuiving maskers 4; en (c) hogere NA. Bij blootstelling aan de lucht (η = 1) NA is altijd kleiner dan één, maar door het introduceren van een vloeistof met η> 1, zoals 5 water, tussen de lens en de wafer, kan NA boven 1 verhoogd, zodat zij andere immersielithografie verbeteren. Nog levensvatbare paden een 20 nm-knooppunt en verder ook extreme UV bronnen (λ = 13 nm) of patroonvormingstechnieken gebruikt complexe dubbele en viervoudige bewerking van een meerlagige fotolak 6, 7.
Bij nanometer-lengteschalen, statistische fluctuaties, veroorzaakt door shot-noise (SN), het aantal fotonen aankomen binnen een nano-gebied veroorzaken variaties in de afmetingen van lithogra corticale patronen. Deze effecten zijn meer uitgesproken met blootstelling aan hoge-energie-EUV-licht en E-stralen, systemen die ordes van grootte minder fotonen / deeltjes nodig hebben in vergelijking met normale optische lithografie 8. Overgevoelige chemisch versterkte (met een kwantumrendement> 1) lichtgevoelige introduceren ook een chemische SN veroorzaakt door een variatie in het aantal fotoreactieve moleculen blootgesteld nanoregions 9, 10. Lagere gevoeligheid lichtgevoelige dat langere blootstelling moeten onderdrukken deze effecten, maar ze verminderen ook doorzet.
Op moleculaire schaal, de bijdrage aan lijn rand ruwheid van de moleculaire grootteverdeling inherent aan de fotoresist polymeren kunnen worden verminderd door moleculaire 11 resists. Een aanpak die complementair is aan deze top-down verwerking van nano-patroonvorming is het gebruik van bottom-up methoden 12,s = "xref"> 13 die beroept op de gerichte zelfassemblage (DSA) van diblokpolymeren 14. Het vermogen van deze processen direct kiemvorming en niet-uniforme afstand tussen gewenste patronen, zoals gaten of lijnen maken, blijft een uitdaging. De grootteverdeling van moleculaire componenten 15, 16 beperkt ook de omvang en opbrengst van fabricage 17, 18. Soortgelijke problemen beperken microcontactprinten van nanodeeltjes in zachte lithografie 19.
Dit artikel presenteert studies van een nieuwe hybride aanpak (Figuur 1) dat de klassieke top-down projectie lithografie met elektrostatisch gericht zelfassemblage combineert om het effect van SN / line-edge ruwheid (LER) 20 te verminderen. Positief geladen aminogroepen op zelf-geassembleerde monolagen (SAMs) N – (2-aminoethyl)-11-Amino-undecyl-methoxy-silaan (AATMS) achter de PMMA film blootgesteld na ontwikkeling. De negatief geladen fotolaklaag van PMMA elektrostatisch trechters negatief geladen gouden nanodeeltjes (BNP), afgedekt met citraat, 21-24 in-SN getroffen gaten 25. Opnieuw stroming van de PMMA fotoresist overspoelt predeposited nanodeeltjes in de film.
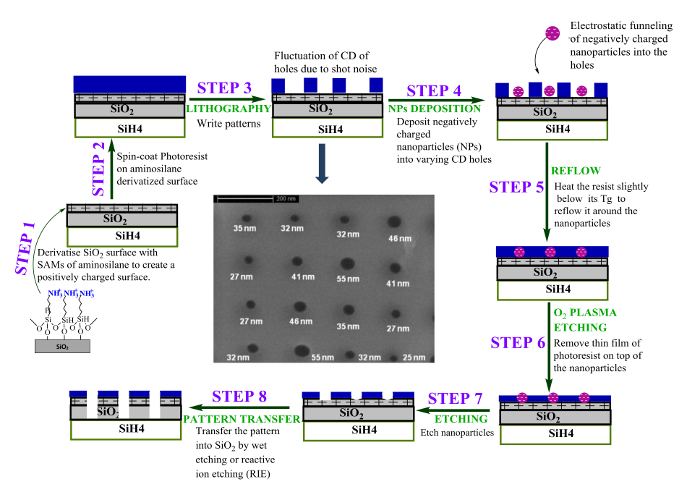
Figuur 1: Schematische weergave van de strategie om de gevolgen van de opname-noise en line-edge ruwheid te verwijderen voor de patroonvorming van contact gaten met behulp van NP van precieze grootte. Hier is de kritische dimensie (CD) is de gewenste diameter van de gaten. De benadering (stap 1) begint met afzetten van een zelf-geassembleerde monolaag (SAM) silaan molecule die positief geladen aminogroepen op het oxide brandingace van een silicium wafer. Vervolgens wordt E-lithografie gebruikt om de gaten patroon (stappen 2 en 3) in PMMA fotolaklaag, de blauwe laag die opname-lawaai ontstaat zoals weergegeven beeld de inzet SEM. Lithografie blootstelt aminegroepen onder in de gaten. Stap 4 behelst de waterfase afzetting van gecontroleerde-size, citraat bedekte (negatief geladen) gouden nanodeeltjes (BNP) in lithografisch patroon gaten met behulp van elektrostatische trechtervorming (EF). In stap 5 verhitten van de plak tot 100 ° C, beneden de glasovergangstemperatuur van het PMMA, 110 ° C, veroorzaakt de reflow van de fotoresist rond eerder afgegeven nanodeeltjes. Etsen bedekt met PMMA zuurstofplasma (stap 6) brengt BNP, en vervolgens nat-etsen (jodium) van de blootgestelde deeltjes (stap 7) creëert openingen overeenstemming met de diameter van het BNP. In combinatie met reactieve-ionen / nat-etsen, is het mogelijk om het gatenpatroon overdragen de fotoresist op SiO 2 (stap 8) 31. Opnieuwbedrukt met toestemming van referentie 20. Klik hier om een grotere versie van deze figuur te bekijken.
De elektrostatische interactie tussen de tegengesteld geladen BNP en aminegroepen op het substraat verhindert de verplaatsing van het BNP van de bindingsplaats. De reflow stap handhaaft de relatieve locatie van het BNP, maar wist de gaten en de effecten van SN / LER. Plasma / nat etsen stappen regenereren gaten dat de omvang van het BNP hebben. Reactief-ion etsen overdraagt hun patroon SiO 2 hard-masker lagen. De werkwijze berust op het gebruik van meer uniforme grootte nanodeeltjes dan gevormde nanohole (NH), uitgedrukt als de standaarddeviatie σ, zodat σ BNP <σ NH. Dit rapport staat stappen (4 en 5 in figuur 1 beschreven) waarbij de afzetting van nanodeeltjes uit dispersie en dereflow van de fotoresist om hen de voordelen en beperkingen van de methode te bepalen. Beide stappen zijn in beginsel schaalbaar tot grotere substraten, waarvoor geen uitgebreide modificatie van de stroom produceren moderne geïntegreerde circuits op chips.
Protocol
Representative Results
Discussion
Shot-noise (SN) in lithografie is een eenvoudige gevolg van statistische fluctuaties in het aantal fotonen of deeltjes (N) aankomst in een bepaalde nano-regio; is omgekeerd evenredig met de vierkantswortel van een aantal fotonen / deeltjes:

waarin A en R de stippellijn de grootte van het blootgestelde gebied, respectievelijk. Bijvoorbeeld, bij gebruik van een ArF-193 nm (6,4 eV) ex…
Disclosures
The authors have nothing to disclose.
Acknowledgements
Intel Corporation gefinancierd dit werk door middel van subsidie nummer 414.305, en de Oregon Nanotechnologie en microtechnologie Initiative (ONAMI) voorzien matching funds. Wij dankbaar erkennen de ondersteuning en advies van Dr. James Blackwell in alle fasen van dit werk. Speciale dank gaat uit naar Drew Beasau en Chelsea Benedict voor het analyseren deeltje positionering statistieken. Wij danken Professor Hall voor een zorgvuldige lezing van het manuscript en Dr. Kurt Langworthy, aan de Universiteit van Oregon, Eugene, OR, voor zijn hulp bij E-lithografie.
Materials
| AATMS (95%) | Gelest Inc. | SIA0595.0 | N-(2-aminoethyl)-11-aminoundecyltrimethoxysilane |
| Gold colloids (Ted Pella Inc.) | Ted Pella | 15705-20 | Gold Naoparticles |
| hydrogen peroxide | Fisher Scientific | H325-100 | Analytical grade (Used to clean wafer) |
| hydrochloric acid | Fisher Scientific | S25358 | Analytical grade |
| Ammonium hydroxide | Fisher Scientific | A669S-500SDS | Analytical grade (Used to clean wafer) |
| hydrogen fluoride | Fisher Scientific | AC277250250 | Analytical grade(used to etch SiO2) |
| Toluene (anhydrous, 99.8 %) | Sigma Aldrich | 244511 | Analytical grade (solvent used in Self Assembly of AATMS |
| Isopropyl alcohol (IPA) | Sigma Aldrich | W292907 | Analytical grade (Used to make developer) |
| Methyl butyl ketone (MIBK) | Sigma Aldrich | 29261 | Analytical grade(used to make developer) |
| 1:3 MIBK:IPA developer | Sigma Aldrich | Analytical grade (Developer) | |
| 950 k poly(methyl methacylate (PMMA, 4 % in Anisole) | Sigma Aldrich | 182265 | Photoresist for E-beam lithography |
| Purified Water : Barnstead Sybron Corporation water purification Unit, resistivity of 19.0 MΩcm | Water for substrate cleaning | ||
| Gaertner ellipsometer | Gaertner | Resist and SAM thickness measurements | |
| XPS, ThermoScientifc ESCALAB 250 instrument | Thermo-Scientific | Surface composition | |
| An FEI Siron XL30 | Fei Corporation | Characterize nanopatterns | |
| Zeiss sigma VP FEG SEM | Zeiss Corporation | E-beam exposure and patterning | |
| MDS 100 CCD camera | Kodak | Imaging drop shapes for contact angle measurements | |
| Tegal Plasmod | Tegal | Oxygen plasma to etch photoresist | |
| I2 | Sigma Aldrich | 451045 | Components for gold etch solution |
| KI | Sigma Aldrich | 746428 | Components for gold etch solution |
| Ellipsometer ( LSE Stokes model L116A); | Gaertner | L116A | AATMS self assembled monolayer film thickness measurements |
References
- Moore, G. E. Cramming more components onto integrated circuits. Electronics. 38 (8), 114 (1965).
- Moore, G. E., Allen, R. D. Lithography and the future of Moore’s law. SPIE Proc.: Advances in Resist Technology and Processing XII. 2438, 2-17 (1995).
- Rayleigh, L. On the theory of optical images, with special reference to the microscope. The London, Edinburgh, and Dublin Philosophical Magazine and J. Sci. 42 (255), 167-195 (1896).
- Levenson, M. D., Viswanathan, N. S., Simpson, R. A. Improving resolution in photolithography with a phase-shifting mask. IEEE Trans. Electron Devices. 29 (12), 1828-1836 (1982).
- French, R. H., Tran, H. V. Immersion Lithography: Photomask and Wafer-Level Materials. Annu. Rev. Mater. Res. 39 (1), 93-126 (2009).
- Borodovsky, Y. Complementary Lithography at Insertion and Beyond. , (2012).
- Reiser, A. . Photoreactive Polymers: the Science and Technology of Resists. , (1989).
- Brunner, T. A. Why optical lithography will live forever. J. of Vac. Sci. & Technol. B: Microelectronics and Nanometer Structures. 21 (6), 2632-2637 (2003).
- Tran, H., Jackson, E., Eldo, J., Kanjolia, R., Rananavare, S. B. Photochemical reactivity of bis-carbamate photobase generators. , 1683-1688 (2011).
- Hallett-Tapley, G. L., et al. Single component photoacid/photobase generators: potential applications in double patterning photolithography. J. Mater. Chem. C. 1 (15), 2657-2665 (2013).
- Krysak, M., De Silva, A., Sha, J., Lee, J. K., Ober, C. K., Henderson, C. L. Molecular glass resists for next-generation lithography. Proc. SPIE: Advances in Resist Materials and Processing Technology XXVI. 7273, 72732N (2009).
- Li, M., et al. Bottom-up assembly of large-area nanowire resonator arrays. Nat Nano. 3 (2), 88-92 (2008).
- Thiruvengadathan, R., et al. Nanomaterial processing using self-assembly-bottom-up chemical and biological approaches. Rep. Prog. Phys. 76 (6), 066501 (2013).
- Tsai, H. Y., Zhang, Y., Oehrlein, G. S., Lin, Q., et al. Pattern transfer of directed self-assembly (DSA) patterns for CMOS device applications. Proc.SPIE Advanced Etch Technology for Nanopatterning II. 8865, 86850L-86850L (2013).
- Hawker, C. J., Russell, T. P. Block Copolymer Lithography: Merging "Bottom-Up" with "Top-Down" Processes. MRS Bulletin. 30 (12), 952-966 (2005).
- Lin, Y., et al. Self-directed self-assembly of nanoparticle/copolymer mixtures. Nature. 434 (7029), 55-59 (2005).
- Cheng, J. Y., et al. Simple and Versatile Methods To Integrate Directed Self-Assembly with Optical Lithography Using a Polarity-Switched Photoresist. ACS Nano. 4 (8), 4815-4823 (2010).
- Wong, H. S. P., Bencher, C., Yi, H., Bao, X. Y., Chang, L. W., Tong, W. .. Block copolymer directed self-assembly enables sublithographic patterning for device fabrication. Proc. SPIE. 8323, Alternative Lithographic Technologies IV, (2012).
- Chan, J. C., Hannah-Moore, N., Rananavare, S. B. Controlled Deposition of Tin Oxide and Silver Nanoparticles Using Microcontact Printing. Crystals. 5 (1), 116-142 (2015).
- Morakinyo, M. K., Rananavare, S. B. Reducing the effects of shot noise using nanoparticles. J. Mater. Chem. C. 3 (5), 955-959 (2015).
- Cui, Y., et al. Integration of Colloidal Nanocrystals into Lithographically Patterned Devices. Nano Lett. 4 (6), 1093-1098 (2004).
- Huang, H. W., Bhadrachalam, P., Ray, V., Koh, S. J. Single-particle placement via self-limiting electrostatic gating. Appl. Phys. Lett. 93 (7), 073110-073113 (2008).
- Ma, L. C., et al. Electrostatic Funneling for Precise Nanoparticle Placement: A Route to Wafer-Scale Integration. Nano Lett. 7 (2), 439-445 (2007).
- Richard Bowen, W., Filippov, A. N., Sharif, A. O., Starov, V. M. A model of the interaction between a charged particle and a pore in a charged membrane surface. Adv. Colloid Interface Sci. 81 (1), 35-72 (1999).
- Morakinyo, M. K., Rananavare, S. B. Positional control over nanoparticle deposition into nanoholes. , 1677-1682 (2011).
- Keymeulen, H. R., et al. Measurement of the x-ray dose-dependent glass transition temperature of structured polymer films by x-ray diffraction. J. Appl. Phys. 102 (1), 013528 (2007).
- Feng, B. C. Resist Reflow Method for Making Submicron Patterned Resist Masks. US patent A. , (1977).
- You, J. H., et al. Position Shift Analysis in Resist Reflow Process for Sub-50 nm Contact Hole. Jpn. J. Appl. Phys. 48 (9), 096502 (2009).
- Montgomery, P. K., Fedynyshyn, T. H., et al. Resist reflow for 193-nm low-K1 lithography contacts. Proc. SPIE Advances in Resist Technology and Processing XX. 5039, 807-816 (2003).
- King, W. P., et al. Atomic force microscope cantilevers for combined thermomechanical data writing and reading. Appl. Phys. Lett. 78 (9), 1300-1302 (2001).
- Chuo, Y., et al. Rapid fabrication of nano-structured quartz stamps. Nanotechnology. 24 (5), 055304 (2013).
- Moreau, W. M. . Semiconductor Lithography: Principles, Practices, and Materials. , 419 (2012).
- Chan, J. C., Tran, H., Pattison, J. W., Rananavare, S. B. Facile pyrolytic synthesis of silicon nanowires. Solid-State Electron. 54 (10), 1185-1191 (2010).
- Tran, H. A., Rananavare, S. B. Synthesis and characterization of N- and P- doped tin oxide nanowires. , (2011).
- Tran, H. A., Rananavare, S. B., Morris, J. E., Iniewski, K. Ch. 39, Synthesis and Characterization of n- and p-Doped Tin Oxide Nanowires for Gas Sensing Applications. Nanoelectronic Device Applications Handbook . , (2013).

